
一种硅片背表面喷砂装置及工艺.pdf

猫巷****婉慧







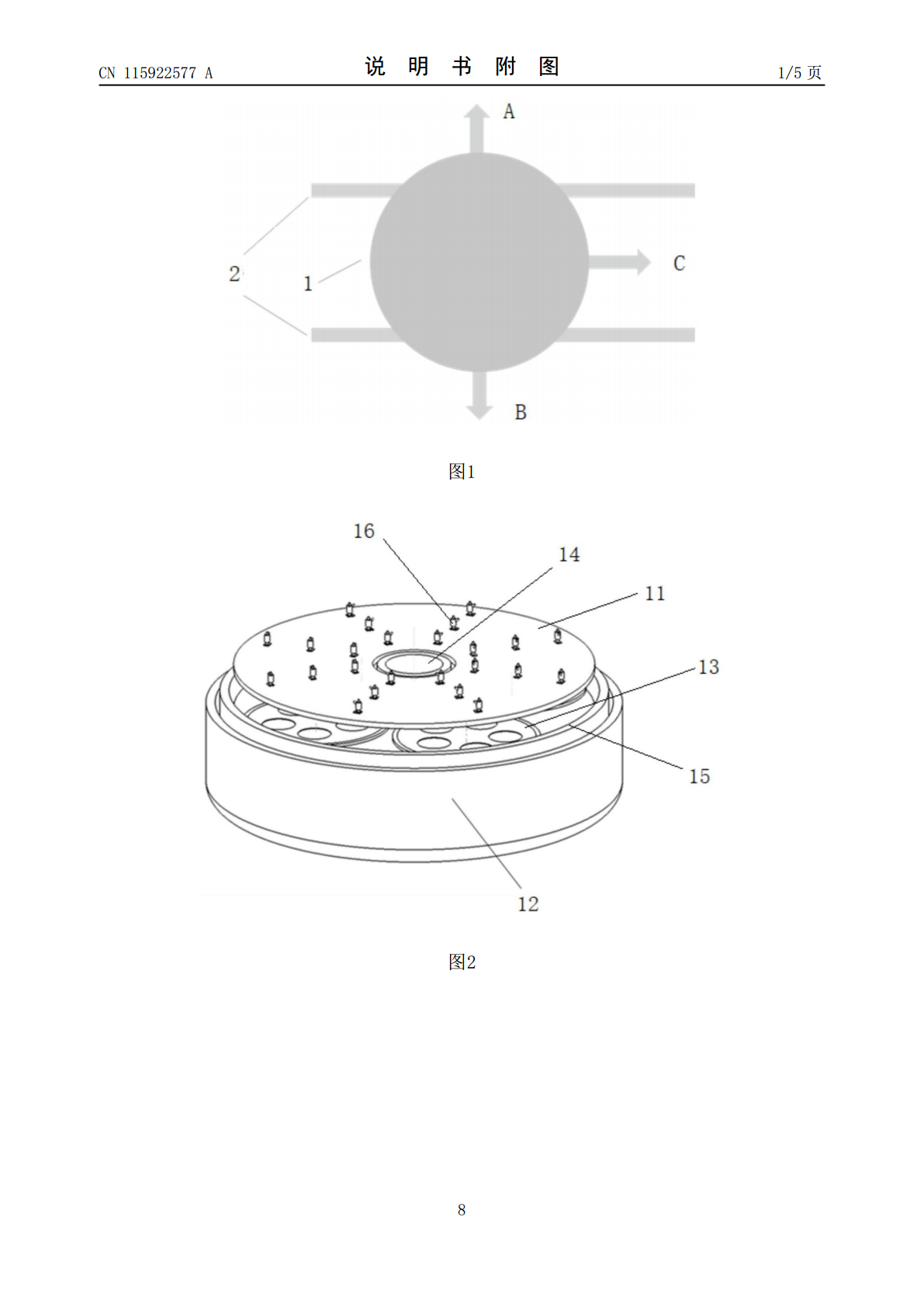
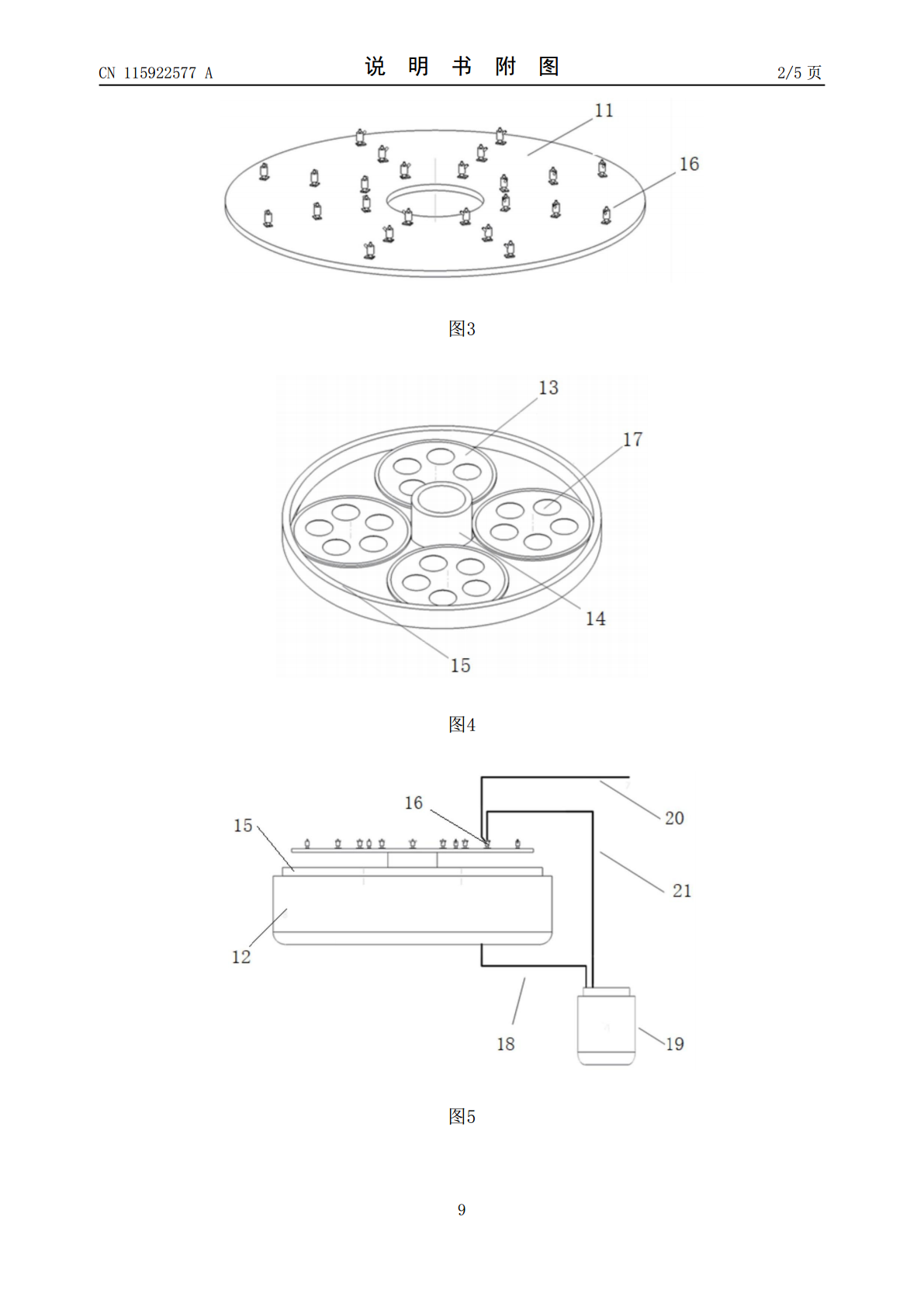

亲,该文档总共12页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种硅片背表面喷砂装置及工艺.pdf
本发明公开了一种硅片背表面喷砂装置及工艺。该喷砂装置包括盖板式喷枪上支架、设置在该喷枪上支架下方的壳体以及组装在该壳体中的多个陶瓷载具、内齿圈、外齿圈;内齿圈为柱状,其外周面具有内传动齿;外齿圈为圆环形,其外周面光滑,内周面具有外传动齿;多个陶瓷载具均匀分布在内齿圈与外齿圈之间,各陶瓷载具的外周分别与内齿圈外周面上的内传动齿和外齿圈内周面上的外传动齿啮合,内传动齿和外传动齿带动各陶瓷载具运转。在喷砂时,将硅片放置于陶瓷载具的硅片承载孔中,设定内齿圈的转向为正,转速为30‑65rpm;外齿圈的转向为负,转速

一种硅片表面处理装置.pdf
本实用新型公开了一种硅片表面处理装置,包括底座,所述底座的侧边设有电动升降杆,所述底座上设有转盘,所述转盘的底部与底座内的旋转电机相连接,所述转盘上设有多个夹持机构,本实用新型结构简单,设计新颖,特设的夹持机构不仅可对硅片进行定位,保证硅片在抛光过程中,不会随意移动,大大降低了硅片边缘被擦伤的风险,而且只需要通过调整夹持机构的松紧,即可轻松的将硅片取出,方便快捷。

一种筛板表面处理喷砂装置.pdf
本发明提供一种筛板表面处理喷砂装置,包括喷砂平台,所述喷砂平台的两侧依次滑动若干个夹紧件且端部设有立板;所述立板通过若干个夹持板与外环体连接固定;所述外环体的边沿部设有齿圈,电机通过齿轮与所述齿圈连接固定;所述喷砂平台正上方通过气缸连接罩体,所述喷砂平台的底部与旋流喷砂处理机相通连接;所述夹紧件包括滑框、与所述滑框铰接固定的压块;所述压块的两端连接万向滚珠。本发明的有益效果是:设计合理,结构稳固,提升产品良品率且操作方便。

一种陶瓷件表面喷砂处理工艺及喷砂机.pdf
本发明公开了一种陶瓷件表面喷砂处理工艺及喷砂机,喷砂机包括处理箱、喷涂组件、防护壳、电控板、清洗组件、定位组件、第一调节槽、排水孔、机架和输料组件,所述机架的顶部端面上方通过螺栓固定安装有处理箱,所述处理箱的顶部通过螺栓固定安装有防护壳,所述防护壳的内部一侧安装有喷涂组件,且喷涂组件与处理箱的内部连接,所述防护壳的端面一侧固定安装有电控板,所述处理箱的内侧底部中央开设有若干个排水孔,所述处理箱的底部端面两侧均开设有第一调节槽;本发明,上下料方便快捷;能够有效除去陶瓷件表面残留的灰尘和杂质;同时,陶瓷件安装

一种石英坩埚表面喷砂处理装置.pdf
本发明涉及石英坩埚表面处理技术领域,具体为一种石英坩埚表面喷砂处理装置,包括工作台,工作台上设有砂洗室,工作台上安装有传输装置;工作台内滑动有滑动装置、限位件,限位件与转轴通过凸轮连接,承载滑块上设有固定件,工作台内滑动有顶起件。通过滑动装置、限位件、凸轮连动并相抵设置,第一电机启动时破坏力平衡状态来使顶起件顶出固定件,固定件向上滑动,从而来固定石英坩埚,解决了现有技术中喷砂处理过程中受夹具影响的问题。
