
半导体器件及其制造方法.pdf

是你****盟主






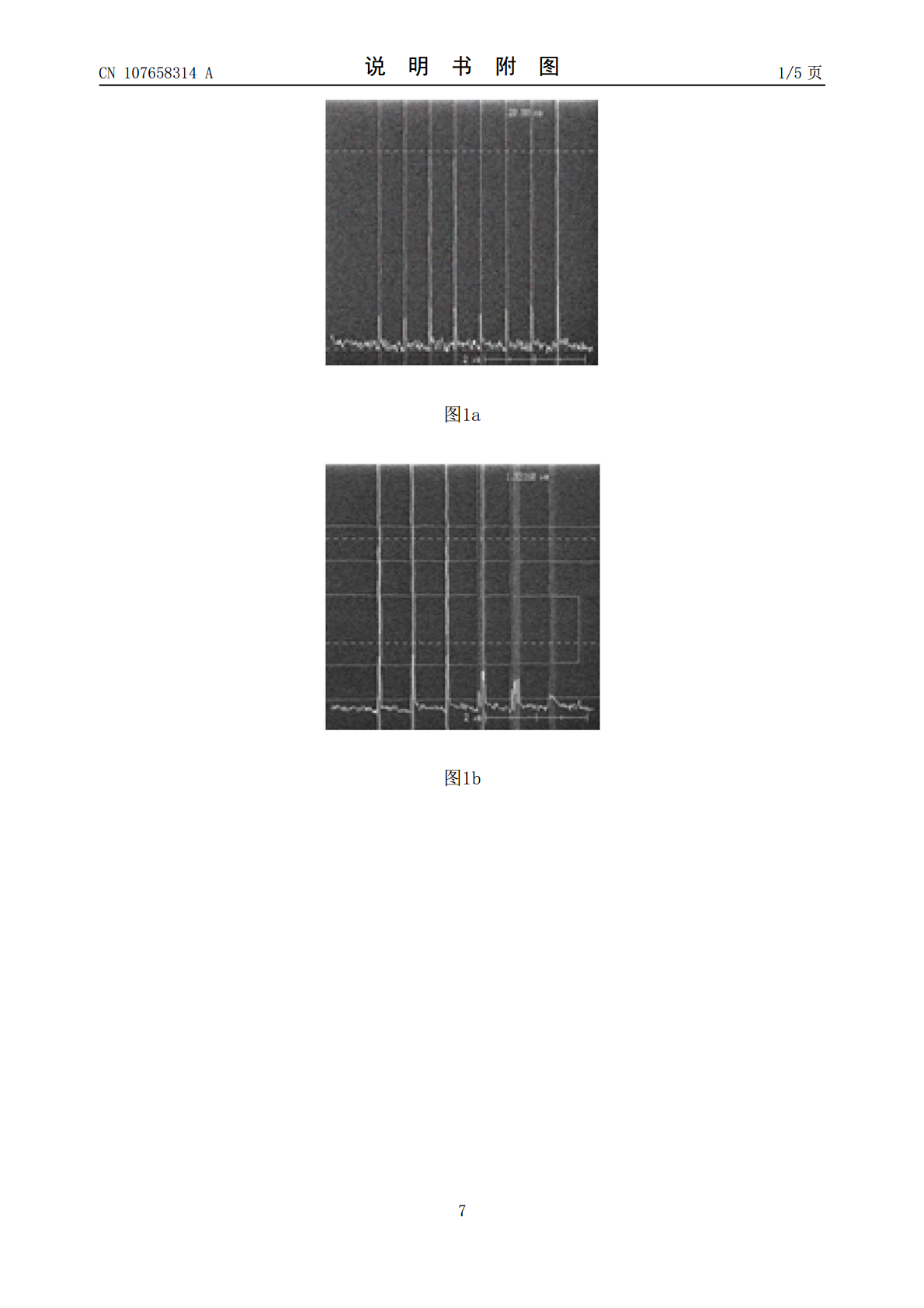
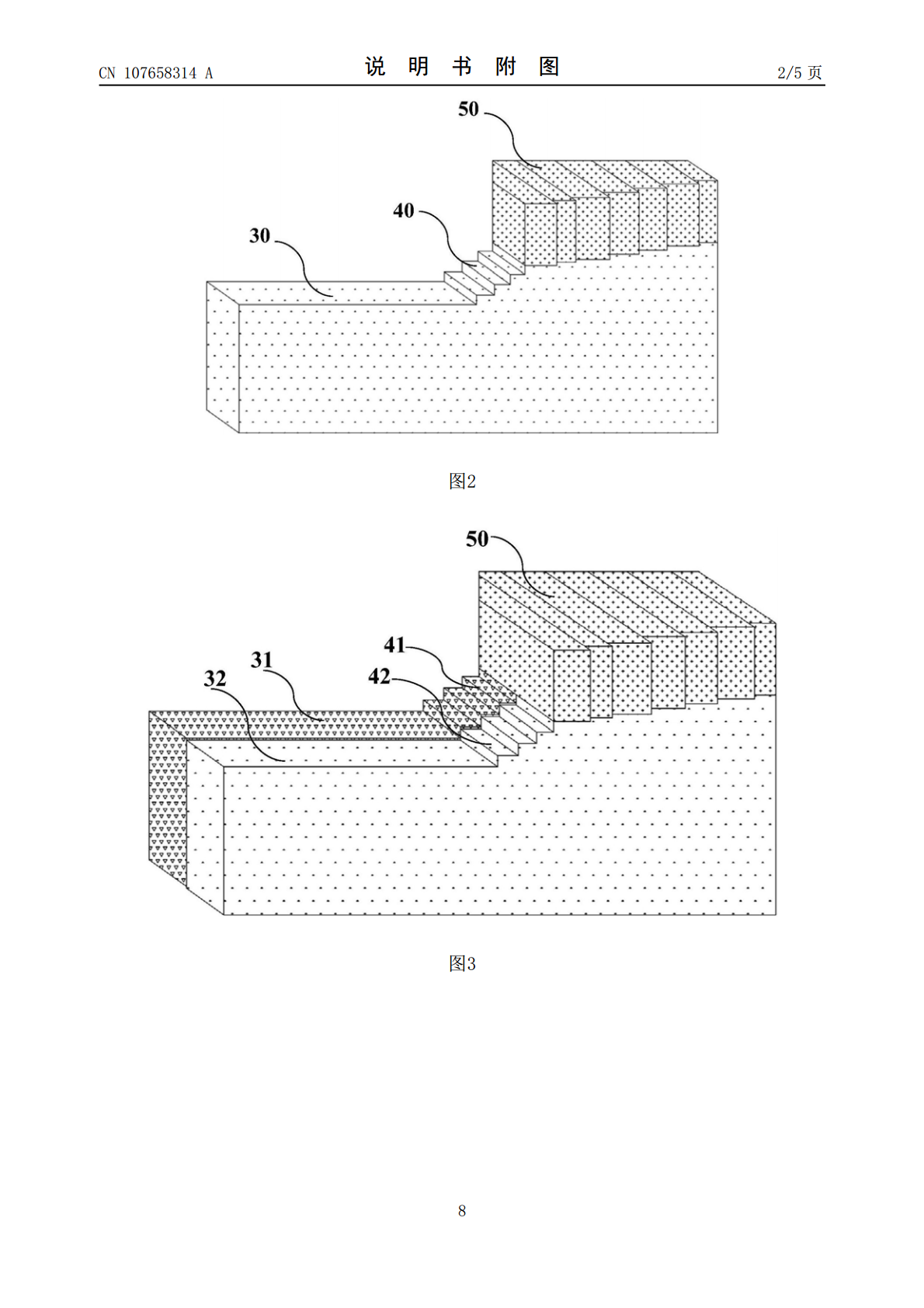
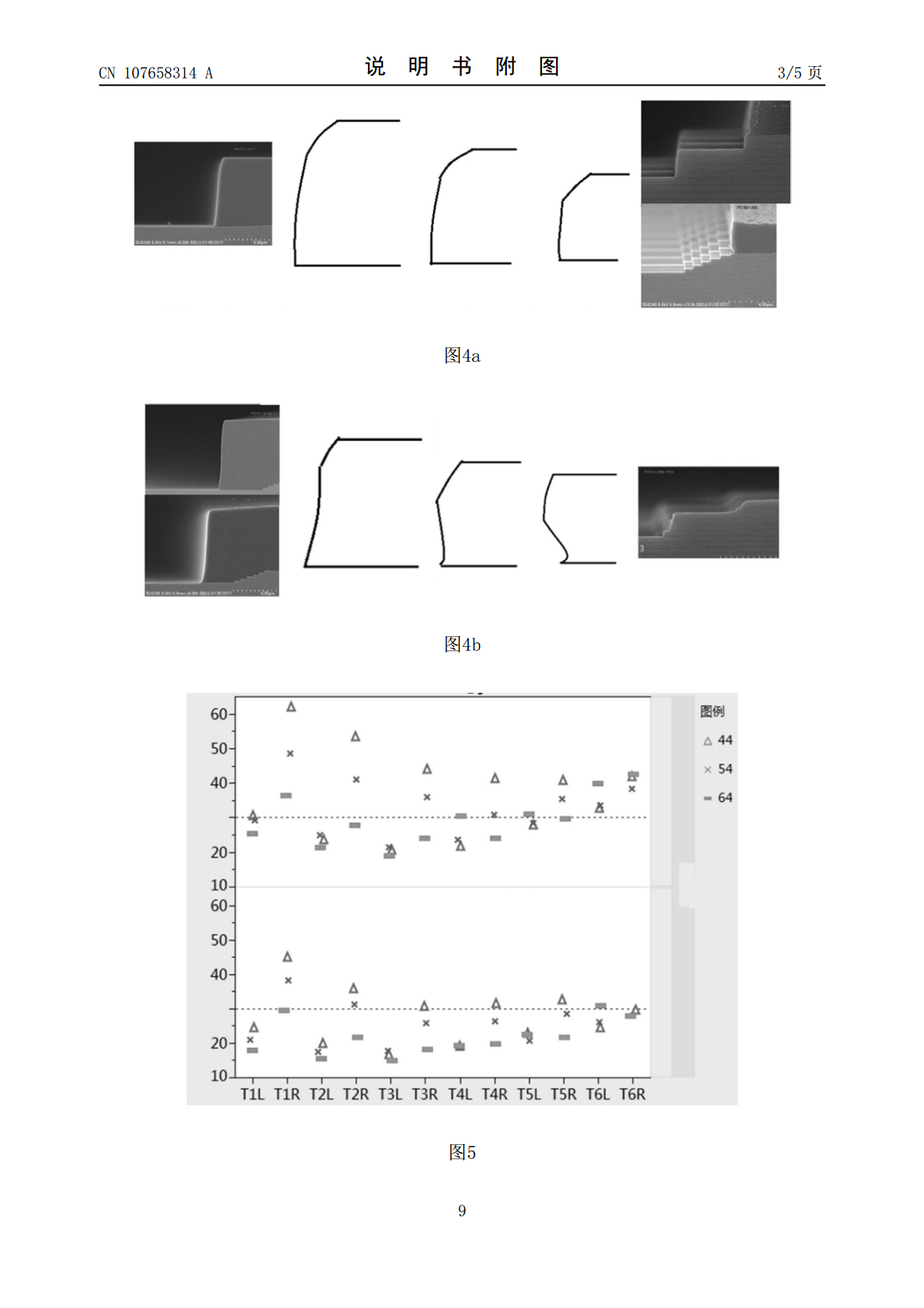

亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体器件及其制造方法.pdf
本发明属于半导体器件的制造技术领域,具体涉及一种半导体器件及其制造方法。随着半导体器件由32层向64层发展,线边缘粗糙度的问题也愈发突出,本发明在阶梯刻蚀过程中,通过严格控制光刻胶的边缘轮廓的形状,来解决台阶边缘粗糙度的问题,由于改善了阶梯的线边缘粗糙度,因而可以增加连接孔刻蚀关键尺寸的制程窗口。

半导体器件及其制造方法.pdf
本发明提供了一种半导体器件及其制造方法,涉及半导体技术领域。通过在制作栅极的过程中,先去除电极材料的一部分,使电极槽内保留的电极材料与第一隔离层之间形成隔离沟槽,同时隔离沟槽内可以再制作第二隔离层。如此,第一隔离层和第二隔离层的厚度之和会明显大于第一氧化层的厚度,从而使得第一电极和场板之间的隔离层的总体质量得到提高,使得半导体器件的栅源最大电压的极限值更高,同时可以解决器件的IGSS/HTGB失效问题,可以提高电极间的坚固性,提高器件的可靠性,器件的制作流程简单,隔离层的厚度可控,制作成本较低。

半导体器件及其制造方法.pdf
本发明实施例提供一种半导体器件及其制造方法,涉及微电子技术领域。该半导体器件包括半导体基底、源极、栅极和漏极。源极、栅极和漏极制作于所述半导体基底一侧,在源极所在区域预留有通孔区域并在该通孔区域制作有刻蚀阻挡层;位于所述刻蚀阻挡层下方设置有贯穿所述半导体基底的通孔。通过在源极中设置通孔区域,并在通孔区域内设置刻蚀阻挡层,使得在进行与源极对应的通孔刻蚀时,能减少对通孔区域源极金属的刻蚀损伤。在刻蚀过程中,可以更容易的判断刻蚀进度,降低通孔刻蚀的工艺难度。同时可以提高通孔刻蚀时的刻蚀选择比,减少刻蚀过程中刻蚀

半导体器件及其制造方法.pdf
本发明的各个实施例涉及半导体器件及其制造方法。半导体器件的性能得到改进。在用于制造半导体器件的方法中,在控制栅极电极的表面处顺序地形成第一绝缘膜、导电膜、包含硅的第二绝缘膜、和由硅形成的第三膜。然后,对第三膜进行回蚀刻,以经由第一绝缘膜、导电膜和第二绝缘膜将第三膜保留在控制栅极电极的侧表面处,从而形成间隔件。然后,对导电膜进行回蚀刻,以在间隔件与控制栅极电极之间、以及在间隔件与半导体衬底之间,形成由导电膜形成的存储器栅极电极。

半导体器件及其制造方法.pdf
本发明公开了一种半导体器件制造方法,包括:在衬底上形成沿第一方向延伸的多个鳍片;在鳍片上形成沿第二方向延伸的假栅极堆叠结构;在假栅极堆叠结构两侧的鳍片中形成第一源漏凹槽;在鳍片中第一源漏凹槽下方形成第二源漏凹槽,以及在第二源漏凹槽侧面形成第三源漏凹槽;在第二源漏凹槽和第三源漏凹槽中形成绝缘隔离层;在第一源漏凹槽中形成源漏区,源漏区之间的鳍片构成沟道区;在器件上形成层间介质层;去除假栅极堆叠结构,在层间介质层中留下栅极沟槽;在栅极沟槽中形成栅极堆叠结构。依照本发明的半导体器件及其制造方法,通过横向刻蚀源漏区
