
一种倒装GaN HEMT器件阵列的转移和异质集成方法及其器件阵列.pdf

如灵****姐姐








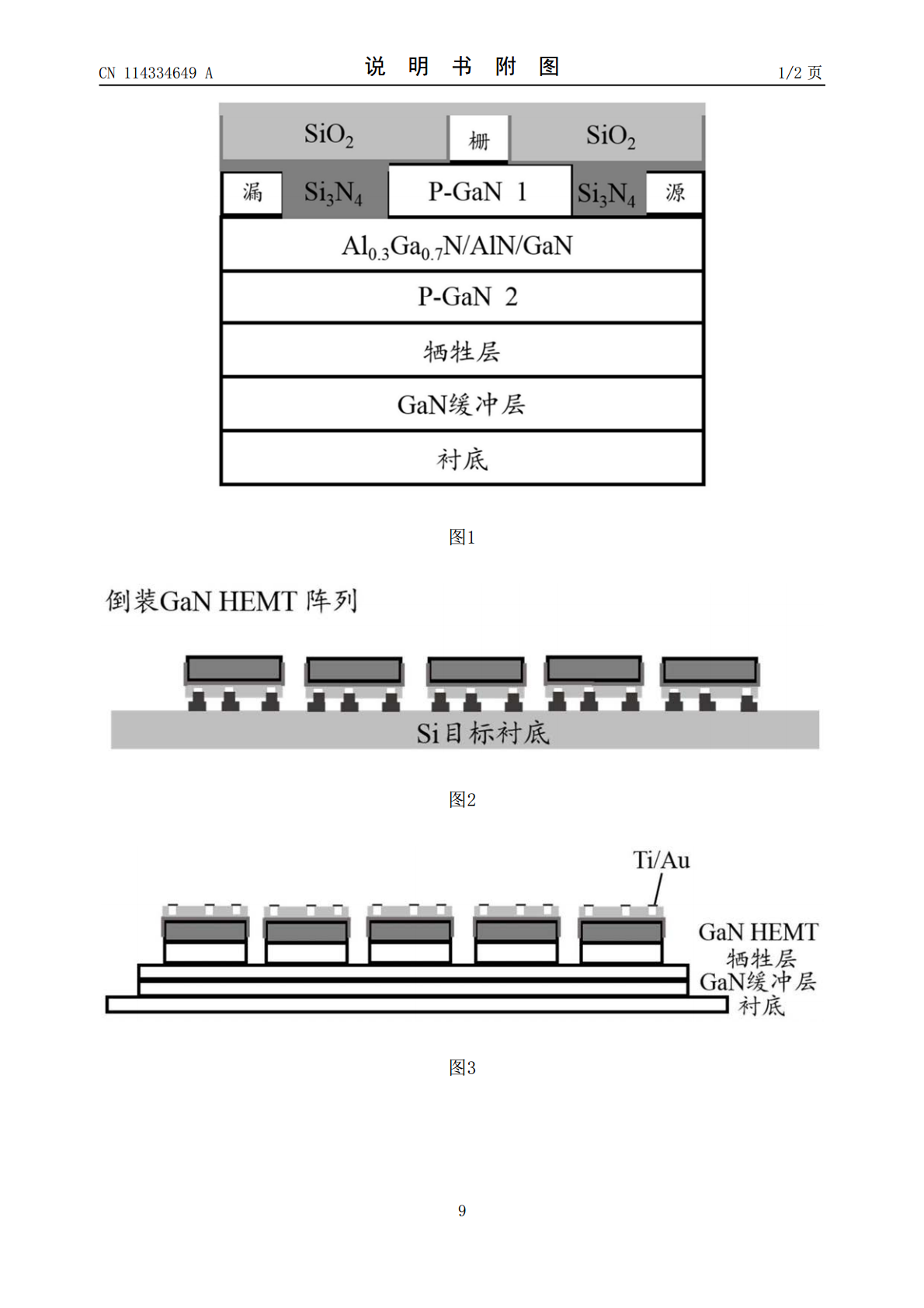
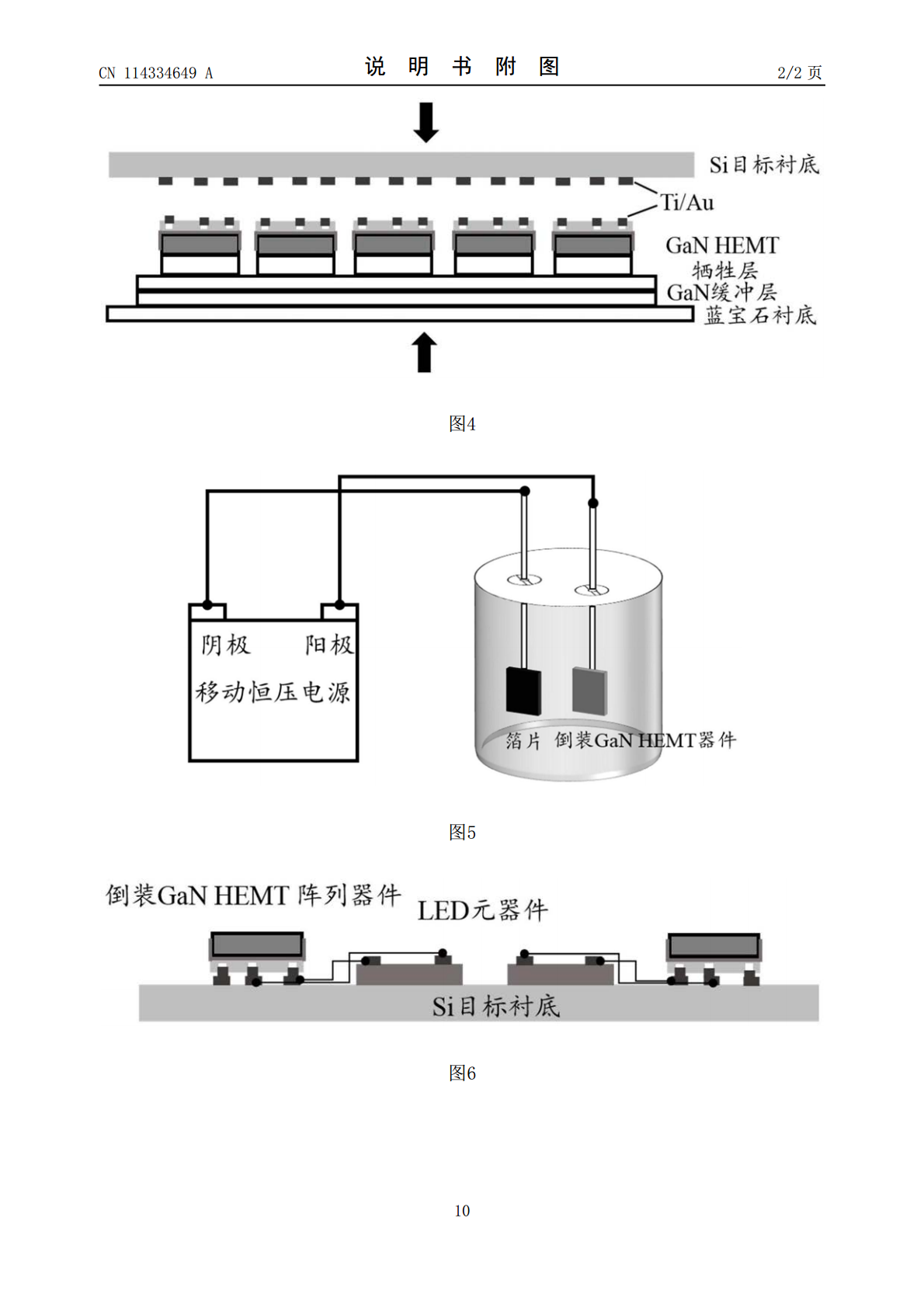
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种倒装GaN HEMT器件阵列的转移和异质集成方法及其器件阵列.pdf
本发明涉及一种倒装GaNHEMT器件阵列的转移和异质集成方法及其器件阵列,该方法通过设置包含有重掺杂GaN牺牲层和阻断漏电流通路的高阻层的GaNHEMT器件阵列结构,在器件的表面覆盖钝化绝缘层保护器件,通过在钝化绝缘层上开设通孔暴露源漏和栅极进而通过键合金属将其键合至目标基底,进一步地结合特定的电化学腐蚀方法,将HEMT阵列从刚性衬底释放,实现了器件阵列的无损剥离,释放了材料内部的应力,有效的解决了缓冲层和衬底漏电的问题,极大的提升了HEMT器件的性能,为HEMT器件与目标基底的异构集成提供了新渠道,

GaN基微型LED阵列器件的制备方法及阵列器件.pdf
本发明涉及一种GaN基微型LED阵列器件的制备方法,该方法在LED阵列器件的外延结构上生长一层ITO薄膜,然后采用掩膜对外延结构非像素点区域的ITO薄膜进行湿法刻蚀,保留像素点区域的ITO薄膜作为像素点P电极的欧姆接触层。

GaN基HEMT器件及其制备方法.pdf
本发明提供一种GaN基HEMT器件及其制备方法,在衬底上先形成外延结构及SiN钝化保护层,而后形成源极区及漏极区,及对应的源电极及漏电极,之后去除SiN钝化保护层,并进行表面清洗后,再采用原子层沉积及等离子退火工艺形成单晶AlN势垒层,以调制GaN沟道内二维电子气,同时在AlGaN势垒层内形成区域性薄层附属沟道,以提高器件整体线性度,且在同一沉积腔内采用原子层沉积在单晶AlN势垒层上形成非晶AlN钝化保护层,由于采用连续原位原子层沉积单晶和非晶AlN层,可以提高晶体/非晶AlN的界面质量,以优化器件Pul

一种GaN基HEMT器件及其制备方法.pdf
本申请公开了一种GaN基HEMT器件及其制备方法,包括衬底、缓冲层、沟道层、势垒层、帽层、源极、栅极和漏极,由于该GaN基HEMT器件在制备过程中应用H等离子体处理技术将帽层制备成高阻态,以优化该GaN基HEMT器件的内部电场分布,降低了表面陷阱对器件性能的影响。

一种具有阵列侧栅结构的HEMT器件及其制备方法.pdf
一种具有阵列侧栅结构的HEMT器件及其制备方法,属于半导体器件技术领域。技术方案:在衬底上依次生长缓冲层、沟道层、势垒层,源极和漏极设置在势垒层上方,栅极设置在势垒层上方、并延伸至沟道层;位于栅极区的沟道层、势垒层、栅金属形成阵列侧栅结构,阵列侧栅包括若干由沟道层和势垒层构成的纵向截面为等腰梯形的结构,侧栅结构在沟道层一侧的外角为钝角弧形。有益效果:本发明利用对沟道分区域进行浅刻蚀和深刻蚀与栅金属/半导体功函数差相结合的方式来调节沟道电子浓度,有效提升器件阈值电压和输出电流。同时可以通过优化侧栅倾角α以减
