
一种FinFET结构的固相源掺杂方法.pdf

努力****幻翠









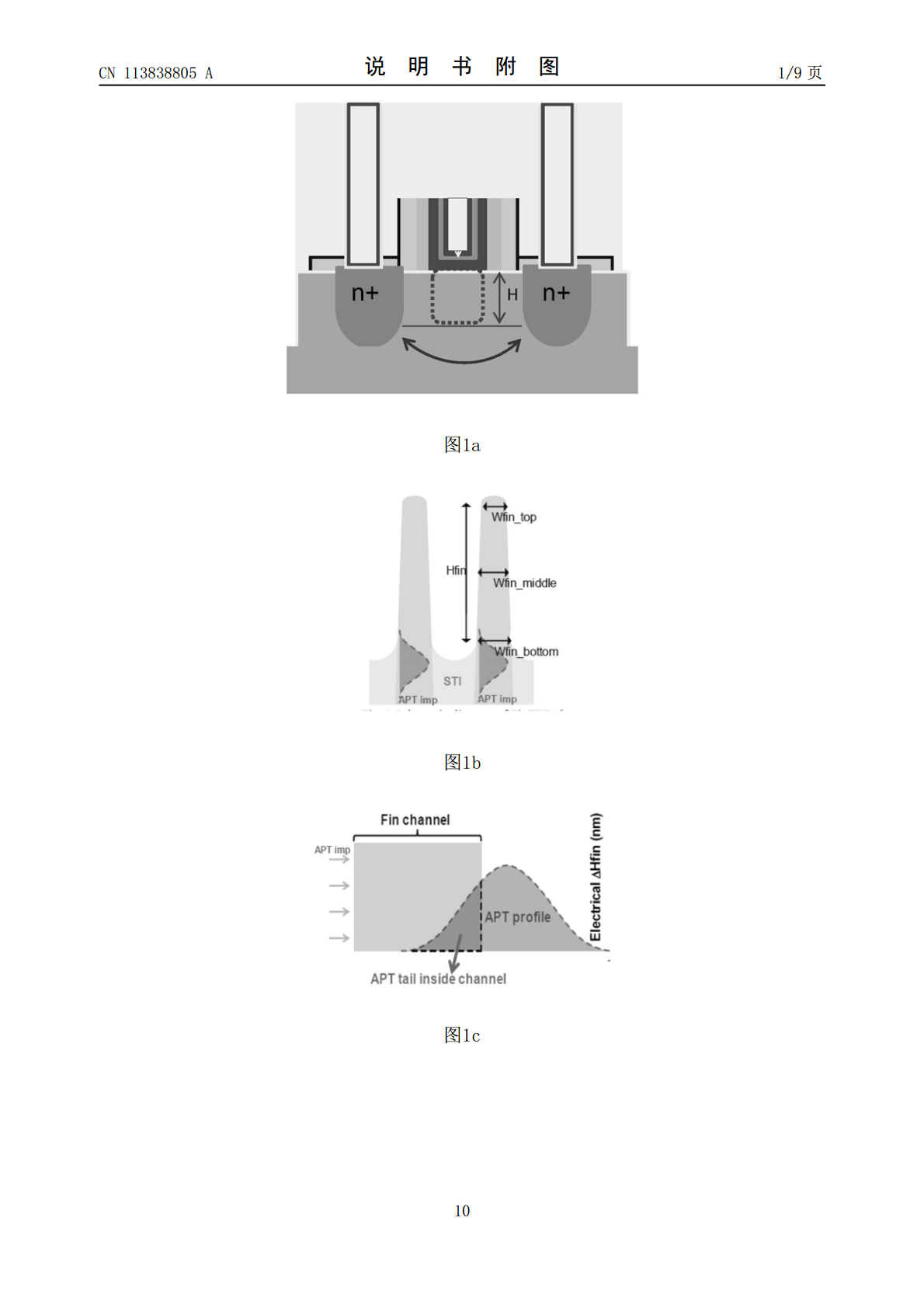
亲,该文档总共18页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种FinFET结构的固相源掺杂方法.pdf
本发明提供一种FinFET结构的固相源掺杂方法,Fin结构及其上的缓冲层、缓冲层上的硬掩膜层构成叠层,用作PMOS的叠层为第一结构;用作NMOS的叠层为第二结构;沉积BSG层覆盖叠层及基底上表面;去除第一结构上的BSG层;沉积PSG层覆盖第二结构上的BSG层、第一结构以及基底上表面;去除第二结构上的PSG层;在基底上表面的PSG层和BSG层上形成介质层;去除介质层以上的PSG层和BSG层;去除介质层将Fin结构侧壁剩余的PSG层和BSG层及基底上表面的PSG层和BSG层暴露;沉积帽层以覆盖叠层及Fin结构

一种微波固相法快速制备氮掺杂石墨烯的方法.pdf
本发明涉及无机化学应用技术领域,具体涉及一种利用乙二胺做为氮源的固相微波辅助快速高效制备氮掺杂石墨烯的方法。一种微波固相法快速制备氮掺杂石墨烯的方法,采用如下步骤:步骤1:通过低温、中温以及高温三个阶段完成氧化石墨的制备;步骤2:氮掺杂石墨烯的制备:先制成功能化石墨烯,然后对其进行回流反应以及微波加热完成氮掺杂石墨烯的制备。本发明采用乙二胺对氧化石墨进行功能化,并通过固相微波处理乙二胺功能化石墨烯的过程成功实现对石墨烯的氮掺杂。相对于传统的氮掺杂方法,该方法避免了使用高腐蚀性以及高毒性的氨气,表现出环境友

用于FinFET的方法和结构.pdf
本发明公开了半导体器件及其形成方法。该方法包括接收衬底,衬底具有有源鳍、位于有源鳍上方的氧化物层、位于氧化物层上方的伪栅极堆叠件以及位于氧化物层上方和伪栅极堆叠件的侧壁上的间隔件部件。该方法还包括去除伪栅极堆叠件,从而产生第一沟槽;蚀刻第一沟槽中的氧化物层,从而产生位于间隔件部件下方的空腔;在第一沟槽和空腔中沉积介电材料;以及蚀刻第一沟槽以暴露出有源鳍,从而在空腔中留下介电材料的第一部分。本发明的实施例还涉及用于FinFET的方法和结构。

固相掺杂方法、装置、重掺砷硅单晶生产系统及生产方法.pdf
本发明提供一种固相掺杂方法、装置、重掺砷硅单晶生产系统及生产方法,属于重掺杂硅单晶技术领域。该固相掺杂方法将未经气化的固体掺杂剂或含固体掺杂剂的掺杂料投入化料后的硅熔液中。该固相掺杂装置包括石英杯及石英浮杆,石英杯的上端开口,且设置有用于挂接于单晶炉上的挂钩,石英杯的下端设置有锥形的导料部,导料部的下端连接有下料管。石英浮杆沿下料管的轴向穿过下料管,石英浮杆的上端设置有浮阀,浮阀能够盖合于下料管的上端,石英浮杆的下端设置有浮子。实践表明,采用本发明提供的固相掺杂方法能够提升低电阻率产品的比率,降低晶变的概

一种气固两相密封结构.pdf
本发明公开了一种气固两相密封结构,包括主轴、活动环、静止环和前轴承,其特征在于所述的活动环固定在所述的主轴上;所述的静止环固定在干混砂浆混合机的筒体的外侧壁上,其上开设有斜向的充气槽和与所述充气槽联通的向心环形缺口;所述的活动环和静止环的端面通过环状齿槽啮合的方式形成配合;所述静止环外侧与所述前轴承的外圈连接。本发明采用迷宫式的微隙通道,延长了混合机内物料向外界泄漏的路径,增加了气流阻力,物料经多次阻挡后很难到达外界;活动环在作旋转运动的过程中产生离心现象,使靠近活动环的固相物料被抛洒开去,进一步提高了防
