
半导体设备及其制造方法.pdf

子璇****君淑








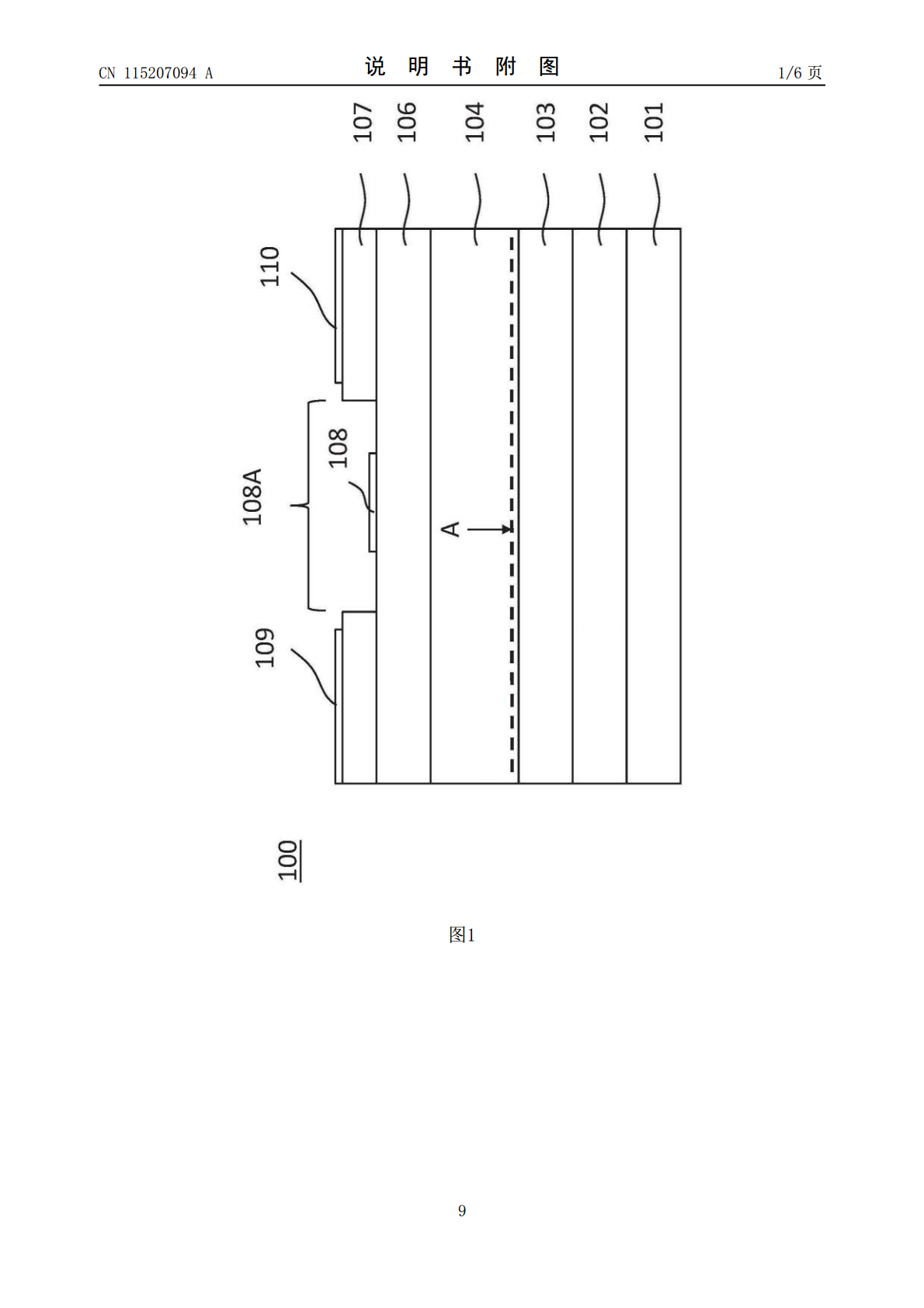

亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体设备及其制造方法.pdf
公开了半导体设备及其制造方法。本发明涉及一种基于氮极性GaN的高电子迁移率晶体管HEMT。本发明还涉及一种制造这种HEMT的方法。根据本发明,基于氮极性GaN的HEMT包括:设置在缓冲层上的AlGaN背势垒、设置在缓冲层上的沟道层、设置在沟道层上的AlGaN帽层、以及设置在AlGaN帽层上的第二GaN层。根据本发明,沟道层包括第一GaN层和AlGaN沟道层,其中,AlGaN沟道层设置在第一GaN层和AlGaN背势垒之间。此外,肖特基接触设置在第一GaN层上。

半导体发光设备及其制造方法.pdf
半导体发光设备及其制造方法。公开了一种半导体发光设备。该半导体发光设备包括:基板;以网状网形状形成在所述基板上的电流集中防止图案;形成在载有所述电流集中防止图案的所述基板上的n型覆层;依次形成在所述n型覆层上的有源层和p型覆层;形成在所述n型覆层的通过对所述p型覆层和有源层进行部分蚀刻而露出的一部分上的n型电极;以及形成在所述p型覆层上的p型电极。所述电流集中防止图案形成为双层结构,该双层结构包括由SiO和SiN中的一种材料形成在所述基板上的第一层、和由金属材料形成在所述第一层上的第二层。

半导体发光设备及其制造方法.pdf
本发明公开了一种半导体发光设备及其制造方法,其通过在基板上用于生长氮化物半导体材料的表面上形成多个凸部来提高光出射效率,该半导体发光设备包括:基板;位于所述基板上的一个或更多个第一凸部,各第一凸部具有凹部,所述基板的表面通过该凹部平坦地露出;位于包括所述第一凸部的基板上的第一半导体层;位于所述第一半导体层上的有源层;位于所述有源层上的第二半导体层;位于所述第一半导体层的预定部分上的第一电极,其中,所述有源层和第二半导体层未形成在所述第一半导体层的所述预定部分上;以及位于所述第二半导体层上的第二电极。

半导体光学设备及其制造方法.pdf
一种半导体光学设备,包括:下台面结构,所述下台面结构以条带形状延伸并且由包括活性层的一些层组成;掩埋层,所述掩埋层被配置为掩埋所述下台面结构的两侧并且由磷化铟制成;以及上台面结构,所述上台面结构以条带形状延伸并且由一些层组成,所述一些层包括由无磷材料制成的底层,所述底层具有从所述下台面结构的最顶层突出的底表面,所述底表面与所述下台面结构和所述掩埋层接触。

半导体模块及其制造方法.pdf
在半导体模块(100)中,带导电图案绝缘基板(2)粘着了半导体芯片、主电路端子(4)、控制端子(5),在粘着了带导电图案绝缘基板(2)的金属散热基板(1)上粘着具有使主电路端子(4)的表面以及控制端子(5)露出的第1开口部(11)的树脂外壳(8),在形成于构成树脂外壳(8)的侧壁的第2开口部(11)插装埋入了固定主电路端子(4)以及控制端子(5)的螺母(22)的树脂体(7),在树脂外壳(8)内填充树脂材料(9),其中,使第1开口部(11)的侧壁(18)为表面侧变窄的锥形,在控制端子(5)设置与该锥形的侧壁
