
封装基板及其制作方法、封装结构.pdf

一吃****瀚文









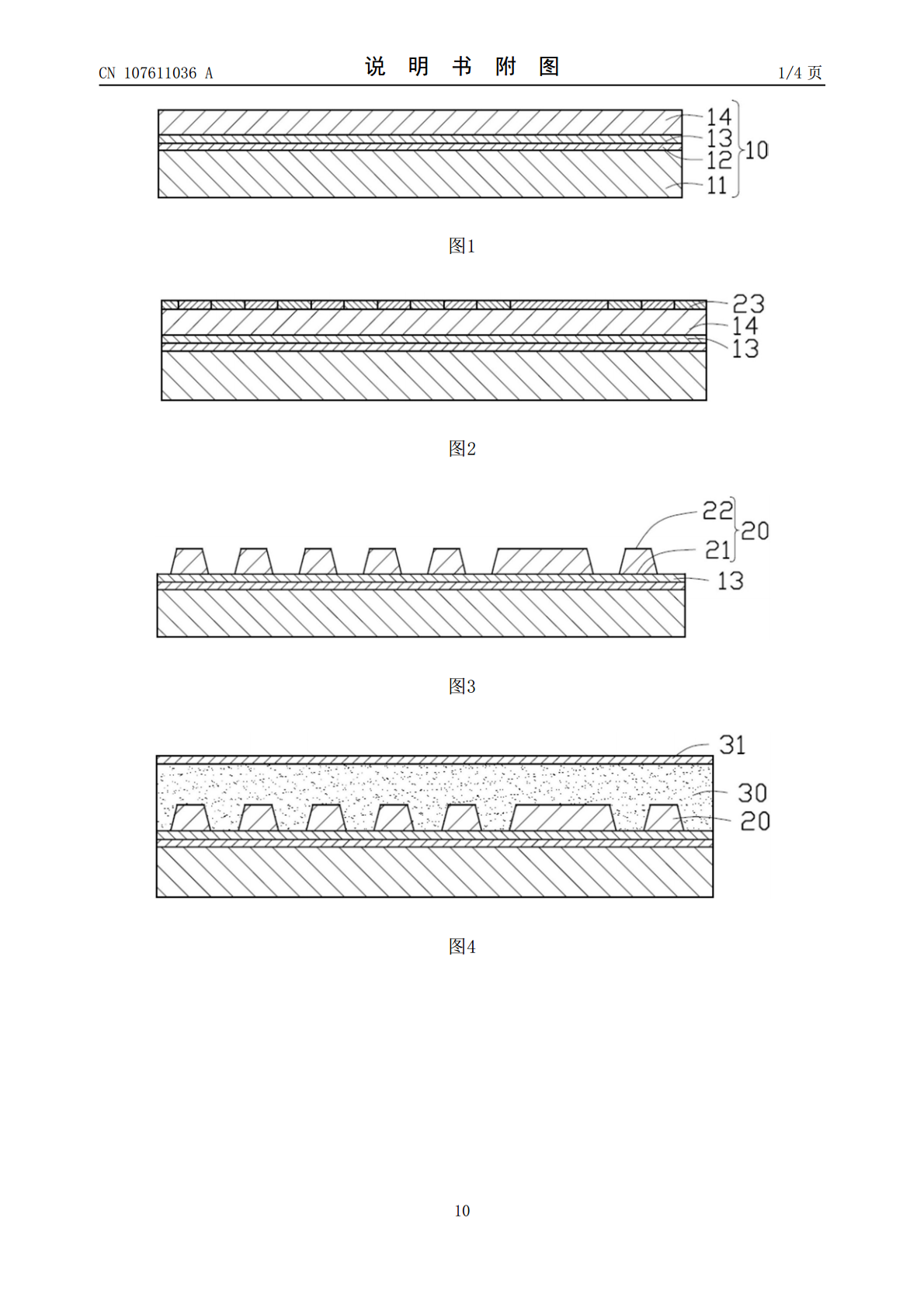
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

封装基板及其制作方法、封装结构.pdf
一种封装基板包括第一导电线路层以及绝缘层。第一导电线路层包括相对的第一端部以及第二端部。绝缘层包覆第二端部并填充第一导电线路层所形成的间隙,以使第一导电线路层内埋于绝缘层中,第一端部的宽度大于第二端部的宽度。绝缘层内开设多个用于暴露第一导电线路层的盲孔,盲孔中形成有导电部。绝缘层上还形成有第二导电线路层。第二导电线路层与绝缘层接触的部分设有一第二铜箔层。第二导电线路层包括临近第二端部设置的第三端部以及与第三端部相对的第四端部。第三端部的宽度大于第四端部的宽度。第一导电线路层和第二导电线路层上形成有防焊层。

封装基板及其制作方法、芯片封装结构及芯片封装体制作方法.pdf
一种封装基板,其包括铜箔基板、溅镀铜层、多个导电接点、介电层及导电线路层,所述溅镀铜层形成于所述铜箔基板表面,所述多个导电接点形成于所述溅镀铜层远离所述铜箔基板的表面,所述介电层位于所述导电线路层合所述溅镀铜层之间,所述介电层内形成有与多个导电接点一一对应的多个导电盲孔,所述导电线路层包括与多个导电盲孔一一电导通的多条导电线路及与所述多条导电线路一一电连接的多个连接垫,每个导电接点通过一个对应的导电盲孔、一条对应的导电线路与一个对应的连接垫相互电导通。本发明还提供该封装基板的制作方法及封装结构及芯片封装体

芯片封装基板和结构及其制作方法.pdf
一种芯片封装基板,包括第三和第六胶片、第一和第三导电线路层、第一防焊层及多个导电接点。第六胶片与第三胶片相互粘接。第一导电线路层形成于第三胶片相邻于第六胶片的表面。第三导电线路层形成于第六胶片远离第一导电线路层的表面,第三导电线路层通过第一导电盲孔电连接于第一导电线路层。第一防焊层形成于第三导电线路层,并部分覆盖第三导电线路层,以构成多个露出于第一防焊层的电性接触垫。多个导电接点形成于第三胶片的远离第一导电线路层的表面,多个导电接点通过形成于第三胶片的多个第二导电盲孔电连接于第一导电线路层。第一和第二导电

封装基板及其制作方法.pdf
一种封装基板及其制作方法,包括:具有多个导电穿孔的中介层、形成于该中介层一侧上的感旋光性介电层、以及形成于该感旋光性介电层中且电性连接该导电穿孔的导电盲孔。借由黄光开孔工艺的对准度佳的特性,而于该感旋光性介电层上形成孔径极小的盲孔时仍能有效对准该导电穿孔,所以该导电穿孔的孔径可缩小至所需尺寸,而不受盲孔的对位限制,因而提高该导电穿孔于该中介层上的布设密度。

封装基板及其制作方法.pdf
本发明公开一种封装基板及其制作方法。其制作方法包括:形成第一底材。以电镀的方式形成多个金属凸块于第一底材上。提供具有上表面与下表面、核心介电层、第一铜箔层、第二铜箔层及多个容置凹槽的第二底材。形成黏着层于容置凹槽的内壁。压合第一与第二底材,以使金属凸块容置于容置凹槽内。移除第一底材。形成多个从上表面延伸至金属凸块的盲孔。形成导电材料层于第一及第二铜箔层上,其中导电材料层填满盲孔而定义出多个导通孔。图案化导电材料层而形成第一图案化金属层及第二图案化金属层。
