
一种栅极制造方法.pdf

戊午****jj






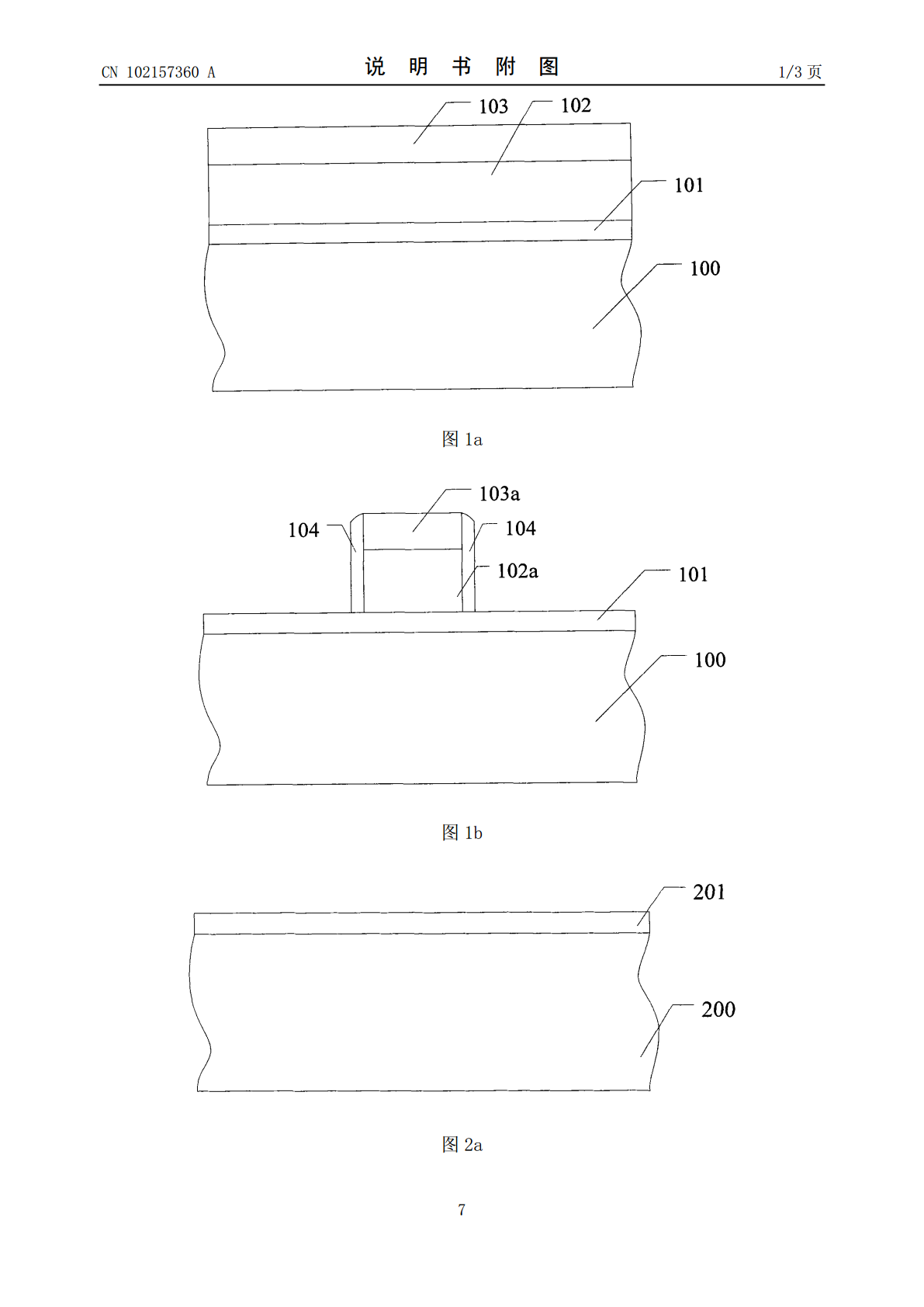
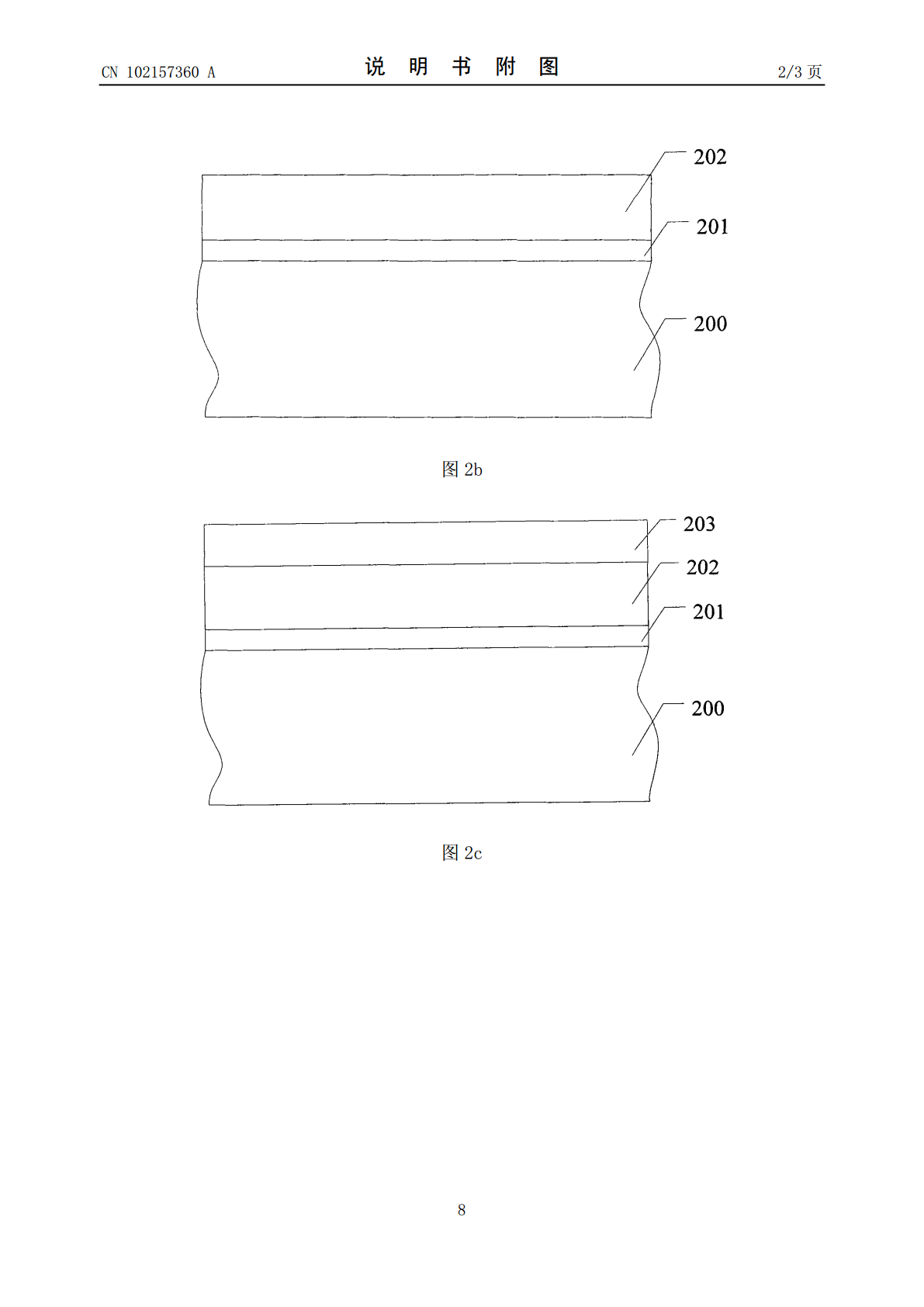
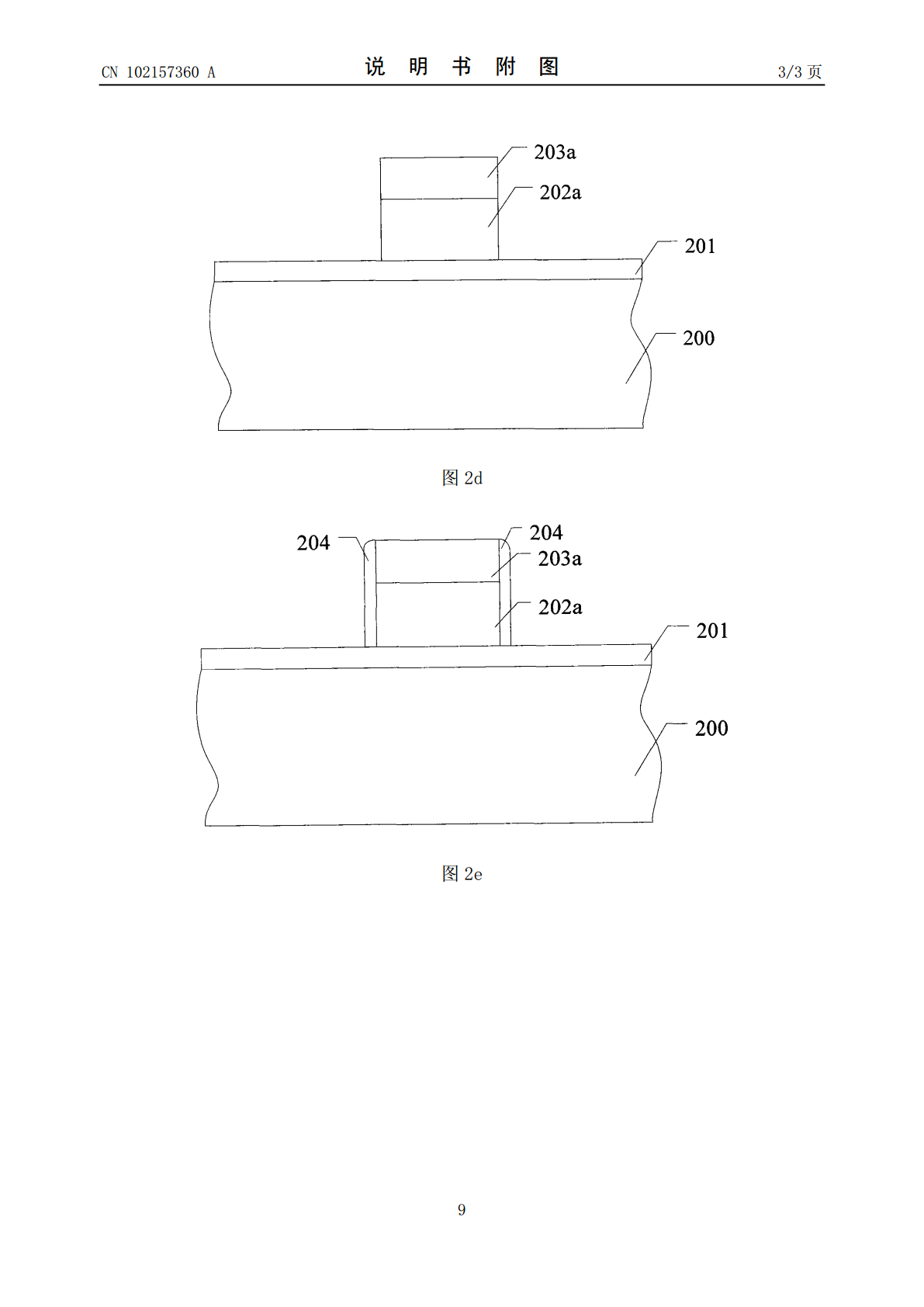
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种栅极制造方法.pdf
本发明提供一种栅极制造方法,包括:提供一半导体衬底,在所述半导体衬底上依次形成栅介质层,多晶硅层、硅化钨层;图案化所述硅化钨层、多晶硅层;还包括:对图案化的所述硅化钨层和所述多晶硅层进行普通高温炉退火,工艺条件为:N2流量≥25L/分钟,使腔体内2~4分钟后O2的含量为ppm级别,温度为650~850℃,高温炉排气端的压力为87pa~385pa,退火时间15-25分钟;在普通高温炉内执行氧化工艺,在所述硅化钨层和所述多晶硅层的侧壁形成侧墙。本发明方法省略了一个快速热退火步骤,减少了工艺步骤和使用设备,缩短

一种多晶硅栅极的制造方法及多晶硅栅极.pdf
本发明提供了一种多晶硅栅极的制造方法及多晶硅栅极,其中,多晶硅栅极的制造方法包括:在衬底上依次生成栅氧化层、多晶硅层和氮化硅层;对所述氮化硅层和所述多晶硅层进行光刻和刻蚀,且所述多晶硅层上被刻蚀的位置保留预设厚度的余量;对外露的所述多晶硅层进行氧化,得到氧化层;去除所述氮化硅层,并在露出的所述多晶硅层上生成硅化物,形成多晶硅栅极。本发明提供的方案通过在刻蚀多晶硅时保留一定的余量,然后通过氧化将其转化为二氧化硅(氧化层),能够保证多晶硅层下方任何位置处的栅氧化层都不会被损伤到,简化了制作工艺;同时保留了完整

闪存栅极的制造方法.pdf
本发明公开了一种闪存栅极的制造方法,包括步骤:形成浅沟槽场氧隔离出有源区。进行离子注入形成闪存的阱区。在硅衬底的表面依次生长ONO层和多晶硅层并对多晶硅层进行掺杂。在多晶硅层表面沉积金属硅化钨层。依次采用炉管工艺和化学气相淀积工艺生长第四氮化硅层和第五氮化硅层并叠加形成栅极硬掩膜层。采用光刻刻蚀工艺依次对栅极硬掩膜层、金属硅化钨层和多晶硅层进行刻蚀并形成闪存的栅极。本发明能够使栅极保持良好的形貌,能对闪存的ONO缺陷进行良好的修复从而提高闪存的寿命以及消除单独采用化学气相淀积工艺形成氮化硅层时所带来的耐久

金属栅极的制造方法.pdf
本发明公开了一种金属栅极的制造方法,包括步骤:步骤一、形成多个伪栅结构,由第一侧墙和第二侧墙叠加组成侧墙,接触孔刻蚀停止层和层间膜;第二侧墙的材料的刻蚀速率和两侧的第一侧墙和接触孔刻蚀停止层的刻蚀速率不同。步骤二、自对准刻蚀去除第二侧墙并形成第一间隙。步骤三、淀积第三介质层填充第一间隙,利用第一间隙的顶部和底部的填充速率差异使第三介质层在第一间隙的顶部产生封口并在第一间隙的底部保留空隙从而形成间隙侧墙。步骤四、去除伪栅结构。步骤五、进行金属栅的金属沉积。步骤六、对金属栅的金属进行平坦化。本发明能形成间隙侧

栅极侧墙的制造方法.pdf
本发明公开了一种栅极侧墙的制造方法,包括步骤:步骤一、在半导体衬底表面形成由栅介质层、多晶硅栅和硬质掩膜层叠加而成的栅极结构;步骤二、形成侧墙介质层;步骤三、在侧墙介质层的表面形成侧墙保护介质层;步骤四、对侧墙保护介质层进行第一次全面刻蚀并使侧墙保护介质层仅位于栅极结构侧面;步骤五、对侧墙介质层进行第二次全面刻蚀形成侧墙,所保留的侧墙保护介质层对侧墙的侧面进行保护,侧墙保护介质层和硬质掩膜层自对准暴露出侧墙的顶部表面从而能调节侧墙的高度;步骤六、去除所保留的侧墙保护介质层。本发明能防止侧墙的厚度减薄,使侧
