
一种LDMOS晶体管用硅外延片的制备方法.pdf

星星****眨眼








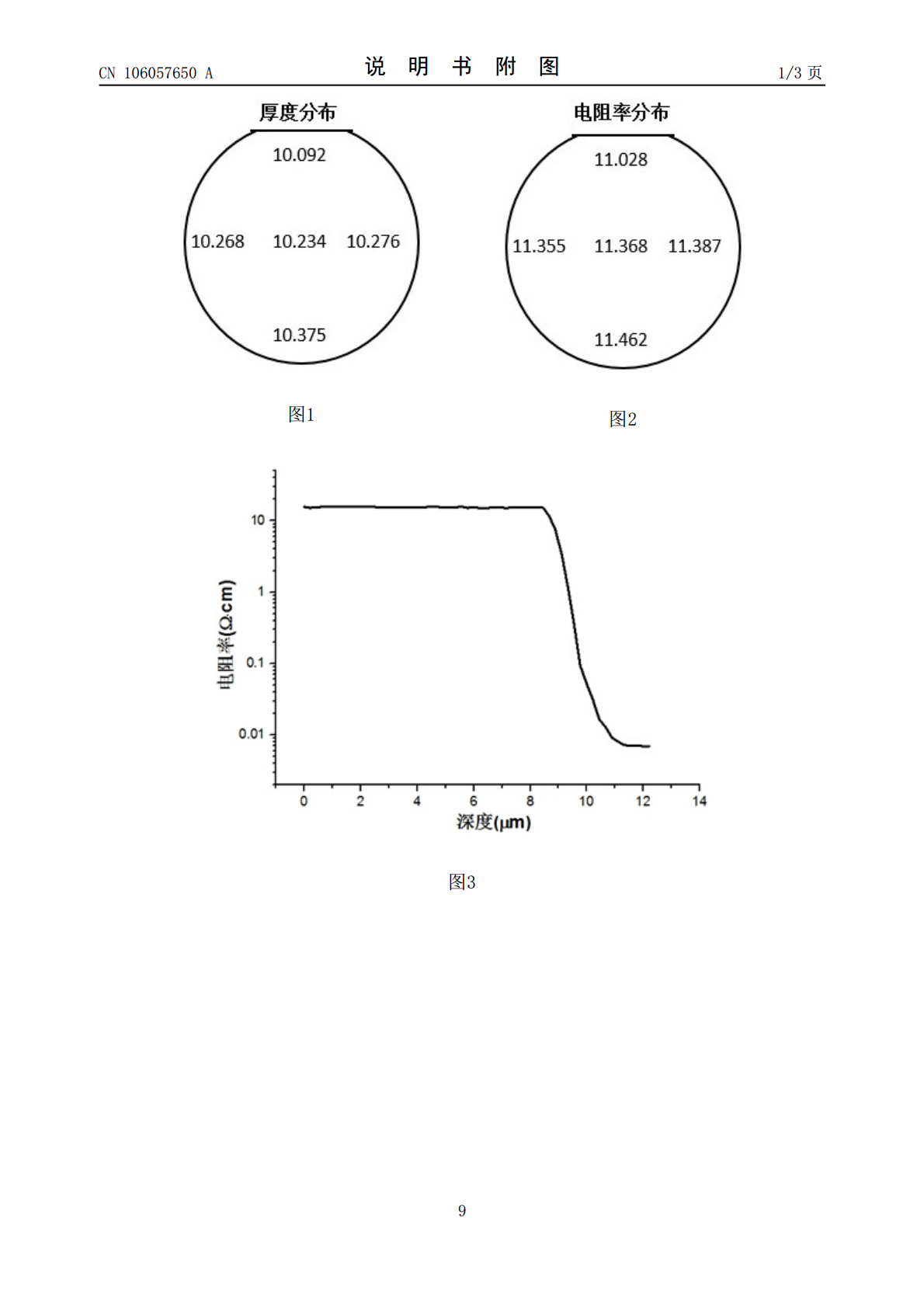

亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种LDMOS晶体管用硅外延片的制备方法.pdf
本发明涉及一种LDMOS晶体管用硅外延片的制备方法。先对外延炉基座进行腐蚀;向外延炉桶式基座片坑内装入硅单晶衬底片;对硅衬底片的表面进行HCl抛光;在硅片上生长一层本征外延层;利用HCl气体将外延表面受自掺杂严重的部分抛去;进行变温变流量吹扫过程;进行掺杂外延层的生长;掺杂外延层生长达到预定时间后开始降温;对外延片的厚度进行测量,共计五个测试点的厚度,共计五个测试点的电阻率,利用扩展电阻测试法测量外延片的过渡区结构;提高了外延片厚度和电阻率均匀性水平,不均匀性

快速恢复外延二极管用双层硅外延片的制备方法.pdf
本发明提供了一种快速恢复外延二极管用双层硅外延片的制备方法,属于半导体材料制备技术领域,方法包括硅衬底片的预处理:外延前对选用的硅衬底片进行清洗、抛光,并在抛光时,外延腔室内温度升温至1030~1060℃;外延生长:在外延腔室内通入三氯氢硅作为硅源,外延腔室内温度保持1030~1060℃;在硅衬底片上低速生长本征外延层;在外延腔室内通入H<base:Sub>2</base:Sub>变流量吹扫1?3分钟清理杂质;在本征外延层上变高速生长掺杂磷烷的第一层外延层;再次通入H<base:Sub>2</base:S

一种阶跃恢复二极管用硅外延片的制备方法.pdf
本发明公开了一种阶跃恢复二极管用硅外延片的制备方法。该制备方法克服了现有阶跃恢复二极管用硅外延片工艺中存在的过渡区宽度的控制问题,在外延层生长过程中采用两段生长,先使用反复变流量的氢气吹扫一段时间,将杂质不断稀释排除出外延炉反应腔体,然后低温低速生长第一段外延,减少了气相自掺杂的影响,改善了过渡区的结构,随后使用反复变流量的氢气再吹扫一段时间,然后高温快生长第二段外延层,最终达到目标厚度和电阻率。通过外延工艺的优化,实现了常压下对衬底杂质自扩散因素的控制,缩短了过渡区的宽度,使其占外延层厚度百分比的13%

一种肖特基器件用硅外延片的制备方法.pdf
本发明涉及一种肖特基器件用硅外延片的制备方法,向硅外延炉反应腔体内通入氯化氢气体,对基座上残余沉积物质进行刻蚀;将主工艺氢气携带气态三氯氢硅进入硅外延炉反应腔体,基座表面沉积一层无掺杂的致密多晶硅;将基座温度降低,向基座上装入硅衬底片;基座升温,对硅衬底片的表面进行高温烘焙;通入主工艺氢气对硅外延炉反应腔体进行吹扫;主工艺氢气携带气态三氯氢硅进入硅外延炉反应腔体,基座下部流入与主工艺氢气流动方向相反的辅助氢气,三氯氢硅在管路中排空;通入主工艺氢气对硅外延炉反应腔体进行吹扫;进行硅外延层生长;硅外延层生长完

一种高频器件用硅外延片的制备方法.pdf
本发明涉及一种高频器件用硅外延片的制备方法,硅外延炉反应腔体的基座升温,通入氯化氢气体对硅外延炉反应腔体的基座进行一次刻蚀,随后将基座温度降温;硅衬底片装在硅外延炉反应腔体的基座上,对硅衬底片表面进行气相抛光;使用氢气对反应腔体进行吹扫;三氯氢硅原料位于鼓泡器内,以氢气鼓泡的方式进入反应腔体,作为硅外延层的生长原料;硅外延片的硅外延层生长完成后,待温度降低后从基座上取出;硅衬底片导电类型为N型,电阻率低于0.005Ω·cm;硅外延片的硅外延层导电类型为N型,厚度为0.3~0.7μm,表层电阻率高于0.3Ω
