
一种PVT法生长大尺寸半绝缘碳化硅单晶的生长方法.pdf

慧颖****23






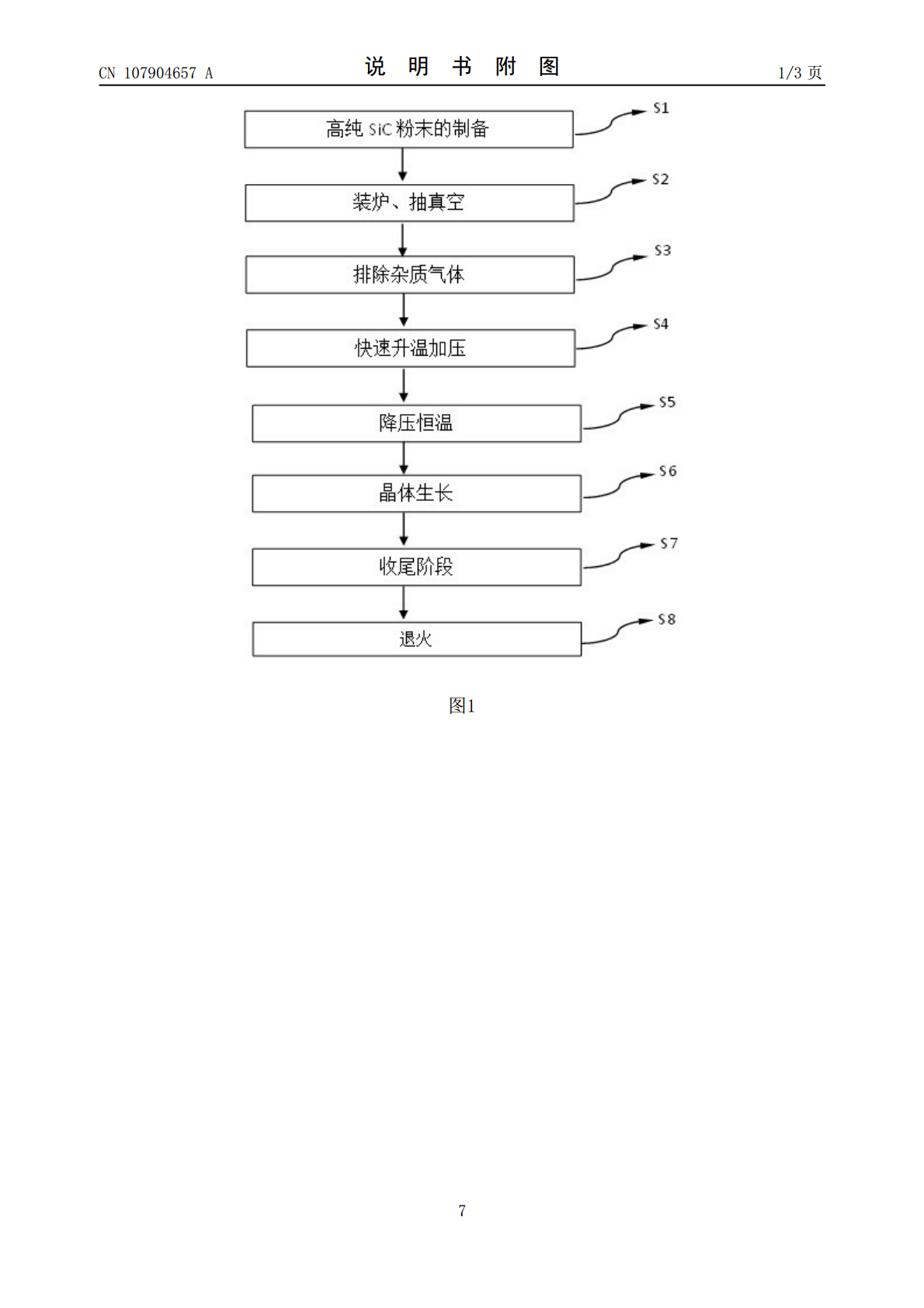
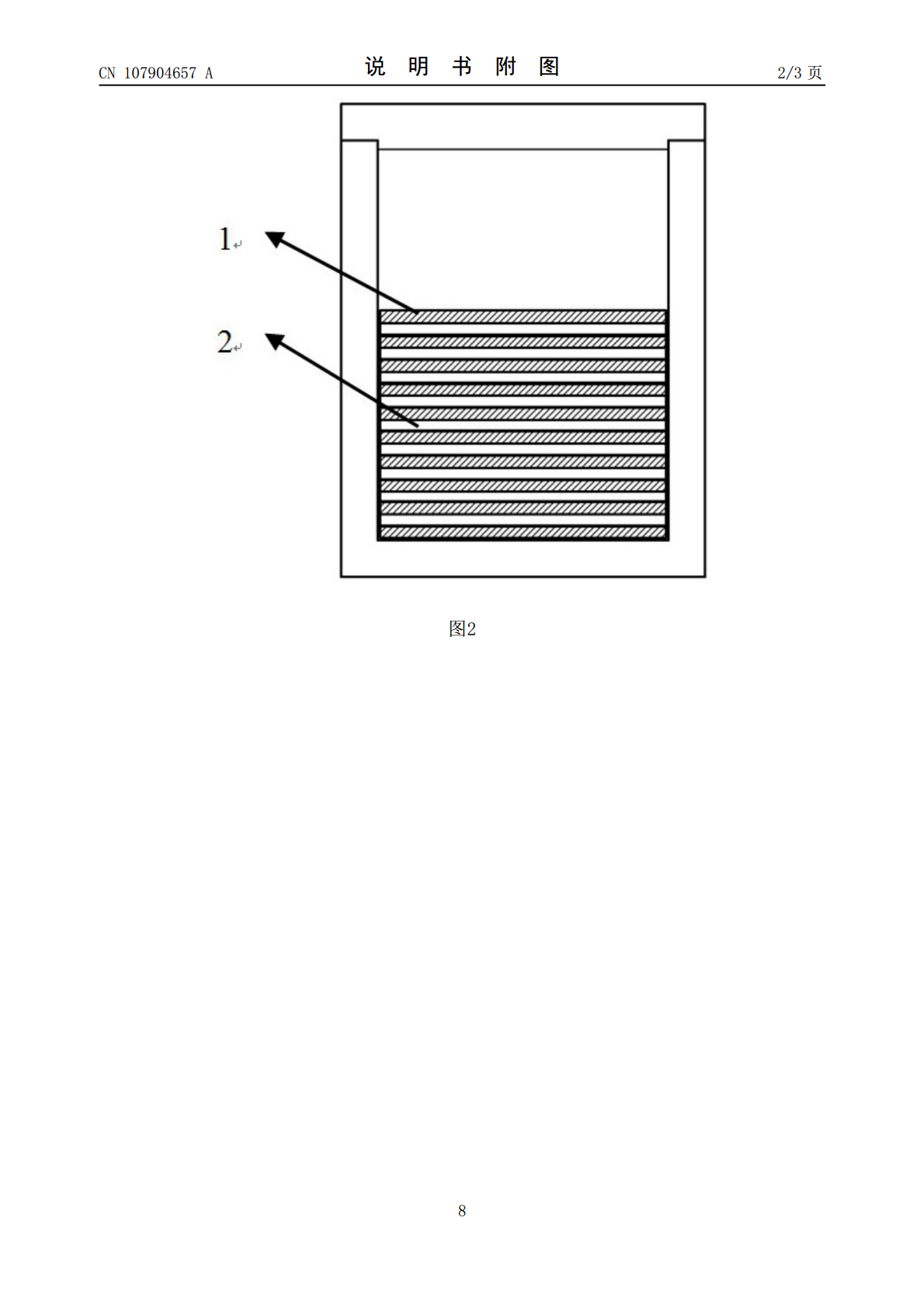
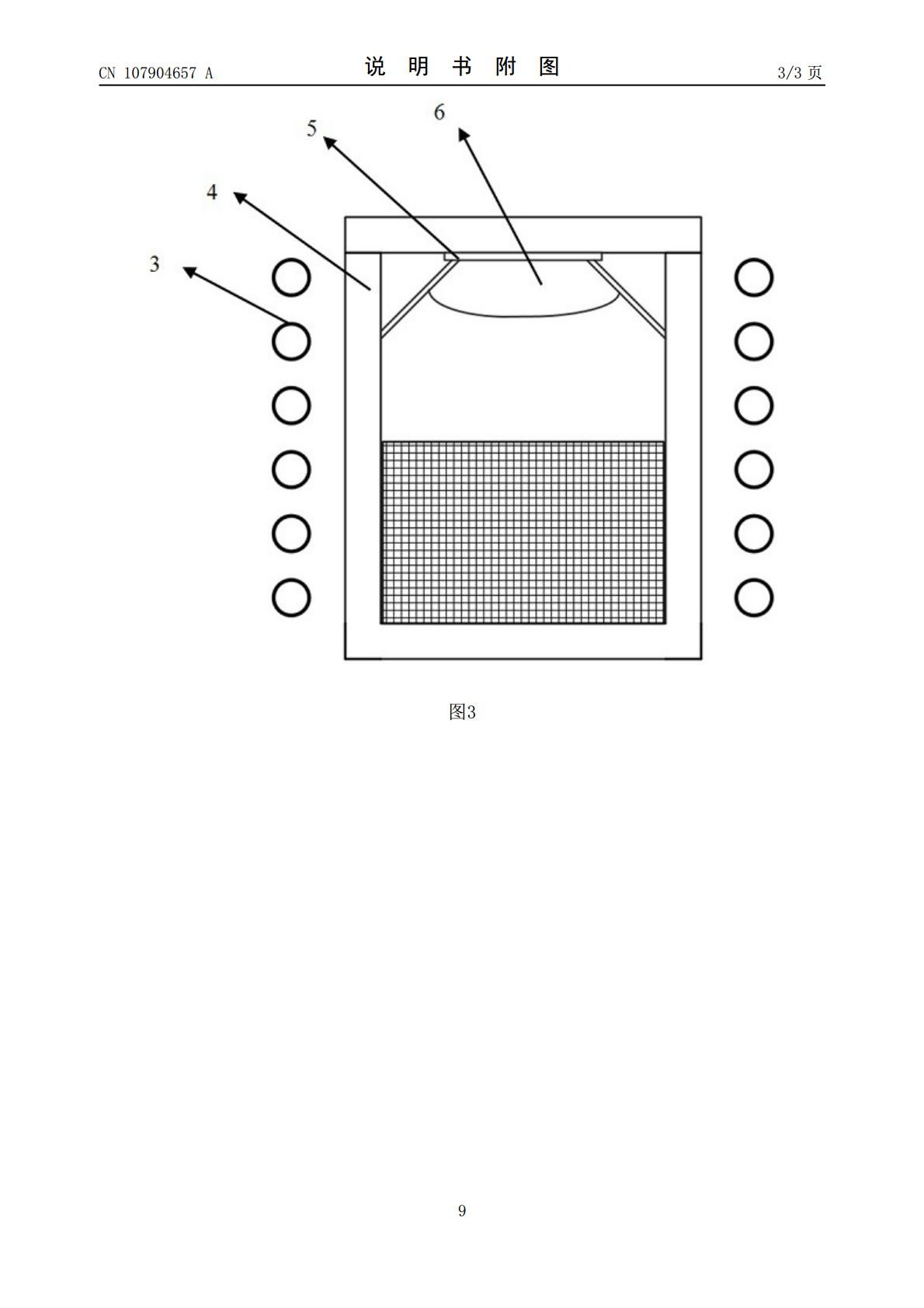
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种PVT法生长大尺寸半绝缘碳化硅单晶的生长方法.pdf
本发明提供了一种PVT法生长大尺寸半绝缘碳化硅单晶的生长方法,它主要包括以下控制阶段:SiC粉末制备、装炉抽真空、排除杂质气体、快速升温加压、降压恒温、晶体生长、收尾阶段和退火。采用PVT法生长碳化硅单晶,首先对原料进行预处理,提高了原料的纯度和密度,减少了晶体中可能出现的缺陷,将SiC粉末装炉,抽真空后通过控制温度在1300~1400℃范围内一段时间以排除杂质气体,充入高纯氩气后快速升温至2100~2400℃。当温度恒定在某一值后,在保持温度平稳的情况下逐渐降低气压,此时粉源开始升华至籽晶处开始生长,晶

一种大尺寸碳化硅单晶的PVT生长装置.pdf
本发明提供一种大尺寸碳化硅单晶的PVT生长装置,包括生长炉、X射线原位成像模块和控制系统,生长炉由外至内包括炉壁、保温毡、板型电阻加热器和坩埚,X射线原位成像模块包括分别设于生长炉的单晶生长的径向方向的相对两侧的X射线源和X射线成像接收器;炉壁于径向方向的两侧具有用于X射线透过的非金属窗口,保温毡、板型电阻加热器和坩埚均由非金属材料制成;控制系统接收X射线成像接收器的成像信号,并控制X射线源和板型电阻加热器工作。该生长装置可满足大尺寸碳化硅PVT单晶生长所需的较小径向温度梯度和必要的轴向温度梯度,并且利用

一种制备大尺寸高纯半绝缘碳化硅单晶的生长方法.pdf
本发明提供了一种工作状态下的碳化硅晶体生长炉。本发明还提供了一种制备大尺寸高纯半绝缘碳化硅单晶的生长方法,通过在碳化硅晶体生长前,增加了高温高压大流量冲洗腔体的关键工艺,高压下可有效保护碳化硅籽晶不被破坏,高温下可使吸附于体系内的氮、硼等杂质挥发或脱吸附,大流量冲洗可有效带走挥发或脱吸附状态下的氮、硼等杂质,通过此工艺可大大降低碳化硅晶体生长前腔体体系内的杂质含量,生长得到高质量的高纯碳化硅晶体。同时并未增加生产设备的结构以及生产工艺复杂性,简单有效,未增加环境污染。

一种PVT法生长碳化硅单晶时随炉退火的方法.pdf
本发明公开了一种PVT法生长碳化硅单晶时随炉退火的方法,为该方法配备一晶体生长用单晶炉,该方法包括如下步骤:步骤1)调整所述保温结构使所述发热筒内得到理想的温区分布,在所述坩埚内进行碳化硅晶体生长;步骤2)碳化硅晶体生长完成后,使用所述提拉机构控制所述坩埚,将其移至所述发热筒内低于晶体生长温度的区域;步骤3)待晶体温度恒定后,启动温控程序将单晶炉内温度缓慢降至室温,降温后出炉、取锭。以此达到去除晶体内部应力的目的。

一种PVT法气流导向的碳化硅单晶生长装置及使用方法.pdf
本发明涉及一种PVT法气流导向的碳化硅单晶生长装置及使用方法。包括粘接石墨籽晶托、籽晶、坩埚上、石墨连接环、坩埚下、外壳箱体、上测温杆和下测温杆,石墨连接环的材质是与坩埚上和坩埚下材质不同的多孔石墨材料,孔径为1‑100μm,孔隙率和孔径均与坩埚上和坩埚下有差异。步骤包括:装炉、升温、抽真空、冲惰性气体、升温保压、降压、降温。本发明使反应系统内的气体利用石墨的孔隙差异在指定位置溢出,通过反应气体在籽晶表面和边缘的滞留时间和流向的控制,以及坩埚内外气体压力差的控制来达到生长高质量,尤其是可以抑制边缘小裂纹和
