
晶圆的表面氧化方法.pdf

是你****岺呀






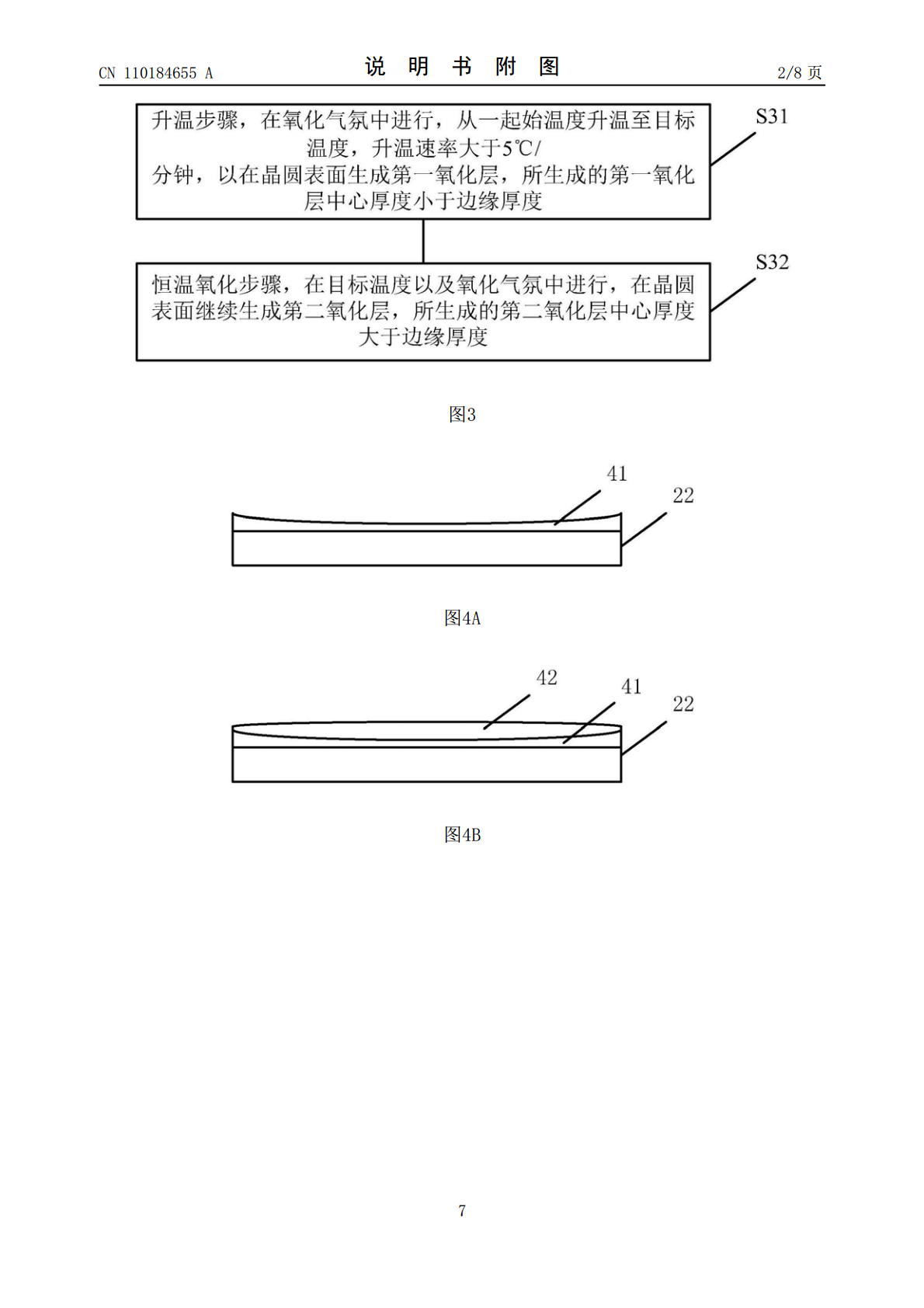


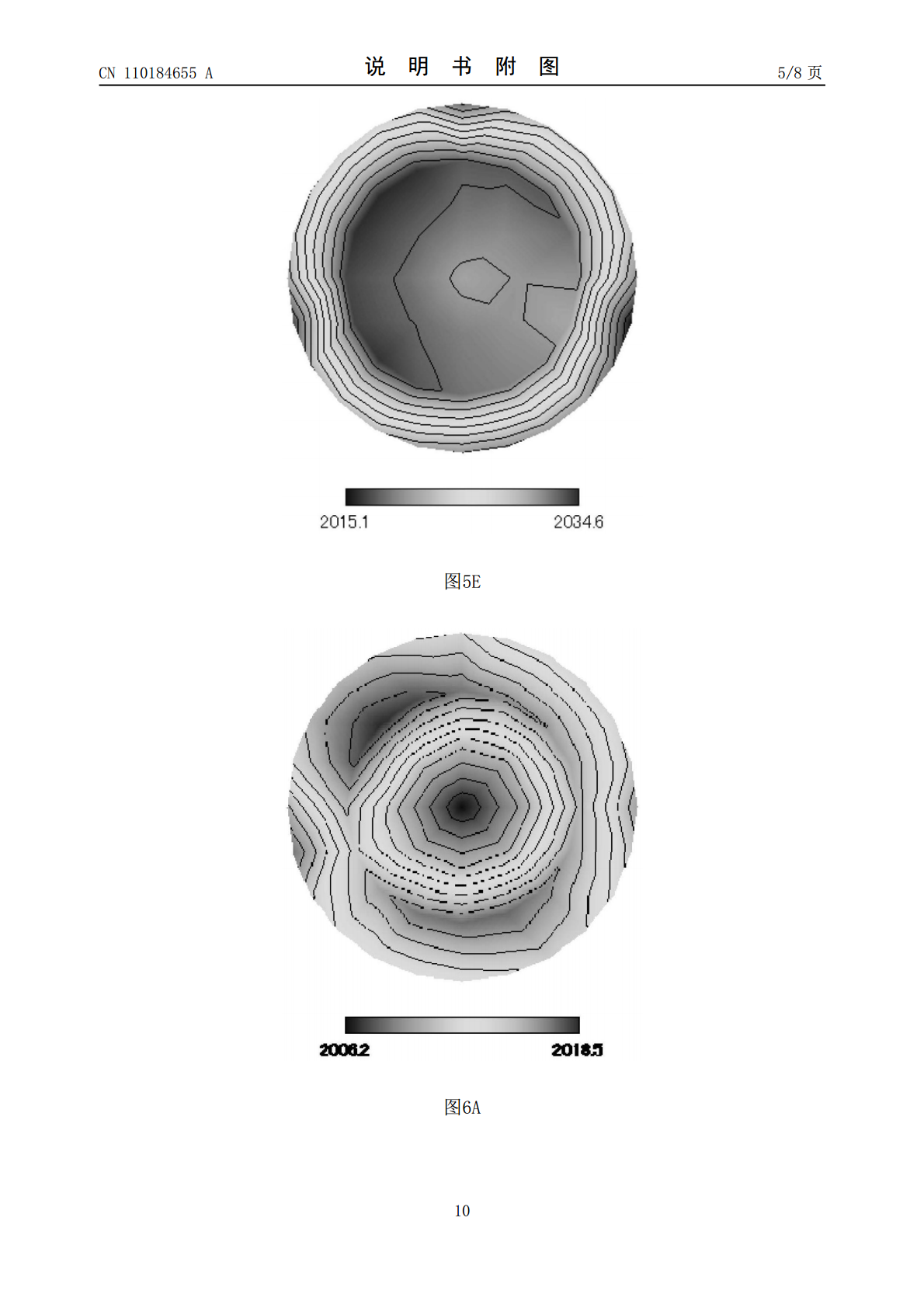
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

晶圆的表面氧化方法.pdf
本发明提供了一种晶圆的表面氧化方法,采用立式炉管的退火炉,所述立式炉管包括设置在侧壁一侧上的进气管路,所述进气管路包括靠近立式炉管底部设置的进气端,以及靠近立式炉管顶部设置的出气端,所述晶圆叠置于所述立式炉管中,包括如下步骤:升温步骤,在氧化气氛中进行,从一起始温度升温至目标温度,升温速率大于5℃/分钟,并同时使晶圆平转,以在晶圆表面生成第一氧化层,所生成的第一氧化层中心厚度小于边缘厚度;恒温氧化步骤,在目标温度以及氧化气氛中进行,并同时使晶圆平转,在晶圆表面继续生成第二氧化层,所生成的第二氧化层中心厚度

扫描晶圆表面图像的方法.pdf
本发明公开了一种扫描晶圆表面图像的方法,包括如下步骤:A、根据晶圆的轮廓获取晶圆的轮廓,并设置扫描的基本单元;B、判断当前所要扫描的基本单元是否位于晶圆的边缘,若是将扫描方向调整为从晶圆内向晶圆边缘外的方向;C、按照调整后的方向扫描所述基本单元,扫描完毕后转至步骤B。本发明方案可以解决现有技术中对晶圆表面扫描时边缘失焦的问题。

去除晶圆表面杂质的方法.pdf
本发明涉及微电子技术领域,公开了一种去除晶圆表面杂质的方法,包括:采用碱溶液对晶圆进行清洗;采用乙醇溶液对所述晶圆进行清洗;将所述晶圆置于真空室中,对所述晶圆进行加热。采用本发明实施例,能够有效去除晶圆表面残留的氟离子杂质,从而提高了晶圆的良率。

热氧化晶圆生成氧化层的方法.pdf
本发明涉及一种热氧化晶圆生成氧化层的方法,包括下列步骤:在炉管内放置需要氧化的晶圆并通过加热器对所述炉管进行加热;向反应器内通入氧气和氢气并混合燃烧;将燃烧后生成的水蒸气和剩余的氧气从所述炉管的进气口通入炉管内;从所述进气口通入氮气以将炉管内的气体从炉管的排气口排出;通入的所述氢气流量的一半加上通入的所述氧气流量等于通入的所述氮气流量。本发明通过重新设计通入的氢气和氧气的流量,使得通入氮气前后炉管内气体的流量保持一致,使得炉管内不同位置的晶圆与水蒸气和氧气反应的时间相等,从而能够获得良好的厚度一致性。

晶圆表面清洗方法.pdf
本发明提供晶圆表面清洗方法,包括步骤:提供晶圆,所述晶圆表面具有刻蚀残留;对所述晶圆表面进行清洗工艺;在晶圆清洗后的晶圆表面形成液膜。本发明可以避免干燥后在晶圆表面留下液痕或者颗粒,从而保证晶圆表面的清洁度。
