
沟槽型MOS器件的制作方法.pdf

青团****青吖






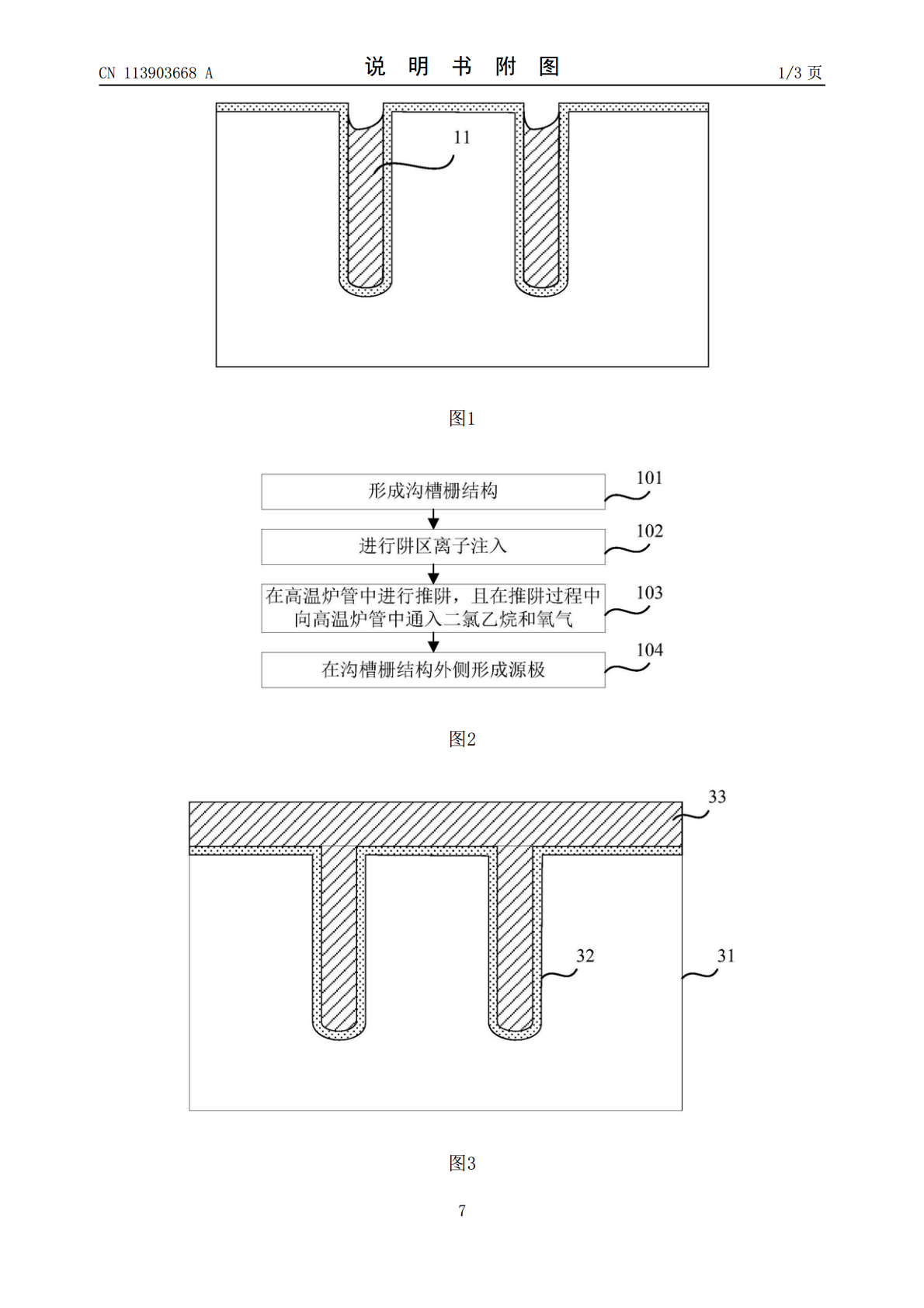
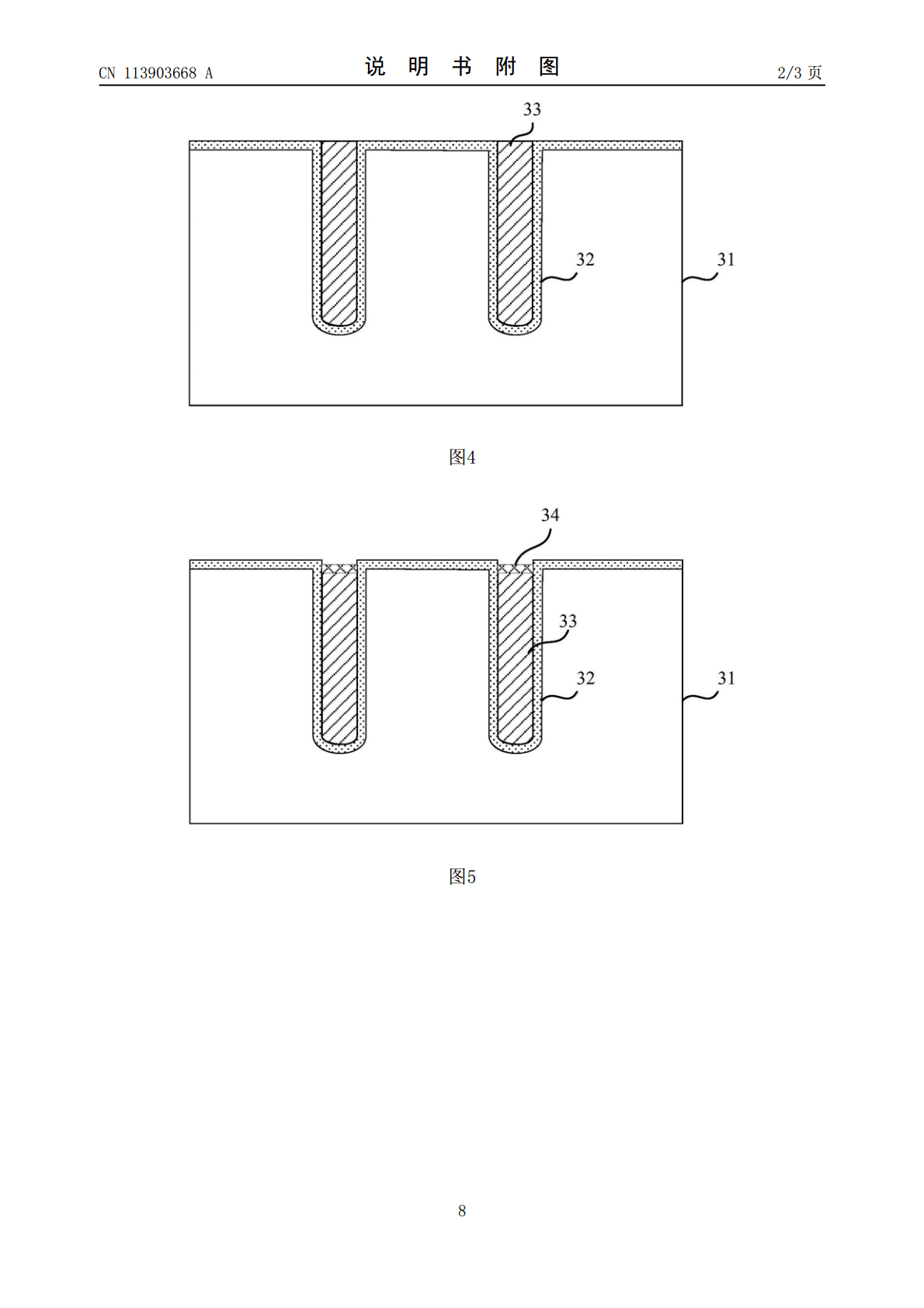

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

沟槽型MOS器件的制作方法.pdf
本申请公开了一种沟槽型MOS器件的制作方法,涉及半导体制造领域。该沟槽型MOS器件的制作方法包括:形成沟槽栅结构,进行阱区离子注入,在高温炉管中进行推阱,且在推阱过程中向高温炉管中通入二氯乙烷和氧气,在沟槽栅结构外侧形成源极;解决了目前沟槽型MOS器件中多晶硅栅容易出现缺陷的问题;达到了改善沟槽型MOS器件的饱和源漏电流性能的效果。

沟槽型MOS器件的制作方法.pdf
本申请公开了一种沟槽型MOS器件的制作方法,涉及半导体制造领域。该沟槽型MOS器件的制作方法包括提供制作有沟槽栅结构的衬底;在所述衬底表面形成可透过紫外线光的氮化硅层;在所述氮化硅层表面形成介质层;在所述介质层中形成接触孔;在介质层表面形成顶部金属层;沉积钝化层;对所述钝化层进行光刻和刻蚀;利用紫外线光照射所述衬底;解决了目前沟槽型MOS器件在介质层下方加垫氮化硅薄膜后,沟道漏电变大的问题;达到了改善沟槽型MOS器件沟道漏电的效果。

沟槽型MOS器件的制造方法.pdf
本发明提供了一种沟槽型MOS器件的制造方法,采用碳膜层和氮氧化硅层作为硬掩膜层,所述碳膜层和所述氮氧化硅层具有很高的刻蚀选择比,由此,可以采用较薄的氮氧化硅层,以形成小尺寸的开口用以执行离子注入工艺并且还易于控制所形成的开口的形貌,从而能够将有源区注入结构的尺寸降下来,并进而可以减小整个MOS器件的尺寸。

沟槽型IGBT器件的制作方法、沟槽型IGBT器件.pdf
本申请公开了一种沟槽型IGBT器件的制作方法,涉及半导体制造领域。该沟槽型IGBT器件的制作方法包括在IGBT终端区对应的衬底中形成场限环;在IGBT终端区对应的衬底中形成场氧;在终端区对应的衬底中形成沟槽场板,沟槽场板与IGBT有源区之间为场限环;在衬底表面形成介质层;在衬底的正面制作接触孔及正面金属层;解决了目前小元胞尺寸沟槽型IGBT器件的制作过程中接触孔和沟槽栅容易出现对准偏差的问题;达到了优化接触孔和沟槽栅的对准效果,提升小元胞尺寸沟槽型IGBT器件的性能的效果。

沟槽型MOS器件及其制造方法.pdf
本发明提供了一种沟槽型MOS器件及其制造方法,所述沟槽型MOS器件的制造方法包括:提供半导体衬底,所述半导体衬底中形成有沟槽栅;对所述沟槽栅侧的所述半导体衬底执行第一离子注入工艺,以在所述沟槽栅侧的所述半导体衬底中形成一阱区阻挡层;以及,在所述阱区阻挡层上的所述半导体衬底中形成阱区以及源区。通过在沟槽栅侧的半导体衬底中形成阱区阻挡层,从而避免后续形成阱区和源区过程中的热过程导致阱区结外扩,进而能实现做短沟道的目的,由此能改善导通电阻,提高沟槽型MOS器件的质量。
