
一种改善绝缘体上硅晶圆的器件硅层厚度均匀性的方法.pdf

秀美****甜v








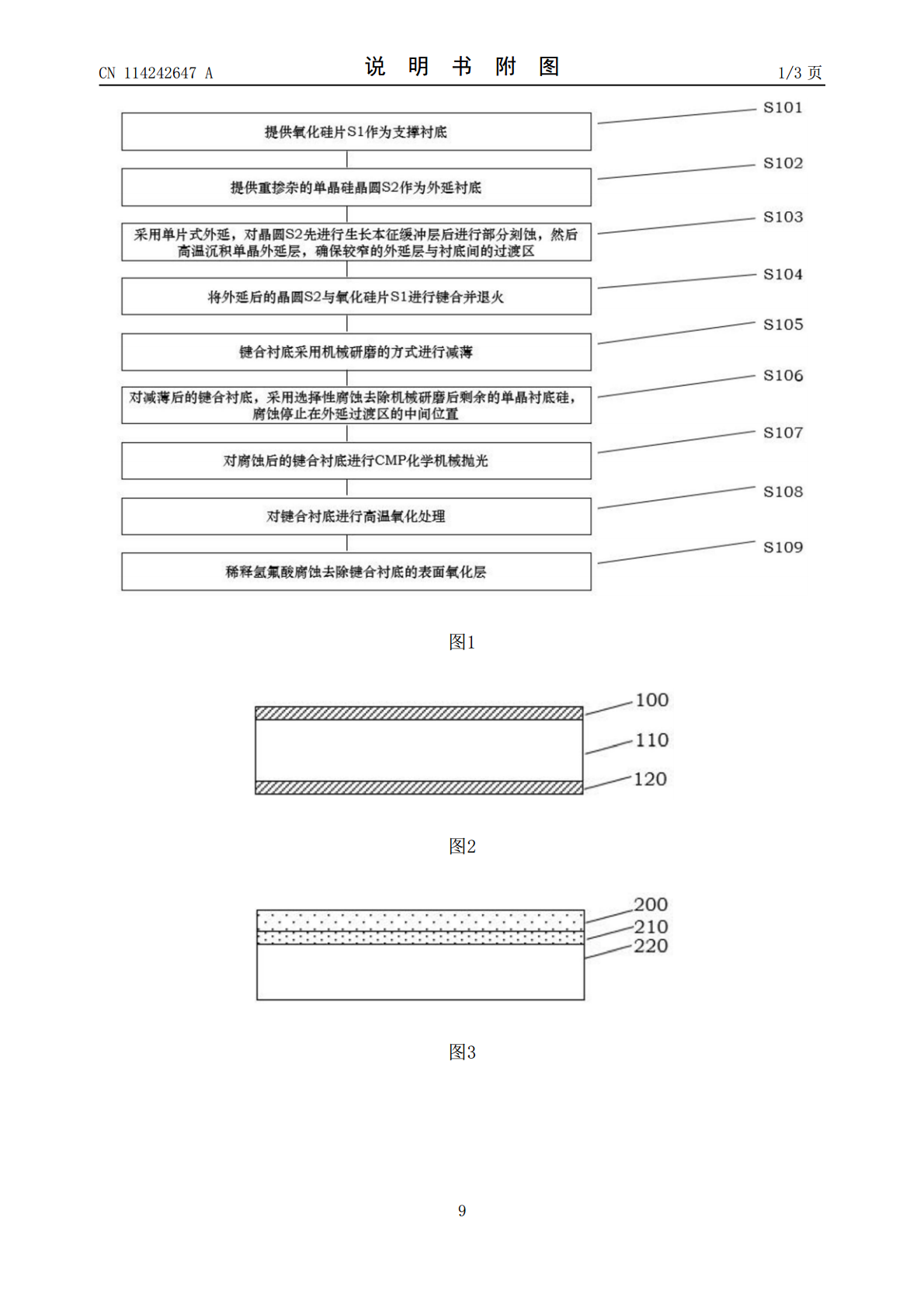
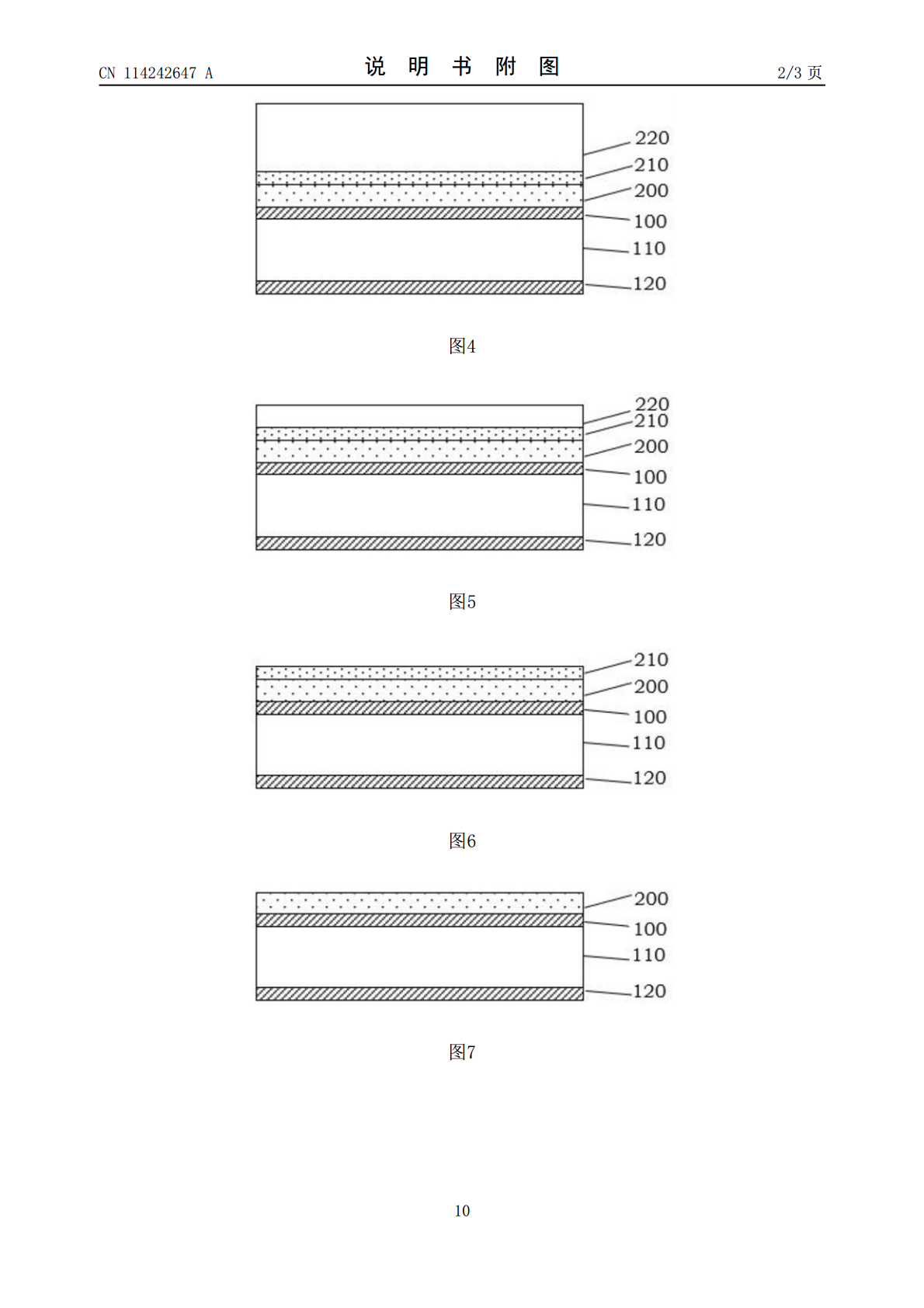
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种改善绝缘体上硅晶圆的器件硅层厚度均匀性的方法.pdf
本发明一种改善绝缘体上硅晶圆的器件硅层厚度均匀性的方法,采用单片式外延炉,在重掺硅衬底上,生长一层本征缓冲层,采用HCL刻蚀去除掉一部分,高温继续淀积生长符合电阻率要求的单晶硅外延;与作为支撑衬底的热氧化硅片进行键合并退火加固;对键合片采用机械研磨进行减薄,进行选择性酸腐蚀去除外延片的重掺硅衬底的残留部分;采用单片式CMP化学机械抛光进行小去除量的抛光,去除掉剩余的外延过渡区并改善面粗糙度,通过高温氧化的方式,在提升键合强度的同时,对绝缘体上的硅表面作进一步的减薄处理至目标厚度,通过含槽式稀氢氟酸腐蚀的湿

一种抛光改善晶圆厚度均匀性的方法.pdf
本发明公开了一种抛光改善晶圆厚度均匀性的方法,包括:保持抛光头不同位置的压力值相同,对待抛光晶圆表面进行第一次抛光处理,得到第一抛光晶圆;对第一抛光晶圆的表面进行厚度测量,得到第一抛光晶圆的整体厚度分布数据;通过第一抛光晶圆的整体厚度分布数据,提取第一抛光晶圆中局部厚度较大的区域作为修正区;通过第一抛光晶圆的修正区设置对应的修正垫,修正垫设置于第一抛光晶圆的修正区对应的第一抛光晶圆的背表面上,或设置于对应的所述抛光头中的气囊膜上;保持抛光头不同位置的压力值相同,对第一抛光晶圆进行第二次抛光处理,得到满足合

改善字线多晶硅层研磨后硬掩模层厚度均匀性的方法.pdf
本申请提供一种改善字线多晶硅层研磨后硬掩模层厚度均匀性的方法,包括:提供一衬底,衬底分为核心区和外围区,核心区上形成有多个闪存栅结构;沉积硬掩模层,覆盖核心区和外围区;刻蚀硬掩模层,在核心区的硬掩模层中形成多个条状沟槽;沉积字线多晶硅层,覆盖硬掩模层并填满多个条状沟槽;研磨字线多晶硅层和硬掩模层至硬掩模层的厚度比预定厚度多出预留部分时终止;实施浸泡工艺去除硬掩模层的预留部分。通过先将硬掩模层研磨至比预定厚度多出预留部分再实施浸泡工艺去除该预留部分的方式,提高字线多晶硅层研磨后硬掩模层厚度的均匀性,减少后续

一种监控多晶硅炉管晶圆厚度的方法.pdf
本发明公开了一种监控晶圆厚度的方法,通过在晶舟内放置4片监测晶圆来对反应炉内晶舟上放置的晶圆多晶硅生长厚度进行监测,相比较现有技术至少采用6片监控片进行监控减少了1/3的成本,同时在不影响晶圆多晶硅生长的前提下,可在晶舟上放置更多的产品晶圆,提高了生产效率。

非晶硅的应用、晶圆上芯片的形成方法及晶圆上芯片.pdf
本发明涉及一种非晶硅在晶圆上芯片中作为芯片之间填充材料的应用、晶圆上芯片的形成方法及晶圆上芯片。其中,晶圆上芯片的形成方法,包括以下步骤:提供待接合的晶圆以及多个芯片;执行接合工艺,在所述晶圆之上接合所述多个芯片且在所述多个芯片之间形成间隙;执行间隙填充工艺,以非晶硅作为填充材料填充所述间隙并覆盖所述芯片的表面;执行化学机械研磨工艺,以露出所述芯片的表面。采用非晶硅作为填充材料填充至各芯片之间的间隙中,由于非晶硅与作为芯片基材的硅的材质相近,在后续利用化学机械研磨工艺进行减薄的过程中,可以降低化学机械研磨
