
形成含有硅的EUV抗蚀剂下层膜的组合物.pdf

书生****aa








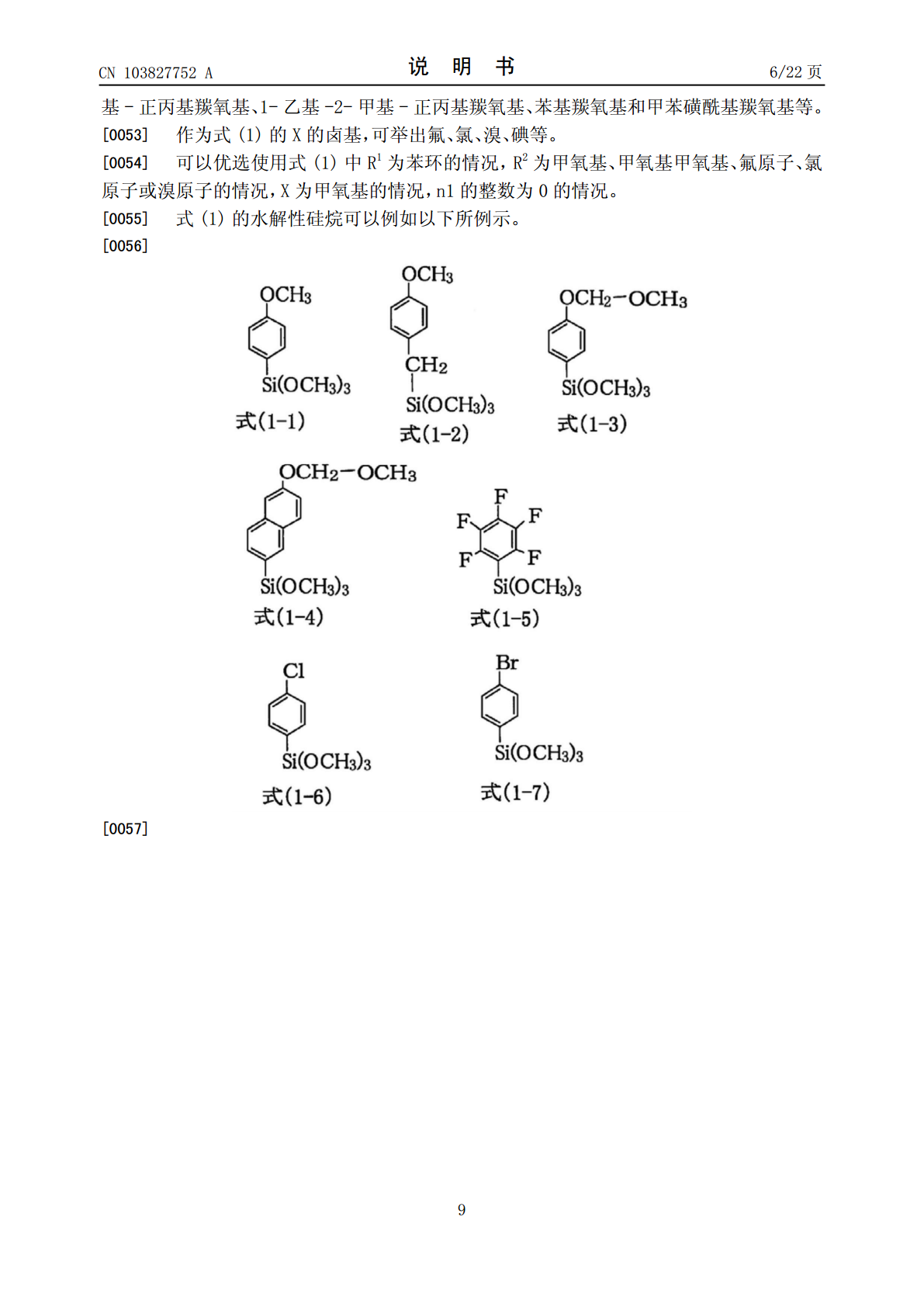

亲,该文档总共25页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

形成含有硅的EUV抗蚀剂下层膜的组合物.pdf
本发明的课题是提供一种EUV抗蚀剂的曝光灵敏度提高,用EUV光曝光时释气发生少的光刻用抗蚀剂下层膜和用于形成该下层膜的形成抗蚀剂下层膜的组合物。作为解决本发明课题的方法涉及一种形成EUV光刻用抗蚀剂下层膜的组合物,其包含作为硅烷的水解性硅烷、其水解物、其水解缩合物、或它们的混合物,该水解性硅烷包含四甲氧基硅烷与烷基三甲氧基硅烷与芳基三烷氧基硅烷的组合,该芳基三烷氧基硅烷由下述式(1)表示:(式(1)中,R1表示由苯环或萘环构成的芳香族环、或者包含异氰脲酸结构的环,R2为芳香族环的氢原子的取代基,为卤原子或

抗蚀剂下层膜形成用组合物.pdf
提供用于形成不溶于抗蚀剂溶剂、光学常数良好、可以适当调整蚀刻速率的抗蚀剂下层膜,并且对高低差基板的埋入性和平坦化性优异的组合物。一种抗蚀剂下层膜形成用组合物,其包含:(A)下述式(I)所示的交联性化合物;以及(D)溶剂。[式中,n为2~6的整数,n个Z各自独立地为包含单甲酰基芳基、二甲酰基芳基、三甲酰基芳基、四甲酰基芳基、五甲酰基芳基或六甲酰基芳基的1价有机基,n个A各自独立地表示?OCH<base:Sub>2</base:Sub>CH(OH)CH<base:Sub>2</base:Sub>O?、或(BB

抗蚀剂下层膜形成用组合物.pdf
本发明提供表现出高耐蚀刻性、良好的干蚀刻速度比及光学常数,对所谓高低差基板被覆性也良好、埋入后的膜厚差小、可形成平坦膜的抗蚀剂下层膜形成用组合物。另外还提供使用了该抗蚀剂下层膜形成用组合物的抗蚀剂下层膜、以及半导体装置的制造方法。该抗蚀剂下层膜形成用组合物包含具有下述式(1)所示的部分结构的聚合物和溶剂。<base:Imagehe=@430@wi=@615@file=@DDA0003586299600000011.JPG@imgContent=@drawing@imgFormat=@JPEG@orient

抗蚀剂下层膜形成用组合物.pdf
提供用于形成不溶于抗蚀剂溶剂、光学常数良好、可以适当调整蚀刻速率的抗蚀剂下层膜,并且对高低差基板的埋入性和平坦化性优异的组合物。一种抗蚀剂下层膜形成用组合物,其包含:(A)下述式(I)所示的交联性化合物;以及(D)溶剂。[式中,n为2~6的整数,n个Z各自独立地为包含单甲酰基芳基、二甲酰基芳基、三甲酰基芳基、四甲酰基芳基、五甲酰基芳基或六甲酰基芳基的1价有机基,n个A各自独立地表示?OCH<base:Sub>2</base:Sub>CH(OH)CH<base:Sub>2</base:Sub>O?、或(BB

纳米压印用抗蚀剂下层膜形成用组合物.pdf
提供在高温烧成时也显示异常高的疏水性、良好的平坦化性,可以通过变更分子骨架来调整为适应于工艺的光学常数、蚀刻速度的纳米压印用抗蚀剂下层膜形成用组合物。一种纳米压印用抗蚀剂下层膜形成用组合物,其包含具有下述式(1)所示的重复单元结构的酚醛清漆树脂,[在式(1)中,基A表示具有芳香族环、稠合芳香族环、或稠合芳香族杂环的有机基,基B表示具有芳香族环或稠合芳香族环的有机基,基E表示单键、或者可以被取代且可以包含醚键和/或羰基的支链或直链的碳原子数1~10的亚烷基,基D表示式(2)所示的碳原子数1~15的有机基,n
