
一种共栅共源型多通道氮化镓HEMT器件及制造方法.pdf

一条****淑淑









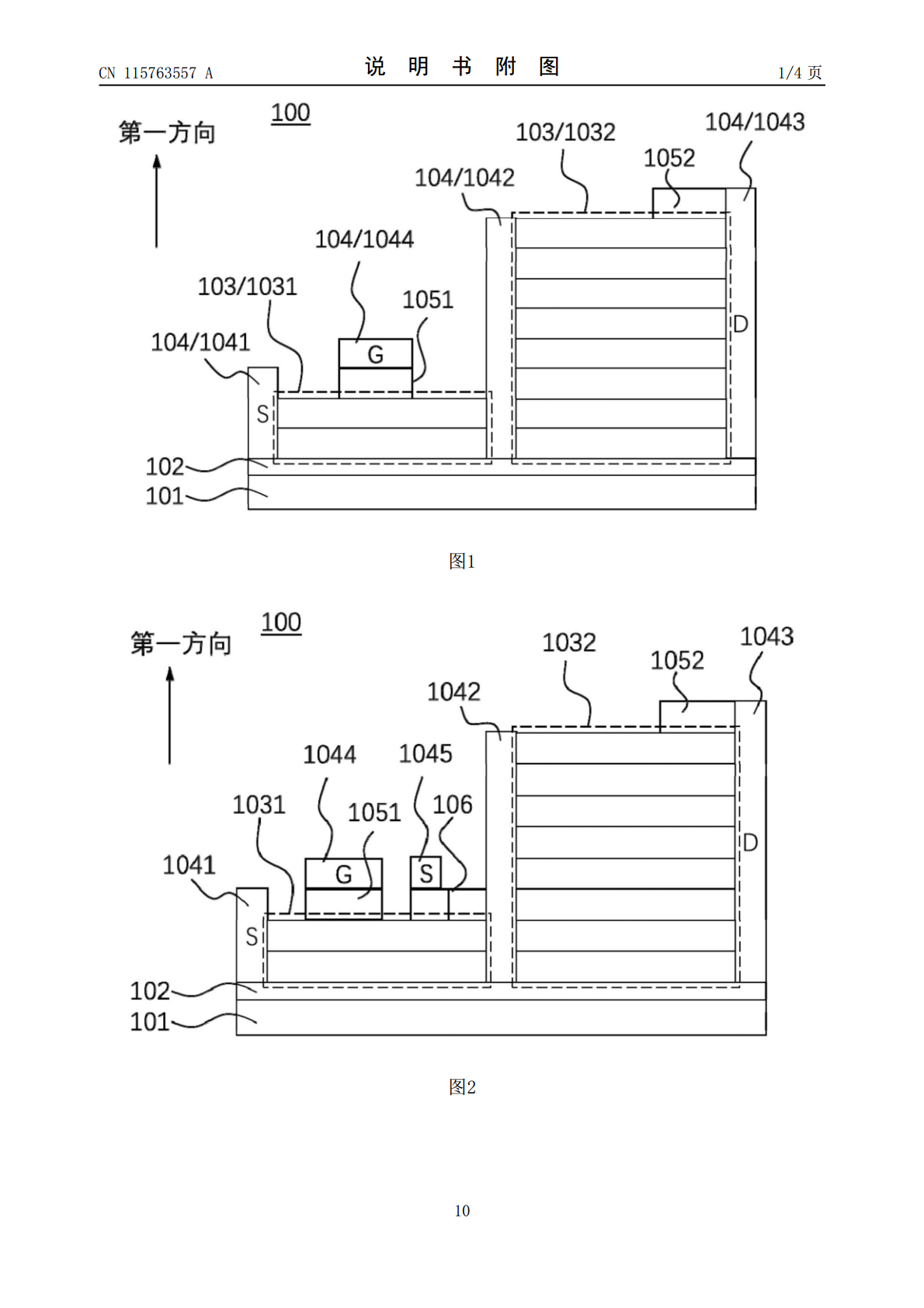
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种共栅共源型多通道氮化镓HEMT器件及制造方法.pdf
本发明涉及一种共栅共源型多通道氮化镓HEMT器件结构和制造方法,其中结构包括衬底基板,位于衬底基板一侧的缓冲层,位于所述缓冲层远离所述衬底基板一侧的第一异质结结构及第二异质结结构,所述第一异质结结构包括至少一个AlGaN/GaN异质结,所述第二异质结结构包括多个沿第一方向叠加的AlGaN/GaN异质结,第一电极与所述第一异质结结构一端连接,金属连接部与第一异质结结构另一端连接且与第二异质结结构的一端连接;第二电极与所述第二异质结结构的另一端连接,栅电极位于所述第一异质结结构远离所述衬底基板的一侧。

一种氮化镓HEMT器件的制造加工设备及制造方法.pdf
本发明涉及半导体加工的技术领域,特别涉及一种氮化镓HEMT器件的制造加工设备及制造方法,其使用了一种氮化镓HEMT器件的制造加工设备,包括安装底板、支撑杆、安装轴、封边装置和驱动装置,所述的安装底板下端面靠近四个拐角处固定有多个支撑杆,安装底板上通过轴承转动安装有多个横向布置的安装轴,安装轴的上端连接有封边装置,其中一个安装轴的下侧连接有驱动装置。相比于现有技术,本发明设计了一种可通过调节以适应不同尺寸外延片的封边装置,提升了该制造加工设备的整体利用率和加工效率,并防止了外延片在进行旋转涂胶时光刻胶容易从

一种氮化镓HEMT射频微波器件栅金属制备的方法.pdf
本申请提供了一种氮化镓HEMT射频微波器件栅金属制备的方法,涉及半导体技术领域,包括如下步骤:将清洗后的GaN片进行第一次烘烤去除水分;对其旋涂电子束光刻胶并第二次烘烤,烘烤后的电子束光刻胶厚度为230nm;基于定义了栅极图案的电子束进行曝光;曝光完成后,使用甲基异丁基酮和异丙醇的溶液显影;在异丙醇中定影溶解显影液中的残胶和残留的甲基异丁基酮;用去离子水对GaN冲洗并第三次烘烤;蒸镀栅金属并在沸腾的丙酮中剥离;采用电子束制备栅长为亚微米级别的栅金属,从工艺上实现了栅长为亚微米级别的栅金属,提高了氮化镓

一种蓝宝石衬底的GaN HEMT器件及共源共栅结构.pdf
本发明公开一种蓝宝石衬底的GaNHEMT器件及共源共栅结构,涉及GaNHEMT器件技术领域,所述蓝宝石衬底的GaNHEMT器件,包括:由上向下依次设置的蓝宝石衬底、GaNHEMT层和电极层;所述电极层包括源极、栅极和漏极。本发明可以实现GaNHEMT器件的高效散热。

一种氮化镓器件及氮化镓器件的封装方法.pdf
本发明提供了一种氮化镓器件及氮化镓器件的封装方法,包括:步骤1:获取基座,并在所述基座的表面设置按照预设位置分布的焊点,得到基座层;步骤2:将氮化镓芯片利用第一结合材焊接在所述基座层,将散热片利用第二结合材焊接在所述氮化镓芯片上方,且将所述散热片的下端贴附在所述基座层;步骤3:对所述散热片和氮化镓芯片进行塑封,得到塑封层,得到氮化镓器件;步骤4:对所述氮化镓器件进行质检,得到满足质检要求的氮化镓器件;通过在氮化镓芯片的上方焊接散热片,避免了热量在所述氮化镓芯片的聚集,同时,通过对氮化镓器件进行质检,保证得
