
等离子残胶去除装置.pdf

书生****66








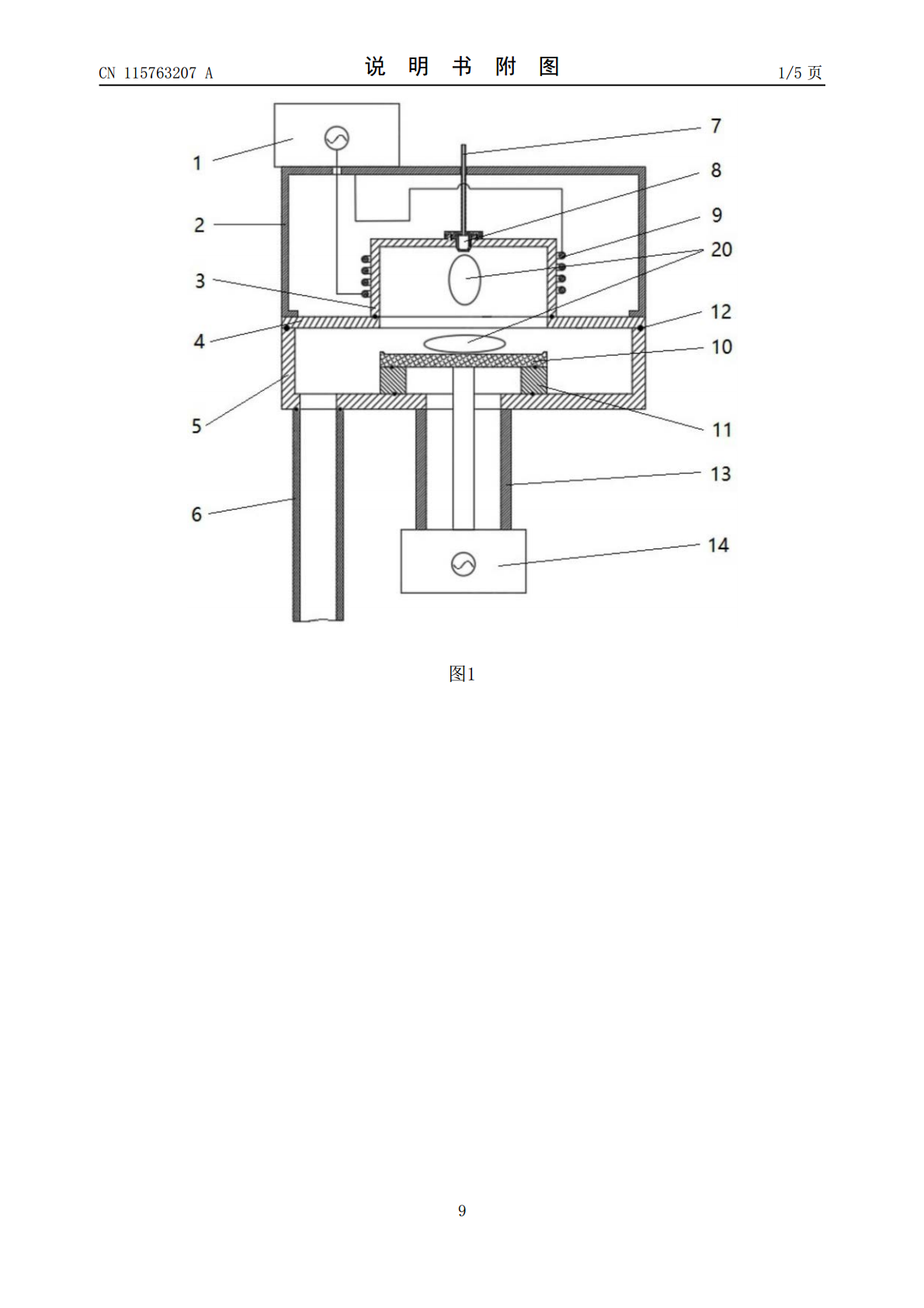

亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

等离子残胶去除装置.pdf
本说明书实施例提供一种等离子残胶去除装置,包括射频匹配器、远程离子源、相互连接的屏蔽罩和工艺腔体,工艺腔体的上部设置有匀气盘,匀气盘与工艺腔体之间绝缘,工艺腔体内部对应匀气盘的下部内壁连接有晶圆载台,其中,匀气盘、晶圆载台、屏蔽罩和工艺腔体均由金属良导体制成;在去除光刻胶残胶的工艺中,匀气盘被配置成电连接射频匹配器的射频高压,晶圆载台被配置成与屏蔽罩、工艺腔体共同射频接地,以使被远程离子源激发的等离子体在直流偏压作用下,轰击晶圆载台上的晶圆去除残胶。该等离子残胶去除装置仅采用一套射频匹配器,即可执行以往需

去除手机中框残胶的激光装置及手机中框残胶去除方法.pdf
(19)中华人民共和国国家知识产权局(12)发明专利申请(10)申请公布号CN110976429A(43)申请公布日2020.04.10(21)申请号CN201911141200.8(22)申请日2019.11.20(71)申请人大族激光科技产业集团股份有限公司地址518000广东省深圳市南山区深南大道9988号(72)发明人代雨成;曹洪涛;吕启涛;黄海庆;刘亮;高云峰(74)专利代理机构深圳市恒申知识产权事务所(普通合伙)代理人鲍竹(51)Int.CI权利要求说明书说明书幅图(54)发明名称去除手机中框

去除手机中框残胶的激光装置及手机中框残胶去除方法.pdf
本发明提供了一种去除手机中框残胶的激光装置及手机中框残胶去除方法,去除手机中框残胶的激光装置包括:底座、运动平台、定位治具、支撑架、光源系统、成像定位组件及激光系统,手机中框残胶去除方法包括:产品上料、打光、采集残胶特征及形成激光加工图档、激光系统去除残胶特征及产品下料。定位手机中框后,运动平台带动定位治具运动从而调整手机中框的空间位姿,光源系统对手机中框进行照明,从而使成像定位组件更加容易而准确地识别残胶特征的位置信息,得到残胶特征的位置信息后,在运动平台的配合下,激光系统即可产生紫外激光并根据位置信息

残液去除装置.pdf
本发明涉及一种残液去除装置,用于电池注液口清洁,包括进气管;排气管,排气管与电池注液口连通;清洁头组件,清洁头组件包括至少一个风道,风道的一端连接进气管,风道的另一端抵接电池注液口。本申请所提供的残液去除装置,将压缩空气通入到清洁头组件上,利用清洁头组件上的至少一个风道,使高压气流喷射在电池注液口并将注液口处的残液雾化,然后利用抽气装置将雾化后的电解液残液抽走来达到清除的目的。采用本申请所提供的残液去除装置,无污染,且废气、废液易回收;可高效清洁电解液注液孔残留物,清洁过程中无需消耗品,无需更换材料,有效

去除烘烤单元加热板PI残胶的方法.pdf
本申请涉及半导体集成电路制造技术领域,具体涉及一种去除烘烤单元加热板PI残胶的方法。去除烘烤单元加热板PI残胶的方法包括:将带有PI残胶的烘烤单元加热板设于清洗区域;将所述烘烤单元加热板的表面浸泡在60℃至80℃之间的二甲基亚砜溶剂中,使得所述烘烤单元加热板表面的PI残胶溶解在二甲基亚砜溶剂中;清洁所述烘烤单元加热板以去除溶解有PI残胶的二甲基亚砜溶剂。本申请提供的去除烘烤单元加热板PI残胶的方法,可以解决相关技术中烘烤单元加热板上PI胶残留严重的问题。
