
键合结构及用于制造键合结构的方法.pdf

努力****采萍









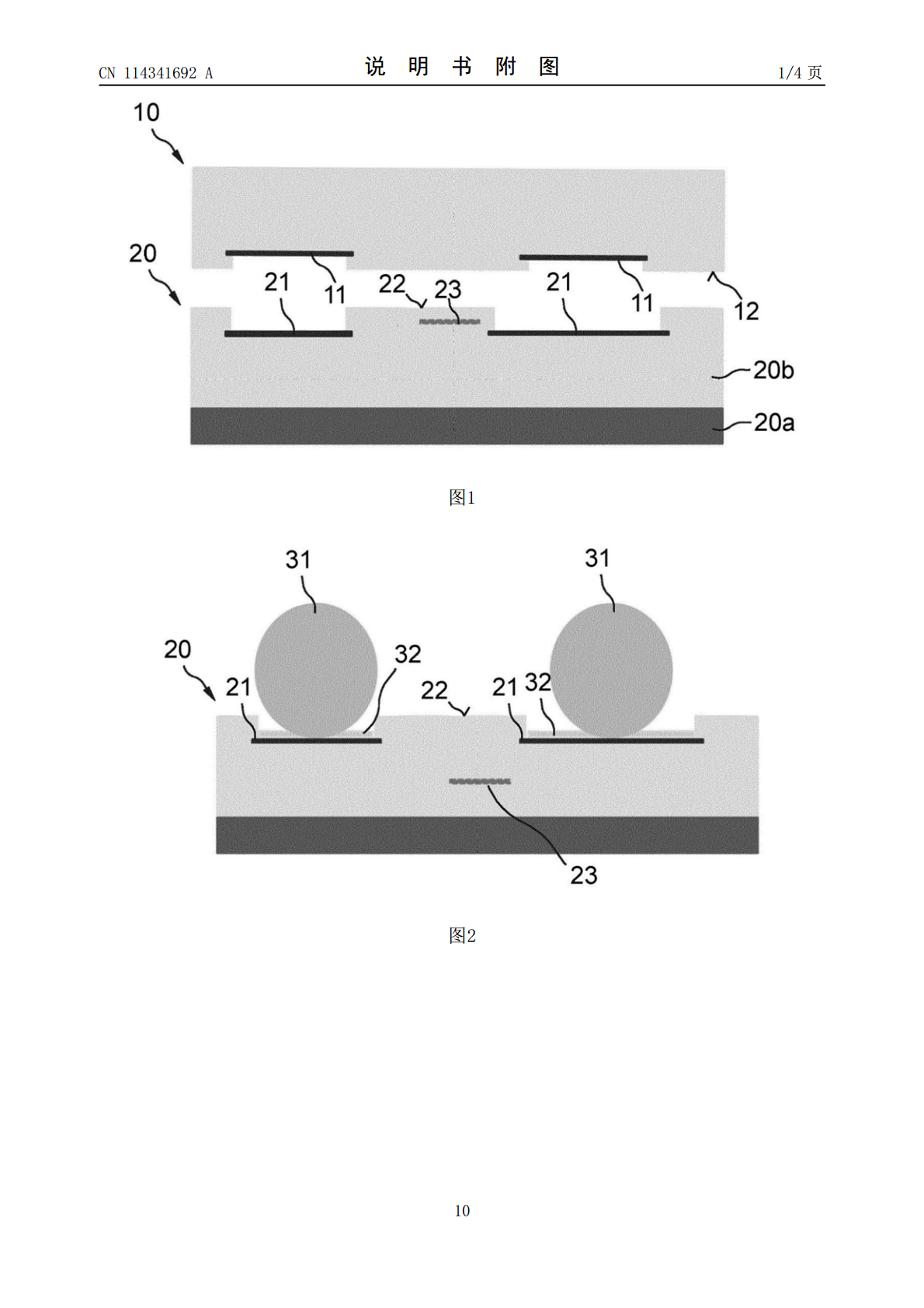
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

键合结构及用于制造键合结构的方法.pdf
键合结构(1)包括具有布置在衬底组件(20)的表面(22)上或内的多个第一焊盘(21)的衬底组件(20),以及具有布置在集成电路组件(10)的表面(12)上或内的多个第二焊盘(11)的集成电路组件(10)。键合结构(1)还包括将第一焊盘(21)物理连接到第二焊盘(11)的多个连接元件(31)。集成电路组件(10)的表面(12)以倾斜角度(α)相对于衬底组件(22)的表面(22)倾斜,该倾斜角度由第一焊盘和第二焊盘(21、11)的表面尺寸的标称变化引起。

晶圆键合方法及晶圆键合结构.pdf
本发明公开了一种晶圆键合方法及晶圆键合结构,晶圆键合方法包括:提供第一晶圆,所述第一晶圆包括若干第一芯片单元,每个所述第一芯片单元包含若干第一焊垫;于所述第一焊垫上形成焊接凸起;提供第二晶圆,所述第二晶圆包括若干第二芯片单元,每个所述第二芯片单元包含若干第二焊垫;采用热压焊或超声焊技术将所述第一晶圆压合于所述第二晶圆上,所述焊接凸起与所述第二焊垫之间电性连接。本发明的晶圆键合方法以及晶圆键合结构,其能够提高集成度,且键合工艺简单,不会对晶圆造成损坏,降底了封装结构的尺寸以及封装成本。

一种晶圆键合方法及键合结构.pdf
本发明提供一种晶圆键合方法及晶圆键合结构,涉及半导体封装技术领域。方法包括:获取待键合的第一晶圆和第二晶圆;所述第一晶圆包括第一面;所述第二晶圆包括第二面;对所述第一晶圆的所述第一面涂覆键合胶形成键合面;在第一温度下的第一真空环境中对所述键合胶加热烘干;以预设间隔距离固定所述第一晶圆和所述第二晶圆,在第二真空环境中对所述键合胶加热至第二温度;在所述第二温度下将所述第一晶圆的所述键合面与所述第二晶圆的所述第二面相互接触,形成键合结构。该方法可以避免键合胶加热气化后部分组分形成的气体以气泡方式从胶内部溢出,进

用于直接键合结构的尺寸补偿控制.pdf
公开了一种将具有差异厚度的第一半导体元件和第二半导体元件直接混合键合的方法。该方法可以包括:对第一半导体元件上的多个第一接触特征进行图案化。该方法可以包括:对第二半导体元件上的与第一接触特征相对应的多个第二接触特征以用于直接混合键合。该方法可以包括:将光刻倍率校正因子应用于第一图案化和第二图案化中的一者,而不将光刻倍率校正因子应用于第一图案化和第二图案化中的另一者。在各种实施例中,差异膨胀补偿结构可以被设置在第一半导体元件和第二半导体元件中的至少一者上。差异膨胀补偿结构可以被配置为补偿第一半导体元件与第二

半导体键合结构及其制备方法.pdf
本发明提供一种半导体键合结构及其制备方法,在第一载片中形成相连通的第一凹槽、第一孔、第二凹槽,以及图形化的第一键合层;在第二载片中形成贯穿第二载片的第二孔,以及图形化的第二键合层;并通过将第一键合层与第二键合层键合构成具有空腔结构的临时键合载片;而后将半导体结构片通过临时键合胶键合于临时键合载片上,从而在后续的工艺过程中,临时键合胶内产生的内压力可以通过临时键合载片中的空腔结构得以释放,以此解决在高温高真空工艺过程中,因为临时键合胶产生的压力无法释放所造成的半导体结构片鼓泡、裂片等问题,以提高最终制备的转
