
金属钨膜及其制备方法.pdf

努力****妙风









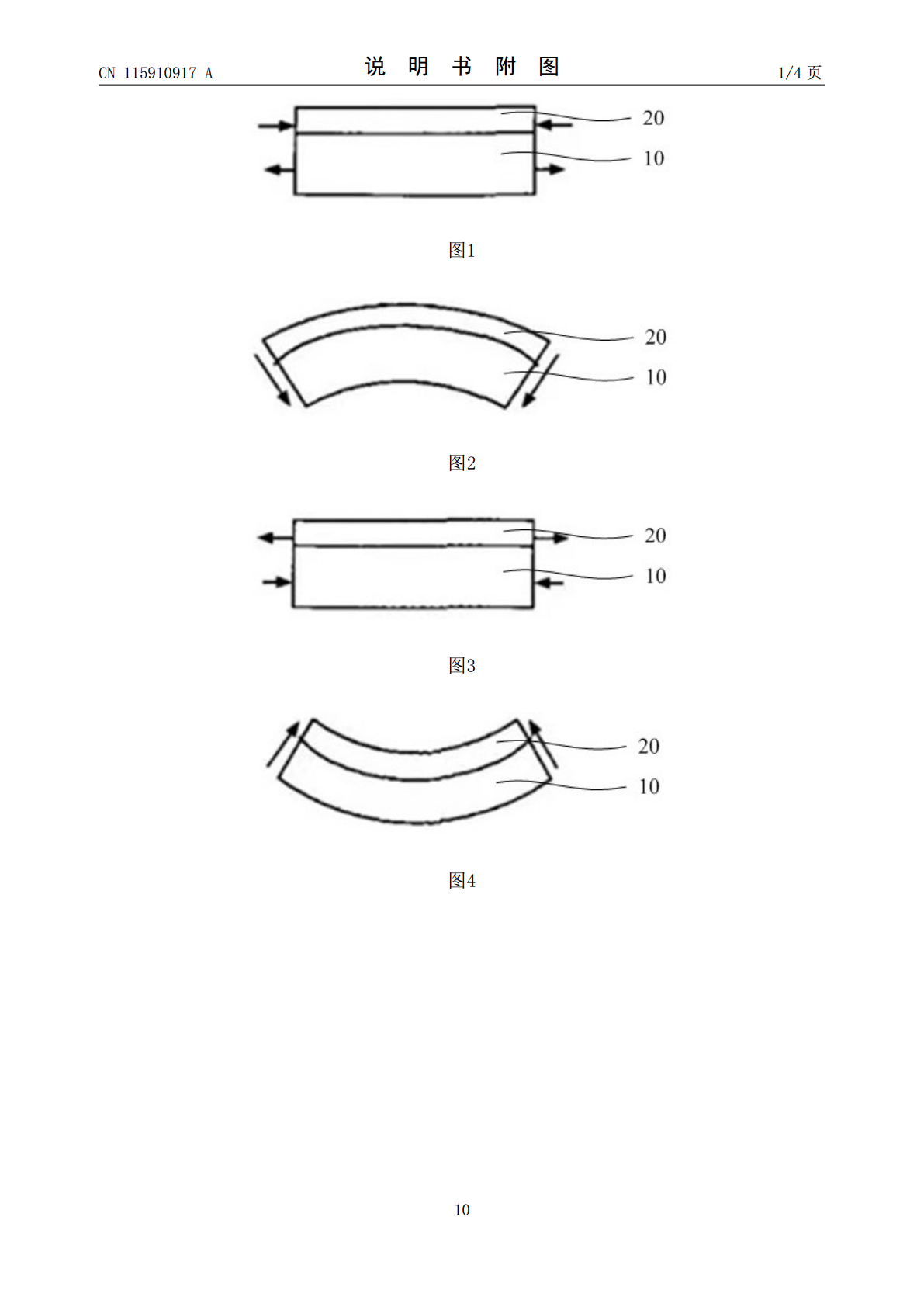
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

金属钨膜及其制备方法.pdf
本发明提供一种金属钨膜及其制备方法,其制备方法包括:提供半导体衬底;于半导体衬底上沉积钨成核层;于钨成核层上沉积钨体沉积层;钨成核层与钨体沉积层的总厚度小于预设厚度,重复进行沉积钨成核层及钨体沉积层至少一次形成多层结构,直至得到预设厚度的金属钨膜。本发明通过一种简单的多层膜层结构设计和WCVD制备方法结合的方式,在不需要改变现有工艺参数的基础上,解决制备大厚度的金属钨膜因应力、衬底弯曲形变较大,出现膜层破裂、剥离翘曲或剥落等问题;本发明以多层结构的方式,将金属钨膜分层沉积,通过细化晶粒、增加晶界面积,使得

一种钨表面阻氧膜及其制备方法.pdf
本发明公开了一种钨表面阻氧膜,包括钨基体,钨基体表面镀有复合膜层,复合膜层依次为铝层、第一氮化铬铝层、铬层、第二氮化铬铝层,复合膜层的底层为铝层,复合膜层的顶层为第二氮化铬铝层。本发明还公开了该阻氧膜的制备方法,首先,将钨基体表面打磨、抛光;再将钨基体依次置于碱溶液和酸溶液中,进行超声波清洗;最后将钨基体置于镀膜机,采用PVD法镀制阻氧膜。钨表面经处理后,不仅可以耐800℃高温,而且具有优良的润滑性能,极大改善了钨工件的使用环境,其硬度可达1800HV以上,该抗氧化膜薄而均匀,保留钨原有尺寸,不影响钨使用

一种石墨烯覆膜钡钨阴极及其制备方法.pdf
本发明公开了一种石墨烯覆膜钡钨阴极及其制备方法,所述石墨烯覆膜钡钨阴极包括石墨烯层和B型钡钨阴极层,B型钡钨阴极层的上表面覆石墨烯层,B型钡钨阴极层置于支撑筒内,支撑筒内的B型钡钨阴极层下设置灯丝。所述制备方法包括以下步骤:(1)制备B型钡钨阴极;(2)在衬底生长石墨烯一侧覆TRT,通过溶液腐蚀去除衬底,保留石墨烯,将覆有石墨烯的TRT清洗,烘干;(3)在温控台上放置石墨烯/TRT膜,B型钡钨阴极倒置其上,控制温度达到TRT热剥离温度,再将阴极取开,石墨烯附着在阴极表面。本发明有利于降低钡钨阴极表面逸出功

一种金属钨超细粉体及其制备方法.pdf
本发明涉及一种金属钨超细粉体及其制备方法。其技术方案是:将12~25wt%的钨酸钠粉体、1.5~5.0wt%的金属铝粉体和70~86wt%的卤化物粉体混合均匀,制得混合物;将混合物置入管式电炉内,在氩气气氛下以2~8℃/min的升温速率升至600~1100℃,保温3~6小时,再将所得产物放入浓度为2.0~4.0mol/L的盐酸中浸泡3~8小时,过滤,用去离子水清洗至清洗液为中性,然后在110℃条件下干燥10~24小时,即得金属钨超细粉体。本发明具有合成工艺简单、合成过程易于控制、反应温度低、产率高和生产成

金属外观效果优秀的装饰膜及其制备方法.pdf
本发明涉及装饰膜及其制备方法,上述装饰膜依次层叠有:具有立体图案的第一紫外线固化性树脂层;基材层;具有横向发丝图案的第二紫外线固化性树脂层;底涂层;以及金属层。
