
一种集成电路封装结构.pdf

鹏飞****可爱





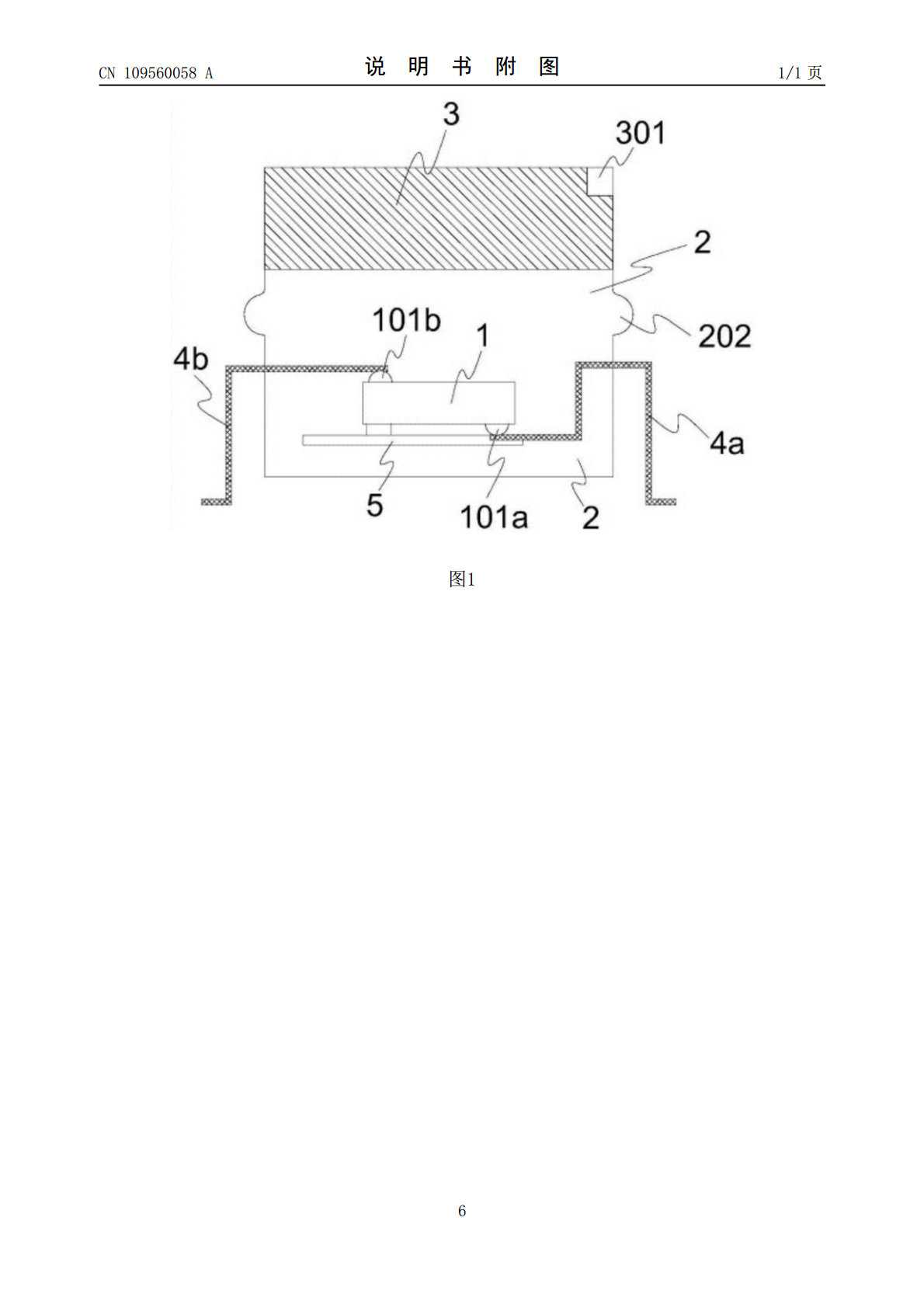
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种集成电路封装方法及封装结构.pdf
本发明公开了一种集成电路封装方法及封装结构。本发明一方面采用在支撑架中设置通槽并利用胶带粘附放置在通槽中的主动和/或被动器件,简化了埋芯集成电路的封装工艺;第二方面,本发明兼容引线键合与倒装键合的优势,并且取消引线键合、倒装键合中的金属线或锡铅球,降低生产成本;第三方面,通过在插件内嵌入主动和/或被动器件并与填充材料无缝连接,改善电性能和提高芯片散热性能,能够实现缩减封装体积,缩短通向外界的连接,使封装的尺寸变得更加轻薄。本发明可广泛应用于各种集成电路封装。

一种集成电路封装结构.pdf
本发明涉及一种集成电路封装结构,包括集成电路本体芯片;所述集成电路本体芯片底部靠近右侧的位置焊接有第一弹性凸点,所述集成电路本体芯片顶部靠近左侧的位置焊接有第二弹性凸点;所述第一弹性凸点和第一引脚结合,所述第二弹性凸点和第二引脚结合;在所述集成电路本体芯片的底部靠近左侧的位置连接预定位支撑架,所述预定位支撑架和第二引脚相连;树脂封装结构将第一弹性凸点和第一引脚封装在一起,同时将第二弹性凸点和第二引脚结合;在树脂封装结构的顶部两侧设置有侧面凸起;在所述树脂封装结构的顶部设置有导热复合层。本发明封装结构芯片和

一种结构优化的集成电路封装.pdf
本发明公开了一种结构优化的集成电路封装,包括基板,基板上固定有两个承载座,承载座上成型有两个凹台,凹台内安置有集成电路芯片,基板的顶面成型有若干条嵌置凹槽,嵌置凹槽内嵌置有冷却液管,冷却液管的两端连接有缓冲连接管,缓冲连接管上套设有石墨散热环;承载座上成型有插接槽,插接槽内插接有限位板,限位板的底面上固定有导电片,导电片的一端抵靠在集成电路芯片的触点上,限位板的上端面中部成型有齿条部,插接槽上成型有连接槽,连接槽内插接有滚轮,滚轮的侧壁上成型有插槽,滚轮内固定驱动齿轮,限位板的齿条部插套在插槽内并与驱动齿

集成电路芯片封装结构.pdf
集成电路芯片封装结构全文共四篇示例,供读者参考第一篇示例:集成电路芯片封装结构是指将制造好的芯片封装在外部保护壳体中,以保护芯片免受外界环境的影响。封装是集成电路芯片制造过程中的最后一道工序,它直接影响到芯片的稳定性、可靠性和性能。不同的封装结构具有不同的特点和适用场景,下面将对常见的集成电路芯片封装结构进行详细介绍。一、单晶片封装单晶片封装是一种最简单的封装结构,它将芯片直接封装在一个封装体中。这种封装结构在芯片面积较小、功耗较低的集成电路中常见。由于单晶片封装没有额外的引脚和连接线路,因此具有较小的封

集成电路芯片封装结构.pdf
集成电路芯片封装结构全文共四篇示例,供读者参考第一篇示例:集成电路芯片封装结构是指将制造好的芯片封装在外部保护壳体中,以保护芯片免受外界环境的影响。封装是集成电路芯片制造过程中的最后一道工序,它直接影响到芯片的稳定性、可靠性和性能。不同的封装结构具有不同的特点和适用场景,下面将对常见的集成电路芯片封装结构进行详细介绍。一、单晶片封装单晶片封装是一种最简单的封装结构,它将芯片直接封装在一个封装体中。这种封装结构在芯片面积较小、功耗较低的集成电路中常见。由于单晶片封装没有额外的引脚和连接线路,因此具有较小的封
