
一种改良石墨坩埚及其制备方法与应用.pdf

论文****可爱









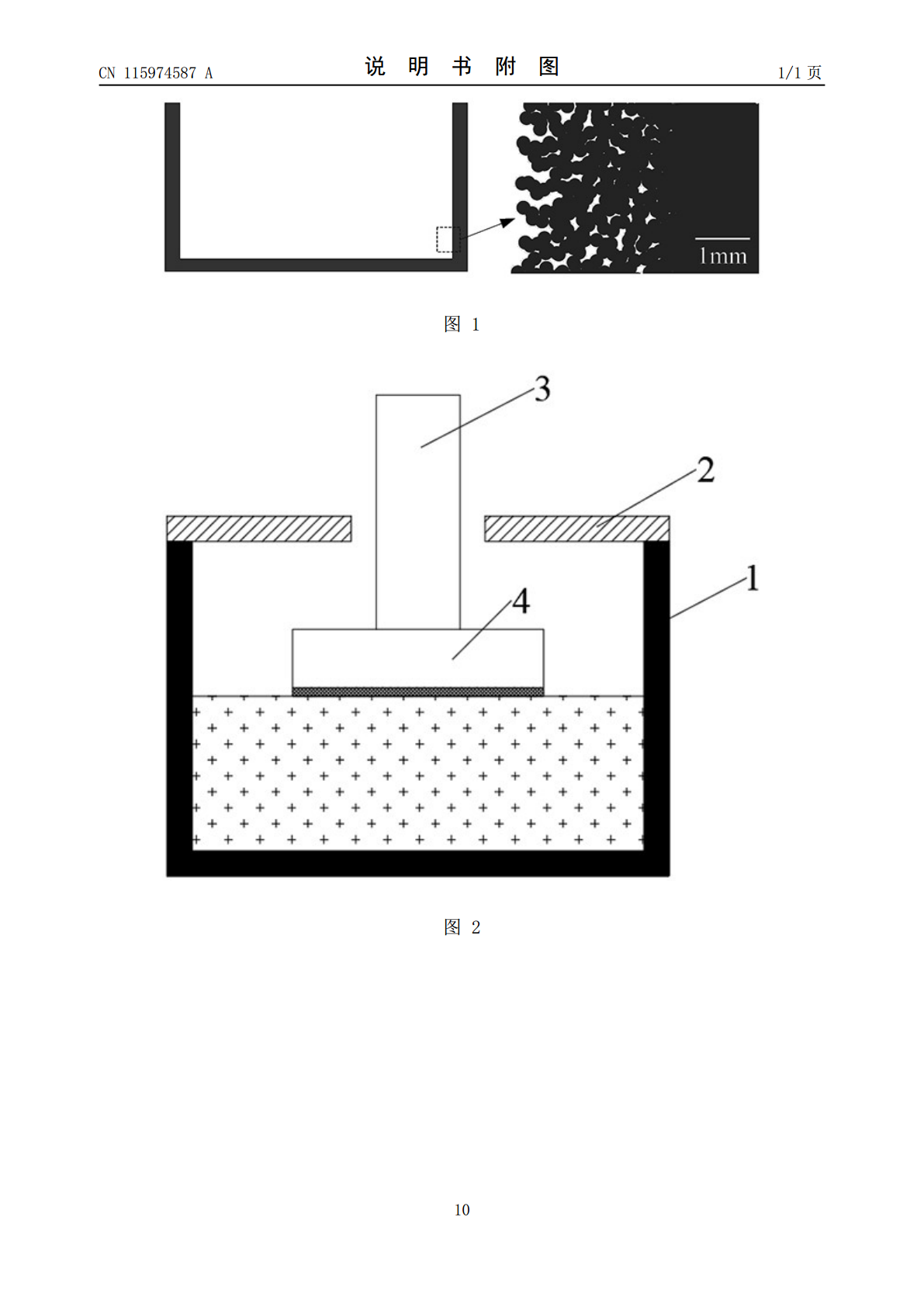
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种改良石墨坩埚及其制备方法与应用.pdf
本发明涉及一种改良石墨坩埚及其制备方法与应用,所述制备方法包括如下步骤:含氧气氛下热处理石墨坩埚的内腔,得到所述改良石墨坩埚。本发明提供的改良石墨坩埚的内壁为孔隙结构;沿远离改良石墨坩埚中心轴的方向,所述孔隙结构的孔隙率逐渐降低。内壁最内层的孔隙结构使石墨与含硅的合金溶液接触的表面积增加,提高了碳元素溶解到含硅的合金溶液中的速度,从而提高了SiC单晶生长的速度。

一种石墨坩埚及其制备方法.pdf
本发明涉及一种石墨坩埚及其制备方法,其通过在石墨坩埚内形成碳化铌膜层,来减少石墨坩埚中碳元素参与到晶体的生产过程,进而抑制晶体石墨化。而在石墨坩埚上制备碳化铌时,利用超声波将氧化铌附着到坩埚上,然后利用现有的长晶炉对坩埚进行热碳还原处理,进而在石墨坩埚上形成碳化铌膜层。该制备过程简单,利用现有的长晶炉即可完成,制备成本低。

一种人造石墨坩埚及其制备方法.pdf
本发明公开了一种人造石墨坩埚及其制备方法。以重量百分含量表示,该人造石墨坩埚主要由原料焦炭45~65%、人造石墨粉15~25%和高温改质沥青20~30%制成。首先将配制的焦炭和人造石墨粉粉碎,高温改质沥青熔化成液体;将处理后的原料混捏均匀,得到糊料;糊料凉料后成型,得到石墨坩埚生制品;将石墨坩埚生制品送入带盖环式焙烧炉焙烧,得到一次焙烧品;将一次焙烧品送入高压浸渍罐加压浸渍,得到石墨坩埚浸渍品;所得浸渍品送入车底式焙烧炉焙烧,得到二次焙烧品;所得二次焙烧品送入石墨化炉,石墨化后得到石墨坩埚石墨化品;最后进

一种用于石墨坩埚的涂层料浆及其制备和应用方法.pdf
本发明涉及钒铝合金冶炼技术领域,尤其涉及一种用于石墨坩埚的涂层料浆及其制备和应用方法,该用于石墨坩埚的涂层料浆,由如下重量份的原料组成:铝酸钙炉渣:5~20份、生石灰:50~100份、氯化镁:2~50份和去离子水:150~500份。本发明提供的用于石墨坩埚的涂层料浆能够大大地降低石墨坩埚与合金在高温下的接触机率,并且该涂层料浆不易熔化,即使出现熔化也不会导致合金中碳杂质含量的增加,能够显著本降低钒铝合金中碳杂质含量,并且能够延长石墨坩埚的使用寿命,降低生产成本。

一种石墨坩埚的制备方法.pdf
本发明公开了一种石墨坩埚的制备方法,包括下列步骤:S1、原料准备:原料包括石墨碎、艾奇逊炉石油焦电阻料、艾奇逊炉石油焦保温料和中温煤沥青;S2、配料:将石墨碎磨成石墨粉,然后与艾奇逊炉石油焦电阻料、艾奇逊炉石油焦电阻料、艾奇逊炉石油焦保温料按3:2:5的质量比例混合、研磨成混合粉,混合粉再与中温煤沥青混合,混合过程中混合粉的质量百分比为65%‑85%,中温煤沥青质量百分比为15%‑35%;S3、混捏;S4、压型;S5、焙烧;S6、加工。本发明采用热压冷出一次性成型方法,所得产品性能优良,表现为良好的抗热震
