
GaN结构的制备方法.pdf

小宏****aa









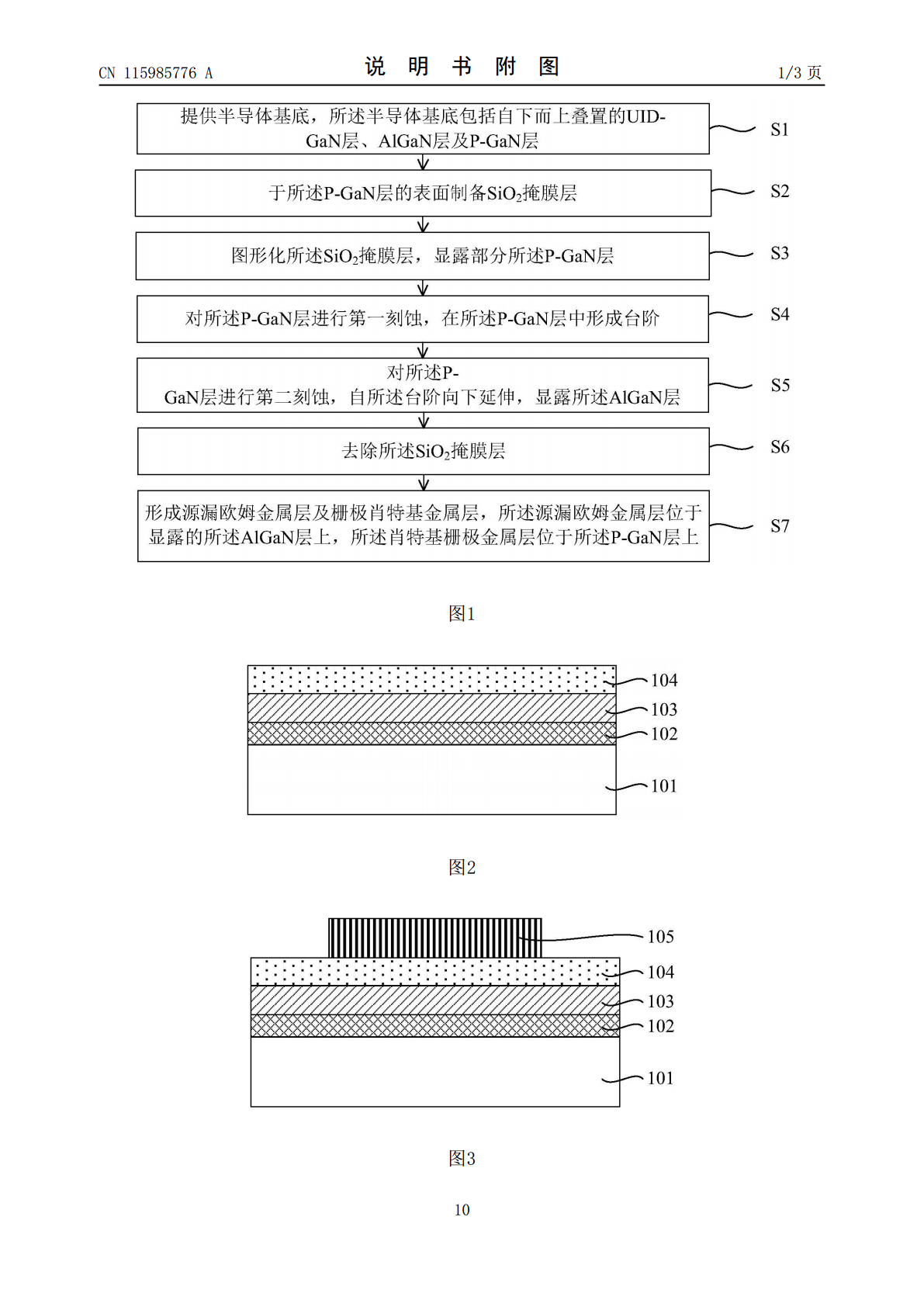
亲,该文档总共12页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

GaN结构的制备方法.pdf
本发明提供一种GaN结构的制备方法,在对P‑GaN层进行刻蚀时,采用两步刻蚀法,通过对第一刻蚀及第二刻蚀的工艺控制,可实现P‑GaN层与AlGaN层的高刻蚀选择比,使得刻蚀之后的AlGaN层的表面光滑,获得低损伤的AlGaN层表面以降低刻蚀损伤;刻蚀工艺过程中,使用SiO

GaN器件结构及其制备方法.pdf
本发明提供一种GaN器件结构及制备方法,制备包括:在基底上制备源极辅助图形和漏极辅助图形,二者之间形成栅槽,分别定义栅源间距、栅漏间距及栅长;制备钝化层;制备遮蔽辅助层并基于其去除部分钝化层;制备源极电极和漏极电极;去除遮蔽辅助层以显露栅槽;制备栅电极结构;去除源极辅助图形和漏极辅助图形。本发明通过引入源极辅助图形和漏极辅助图形,预先定义栅长、源‑栅以及栅‑漏的间距,一步完成,后续步骤无需精确光刻对准,工艺可行性、稳定性高,操作简便。可同时制备悬空栅极,使得器件寄生电容较小,对小尺寸、高频器件有益。本发明

GaN器件结构及其制备方法.pdf
本发明提供一种GaN器件结构及制备方法,制备包括:在衬底上制备GaN沟道层及初始势垒层,制备栅区辅助结构,制备掺杂势垒复合结构及栅极台阶辅助复合结构,栅极台阶辅助复合结构呈台阶状贯穿在掺杂势垒复合结构中,各级栅极台阶辅助结构沿栅极区域指向漏极电极方向逐渐上升,去除栅区辅助结构及栅极台阶辅助复合结构,制备源极电极及漏极电极,制备栅极复合结构。本发明通过引入掺杂势垒复合结构,并基于栅区辅助结构和栅极台阶辅助结构,通过多次选择性外延,可以改善掺杂浓度,实现低欧姆接触电极,并通过设计阶梯型栅极及栅极场板,还可以进

GaN外延层剥离结构、制备方法以及剥离方法.pdf
本申请公开了GaN外延层剥离结构、制备方法以及剥离方法,其中,GaN外延层剥离结构包括由下到上依次设置的衬底、刻蚀层组以及GaN剥离层,所述刻蚀层组包括由下到上依次设置的AlGaN缓冲层、n‑GaN层、u‑GaN层以及GaN牺牲层,所述刻蚀层组具有贯穿刻蚀层组的沟槽组。本申请刻蚀层组存在贯穿整个刻蚀层组的沟槽组,在后续进行电化学剥离时,溶液进入空洞的沟槽组后,与刻蚀层组充分接触,刻蚀可沿着空洞区域向中间进行,刻蚀所需的距离大大减少,大幅提升了剥离时的化学反应效率。

栅指渐宽式GaN FinFET结构及其制备方法.pdf
本发明提供一种栅指渐宽式GaNFinFET结构及其制备方法,该结构包括:第二半导体衬底;位于第二半导体衬底上的键合材料层;位于键合材料层上的FinFET结构,包括:栅极、源极、漏极及栅指,其中源极、漏极及栅指由依次层叠的In
