
GaN外延层剥离结构、制备方法以及剥离方法.pdf

静芙****可爱









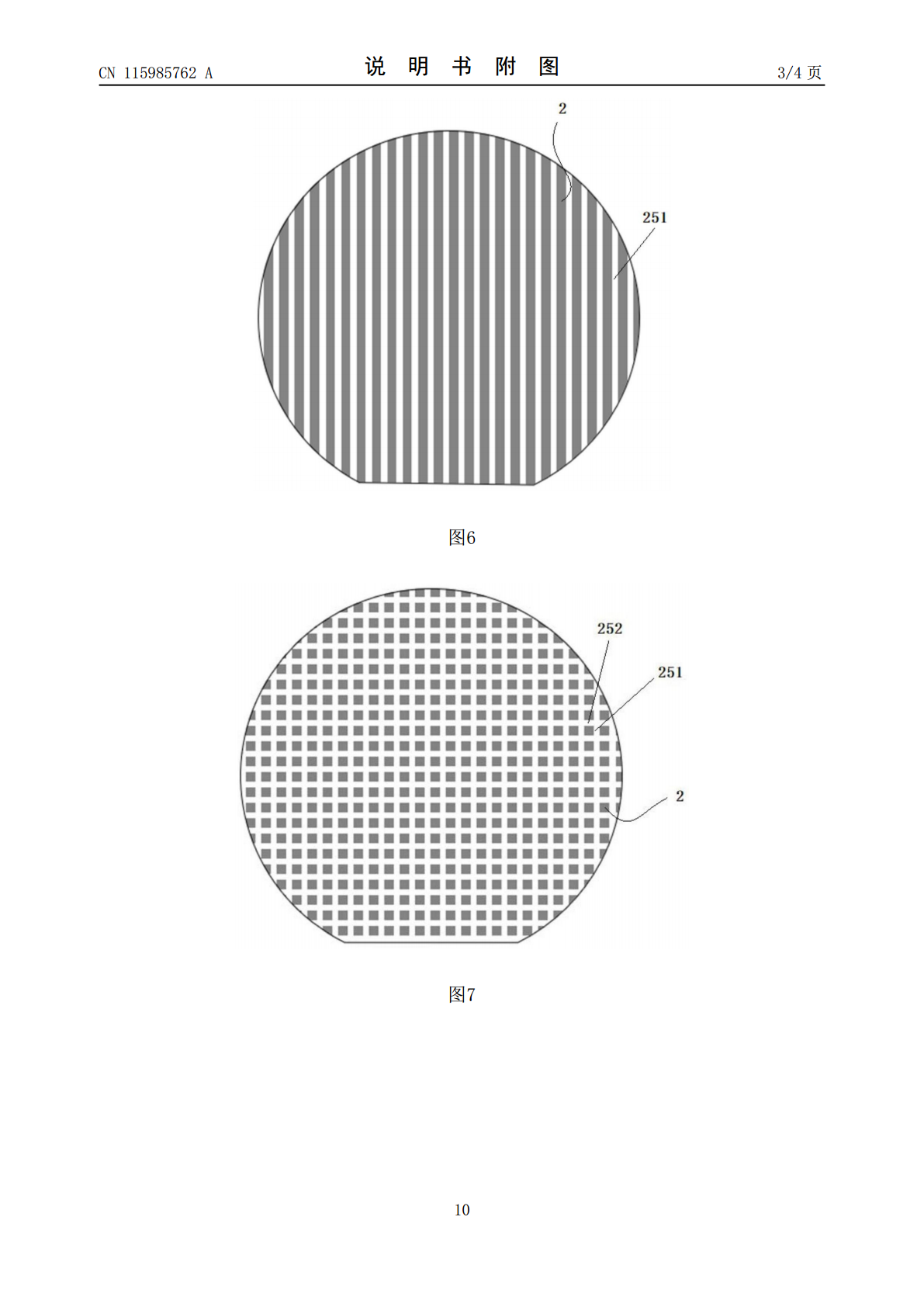
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

GaN外延层剥离结构、制备方法以及剥离方法.pdf
本申请公开了GaN外延层剥离结构、制备方法以及剥离方法,其中,GaN外延层剥离结构包括由下到上依次设置的衬底、刻蚀层组以及GaN剥离层,所述刻蚀层组包括由下到上依次设置的AlGaN缓冲层、n‑GaN层、u‑GaN层以及GaN牺牲层,所述刻蚀层组具有贯穿刻蚀层组的沟槽组。本申请刻蚀层组存在贯穿整个刻蚀层组的沟槽组,在后续进行电化学剥离时,溶液进入空洞的沟槽组后,与刻蚀层组充分接触,刻蚀可沿着空洞区域向中间进行,刻蚀所需的距离大大减少,大幅提升了剥离时的化学反应效率。

一种外延层剥离装置及剥离方法.pdf
本发明公开了一种外延层剥离装置及剥离方法,用于依次包含有衬底、牺牲层、外延层和支撑层的待剥离件的外延层剥离,该外延层剥离装置包括上端开口的盒体,盒体底部设置有弹性缓冲结构;待剥离件放置于弹性缓冲结构上方时,待剥离件的支撑层边沿位于盒体侧壁上,使得待剥离件的支撑层与衬底之间具有一定张角。刻蚀初期,弹性缓冲结构被压缩而缓慢下移,在支撑层自身的应力和外延层剥离装置对待剥离件的支撑力的共同作用下,使得外延层与衬底的张角逐渐变大,增大了腐蚀液和牺牲层界面间形成的腐蚀通道,有利于腐蚀液快速进入及反应副产物的输出,从而

将氮化镓外延层从衬底上剥离的方法.pdf
本公开涉及一种用于将氮化镓外延层从衬底上剥离的方法,所述方法包括:通过MOCVD或MBE沉积方式在图案化蓝宝石衬底上生长氮化镓外延层;将面积等于或大于所述氮化镓外延层的面积的支撑片通粘合剂粘附在所述氮化镓外延层的上表面并进行固化处理;通过向所述氮化镓外延层与图案化蓝宝石衬底之间的界面施加应力而使得所述氮化镓外延层和支撑片整体从图案化蓝宝石衬底上剥离;以及通过对所述氮化镓外延层和所述支撑片之间的界面的所述粘合剂加热,使得粘合剂融化而使得所述氮化镓外延层与所述支撑片分离。

可剥离衬底上的垂直结构GaN基HEMT芯片的制备方法.pdf
本发明涉及垂直结构高电子迁移率(HEMT)芯片技术领域,具体涉及一种可剥离衬底上的垂直结构GaN基HEMT芯片的制备方法,该方法包括在可剥离衬底上生长GaN缓冲层,在GaN缓冲层上的非掺杂GaN层,在非掺杂GaN层上生长AlGaN势垒层,在AlGaN势垒层上生长p型GaN帽子层。随后借助临时衬底,将不导电的可剥离衬底置换成导电衬底,并在导电衬底上蒸镀电极金属作为漏极。接着通过标准光刻工艺和感应耦合等离子刻蚀工艺将p型GaN帽子层刻蚀成栅极图案。再在外延片表面蒸镀和刻蚀出源极和栅极图案。利用等离子体增强化学

制备可剥离密封层的方法.pdf
本发明提供制备可剥离密封层的方法、制备多层膜的方法、由其制备的可剥离密封层以及由其制备的多层膜。在一个方面中,制备可剥离密封层的方法包含(a)提供第一掺合物,包含(i)5到98重量百分比的反应器级丙烯类塑性体或弹性体,其具有小于3.5的分子量分布和小于0.89g/cc的密度,和(ii)2到95重量百分比的选自以下组成的组的第二聚合物:聚乙烯、聚丁烯和苯乙烯聚合物以及其混合物;(b)提供至少一种线性低密度聚乙烯;(c)将第一掺合物与所述至少一种线性低密度聚乙烯掺合在一起以获得第二掺合物;以及(d)挤压第二掺
