
铟镓砷盖革雪崩二极管自淬灭环结构制备方法.pdf

Th****s3







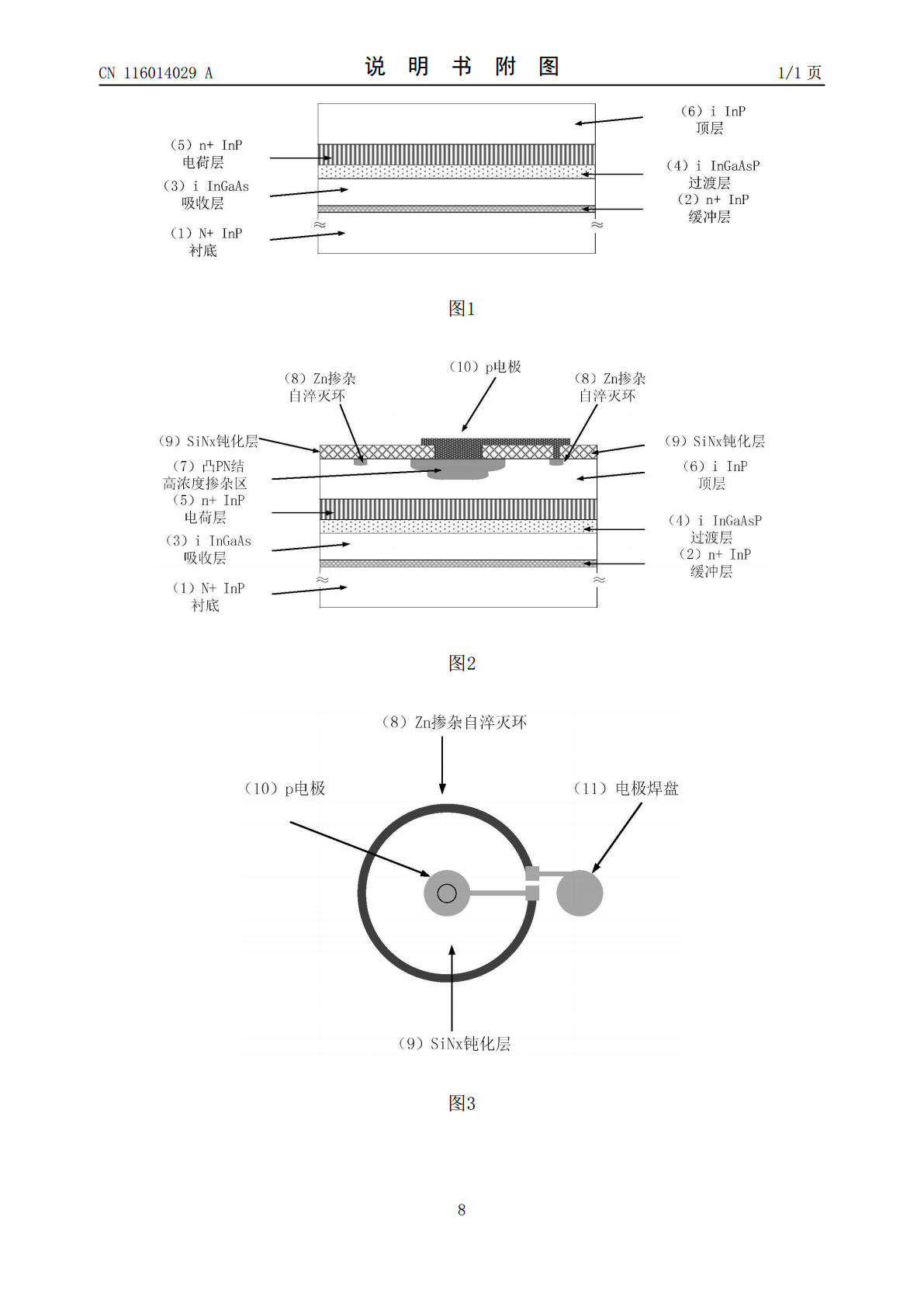
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

铟镓砷盖革雪崩二极管自淬灭环结构制备方法.pdf
本发明属于半导体光电器件技术领域,公开了一种铟镓砷盖革雪崩二极管自淬灭环结构制备方法,采用表面浅层Zn扩散工艺,在铟镓砷盖革雪崩二极管表面的iInP顶层上直接进行浅层Zn扩散,制备Zn掺杂自淬灭环结构,作为铟镓砷盖革雪崩二极管自身的被动淬灭电阻。本发明解决自由模式光子计数用铟镓砷盖革雪崩二极管存在的后脉冲高、死时间长的问题,通过实现低寄生效应的原位被动淬灭,有效提升铟镓砷盖革雪崩二极管的最大计数率,满足单光子计数探测需求。

多像元集成铟镓砷雪崩二极管四象限光电探测芯片.pdf
本发明公开了一种多像元集成铟镓砷雪崩二极管四象限光电探测芯片及制作方法,其包括,在同一铟镓砷外延晶片上,分布有四个光敏探测区,每个光敏探测区内由多个小单元雪崩二极管并联而成的芯片。所述芯片整体光敏面由四个方形雪崩二极管中心对称均布组成,方形APD由尺寸更小的圆形且具有相等光电特性小单元APD并联而成。四个方形光敏探测区,能对连续或低频脉冲激光信号进行坐标定位探测,方形APD光敏探测之间通过刻蚀槽和背面进光面金属膜层遮挡方式隔离四个光敏探测区,其能有效消除光敏探测区之间产生的电学、光学串扰,同时保证不会产生

平面型侧向收集结构铟镓砷红外探测器芯片的制备方法.pdf
本发明公开了平面型侧向收集结构铟镓砷红外探测器芯片的制备方法,步骤包括:1)外延材料清洗,2)淀积氮化硅扩散掩膜,3)第一次光刻,4)开扩散窗口,5)光刻胶剥离,6)闭管扩散,7)开管取片,8)第二次光刻,9)生长P电极,10)光刻胶剥离,11)淀积二氧化硅增透膜,12)P电极退火,13)第三次光刻,14)开P电极孔,15)光刻胶剥离,16)第四次光刻,17)加厚P电极,18)光刻胶剥离,19)背面抛光,20)生长N电极,21)划片。本发明制备方法制得的芯片减小了光敏元的扩散区域,可有效地减少扩散带来的热

像元偏压可控的铟镓砷阵列光敏芯片及其制备方法.pdf
本发明公开了一种像元偏压可控的铟镓砷光敏芯片及其制备方法,所述铟镓砷光敏芯片包括依次设置于衬底的缓冲层、吸收层、帽层、钝化层、电极层以及像元阵列,所述像元阵列包含多个像元,每个像元之间电极独立;所述每个像元内的电极独立。本发明的像元偏压可控的铟镓砷阵列光敏芯片及其制备方法通过合理地设置阵列中各像元间的隔离结构,可对像元形成独立可控的偏压用于读取相应的电信号,从而获取感光探测数据。同时,外接电路也可根据实际应用场景自定义对接电极层中的若干电极,以获取需要的像元参数。本实施例通过像元的偏压独立控制以及像元信号

砷化镓电池外延结构及其制备方法.pdf
本发明提供一种砷化镓电池外延结构及其制备方法。该砷化镓电池外延结构包括衬底和设置在衬底上的牺牲层和电池层,牺牲层和电池层沿远离衬底的方向依次叠置,牺牲层包括叠层单元,叠层单元包括能被湿法腐蚀液腐蚀的膜层和夹设在膜层中的不能被湿法腐蚀液腐蚀的量子点层。该砷化镓电池外延结构,通过设置中间夹层为不能被湿法腐蚀液腐蚀的砷化物量子点层的三明治结构的牺牲层,在湿法腐蚀剥离衬底时,砷化物量子点能通过搅拌腐蚀液整体剥离,以在原来量子点所在位置留下孔洞,孔洞能使腐蚀液与附近未腐蚀的砷化铝层接触面积增大,提高牺牲层在湿法腐蚀
