
晶舟、工艺腔室及半导体工艺设备.pdf

映雁****魔王









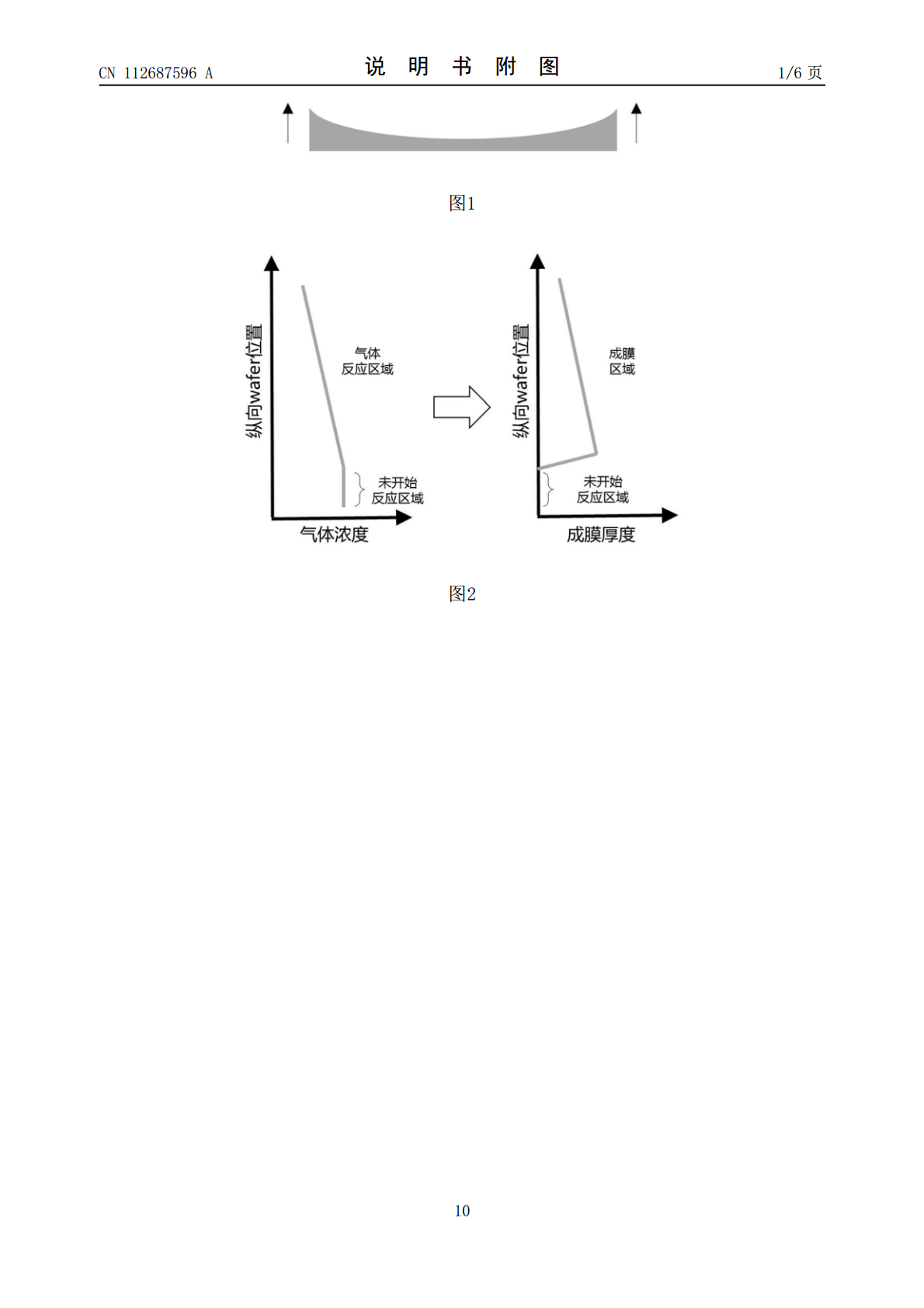
亲,该文档总共15页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

晶舟、工艺腔室及半导体工艺设备.pdf
本发明提供一种晶舟、工艺腔室及半导体工艺设备,该晶舟包括支撑架,支撑架具有多个间隔设置的放片位,晶舟还包括导气通道,导气通道具有至少一个进气口和多个出气口,进气口与气源连通,每个放片位至少对应一个出气口,出气口的出气方向朝向与之对应的放片位的中心区域。应用本发明可以提高wafer片内均匀性及晶舟的利用率。

半导体工艺腔室及半导体工艺设备.pdf
本发明提供一种半导体工艺腔室及半导体工艺设备,半导体工艺腔室包括腔室本体、旋转升降组件和设置在腔室本体内的承载部件和加热组件,承载部件用于承载晶圆,加热组件位于承载部件下方,用于通过加热承载部件,以加热承载部件上的晶圆,旋转升降组件包括分别设置在腔室本体外内的磁发生部件和磁配合部件,磁发生部件用于在通电时产生磁场使磁配合部件磁化,向磁配合部件施加悬浮支撑力和旋转驱动力,磁配合部件与承载部件连接,用于在磁发生部件向其施加的悬浮支撑力和旋转驱动力的作用下悬浮并旋转,带动承载部件在腔室本体内悬浮并旋转。本发明提

半导体工艺腔室和半导体工艺设备.pdf
本申请公开一种半导体工艺腔室和半导体工艺设备,涉及半导体工艺技术领域。该半导体工艺腔室包括腔室本体、用于产生等离子体的线圈、用于承载晶圆的基座和金属结构件,所述基座和所述金属结构件均设置于所述腔室本体内,所述金属结构件的至少部分与所述腔室本体的内壁相对设置,且所述金属结构件设置于所述基座用于放置所述晶圆的位置的周围或侧方,所述金属结构件与所述基座电连接,以在受到所述等离子体中的离子轰击后在所述腔室本体的内壁形成金属膜。该方案能够解决目前的半导体工艺腔室的产能较低的问题。

半导体工艺设备及其工艺腔室.pdf
本申请实施例提供了一种半导体工艺设备的工艺腔室。该工艺腔室的前法兰和后法兰分别设置在炉管的炉口和炉尾处;支撑机构设置于炉管内,支撑机构包括有两个支撑杆,支撑杆用于承载第一晶舟及第二晶舟;两个第一电极机构分别套设于两个支撑杆的第一端,并且两个第一电极结构的极性相反,用于在第一晶舟装载于支撑杆上时,承载第一晶舟前端,并且分别与第一晶舟前端的两侧电连接,以将电极引入至第一晶舟;第二电极机构设置于炉管的炉尾处,用于在第二晶舟装载于支撑杆上时,将电极引入至第二晶舟。本申请实施例实现了避免第一电极结构随悬臂桨及炉门运

反应腔室及半导体工艺设备.pdf
本申请公开了一种反应腔室及半导体工艺设备,涉及半导体工艺设备领域。一种反应腔室,包括:腔室主体;基座,所述基座可旋转地设置于所述腔室主体内,所述基座用于承载晶片;诱导磁组,所述诱导磁组设置于所述基座外侧,且所述诱导磁组与所述基座同步旋转,用于在所述晶片上形成平行于所述晶片的诱导磁场;所述诱导磁组和所述基座的自转速度与所述半导体工艺设备中的磁控装置的旋转速度相同。一种半导体工艺设备,包括靶材、磁控装置和反应腔室,所述靶材设置于所述反应腔室的顶部开口处,所述磁控装置可在所述靶材上方围绕所述反应腔室的轴线转动。
