
改善半导体器件的热载流子注入效应的方法.pdf

听云****君哇









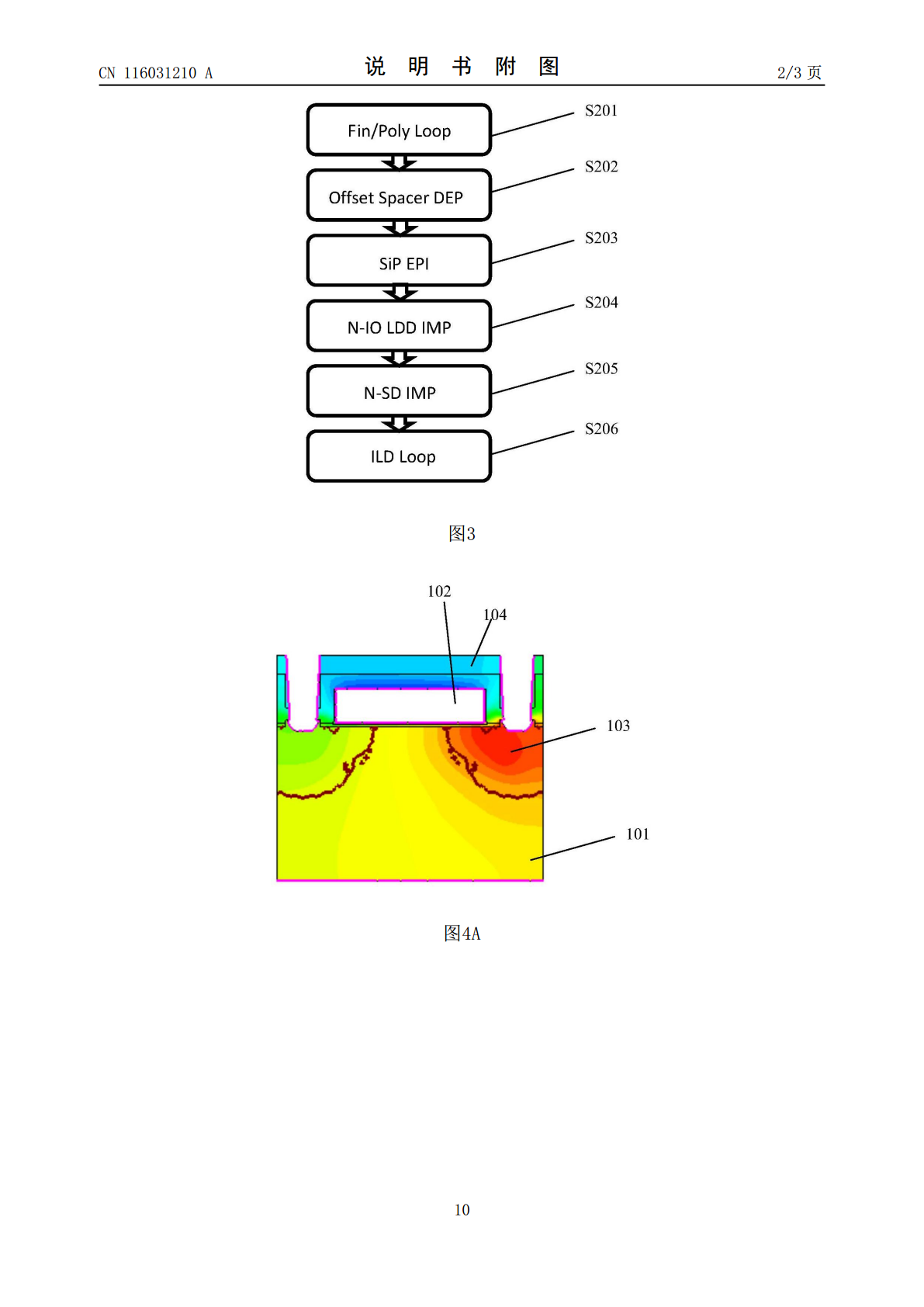
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

改善半导体器件的热载流子注入效应的方法.pdf
(19)国家知识产权局(12)发明专利申请(10)申请公布号CN116031210A(43)申请公布日2023.04.28(21)申请号202310150337.X(22)申请日2023.02.21(71)申请人上海华力集成电路制造有限公司地址201203上海市浦东新区康桥东路298号1幢1060室(72)发明人朱柠镕翁文寅(74)专利代理机构上海浦一知识产权代理有限公司31211专利代理师郭四华(51)Int.Cl.H01L21/8238(2006.01)H01L29/78(2006.01)H01L21

应变硅CMOS器件的自热效应与热载流子效应的任务书.docx
应变硅CMOS器件的自热效应与热载流子效应的任务书任务书题目:应变硅CMOS器件的自热效应与热载流子效应研究背景:CMOS(Complementarymetal-oxide-semiconductor)器件是现代集成电路中最常用的器件结构之一。在nano-scale制造工艺中,为了获得更好的性能与良好的控制,引入了应变硅(strainedsilicon)技术。应变硅把化学组成和晶格结构进行改变以形成一层微小的“压缩应变”或“拉伸应变”,对硅的特性展现出了显著的影响,从而促进了CMOS器件新一代制造技术的发

深亚微米LDD MOSFET器件热载流子效应研究的任务书.docx
深亚微米LDDMOSFET器件热载流子效应研究的任务书任务书一、研究背景随着现代电子技术的不断发展,微电子器件的尺寸越来越小,集成度越来越高。然而,微米甚至亚微米级别以下的尺寸制约了微电子器件的性能和可靠性。其中,深亚微米级别下LDDMOSFET器件的热载流子效应是一个重要的研究问题。由于载流子在小尺寸结构内的极限迁移速度较快,特别是在rampant的电场下会产生大量的载流子生成,进而形成热载流子现象。这种“热载流子”现象不仅会引起器件电学参数的累积偏差,还会导致器件在工作过程中的不可逆损坏,从而影响其可

MOSFET噪声与热载流子效应研究的中期报告.docx
MOSFET噪声与热载流子效应研究的中期报告在MOSFET器件中,电子运动的随机性和热载流子效应可能导致噪声的出现。因此,研究MOSFET噪声与热载流子效应对器件的性能和可靠性具有重要意义。本报告介绍了我们关于MOSFET噪声与热载流子效应研究的中期成果。我们采用了以下方法来研究这些效应:1.噪声参数测量:利用特定的测试电路和测量仪器测量MOSFET器件的噪声参数,包括噪声系数、频谱密度和相关时间等。2.计算模拟:使用SPICE软件进行器件模拟和仿真,以研究热载流子效应对器件的影响。3.实验验证:通过实验

离子注入区的形成方法以及半导体器件.pdf
本申请提供一种离子注入区的形成方法以及半导体器件,所述离子注入区的形成方法包括:提供半导体衬底,所述半导体衬底包括有源区以及用于隔离所述有源区的隔离结构;在所述半导体衬底上形成牺牲氧化层;在所述半导体衬底的部分有源区进行离子注入,在所述半导体衬底内形成离子注入区;退火,使所述离子注入区内的注入离子均匀分布;去除所述牺牲氧化层。所述方法消除了离子注入区与隔离结构边界处的氧化硅残留。
