
引线框架、引线框架的形成方法及引线框架封装体.pdf

睿达****的的









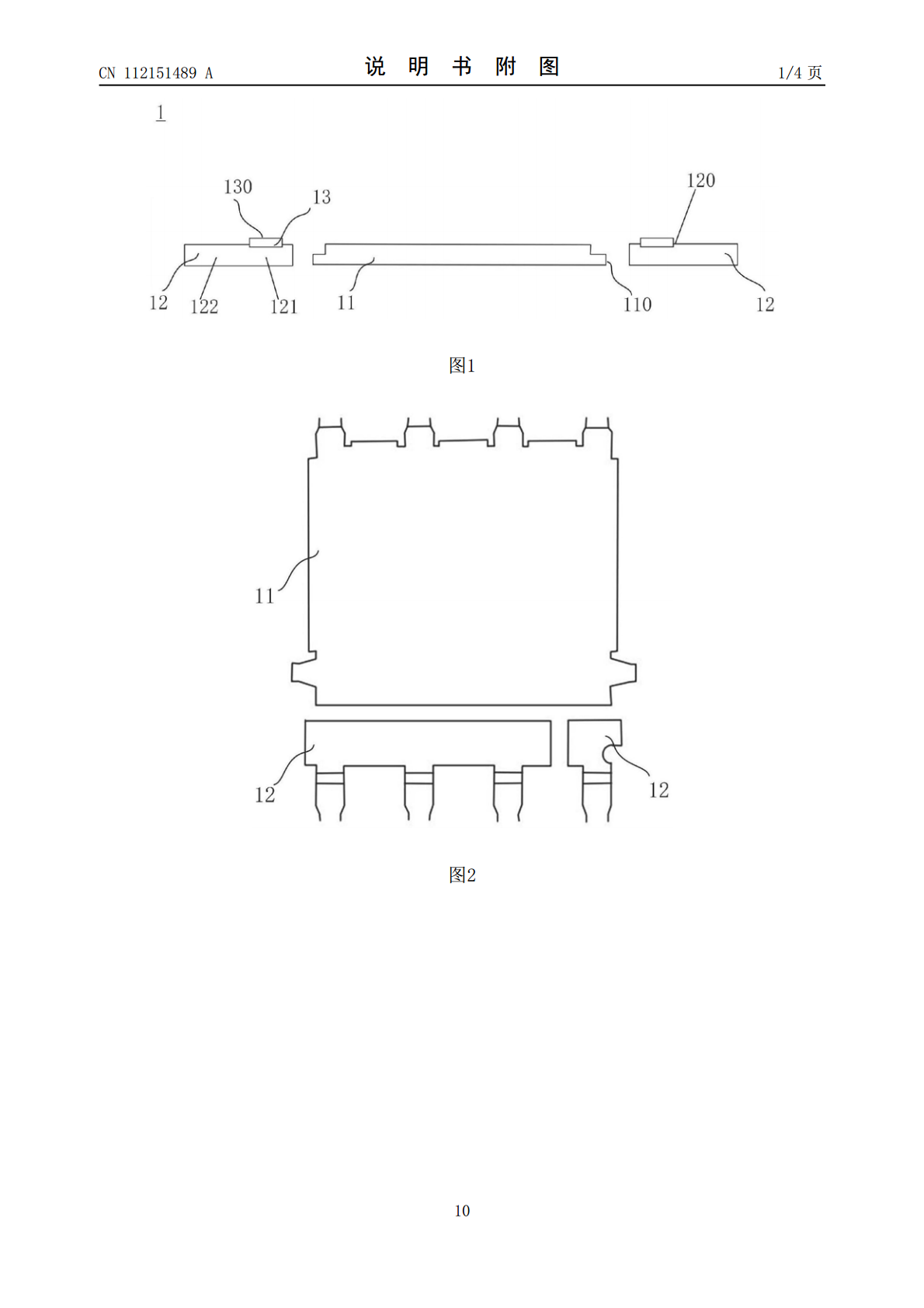
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

引线框架、引线框架的形成方法及引线框架封装体.pdf
本申请公开了一种引线框架、引线框架的形成方法及引线框架封装体。所述引线框架包括:用于承载半导体元件的基岛和围绕所述基岛设置的至少两个引脚;所述引脚的一个表面具有用于连接引线的打线区,其中,所述打线区设有第一金属部,至少所述第一金属部的上表面的材质与待连接引线的材质相同。本申请通过在引脚的打线区设置至少上表面的材质与待连接引线的材质相同的第一金属部,使得引线与引脚之间的结构应力降低,有效提高了引线与框架之间的结合力,从而改善了引线的剥离强度,提高了功率半导体器件的可靠性。

引线框架、引线框架的制备方法、封装结构.pdf
本发明提供一种引线框架、制备方法、封装结构,所述引线框架包括基岛区、与所述基岛区相分离设置的第一引脚区,所述第一引脚区分布于所述基岛区的周侧;所述引线框架还包括用以提高所述基岛区和/或所述第一引脚区的稳定性的加强件;能够使基岛区的基岛和/或第一引脚区的引脚在周向得到较好的支撑,从而,在焊线温度条件下,所述基岛和/或所述引脚不会发生明显的变形翘曲,能够避免焊线过程中发生塌丝现象,提高最终的封装结构的良品率。

引线框架、该引线框架的制备方法、封装结构.pdf
本发明提供一种引线框架、制备方法、封装结构,所述引线框架包括至少一个引线框架单元,所述引线框架单元包括外框、位于所述外框中间的基岛、连接所述基岛与所述外框的连接筋、设于所述外框上的若干第一管脚、填充于所述基岛与所述第一管脚之间的预塑封体、形成于所述预塑封体上的若干第二管脚;一方面,提高了管脚密度,提升最终形成的封装结构的集成度,同时,增加封装结构的导热能力;另一方面,所述预塑封体能够有效支撑所述第一管脚,能够有效避免第一管脚受模流压力而偏移变形,提升产品外观品质。

引线框架及其制造方法、基于该引线框架的芯片封装方法.pdf
本发明公开一种引线框架及其制造方法、基于该引线框架的芯片封装方法,所述引线框架制造方法包括:提供框架支撑板;将具有多个通孔的印刷版与所述框架支撑板相对固定,所述多个通孔排布成预定图案;在所述印刷版上印刷一层金属,所述排布成预定图案的通孔被印刷的金属填充;移除所述印刷版,在所述框架支撑板上留下被填充到所述通孔中的金属,以在所述框架支撑板上形成排布成预定图案的引线金属框。这样,利用印刷版将引线金属框印刷至框架支撑板上,可以省去连筋,从而可以提高封装的密度,降低成本。

引线框架、QFN封装体、及形成QFN封装体的方法.pdf
本发明涉及引线框架、QFN封装体、及形成QFN封装体的方法。一种适于QFN封装的引线框架包括第一芯片座和相邻的第二芯片座、第一引脚阵列和第二引脚阵列。第一、第二引脚阵列配置为连接位于其各自近侧的第一、第二芯片座的电路。第一引脚阵列和第二引脚阵列通过连筋连接在一起,且在曝露表面具有凹槽,该凹槽在去除连筋后仍会部分保留,该凹槽的保留部分的深度在引脚厚度的1/3~2/3的范围之内,开口宽度在引脚宽度的1/4~2/3的范围之内,在引脚长度方向上延伸至1/6~1/2的范围之内。凹槽的该保留的部分在单独的芯片封装体中
