
一种铝基超导电路中叠层刻蚀的侧壁陡直性实现方法.pdf

mm****酱吖









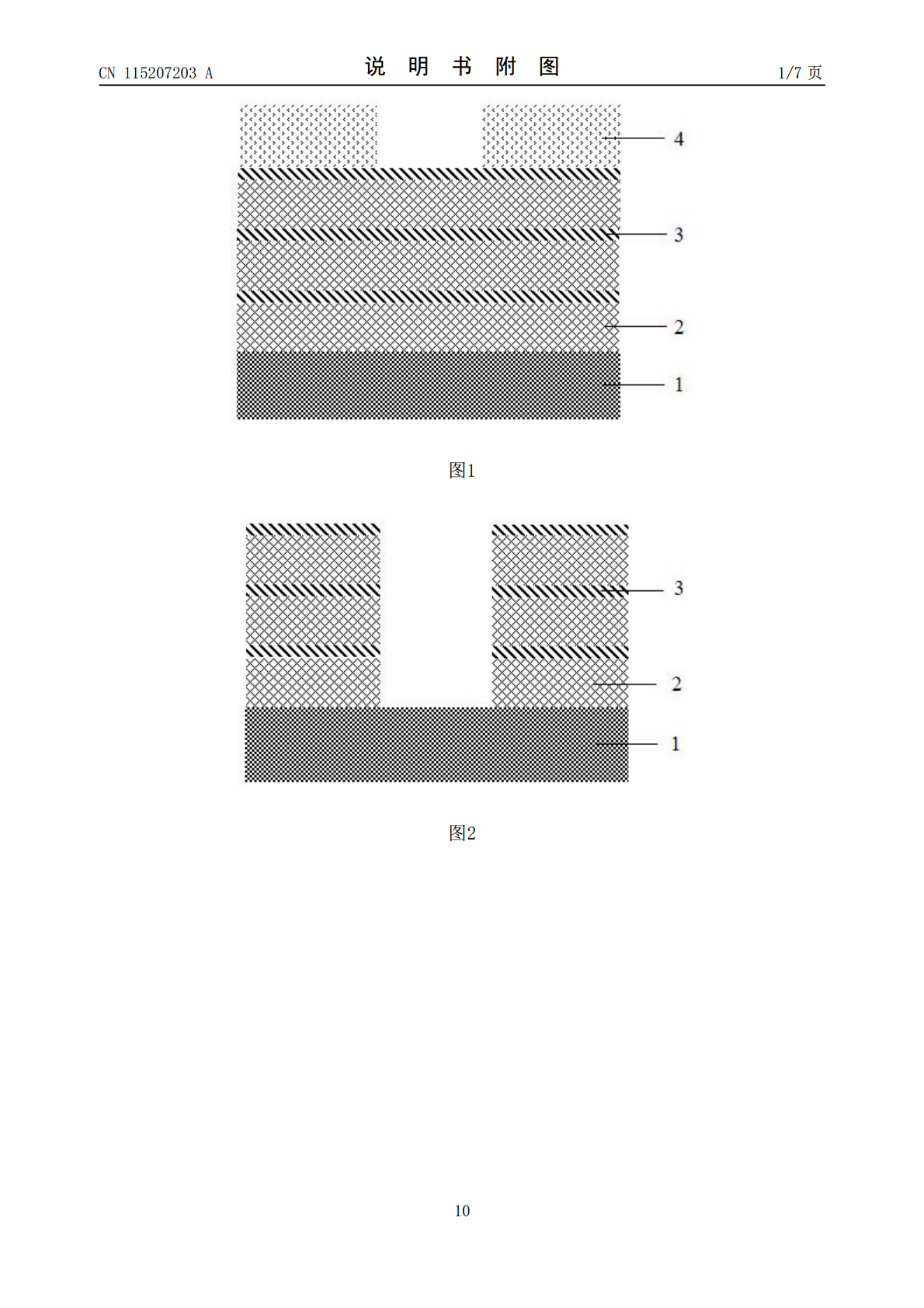
亲,该文档总共16页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种铝基超导电路中叠层刻蚀的侧壁陡直性实现方法.pdf
本发明提供一种铝基超导电路中叠层刻蚀的侧壁陡直性实现方法,包括以下步骤:(1)光刻胶图形化;(2)刻蚀开口暴露的铝金属层,开口暴露出介质层;(3)采用原子层沉积法在光刻胶层上表面、开口侧壁以及开口底面上沉积氧化硅层;(4)刻蚀步骤(3)中光刻胶层上表面以及开口底面上的氧化硅层;(5)刻蚀开口侧壁的氧化硅层以及开口暴露的介质层;(6)依次循环重复步骤(3)、步骤(4)、步骤(2)、步骤(5),直至将开口暴露的铝金属层和介质层均刻蚀掉,暴露出衬底,最后去除光刻胶层。采用本发明的方法,可以解决铝基超导电路中金属

一种铝基超导电路中叠层刻蚀的侧壁陡直性实现方法.pdf
本发明提供一种铝基超导电路中叠层刻蚀的侧壁陡直性实现方法,包括以下步骤:(1)光刻胶图形化;(2)刻蚀开口暴露的铝金属层,开口暴露出介质层;(3)采用原子层沉积法在光刻胶层上表面、开口侧壁以及开口底面上沉积氧化硅层;(4)刻蚀步骤(3)中光刻胶层上表面以及开口底面上的氧化硅层;(5)刻蚀开口侧壁的氧化硅层以及开口暴露的介质层;(6)依次循环重复步骤(3)、步骤(4)、步骤(2)、步骤(5),直至将开口暴露的铝金属层和介质层均刻蚀掉,暴露出衬底,最后去除光刻胶层。采用本发明的方法,可以解决铝基超导电路中金属

多晶硅叠层、双栅以及半导体材料叠层刻蚀方法.pdf
本发明提供了一种多晶硅叠层刻蚀方法、双栅刻蚀方法以及半导体材料叠层刻蚀方法。所述多晶硅叠层刻蚀方法包括:光刻胶涂覆步骤,用于在顶部多晶硅层上涂覆光刻胶;曝光步骤,用于对光刻胶进行曝光以得到光刻胶图案;第一刻蚀步骤,用于以执行曝光步骤之后得到的光刻胶图案为掩模刻蚀顶部多晶硅层,以使得刻蚀后的顶部多晶硅层的截面形成一个上窄下宽的梯形;以及第二刻蚀步骤,用于以执行曝光步骤之后得到的光刻胶图案为掩模刻蚀底部多晶硅层。根据本发明的刻蚀方法,所得到的多晶硅叠层的侧壁能够相对比较垂直,消除了侧壁上的倒凹;并且,本发明的

一种叠层电路结构及其制备方法.pdf
本发明属于集成电路封装相关技术领域,其公开了一种叠层电路结构及其制备方法,该方法包括以下步骤:(1)在陶瓷板相背的两个表面上制备图案化线路,并在所述陶瓷板上制备互通孔道,所述互通孔道连接两个所述图案化线路;所述图案化线路上贴装有半导体器件;(2)在一个所述图案化线路上依次制备多个隔离层及多层电路以得到所述叠层电路结构;所述隔离层与所述电路交互设置;所述电路上贴装有半导体器件,所述半导体器件嵌设在对应的隔离层内,所述隔离层开设有互通孔道,所述互通孔道连接相邻的两层电路。本发明通过磁控溅射的工艺方式形成叠层电

金属栅层/高K栅介质层的叠层结构刻蚀后的清洗方法.pdf
本发明涉及一种金属栅层/高K栅介质层的叠层结构刻蚀后的清洗方法,属于集成电路制造技术领域。在金属栅层/高K栅介质层叠层结构刻蚀后,采用含有氢氟酸的混合溶液进行清洗,不仅可以完全去除栅叠层结构上留下的含有金属的聚合物残余,而且对于高K材料在干法刻蚀过程中部分去除的刻蚀策略,可以在清洗的过程中完全去除高K材料,从而更有利于满足纳米级CMOS器件在形成栅极图形时对Si衬底损失的要求。另外,因该溶液对场区SiO2的腐蚀速率较低,能够满足器件集成的需要。
