
集成电路芯片封装技术芯片互连技术.ppt

胜利****实阿

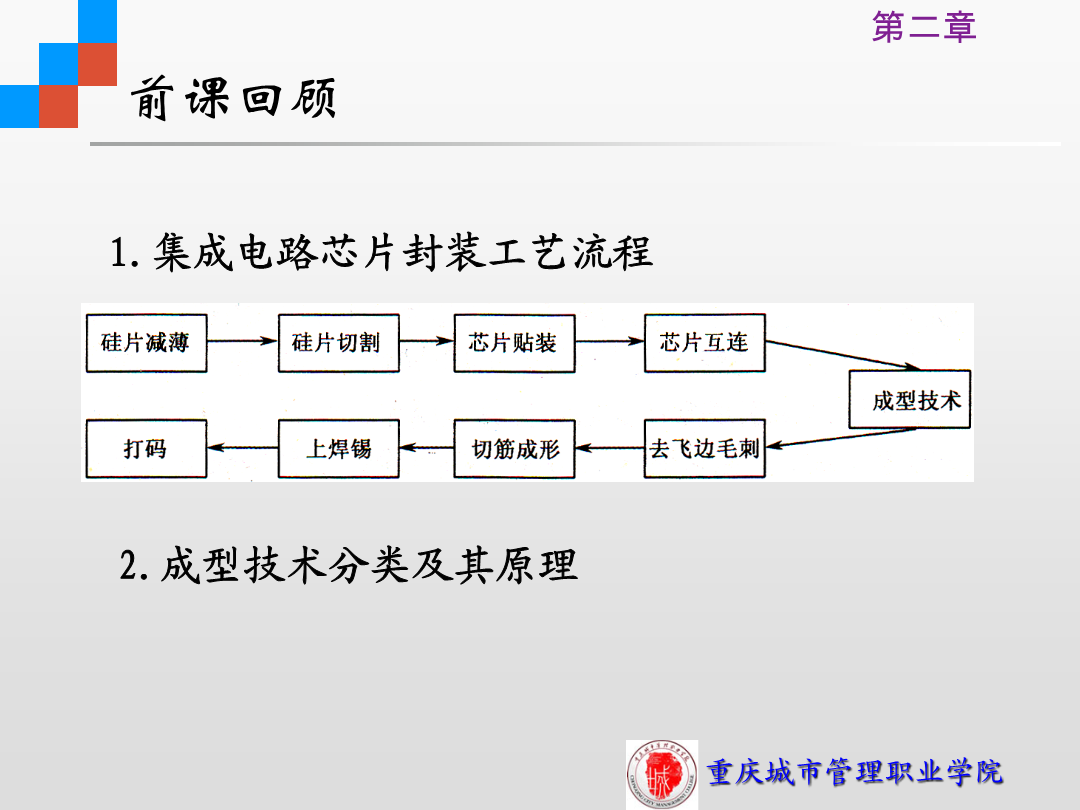

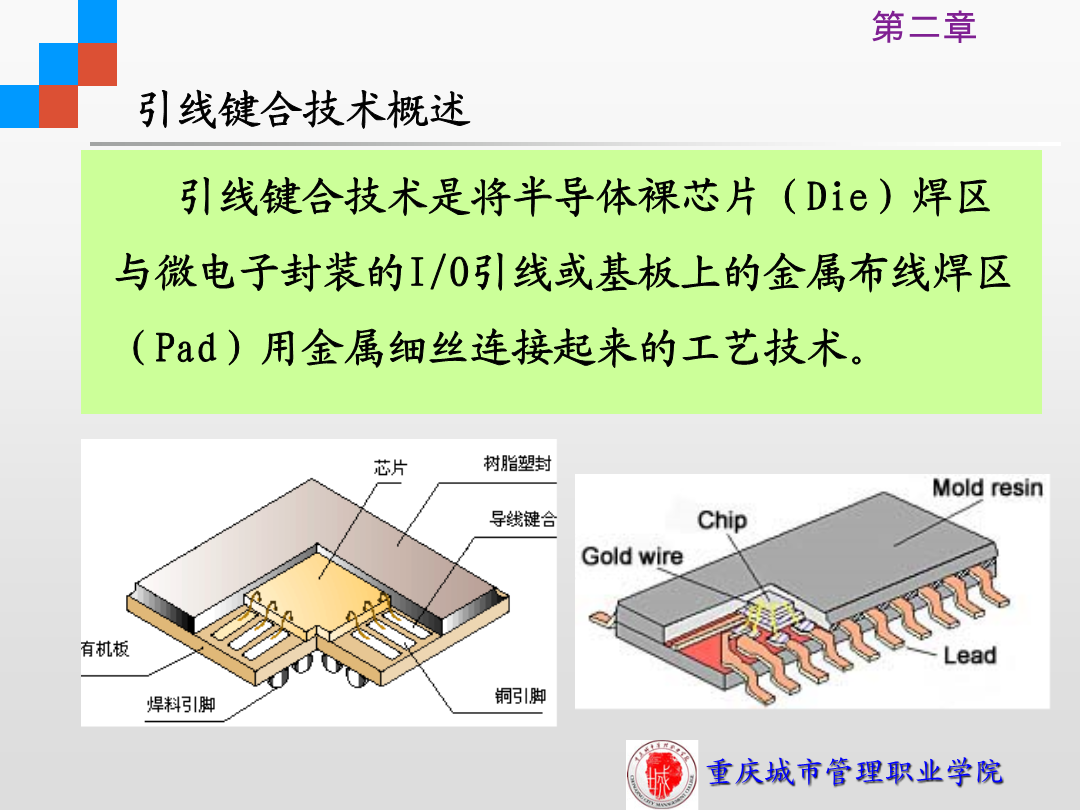






亲,该文档总共40页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

集成电路芯片封装技术芯片互连技术.ppt
芯片互连技术前课回顾引线键合技术(WB)引线键合技术概述引线键合技术分类和应用范围提供能量破坏被焊表面的氧化层和污染物,使焊区金属产生塑性变形,使得引线与被焊面紧密接触,达到原子间引力范围并导致界面间原子扩散而形成焊合点。引线键合键合接点形状主要有楔形和球形,两键合接点形状可以相同或不同。超声键合:超声波发生器使劈刀发生水平弹性振动,同时施加向下压力。劈刀在两种力作用下带动引线在焊区金属表面迅速摩擦,引线发生塑性变形,与键合区紧密接触完成焊接。常用于Al丝键合,键合点两端都是楔形。热压键合:利用加压和加热

集成电路芯片封装结构.pdf
集成电路芯片封装结构全文共四篇示例,供读者参考第一篇示例:集成电路芯片封装结构是指将制造好的芯片封装在外部保护壳体中,以保护芯片免受外界环境的影响。封装是集成电路芯片制造过程中的最后一道工序,它直接影响到芯片的稳定性、可靠性和性能。不同的封装结构具有不同的特点和适用场景,下面将对常见的集成电路芯片封装结构进行详细介绍。一、单晶片封装单晶片封装是一种最简单的封装结构,它将芯片直接封装在一个封装体中。这种封装结构在芯片面积较小、功耗较低的集成电路中常见。由于单晶片封装没有额外的引脚和连接线路,因此具有较小的封

集成电路芯片封装结构.pdf
集成电路芯片封装结构全文共四篇示例,供读者参考第一篇示例:集成电路芯片封装结构是指将制造好的芯片封装在外部保护壳体中,以保护芯片免受外界环境的影响。封装是集成电路芯片制造过程中的最后一道工序,它直接影响到芯片的稳定性、可靠性和性能。不同的封装结构具有不同的特点和适用场景,下面将对常见的集成电路芯片封装结构进行详细介绍。一、单晶片封装单晶片封装是一种最简单的封装结构,它将芯片直接封装在一个封装体中。这种封装结构在芯片面积较小、功耗较低的集成电路中常见。由于单晶片封装没有额外的引脚和连接线路,因此具有较小的封

一种芯片双面互连封装方法.pdf
本发明公开了一种芯片双面互连封装方法,包括:在衬底上下两侧分别沉积绝缘介质,形成绝缘层;在衬底中制作第一通孔;在第一通孔中填入金属形成金属导电块,然后在衬底的下侧制作第一布线层;将第一芯片通过金属引线连接焊盘后,并制作形成第一塑封体;在衬底的上侧制作第二布线层;将第二芯片粘贴在右侧第二布线层上,进行第二次塑封,形成第二塑封体,塑封完成后在左右两端的第二布线层处进行开孔,并在第二通孔中制作第三布线层;在第二塑封体上方沉积介质层后分别对左右两端第三布线层和第二芯片焊盘处进行开孔,形成引脚金属。本发明形成的芯片
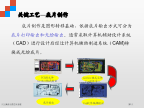
试论集成电路芯片封装.pptx
关键工艺—底片制作线路制作是将底片上电路图案转移到覆铜板上,电镀锡后保护所需部分,经后续去膜腐蚀即完成线路制作。关键工艺—线路制作抛光网印湿膜技术干膜后样板MSM3000丝印机刮好感光油墨线路板需要烘干,依据感光油墨特征,烘干机温度设置为:75度,时间为:15分钟左右。操作步骤:放置电路板→设定温度时间线路对位是对完成图形转移覆铜板进行对位,依据CAM软件里设置定位孔进行定位。显影是将未曝光膜层部分除去得到所需电路图形过程。要严格控制显影液浓度和温度,显影液浓度太高或太低都易造成显影不净。显影时间过长或显
