
增强型GaN基MIS-HEMT器件及其制备方法.pdf

是丹****ni








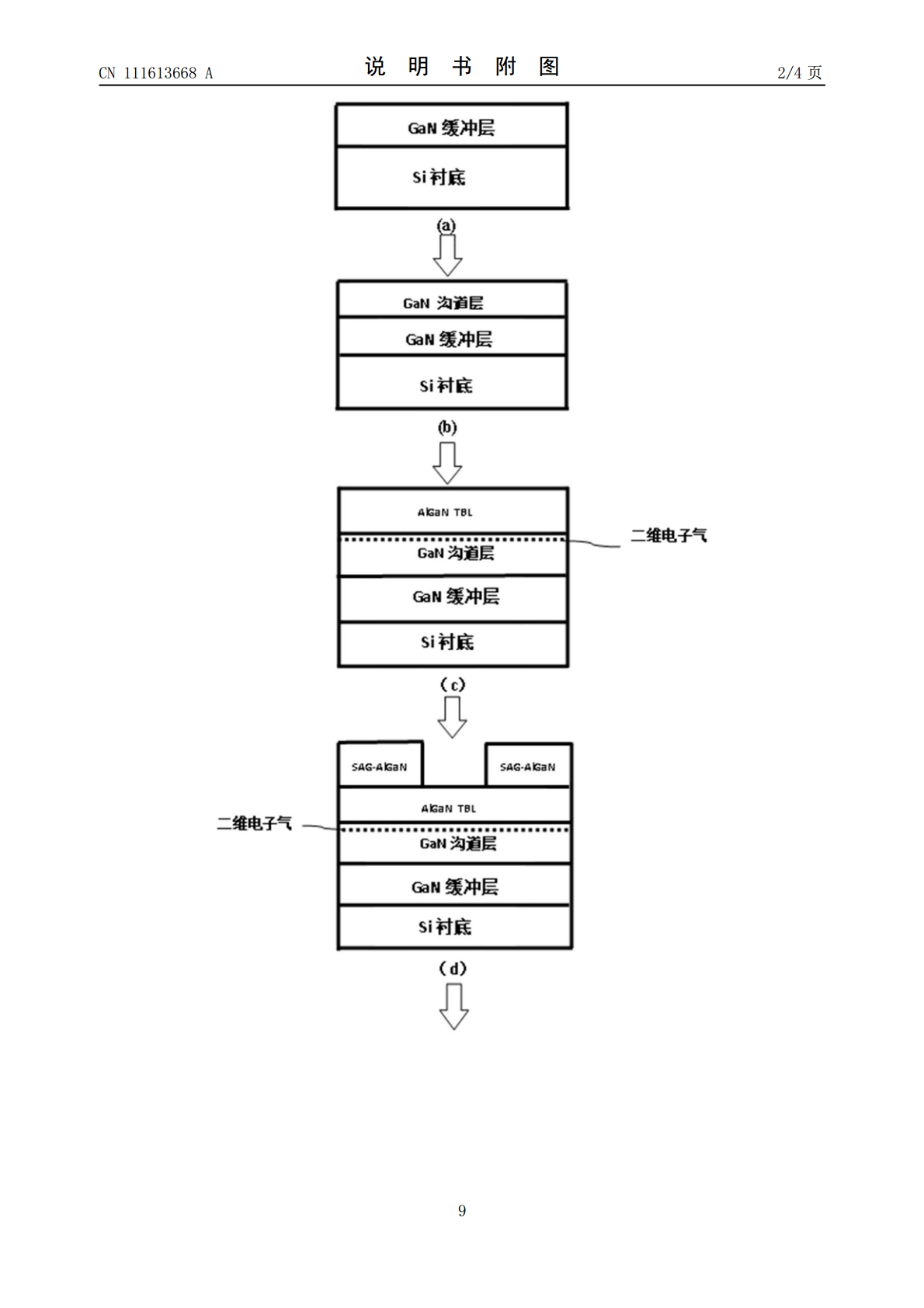

亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

增强型GaN基MIS-HEMT器件及其制备方法.pdf
本发明涉及一种增强型GaN基MIS‑HEMT器件及其制备方法,该MIS‑HEMT器件中,在薄AlGaN势垒层的基础上设置凹陷状的AlGaN势垒层提高通道迁移率和改善导通电阻,在此基础上,采用电子束蒸发法(EBE)生长掩模层结合SAG方法,与常规工艺中使用的PECVD掩模相比,采用EBE生长掩模完全消除了掩模工艺中的等离子体损伤,使得薄的AlGaN/GaN异质结保留了无损伤的晶格,同时AlGaN薄势垒与凹陷状AlGaN势垒层的Al组分不同,进一步提高了阈值电压和沟道电子迁移率。另外本发明器件中栅极介质层采用

GaN基HEMT器件及其制备方法.pdf
本发明提供一种GaN基HEMT器件及其制备方法,在衬底上先形成外延结构及SiN钝化保护层,而后形成源极区及漏极区,及对应的源电极及漏电极,之后去除SiN钝化保护层,并进行表面清洗后,再采用原子层沉积及等离子退火工艺形成单晶AlN势垒层,以调制GaN沟道内二维电子气,同时在AlGaN势垒层内形成区域性薄层附属沟道,以提高器件整体线性度,且在同一沉积腔内采用原子层沉积在单晶AlN势垒层上形成非晶AlN钝化保护层,由于采用连续原位原子层沉积单晶和非晶AlN层,可以提高晶体/非晶AlN的界面质量,以优化器件Pul

GaN基的p-GaN增强型HEMT器件及其制作方法.pdf
本发明公开了一种GaN基的p‑GaN增强型HEMT器件及其制作方法。所述器件包括:隧道结构,其包括异质结,所述异质结包括沟道层和势垒层,且所述异质结内形成有二维电子气;帽层,其至少对隧道结构的局部区域形成三维包覆,并至少用以将所述异质结内分布于栅下区域的二维电子气耗尽;源极、漏极,其分别设置在所述隧道结构两端;栅极,其对所述帽层的形成三维包覆。本发明的HEMT器件具有阈值电压高,p‑GaN帽层掺杂浓度及厚度要求低等优点。

一种Mg扩散增强型GaN基HEMT器件及其制备方法和应用.pdf
本发明公开了一种Mg扩散增强型GaN基HEMT器件及其制备方法和应用。本发明的Mg扩散增强型GaN基HEMT器件的组成包括衬底、GaN沟道层、超晶格结构层、P型Mg离子扩散势垒层、SiO<base:Sub>2</base:Sub>栅绝缘层、源金属电极、漏金属电极和栅金属电极,超晶格结构层由至少2个Al<base:Sub>x</base:Sub>Ga<base:Sub>1?x</base:Sub>N层和至少2个Al<base:Sub>y</base:Sub>Ga<base:Sub>1?y</base:Sub

GaN基增强型HEMT器件制备研究的开题报告.docx
GaN基增强型HEMT器件制备研究的开题报告一、研究背景随着半导体技术的不断发展,尤其是宽禁带半导体材料的发现和研究,GaN材料因其具有宽带隙、高电场饱和漂移速度、高电子迁移率等优异特性而成为研究的热点。GaN材料应用于高频电子元器件,特别是在射频功率放大器方面具有广阔的前景。GaN基HEMT器件(GaN-HEMTs)在此领域的应用逐渐展露。GaN-HEMT可以实现高电压饱和电流、高频率响应、低噪声性能等特性,具有广泛的应用前景,包括无线通信、雷达、卫星通信等。GaN-HEMT的基本结构是GaN作为电子传
