
MEMS器件的制造方法.pdf

努力****星驰








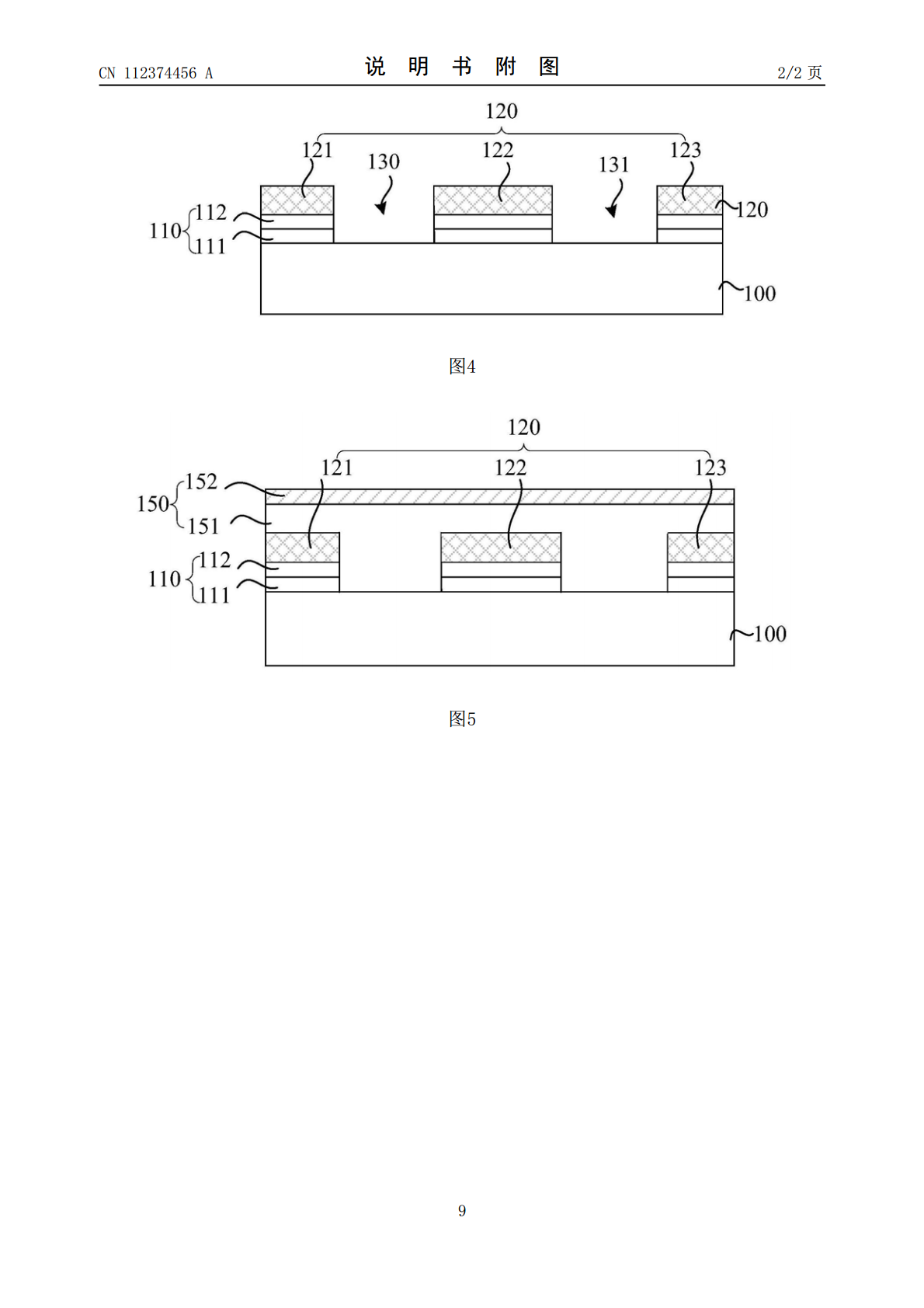
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种MEMS器件制造方法及MEMS器件.pdf
本发明涉及一种MEMS器件制造方法及MEMS器件,选用SOI绝缘体硅片作为衬底,通过SOI顶层硅与作为结构层的硅晶圆进行硅‑硅键合,使整个制造工艺可以兼容VHF工艺;在形成疏水有机膜之前,先在需要去除疏水有机膜的区域淀积一层牺牲层二氧化硅,在形成疏水有机膜后,可以借助VHF工艺将键合区和电极区上的二氧化硅牺牲层刻蚀掉,去除二氧化硅的同时也一并将键合区和电极区上的疏水有机膜去除干净,而其他区域需要保留的疏水有机膜则不会受到影响。本发明所公开的制造方法工艺简单、可实施性强、能够同时将键合区和电极区上的疏水有机

MEMS器件的制造方法.pdf
在本发明提供一种MEMS器件的制造方法,包括:在半导体衬底上依次形成第一粘合层、金属层和第二粘合层;通过在第二粘合层中形成开口,所述开口延伸贯穿金属层,以暴露出部分第一粘合层;去除暴露出的所述第一粘合层和剩余的所述第二粘合层;接着,形成介质层,所述介质层填充所述开口,并延伸覆盖所述第二金属层表面。即在所述第二粘合层中形成开口后,形成所述介质层,由于在形成所述开口时,去除了所述第二粘合层、部分所述金属层和部分所述第一粘合层,在后续对所述介质层刻蚀时,可以避免对所述第二粘合层的刻蚀,由此减少聚合物的产生,从而

MEMS器件的制造方法.pdf
本发明公开了一种MEMS器件的制造方法。该制造方法包括:在SOI片或载体裸硅片的表面喷涂临时键合后解键合时所需的释放层;于SOI片或载体裸硅片上旋涂临时键合时所需的黏胶层;将SOI片和载体裸硅片临时键合在一起并固化;在键合片的载体裸硅片的表面旋涂抗碱腐蚀的胶层;对SOI片的底层硅基体进行腐蚀,以将基底部分腐蚀去除;去除抗碱胶层并清洗键合片;腐蚀去除埋氧层;将键合片器件层一面粘贴于UV膜上;将键合片解键合以移除载体裸硅片;清洗器件层,去除解键合后残留于器件层表面的释放层,以得到器件。本发明的制造方法,能够生

MEMS器件及其制造方法.pdf
本申请公开了一种MEMS器件及其制造方法,该制造方法包括:在第一衬底上形成牺牲层;在牺牲层上形成功能层;在功能层的表面的键合区上形成金属保护层;去除部分功能层形成第一通道;经由第一通道去除部分牺牲层形成空腔,以释放部分功能层形成可移动质量块;形成第一有机膜,第一有机膜覆盖金属保护层、功能层的表面、第一通道与空腔的内表面;加热第一有机膜,以使金属保护层上的第一有机膜的有机分子被破坏;以及去除金属保护层,以暴露键合区。该制造方法通过去除金属保护层将其上的有机膜去除,从而暴露出键合区,其他区域的有机膜被保留,兼

一种MEMS器件的制造方法.pdf
本发明提供一种MEMS器件的制造方法,首先,通过氯、氧混合等离子体刻蚀所述有机填充材料层;接着,在有机填充材料刻蚀之后、导电材料层刻蚀之前,采用氟基气体与低流量氧气的混合气体刻蚀去除了图案化的光刻胶层以及填充材料层暴露表面反应产生的聚合物残留;然后,采用各向同性的方式刻蚀导电材料层;之后,在导电材料层刻蚀之后,采用氟基气体与高量氧气的混合气体低温灰化去除图案化的光刻胶层以及有机填充材料层暴露表面再次产生的聚合物残留,保证了刻蚀导电材料层时所用掩膜的侧壁形貌,改善了导电材料层刻蚀后的形貌;抑制并去除了有机填
