
半导体制造工艺_05光刻(下).ppt

书生****aa
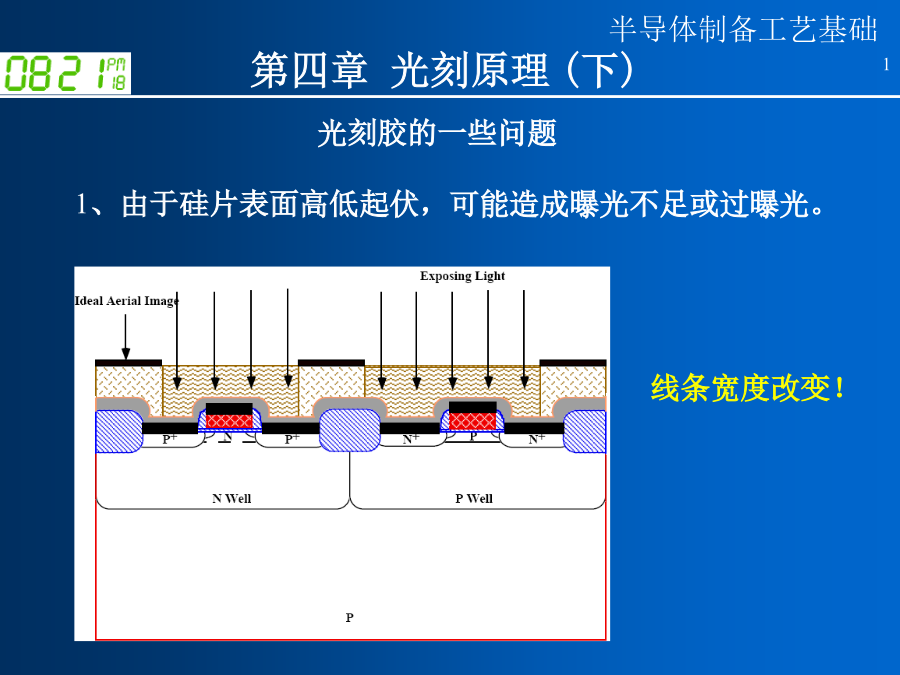
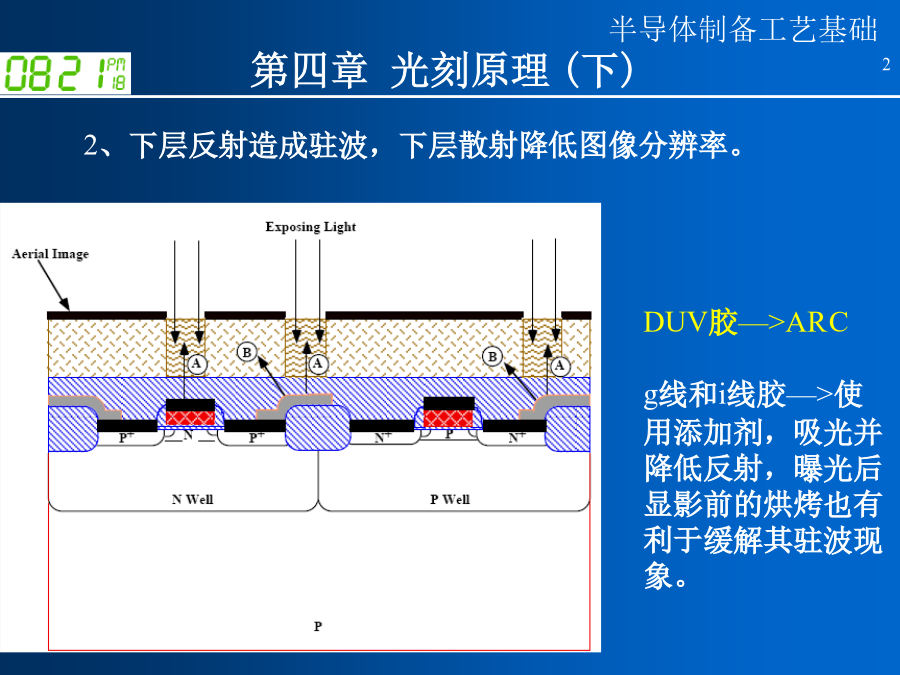
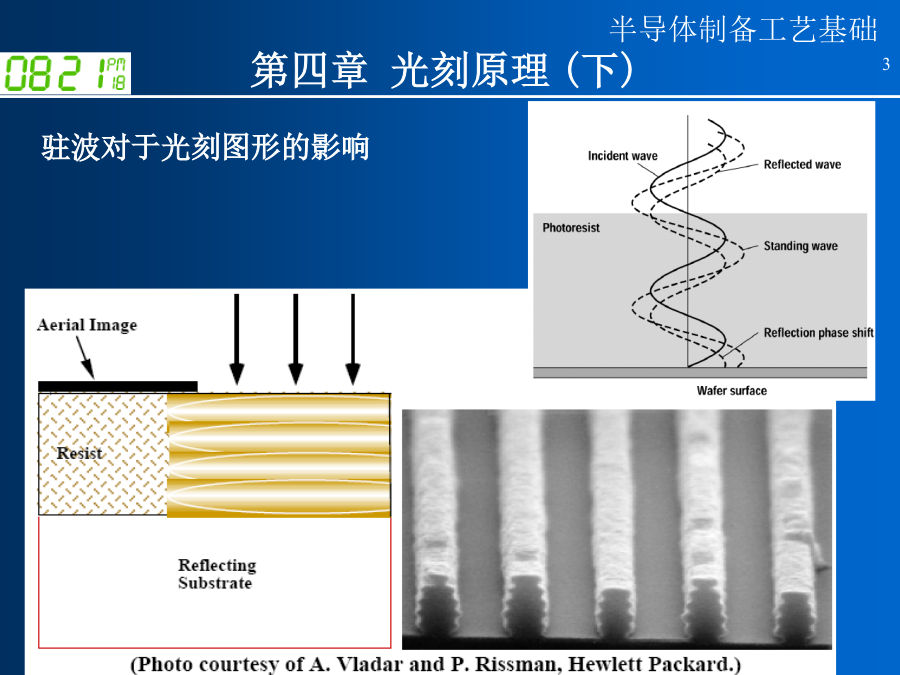






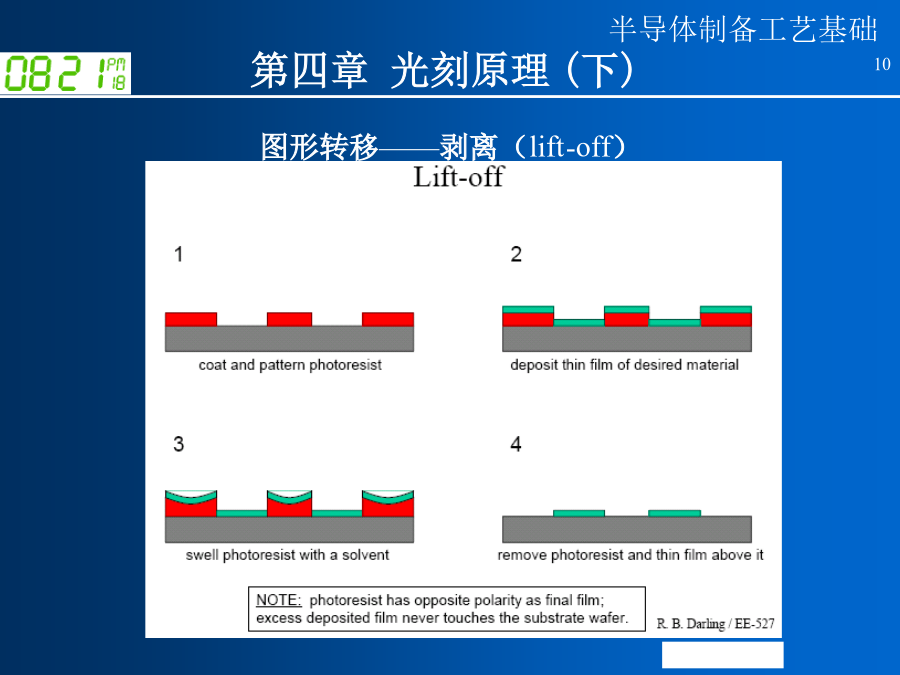
亲,该文档总共40页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体制造工艺_05光刻(下).ppt
光刻胶的一些问题2、下层反射造成驻波下层散射降低图像分辨率。驻波对于光刻图形的影响光刻步骤简述光刻步骤详述硅片对准曝光坚膜:10~30min100~140CStepper&ScanSystem图形转移——刻蚀图形转移——剥离(lift-off)去胶溶剂去胶(strip):Piranha(H2SO4:H2O2)。正胶:丙酮光源248nm2、Reducingresolutionfactork1AlternatingPSMAttenuatedPSM……2.光学光刻分辨率增强技术(RE

半导体制造工艺_05光刻(下).pptx
光刻胶的一些问题2、下层反射造成驻波,下层散射降低图像分辨率。驻波对于光刻图形的影响光刻步骤简述光刻步骤详述硅片对准,曝光坚膜:10~30min,100~140CStepper&ScanSystem图形转移——刻蚀图形转移——剥离(lift-off)去胶溶剂去胶(strip):Piranha(H2SO4:H2O2)。正胶:丙酮光源248nm2、Reducingresolutionfactork1AlternatingPSMAttenuatedPSM……2.光学光刻分辨率增强技术(RET)OPC实例3、离

半导体制造工艺_05光刻(下).ppt
光刻胶的一些问题2、下层反射造成驻波,下层散射降低图像分辨率。驻波对于光刻图形的影响光刻步骤简述光刻步骤详述硅片对准,曝光坚膜:10~30min,100~140CStepper&ScanSystem图形转移——刻蚀图形转移——剥离(lift-off)去胶溶剂去胶(strip):Piranha(H2SO4:H2O2)。正胶:丙酮光源248nm2、Reducingresolutionfactork1AlternatingPSMAttenuatedPSM……2.光学光刻分辨率增强技术(RET)OPC实例3、离

半导体工艺制造.pdf

光器件、半导体基板、光器件的制造方法、以及半导体基板的制造方法.pdf
提供一种光器件,具备:基底基板,包含硅;多个种晶,设置在基底基板上;以及多个3-5族化合物半导体,与多个种晶晶格匹配或者准晶格匹配,其中,在多个3-5族化合物半导体中的至少一个中形成有光电半导体,该光电半导体包含根据供给的驱动电流来输出光的发光半导体、或者接收光的照射来产生光电流的感光半导体,在多个3-5族化合物半导体中的具有光电半导体的3-5族化合物半导体以外的至少一个的3-5族化合物半导体中形成有异质结晶体管。
