
半导体装置及其形成方法.pdf

高格****gu








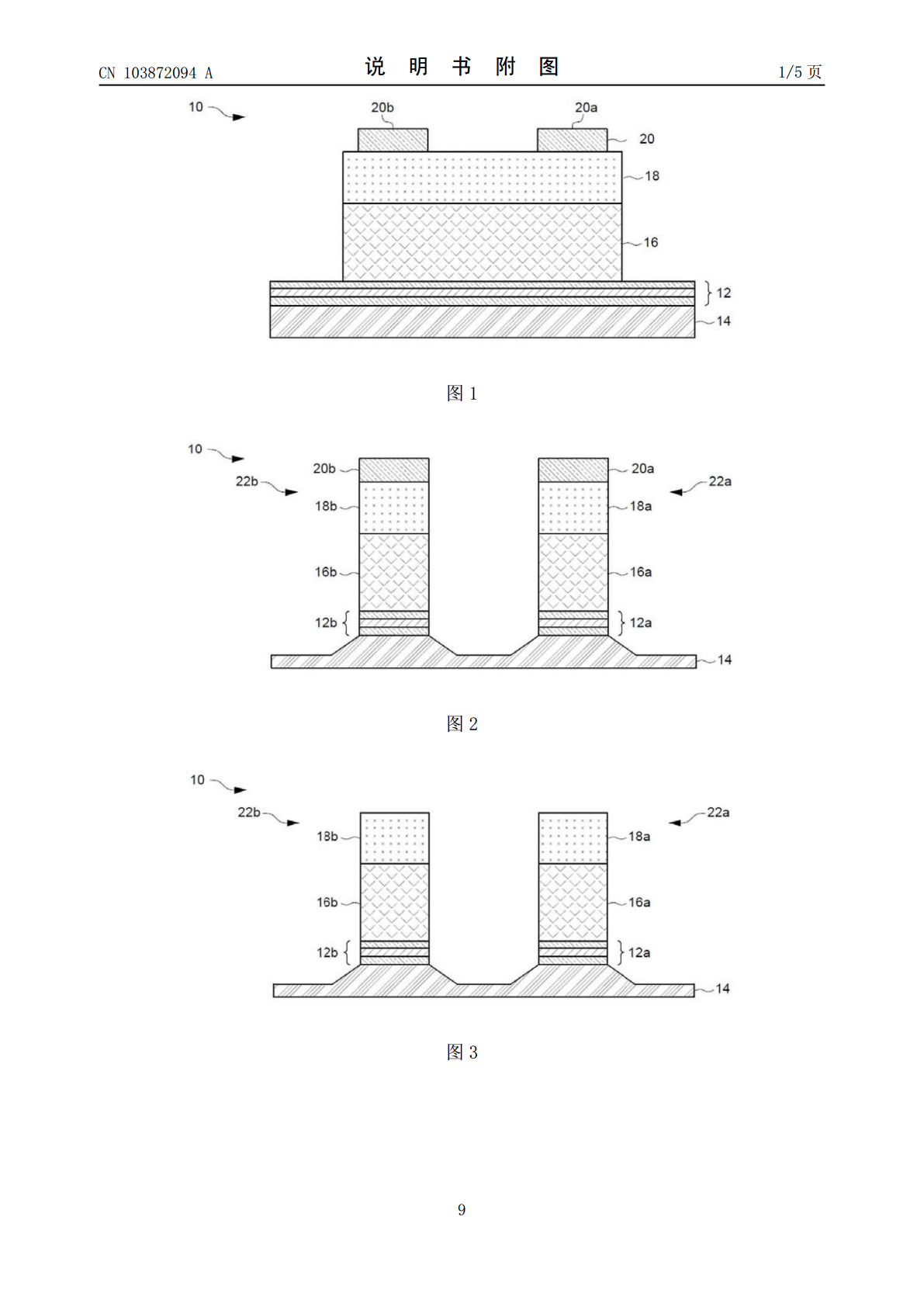
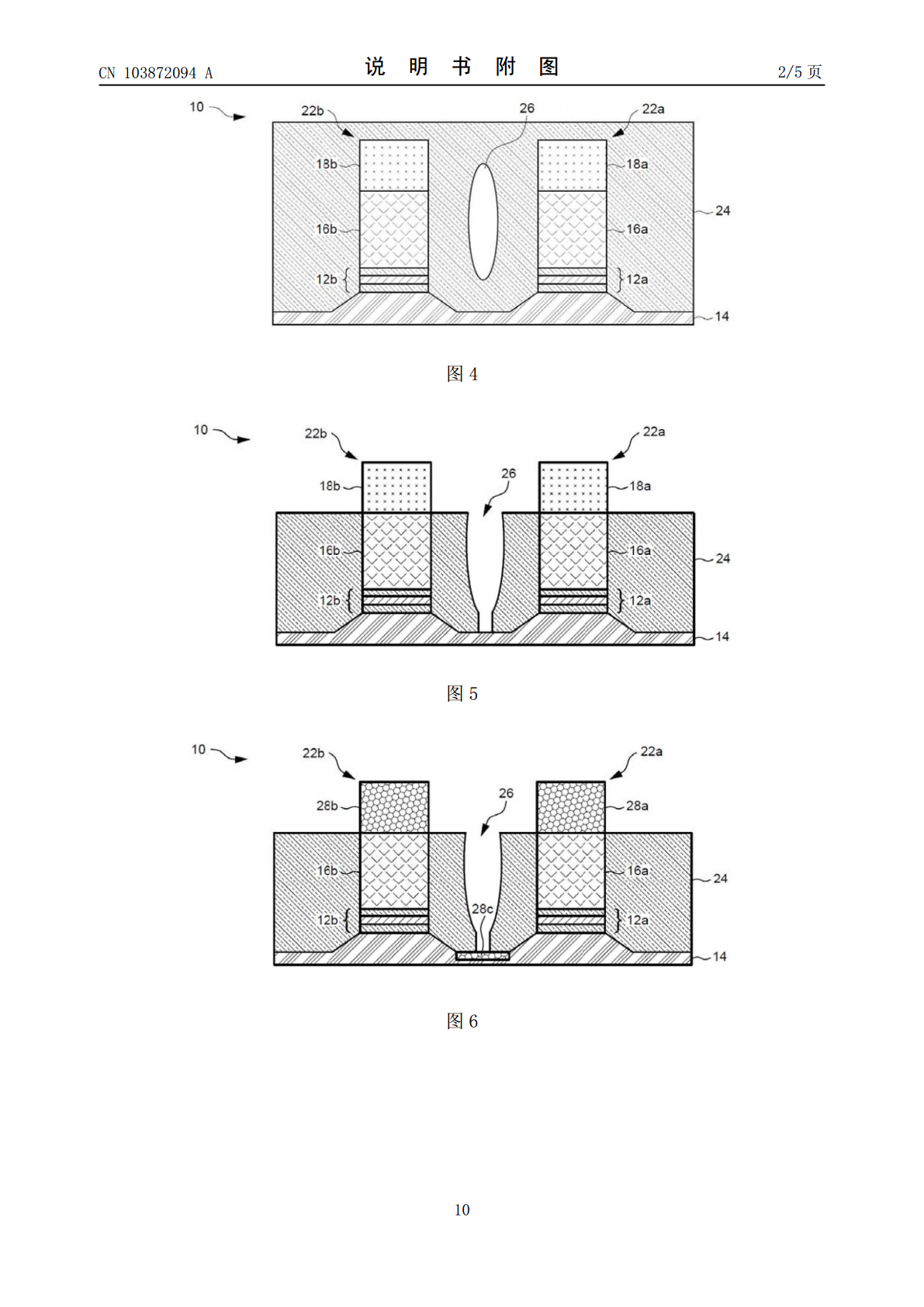
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体装置及其形成方法.pdf
本发明是有关于一种半导体装置及其形成方法。该半导体装置包括一基板、一半导体层以及一材料层。半导体层形成于基板上。材料层形成于半导体层上。半导体层及材料层沿着一从基板延伸的垂直方向具有一锥状轮廓。藉此本发明可以有效的抑制在结构之间的电桥或短路的形成。

半导体装置及其形成方法.pdf
本发明公开一种半导体装置及其形成方法。在各种实施例中,半导体装置形成方法包括:接收包括通道的半导体基板。气氛调节层形成于通道之上。执行退火工艺以形成位于通道与气氛调节层之间的介面层。本发明内容所应用的气氛调节层,能改良介面层的均匀性及应变松驰。此外,本发明内容提供用于栅极介电层/介面层及介面层/半导体基板介面的一个步骤的钝化工艺,能减少成本。本发明内容提供的方法,能保持工艺期间的低热预算及更小的应变松驰,并适用于诸如含锗及基于第III族-第V族的材料的高电子迁移性通道。

半导体装置及其形成方法.pdf
一种半导体装置及其形成方法,包括:半导体基板以及通道层的堆叠在半导体基板上。最顶部通道层的顶表面沿着相对于基板表面的第一高度延伸。最底部通道层的底表面沿着相对于基板表面的第二高度延伸。装置还包括栅极结构,啮合通道层的堆叠且沿着第一方向延伸。额外地,装置包括源极/漏极部件,在通道层的堆叠的第一侧壁表面上以及在基板上,第一侧壁表面平行于第一方向延伸。此外,源极/漏极部件在第一高度具有沿着第一方向的第一宽度,且在第二高度具有沿着第一方向的第二宽度,以及其中第一宽度大于第二宽度。

半导体装置及其形成方法.pdf
本发明实施例提供一种半导体装置及其形成方法。该半导体装置的形成方法包括提供具有切割道的基板、在基板中形成感测像素阵列、在基板上形成多个透光柱、以及在基板及透光柱之上形成遮光层。上述感测像素阵列包括多个感测像素,且上述透光柱对应设置于感测像素阵列的感测像素之上。此方法更包括进行第一切割工艺,以在切割道正上方形成开口,且留下覆盖切割道的剩余材料、以及进行刻蚀工艺以去除此剩余材料,以延伸上述开口直到露出切割道。本发明可以降低在晶圆切割工艺期间造成材料层间微裂或因为基板与其他结构接着性不佳而导致剥离的风险,以消除

半导体装置及其形成方法.pdf
本公开实施例公开了一种具有改善的源极/漏极区域轮廓的半导体装置以及其形成方法。在一实施例中,此方法包含蚀刻半导体鳍片以形成第一凹槽;以及形成源极/漏极区域,其包含在第一凹槽中外延生长第一半导体材料且第一半导体材料为硅;于第一半导体材料上外延生长第二半导体材料且第二半导体材料包含硅锗;以及于第二半导体材料上外延生长第三半导体材料且第三半导体材料具有60‑80原子%的锗浓度,第三半导体材料的锗浓度大于第二半导体材料的锗浓度。
