
结轮廓检测样品及制备方法、结轮廓检测方法.pdf

小寄****淑k






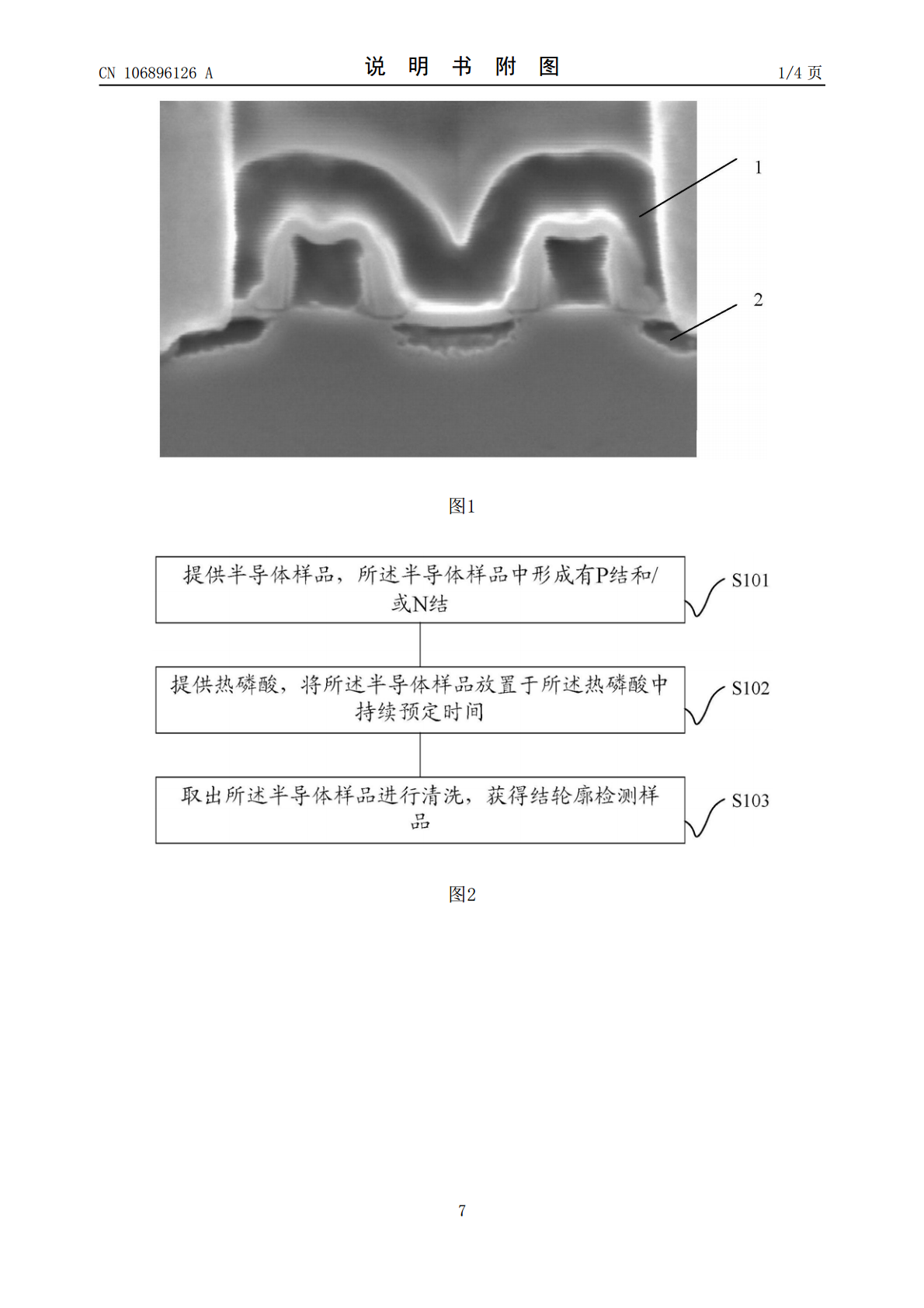
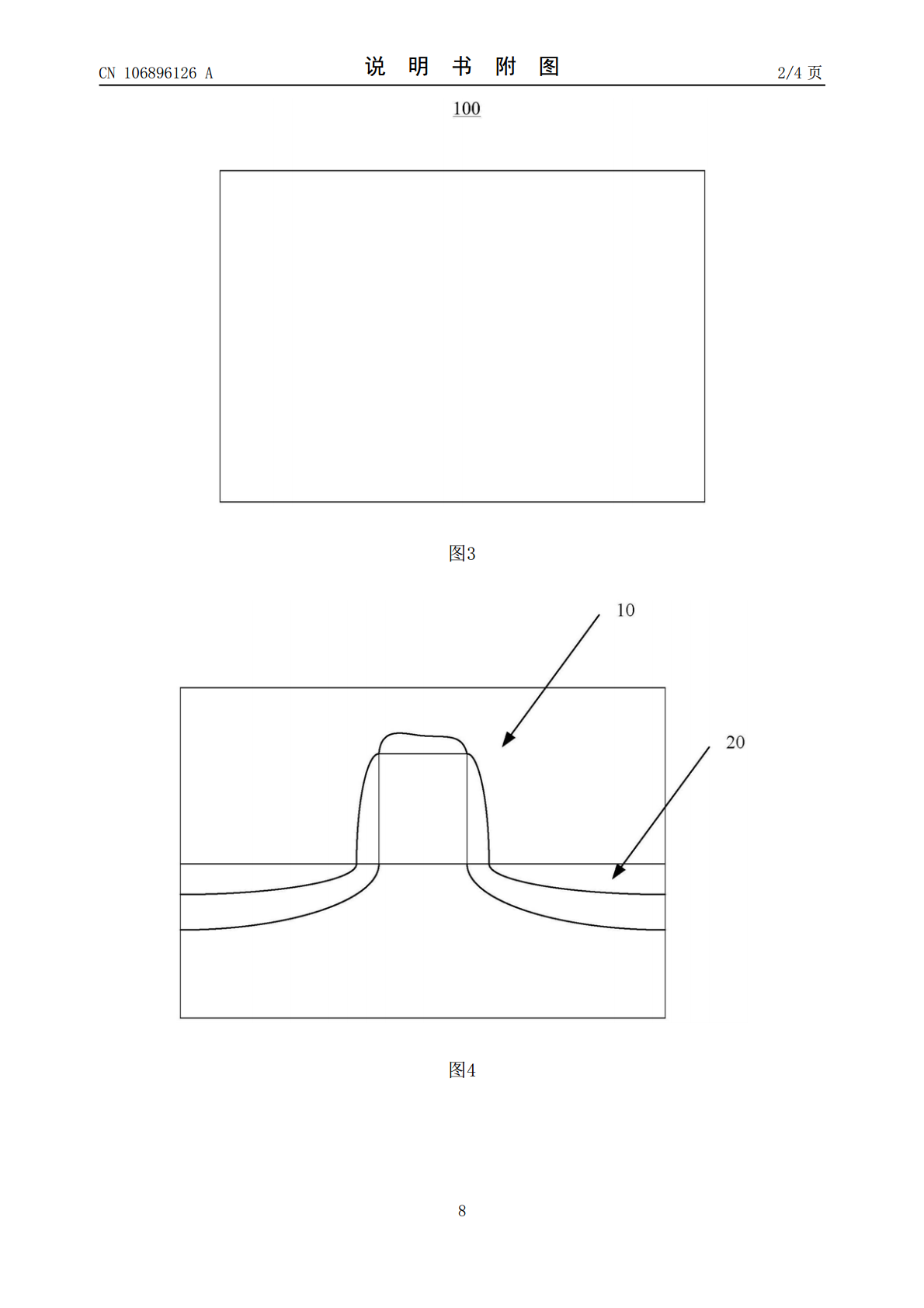
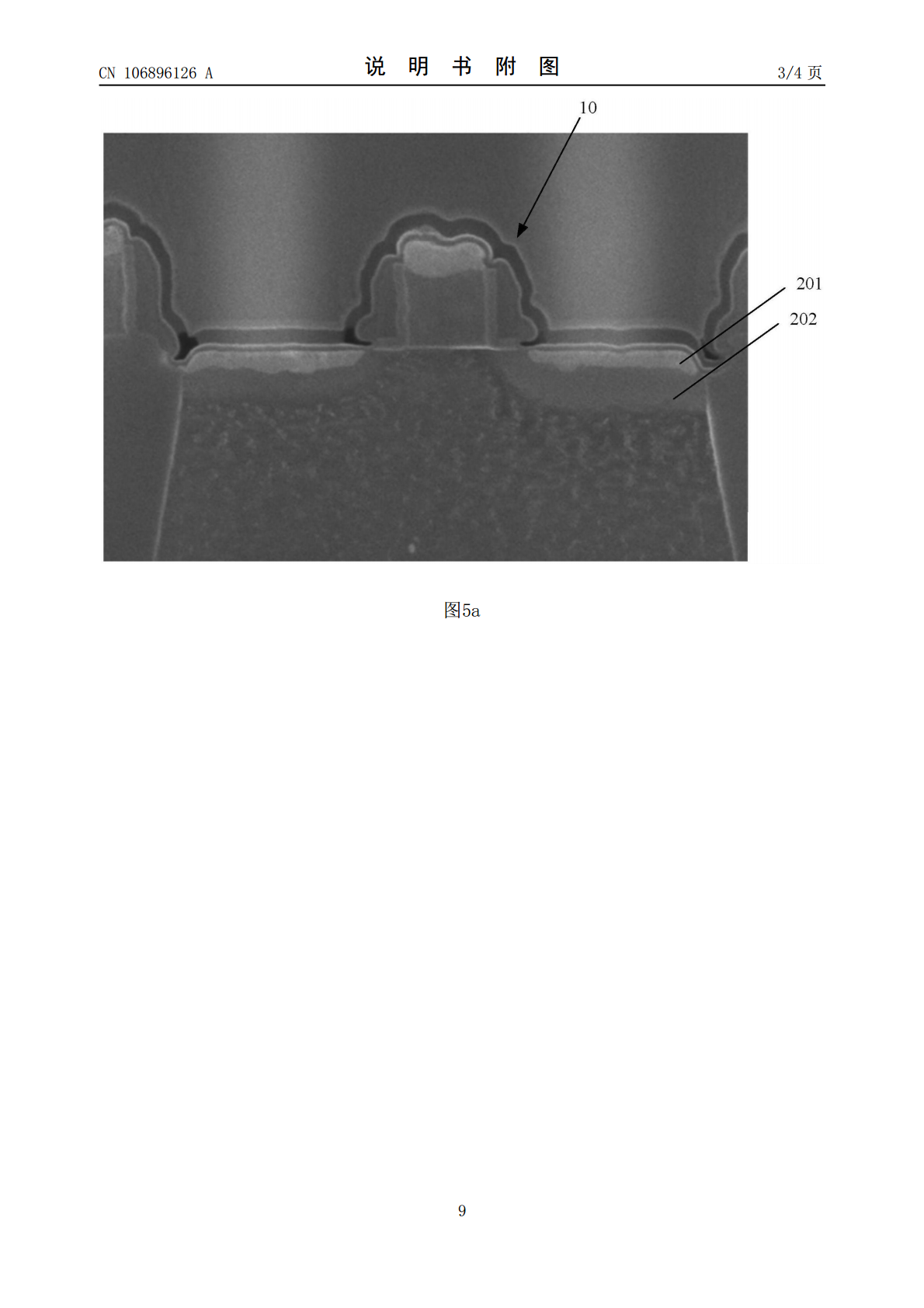
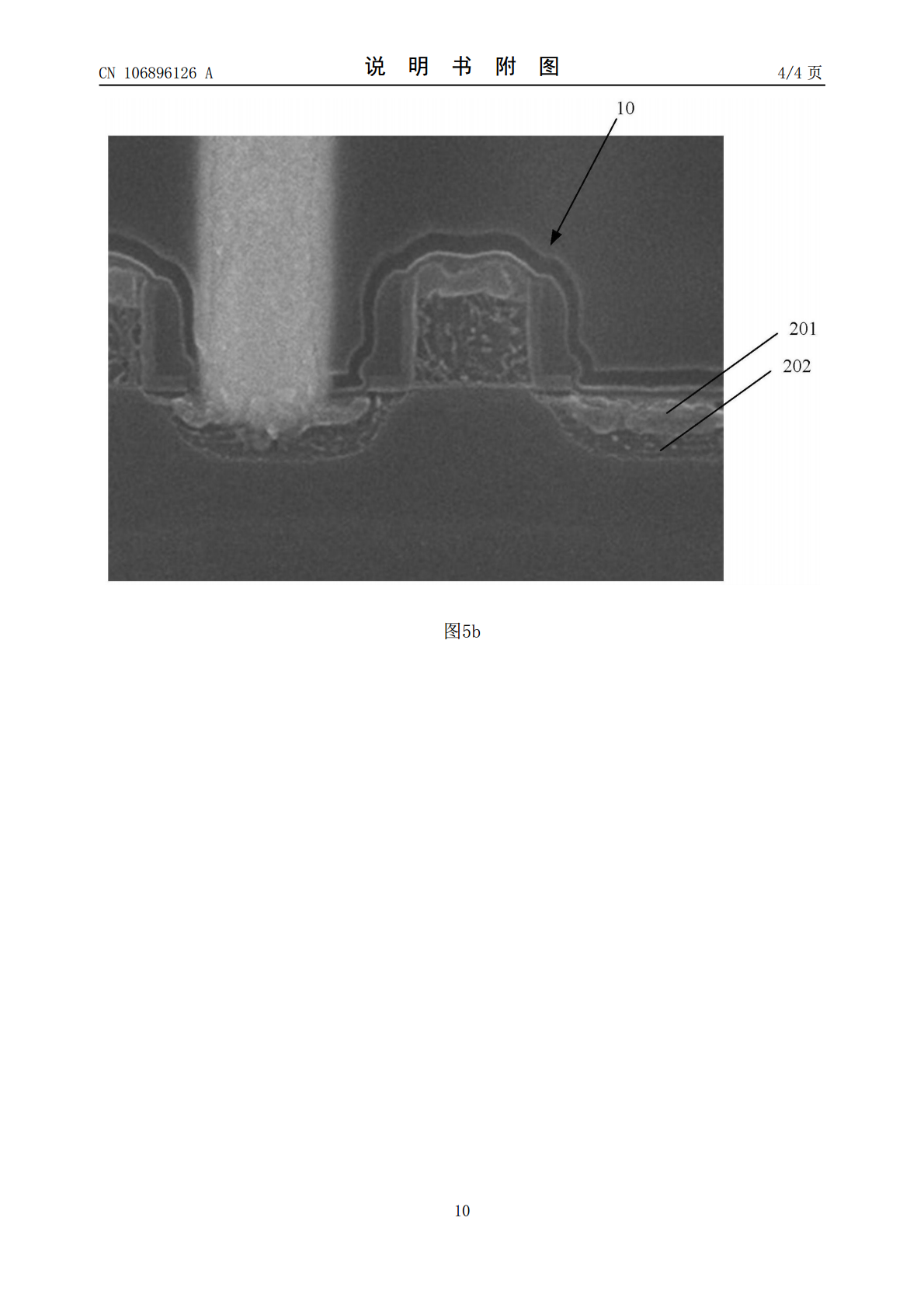
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

结轮廓检测样品及制备方法、结轮廓检测方法.pdf
本发明揭示了一种结轮廓检测样品及制备方法、结轮廓检测方法。本发明提供的结轮廓检测样品的制备方法,包括:提供半导体样品,所述半导体样品中形成有P结和/或N结;提供热磷酸,将所述半导体样品放置于所述热磷酸中持续预定时间;取出所述半导体样品进行清洗,获得结轮廓检测样品。与现有技术相比,本发明成本低廉,制样时间适当,可控性强,能够获得较佳的结轮廓,有着良好的可重复性。

轮廓检测装置、描绘装置、轮廓检测方法以及记录介质.pdf
本发明提供一种轮廓检测装置,具备处理器,所述处理器基于包含学习对象指甲的手指的图像数据即多个学习数据设定包含多个特征点的初始形状,将所述特征点中的与基准位置对应的特征点设为基准点,进行对作为检测对象的指甲轮廓进行检测的学习,从而获得轮廓检测信息,对于包含处理对象指甲的手指的图像数据即处理对象数据,所述处理器以使包含所述处理对象指甲的手指的手指轮廓中的与所述基准位置对应的点和所述基准点重叠的方式配置所述初始形状的初始位置,将所述初始形状从所述初始位置向所述处理对象指甲匹配,从而对所述处理对象指甲的所述指甲轮

轮廓检测装置,印刷装置,轮廓检测方法以及记录介质.pdf
一种轮廓检测装置,具备以下部分:显示器;和处理器,所述处理器取得拍摄了检测对象的检测对象图像,进行轮廓检测处理,所述轮廓检测处理中,多次进行对所述检测对象的轮廓的形状进行识别的形状识别,从所述检测对象图像检测所述检测对象的轮廓,使所述显示器显示基于所述轮廓检测处理的检测结果,在所述轮廓检测处理中,针对构成通过多次所述形状识别而得到的所述轮廓的特征点,分别按对应的每个特征点,计算多次所述形状识别中的离差,将计算出的离差的值为所设定的值以上的所述特征点判断为可靠度低的特征点。

空调外观轮廓检测方法.pdf
本发明涉及空调外观轮廓检测方法,包括如下步骤:对标准空调工件建立模块轮廓特征;对待检测空调工件建立轮廓特征;判断标准空调工件的模板轮廓特征和待检测空调工件的轮廓特征的相似度是否达到预设值且满足目标个数,若是,则认定待检测空调工件外观合格,否则,认定待检测空调工件外观不合格。本发明无需人工对空调的外观进行手动检测,避免了人工检测所带来的主观误差以及仪器测量自身带来的系统误差,实现了自动化检测,通过将待检测工件与标准工件相比,具有高精度检测保证,测量方法效率高。

光斑轮廓的检测方法.pdf
本发明提供一种光斑轮廓的检测方法,包括光源产生目标光斑并投射在图像传感器的视场范围内,运动台载动所述图像传感器按一设定路线进行步进,并在每一步进位置进行图像采集,然后对采集的图像进行补偿整合。本发明通过运动台载动图像传感器进行图像采集,通过补偿整合形成高分辨率图像,间接提高了图像传感器的分辨率,实现光斑轮廓的高精度检测。进一步的,本发明提供的光斑轮廓的检测方法在现有光斑轮廓的检测系统的基础上实现光斑轮廓的检测,不需要增加额外硬件,节约了检测成本。
