
减小MEMS谐振器件误差影响的弹簧设计结构及方法.pdf

是你****深呀







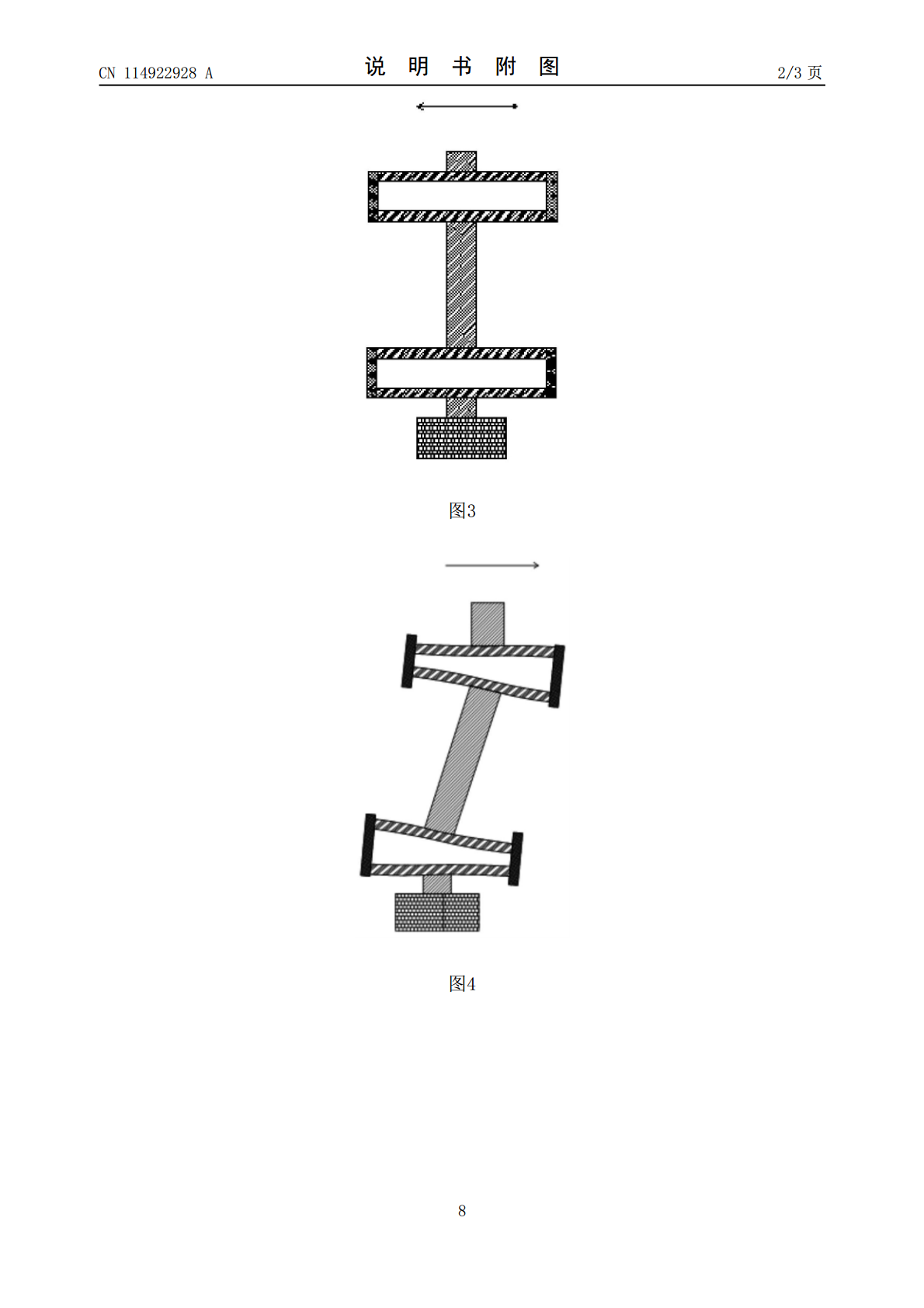
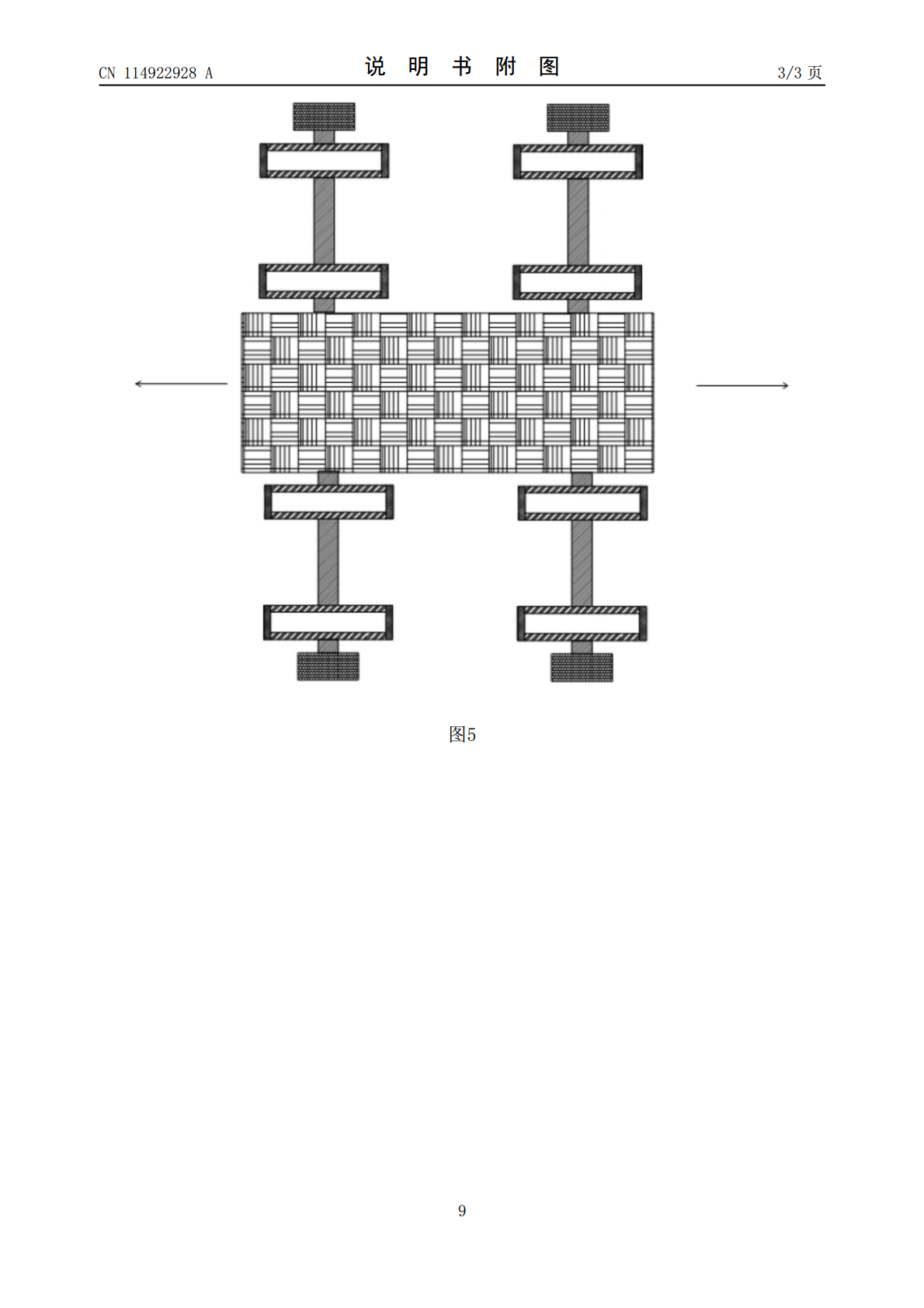
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

减小MEMS谐振器件误差影响的弹簧设计结构及方法.pdf
减小MEMS谐振器件误差影响的弹簧设计结构,包括端点,刚体,刚性连接模块,柔性梁,固定点;其中:刚体上端为端点结构,平行于位移方向的柔性梁之间设置有刚性连接模块,固定点,刚体下方设置有固定点。一种减小MEMS谐振器件误差影响的弹簧设计结构的方法,MEMS柔性的结构,安排多个以交互方式偏转的柔性梁,柔性梁能实现针对蚀刻误差的自补偿效应;柔性梁以反对称方式偏转,柔性梁的任何平面都是自补偿。本发明的优点:能实现MEMS柔性结构的特定设计,以获得对蚀刻误差不敏感的器件,实现一种针对蚀刻误差的自补偿效应。解决在机械

MEMS谐振器及其加工方法,时钟器件.pdf
本申请实施例公开了一种MEMS谐振器,应用于通信、时钟器件等领域。MEMS谐振器包括固定部件,谐振子和支撑梁。谐振子通过支撑梁与固定部件相连。谐振子包括上电极层,压电层和器件层。压电层在上电极层和器件层之间。在压电层和器件层之间设置有缓冲层。压电层的材料温度系数大于缓冲层的材料温度系数,缓冲层的材料温度系数大于器件层的材料温度系数。在本申请中,通过在垂直方向上增加缓冲层,可以在降低热弹性损耗的基础上,降低工艺难度。

MEMS器件的微机械薄膜结构及MEMS器件.pdf
本发明公开了一种MEMS器件的微机械薄膜结构及MEMS器件,微机械薄膜结构包括:衬底;锚点座,锚点座设在衬底上;弹性薄膜组件,弹性薄膜组件包括薄膜件和应力吸收件,应力吸收件设在薄膜件上以吸收引发薄膜件蠕变的应力,薄膜件和应力吸收件二者中的一者设在锚点座上。本发明通过设置应力吸收件吸收引发薄膜件蠕变的应力,使弹性薄膜组件上的集中应力得到释放或均匀化处理,从而改善抗蠕变特性,避免MEMS器件的性能发生漂移。

MEMS器件的形成方法及MEMS器件.pdf
本发明涉及一种MEMS器件的形成方法和MEMS器件。所述方法包括:在衬底上形成牺牲层;在所述牺牲层上形成功能层和与所述功能层电连接的导电连接层;形成贯穿所述导电连接层的导通槽;形成保护层,所述保护层至少覆盖经由所述导通槽暴露出的所述导电连接层的侧壁;形成暴露出所述牺牲层的释放槽,所述释放槽在所述衬底平面上的垂直投影落入所述导通槽在所述衬底平面上的垂直投影内,以使所述导通槽的侧壁保留有部分厚度的所述保护层;经由所述释放槽去除所述牺牲层。本发明所提供的MEMS器件的形成方法和MEMS器件,使空气桥的结构更坚固

一种MEMS器件制造方法及MEMS器件.pdf
本发明涉及一种MEMS器件制造方法及MEMS器件,选用SOI绝缘体硅片作为衬底,通过SOI顶层硅与作为结构层的硅晶圆进行硅‑硅键合,使整个制造工艺可以兼容VHF工艺;在形成疏水有机膜之前,先在需要去除疏水有机膜的区域淀积一层牺牲层二氧化硅,在形成疏水有机膜后,可以借助VHF工艺将键合区和电极区上的二氧化硅牺牲层刻蚀掉,去除二氧化硅的同时也一并将键合区和电极区上的疏水有机膜去除干净,而其他区域需要保留的疏水有机膜则不会受到影响。本发明所公开的制造方法工艺简单、可实施性强、能够同时将键合区和电极区上的疏水有机
