
无硅通孔高可靠性图像传感器封装结构的实现方法.pdf

一只****ua








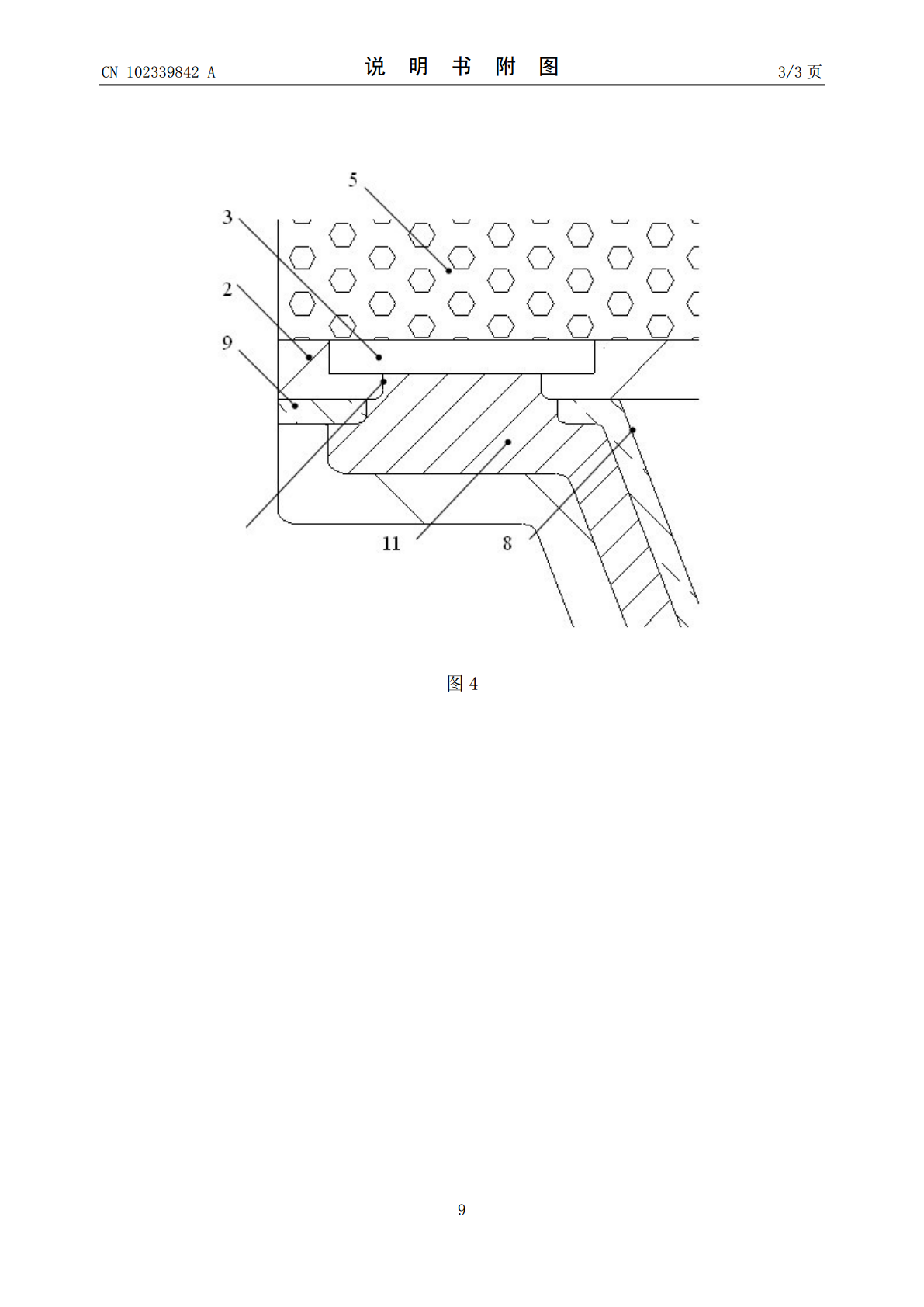
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

无硅通孔高可靠性图像传感器封装结构的实现方法.pdf
本发明涉及一种无硅通孔高可靠性图像传感器封装结构的实现方法,所述结构包括芯片本体(1),在芯片本体的上表面设置隔离层(5),在隔离层上设置透光盖板(6);在芯片本体上形成硅沟槽(8);在芯片本体下表面、硅沟槽(8)侧壁及裸露出的芯片内部钝化层(2)的下表面选择性的设置绝缘层(9);在芯片内部钝化层(2)上形成盲孔(10);在绝缘层(9)表面及盲孔(10)内选择性的形成金属线路层(11);在绝缘层(9)及金属线路层(11)上选择性的设置线路保护层(12);在金属线路层(11)露出线路保护层(12)的地方设置

无硅通孔高可靠性图像传感器封装结构.pdf
本发明涉及一种无硅通孔高可靠性图像传感器封装结构,所述结构包括芯片本体(1),在芯片本体的上表面设置隔离层(5),在隔离层上设置透光盖板(6);在芯片本体上形成硅沟槽(8);在芯片本体下表面、硅沟槽(8)侧壁及裸露出的芯片内部钝化层(2)的下表面选择性的设置绝缘层(9);在芯片内部钝化层(2)上形成盲孔(10);在绝缘层(9)表面及盲孔(10)内选择性的形成金属线路层(11);在绝缘层(9)及金属线路层(11)上选择性的设置线路保护层(12);在金属线路层(11)露出线路保护层(12)的地方设置焊球(13

无键合线、无硅通孔的MCM封装结构、设计及加工方法.pdf
一种无键合线、无硅通孔的MCM封装结构,包括封装基板、晶片和封装料,晶片和封装基板进行物理连接以及电连接后,由封装料包裹构成封装结构。晶片有多个,它们分为上层晶片和下层晶片;上层晶片和下层晶片的正面都朝下;上层晶片与封装基板之间留有间隙,下层晶片的位置在间隙内;上层晶片正面的焊盘处都有多个高凸点,上层晶片与封装基板的顶面焊盘通过高凸点连接;下层晶片正面的焊盘处都有多个矮凸点,下层晶片与封装基板的顶面焊盘通过矮凸点连接。本发明可以减小封装厚度与尺寸,提升高速高频信号的传输性能,降低了封装成本与工艺难度。

铆钉互联结构的图像传感器封装结构及实现方法.pdf
本发明涉及一种铆钉互联结构的图像传感器封装结构及实现方法,所述结构包括已经设置有芯片内部钝化层(2)、芯片内部金属层(3)及感光区(4)的芯片本体(1)以及隔离层(6)、硅沟槽(13)和盲孔Ⅰ(6.1),在所述盲孔Ⅰ(6.1)内以及芯片内部钝化层(2)的下表面形成钉帽(7),在芯片本体(1)下表面、硅沟槽(13)内、裸露出的芯片内部钝化层(2)的下表面以及钉帽(7)的帽沿(7-2)的表面选择性的设置绝缘层(8),并在所述钉帽(7)下方的绝缘层(8)上设置开口,形成盲孔Ⅱ(8-1),金属线路层(9)填充于所

微凸点互联结构的图像传感器封装结构及实现方法.pdf
本发明涉及一种微凸点互联结构的图像传感器封装结构及实现方法,所述结构包括已经设置有芯片内部钝化层(2)、芯片内部金属层(3)及感光区(4)的芯片本体(1)、隔离层(6)、硅沟槽(13)和开口(2-1),在开口(2-1)内以及芯片内部钝化层(2)下表面形成金属微凸点(7),在芯片本体下表面、硅沟槽内、裸露出的芯片内部钝化层的下表面以及金属微凸点的表面选择性的设置绝缘层(8),在绝缘层上设置开口,形成盲孔(8-1),金属线路层(9)填充于盲孔(8-1)内,以及选择性的形成于绝缘层(8)表面,在绝缘层(8)及金
