
利用多晶锗硅通孔形成MEMS晶圆电连接的方法.pdf

新槐****公主







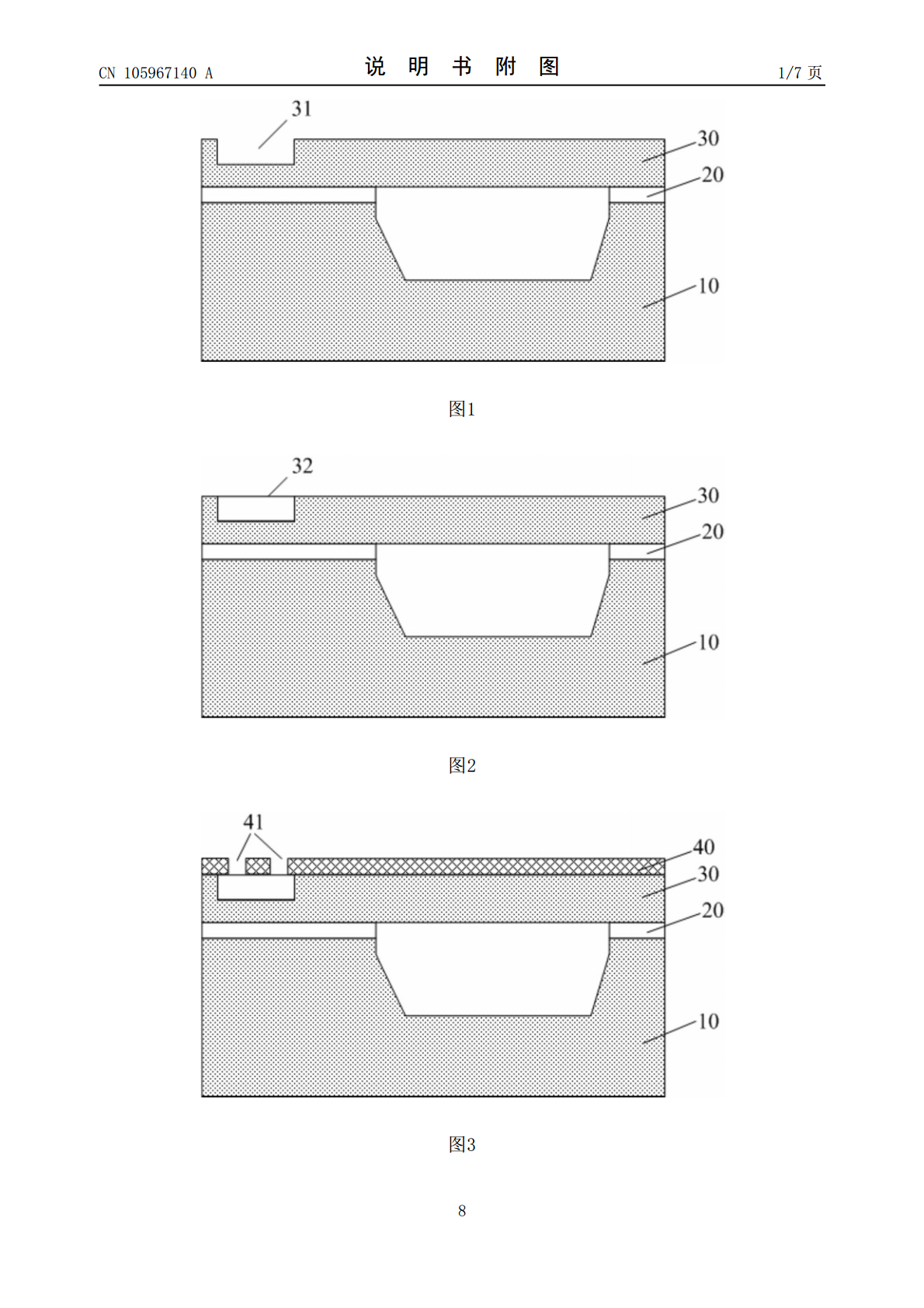
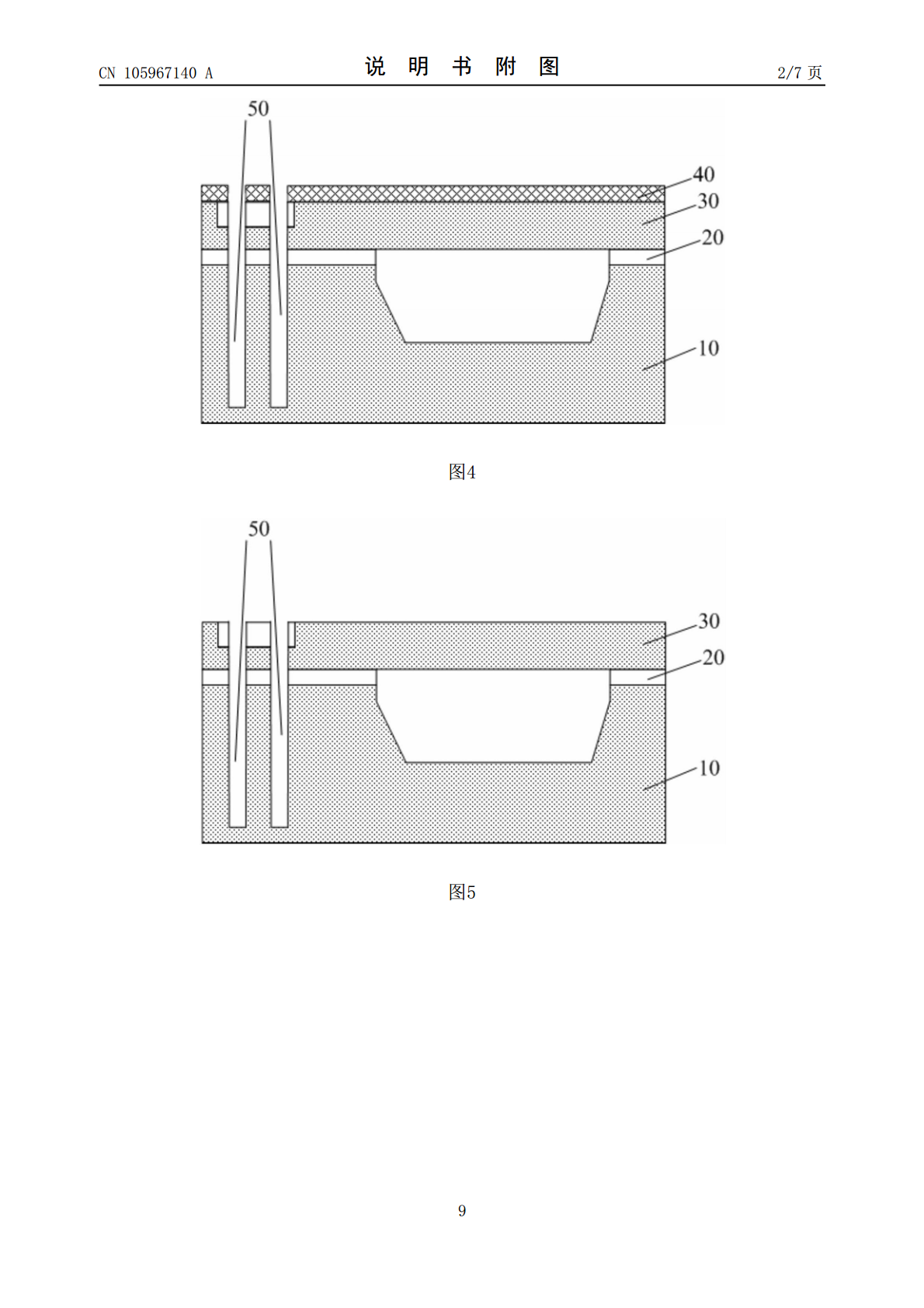

亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

利用多晶锗硅通孔形成MEMS晶圆电连接的方法.pdf
一种利用多晶锗硅通孔形成MEMS晶圆电连接的方法,包括:在MEMS硅晶圆上形成上部硅层;在上部硅层的凹进部中填充氧化物;沉积第一光刻胶层,在凹进部区域上方形成光刻胶开口;刻蚀以形成进入MEMS硅晶圆的盲孔;在暴露的表面上形成第三氧化层;生长掺杂的多晶锗硅层;进行研磨直到露出上部硅层;沉积合金层并形成合金层图案;对MEMS硅晶圆的隔离凹槽上方的上部硅层进行刻蚀;在目标晶圆形成有处于金属互连层的金属互连;使MEMS硅晶圆与目标晶圆相对并接触,使得合金部分接触重布线层;将MEMS硅晶圆的相对面减薄,暴露所述多晶

硅通孔的形成方法.pdf
本发明提供一种硅通孔的形成方法,包括:提供衬底;在所述衬底上形成通孔;在所述通孔中填充金属层;进行第一平坦化处理,去除衬底上方的金属层,保留通孔中的金属层;在所述衬底和金属层上覆盖应力层,所述应力层用于提供压应力;对所述金属层进行再结晶处理;进行第二平坦化处理,去除衬底上方的应力层。其中,在第一平坦化处理之后,对所述金属层进行再结晶处理之前,在所述衬底和金属层上覆盖应力层,所述应力层能够提供压应力,提高金属原子向金属层表面扩散所需要的能量,从而降低金属原子向金属层表面扩散的扩散率,进而降低金属层内的空洞率

具有多晶硅层的晶圆的处理方法及其系统.pdf
本发明提供一种用于处理具有多晶硅层的晶圆的方法。该晶圆装载在处理系统上。该处理系统包括研磨模块和连接研磨模块的清洁模块。研磨模块包括至少第一研磨盘和第二研磨盘。第一研磨盘和第二研磨盘中的每一个均包括用于研磨晶圆的研磨垫。将研磨浆施加到研磨模块的第一研磨盘上以进行多晶硅层的平坦化。在平坦化后,通过非离子表面活性剂溶液处理表面多晶硅层,使其表面性质改变为亲水性。在后CMP清洗工艺中,可以通过氟化氢溶液和SC1溶液轻松去除多晶硅层表面上的有机污染物,而无需额外的硫酸清洗工艺。

非晶硅的应用、晶圆上芯片的形成方法及晶圆上芯片.pdf
本发明涉及一种非晶硅在晶圆上芯片中作为芯片之间填充材料的应用、晶圆上芯片的形成方法及晶圆上芯片。其中,晶圆上芯片的形成方法,包括以下步骤:提供待接合的晶圆以及多个芯片;执行接合工艺,在所述晶圆之上接合所述多个芯片且在所述多个芯片之间形成间隙;执行间隙填充工艺,以非晶硅作为填充材料填充所述间隙并覆盖所述芯片的表面;执行化学机械研磨工艺,以露出所述芯片的表面。采用非晶硅作为填充材料填充至各芯片之间的间隙中,由于非晶硅与作为芯片基材的硅的材质相近,在后续利用化学机械研磨工艺进行减薄的过程中,可以降低化学机械研磨

美国多晶硅-单晶硅-硅晶圆市场研究.docx
美国多晶硅-单晶硅-硅晶圆市场研究随着可再生能源的需求不断增长,太阳能技术的发展已成为全球关注的焦点之一。而作为太阳能电池制造的关键材料,硅晶圆的供应也日益重要。本文将以美国市场为例,分析该国多晶硅、单晶硅以及硅晶圆市场的情况。一、多晶硅市场多晶硅是太阳能电池制造过程中最主要的原材料之一,其市场需求随着太阳能产业的发展呈现增长态势。根据市场研究机构的数据,全球多晶硅市场规模在未来几年内将以年复合增长率5%的速度增长。目前,全球多晶硅市场主要由中国、美国、德国等国家供给。在美国市场上,多晶硅的主要供应商包括
