
低电感轻薄型功率模块.pdf

努力****采萍







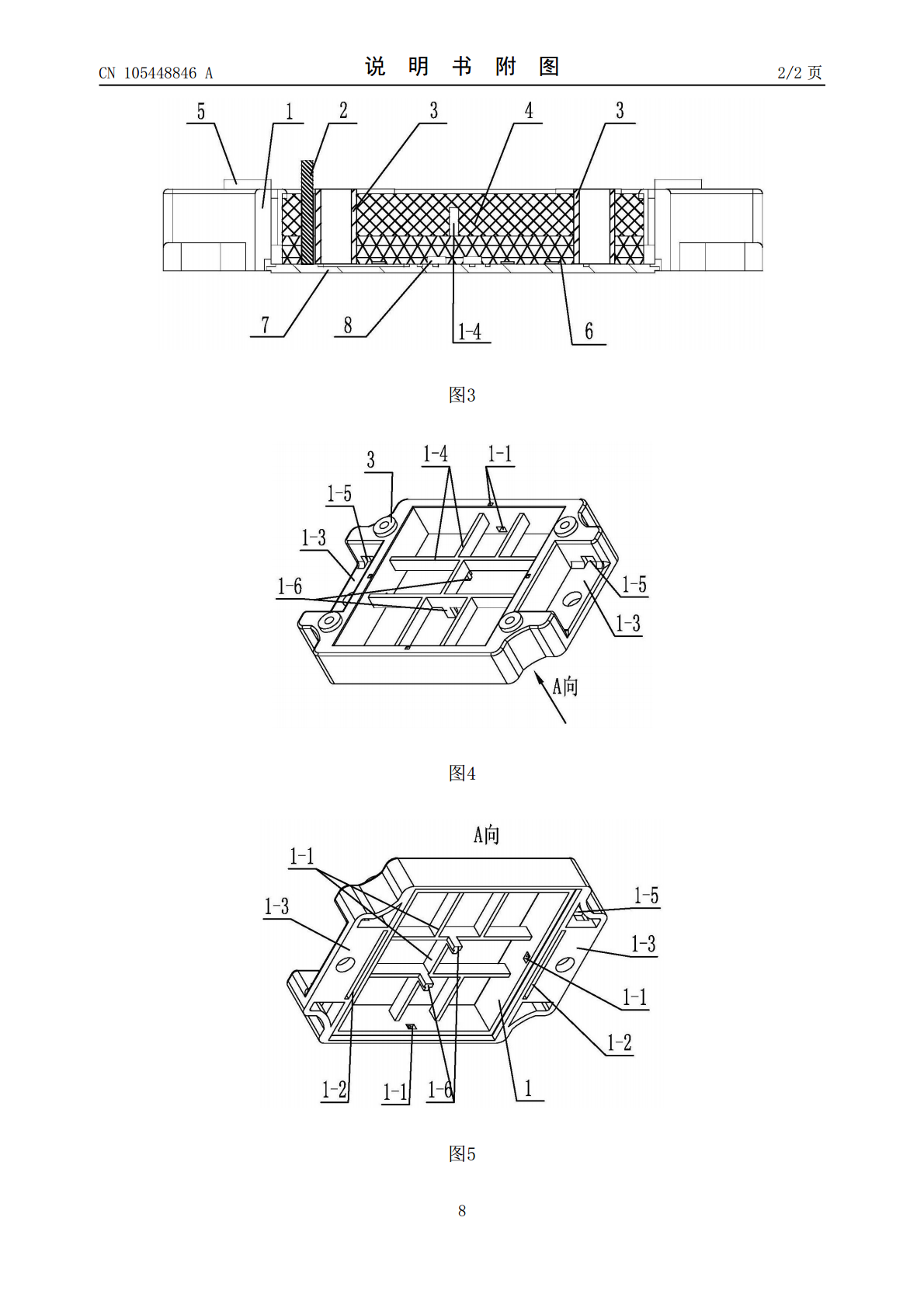
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

低电感轻薄型功率模块.pdf
本发明涉及一种低电感轻薄型功率模块,包括外壳,焊接在覆金属陶瓷基板上的半导体芯片、功率端子及控制端子构成的电路,功率端子为内孔设有螺纹的圆柱体,圆柱体的底部固定在覆金属陶瓷基板上;外壳的壳壁内设有横向和纵向相交的挡条,挡条下部设有至少一个限位柱,覆金属陶瓷基板连接在外壳底部,挡条上的限位柱顶在覆金属陶瓷基板上,外壳内注有软的硅凝胶层,外壳在壳壁四周设有的通孔用于硅凝胶层膨胀及收缩时所产生应力释放,各功率端子和各控制端子穿过硅凝胶层,环氧树脂层与外壳、外壳内的挡条以及各功率端子和各控制端子固化成整体结构。本

一种低寄生电感的Si-SiC功率集成模块.pdf
本发明公开了一种低寄生电感的Si‑SiC功率集成模块,其电路结构包括三相逆变电路、制动电路和三相整流电路。具体组成包括硅基IGBT芯片、碳化硅SBD芯片、硅基FRD芯片、硅基整流二极管芯片、覆铜陶瓷基板、焊料层、键合引线、铜垫片、引脚电极等。本发明的三相逆变电路采用三组直流母线引脚电极分别连接上桥臂各相的集电极,保证三相功率换流回路寄生电感较低并且满足三相均衡工作的要求。制动电路中IGBT芯片的栅极放置在靠近覆铜陶瓷基板边缘引线框架位置,并采用局部双层基板结构,即用铜片代替制动电路发射极键合线的方式,减小

具有降低的固有电感的功率模块.pdf
本发明涉及一种具有降低的固有电感的功率模块(1),包括至少部分电绝缘层(3),绝缘层(3)具有第一侧(3a)和与第一侧(3a)相对的第二侧(3b),第一侧(3a)上布置有功率电子单元(2),补偿层(10)布置在第二侧(3b)上,补偿层是导电的,并且电势可以被施加到补偿层。本发明还涉及一种用于生产功率模块的方法,功率模块优选如以上所描述的功率模块。

寄生电感的抑制结构及方法、功率电路模块.pdf
本发明提供了一种寄生电感的抑制结构、一种功率电路模块,以及一种抑制寄生电感的方法。所述抑制结构包括:第一抑制片,由导电材料制成,覆盖功率电路的第一表面;第二抑制片,由导电材料制成,覆盖所述功率电路的第二表面,其中,所述第一表面与所述第二表面位于所述功率电路的相反方向;以及至少一个解耦电容,其第一端连接所述第一抑制片,而其第二端连接所述第二抑制片,用于在所述功率电路运行时从所述第一抑制片及所述第二抑制片吸收与所述功率电路的工作电流反向的感应电流。

双电感型脉冲电源模块负载电流的研究.docx
双电感型脉冲电源模块负载电流的研究双电感型脉冲电源模块是一种常见的电源模块,其负载电流具有重要的研究意义。本文将探讨双电感型脉冲电源模块负载电流的特点、对电路性能的影响,以及提高其电路性能的方法。一、双电感型脉冲电源模块负载电流的特点双电感型脉冲电源模块的主要特点是输出电流具有脉冲状波形,且在输出电流变化过程中会出现较大的瞬态电压。此外,其输出电流与负载部分电路的参数、工作状态等密切相关。因此,了解双电感型脉冲电源模块的特点非常重要,对其应用和改进具有重要的指导意义。二、双电感型脉冲电源模块负载电流对电路
