
深槽隔离结构的制造方法.pdf

Jo****63




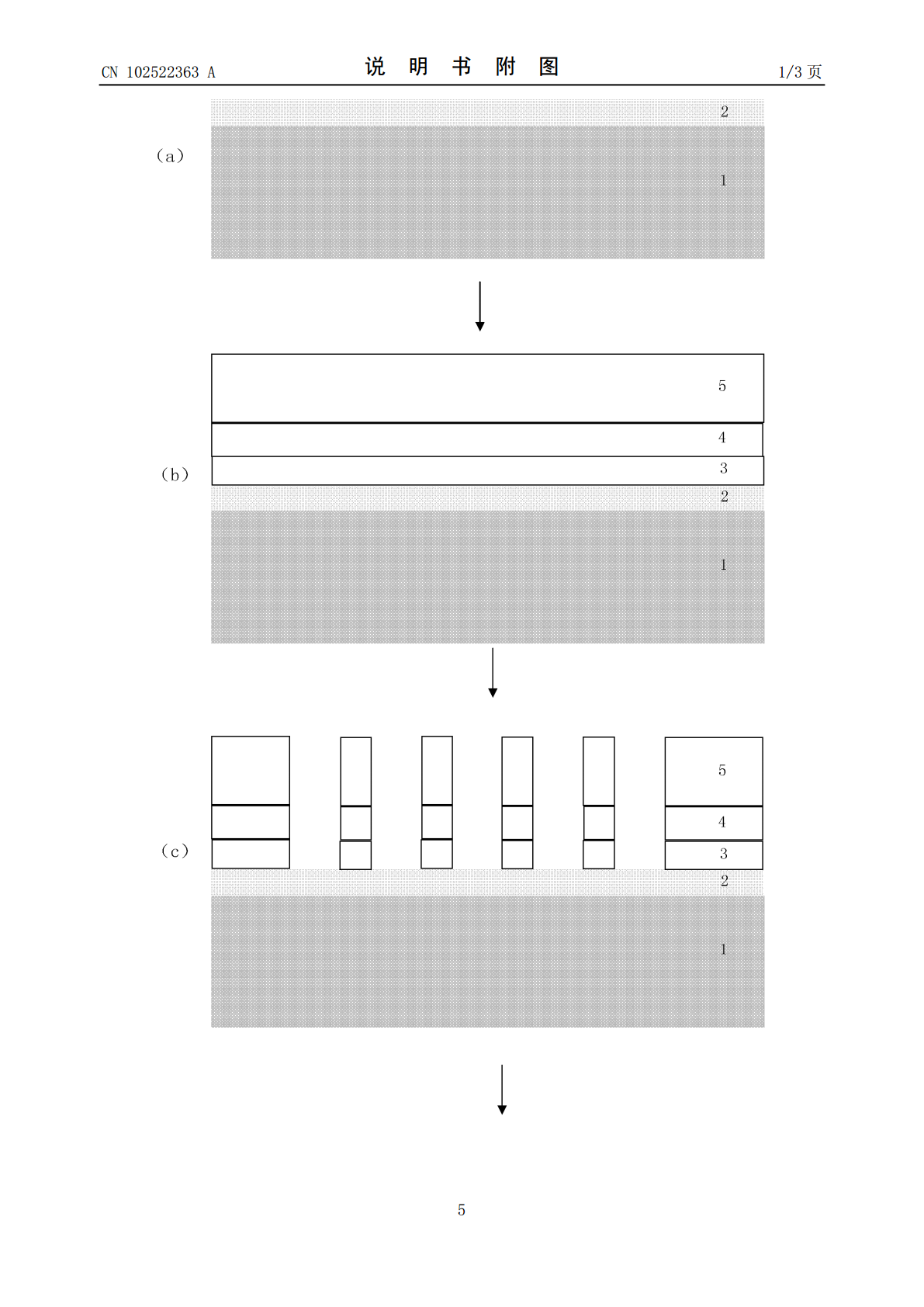
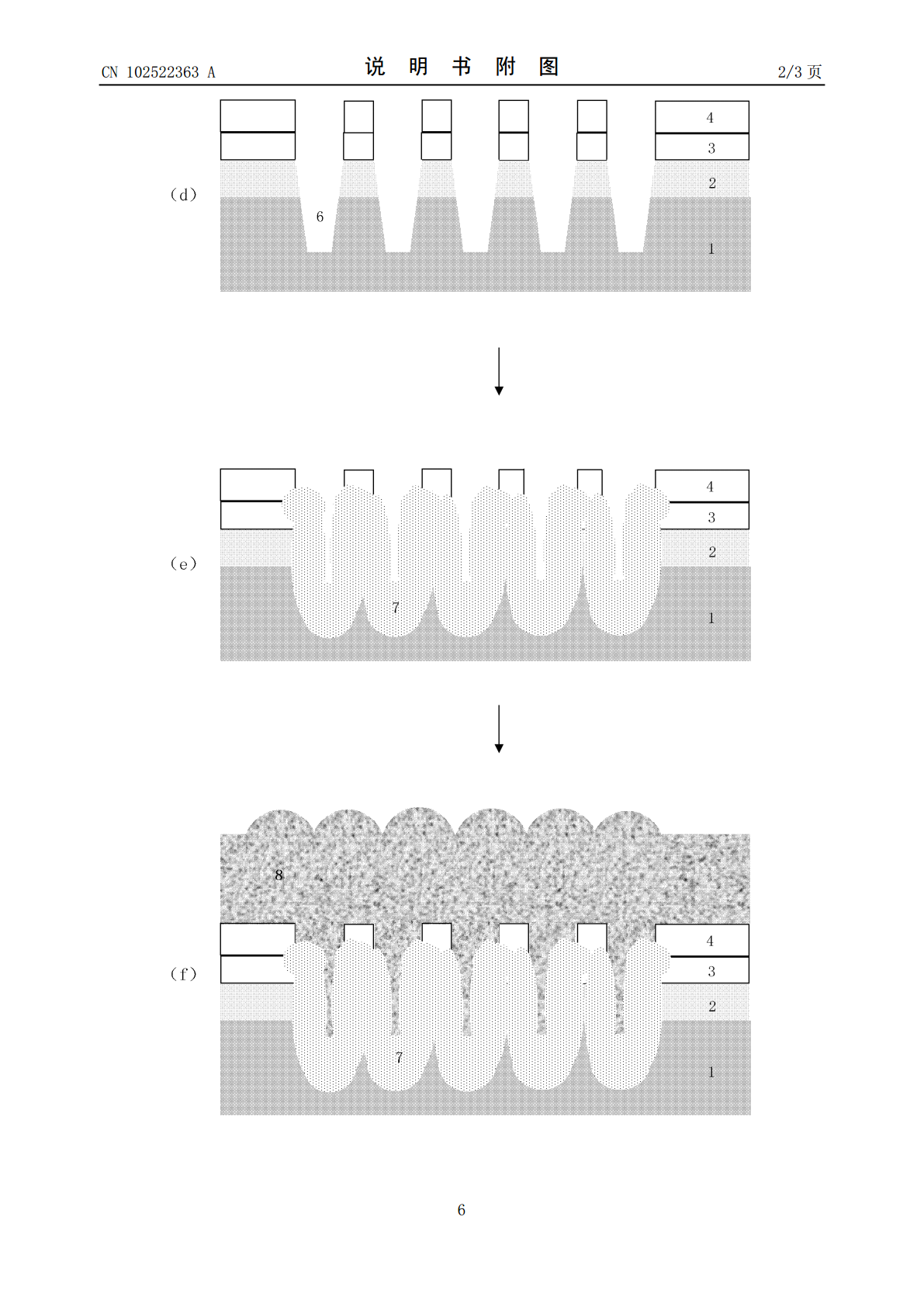
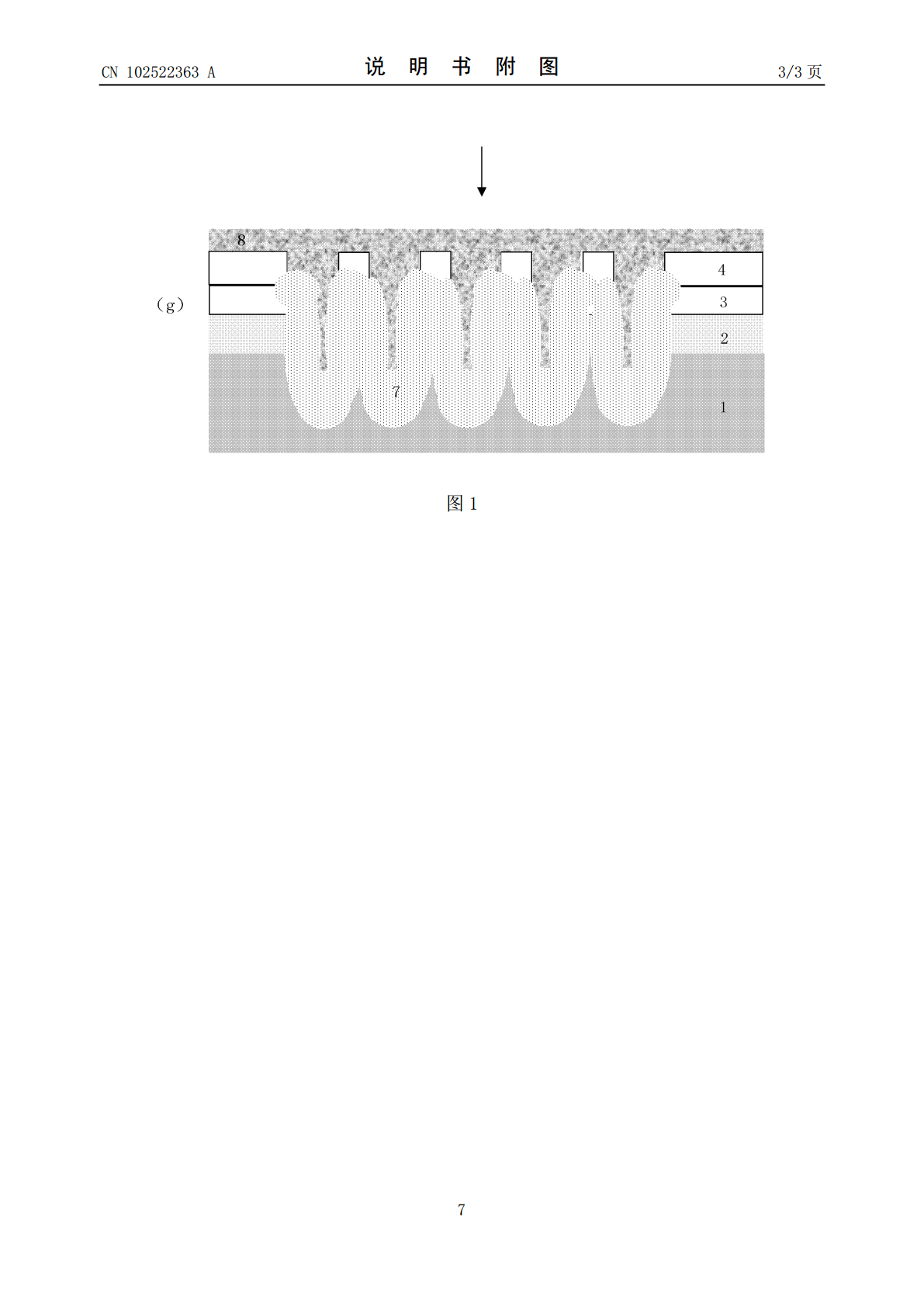
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

深槽隔离结构的制造方法.pdf
本发明公开了一种深槽隔离结构的制造方法,该方法在成长外延层后,按照以下步骤制造深槽隔离结构:1)炉管成长二氧化硅和氮化硅,再在氮化硅上淀积二氧化硅;2)曝光显影,干法刻蚀打开要刻蚀深槽的区域;3)以步骤1)形成的二氧化硅-氮化硅-二氧化硅作为刻蚀阻挡层,干法刻蚀形成深槽;4)再次炉管氧化,成长二氧化硅,将深槽隔离区域的氮化硅下方的硅全部氧化;5)淀积二氧化硅,封住深槽开口;6)深槽表面平坦化。该方法通过深沟槽刻蚀和氧化技术,形成超厚场氧化隔离层,同时利用氮化硅作为平坦化的阻挡层,从而不仅达到了隔离的效果,

一种深槽隔离结构的制造方法.pdf
本发明提供了一种深槽隔离结构的制造方法,包括提供半导体基底,所述半导体基底中形成有浅沟槽隔离结构和栅极;形成第一介质层,所述第一介质层覆盖所述半导体基底、所述浅沟槽隔离结构和所述栅极,所述第一介质层的厚度大于目标侧墙厚度;形成一开口,所述开口贯穿所述第一介质层及所述浅沟槽隔离结构,并露出所述半导体基底;以所述第一介质层为掩膜,在所述开口中刻蚀所述半导体基底以形成深槽;去除所述半导体基底表面、所述浅沟槽隔离结构表面和所述栅极顶面的第一介质层,保留所述栅极侧壁的第一介质层,形成侧墙结构,所述侧墙的厚度为所述目

深槽隔离工艺方法.pdf
本发明公开了一种深槽隔离工艺方法,包含:在半导体衬底表面依次形成一层氧化硅层及一层氮化硅层;通过光刻胶定义,对氮化硅层及氧化硅层进行刻蚀,打开欲形成深沟槽的区域,向下刻蚀形成一定深度的沟槽;在沟槽内形成衬垫氧化层,然后填充多晶硅;回刻多晶硅;进行炉管氧化形成氧化硅层;去除氧化硅层及氮化硅层;进行外延生长;形成氧化硅层,然后填充多晶硅;对外延表面的多晶硅以及深沟槽内的多晶硅进行回刻;刻蚀去除外延表面的氧化硅层。本发明工艺方法,在外延淀积工艺前先形成一部分深度的沟槽,再利用外延淀积工艺选择性生长的特性,形成后

浅槽隔离结构的制备方法、浅槽隔离结构和半导体结构.pdf
本申请实施例提供了一种浅槽隔离结构的制备方法、浅槽隔离结构和半导体结构,该浅槽隔离结构的制备方法包括:提供基底,于基底上形成多个第一沟槽,且第一沟槽的剖面宽度沿垂直方向向下呈增大趋势;于基底的顶部和多个第一沟槽的内侧通过沉积工艺形成连续的第一隔离层,且第一隔离层位于第一沟槽内的部分形成第二沟槽;第二沟槽的剖面宽度沿垂直方向向下保持不变;于第一隔离层的表面通过ISSG工艺形成连续的第二隔离层,且第二隔离层位于第二沟槽内的部分将第二沟槽完全填满。这样,由于第一沟槽的剖面宽度沿垂直方向向下呈增大趋势,可以直接对

CMOS光学传感器的深槽隔离结构及形成方法.pdf
本发明公开了一种CMOS光学传感器的深槽隔离结构,包含:提供一半导体基底,所述基底中形成有光电二极管;所述的深槽隔离结构位于半导体基底中,形成一个个深槽构成阵列,所述光电二极管均位于深槽隔离的下方,每个深槽隔离形成一个像素子单元;深槽隔离的上方具有开口;所述的深槽隔离为空气隔离,深槽的侧壁为充满空气的一圈薄壁空间。本发明通过空气隔离(Air‑gap)的方式将原本需要介质填充的深沟槽结构提前封闭,而使空气保留其中,从而在像素单元周围形成一周气隙,使大角度入射光发生全反射,光线被局限在介质与气隙界面间,从而达
