
自对准接触孔的工艺方法.pdf

宜欣****外呢




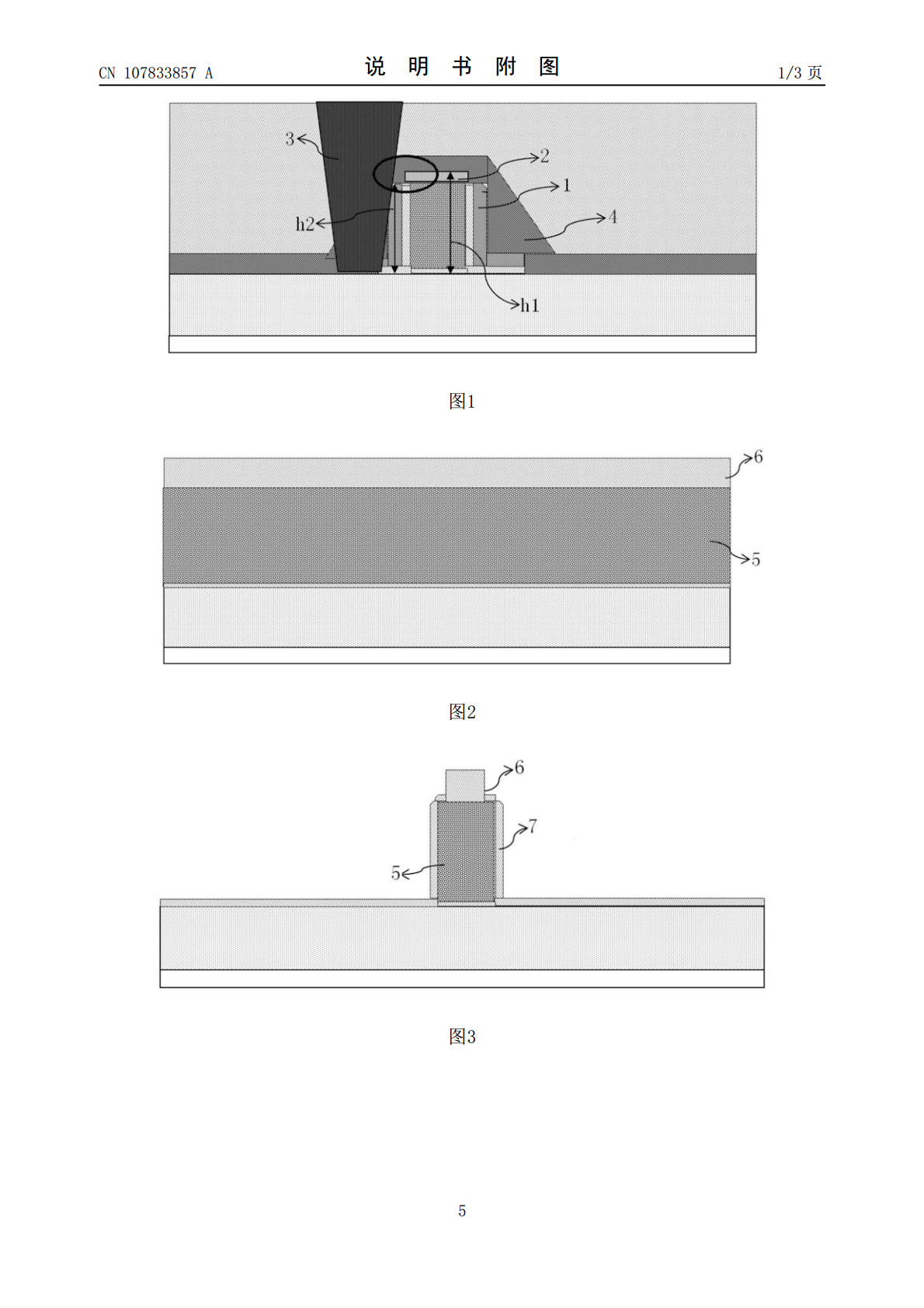
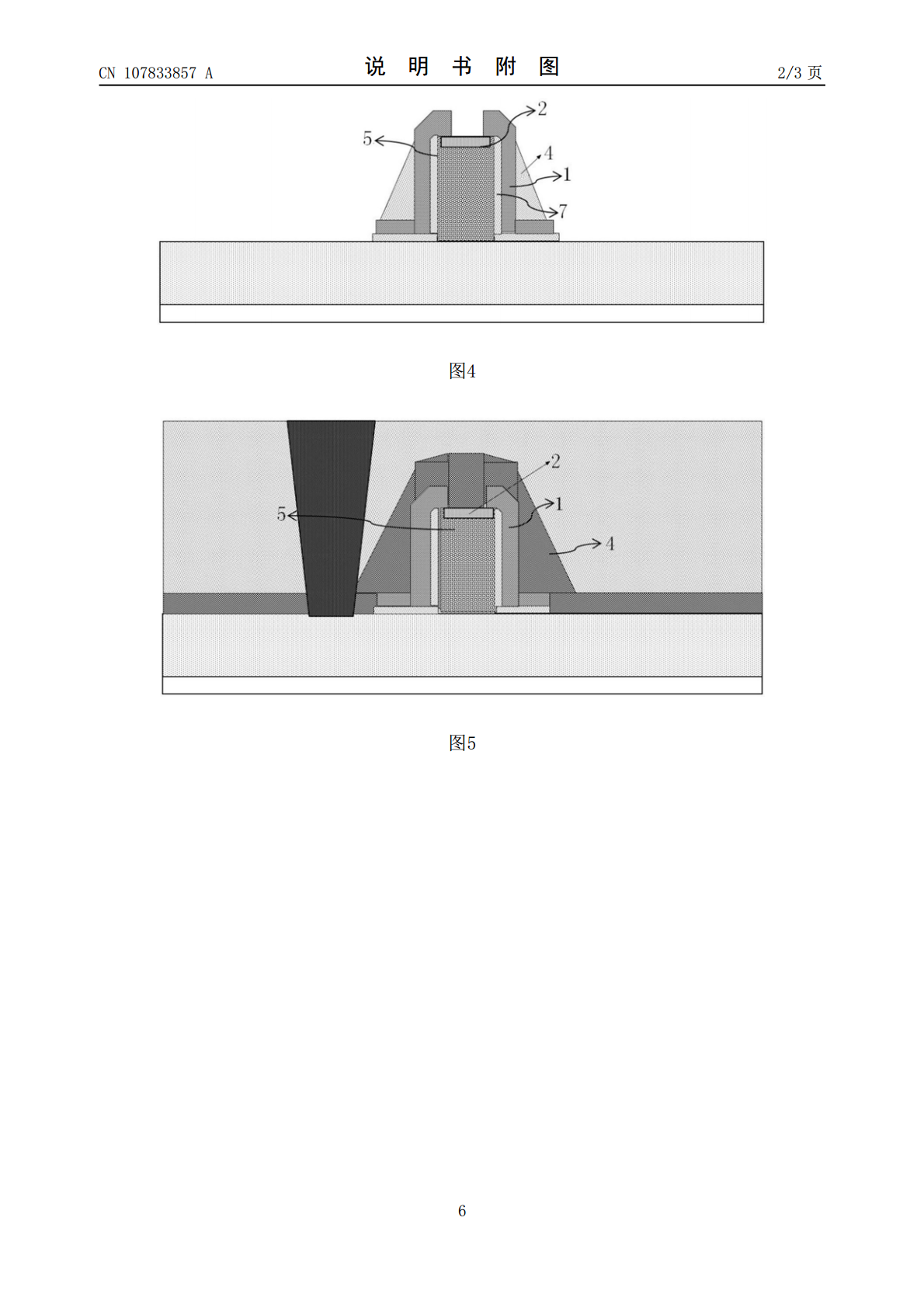

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

自对准接触孔的工艺方法.pdf
本发明公开了一种自对准接触孔的工艺方法,包含:步骤一,在硅衬底上形成一层多晶硅,然后再形成一层氮氧化硅;步骤二,利用栅极层次的光罩形成光刻胶图形;然后对氮氧化硅及多晶硅进行刻蚀,形成晶体管的栅极;再对栅极上的氮氧化硅进行回刻蚀;对栅极进行快速热退火或炉管,从而形成栅极二氧化硅保护层;步骤三,沉积氮化硅和二氧化硅;并对硅片进行普遍刻蚀,从而形成栅极侧墙;再刻蚀掉栅极侧墙上和栅极顶部的氮氧化硅;进行源漏区注入及形成钴硅合金;步骤四,形成刻蚀阻挡层和接触孔介质层,进行化学机械研磨,进行接触孔刻蚀。本发明有更高的

自对准接触孔的制备方法.pdf
本发明提供一种自对准接触孔的制备方法,在自对准接触孔工艺的刻蚀、干法去胶以湿法清洗等各个阶段过程中均实施了对聚合物分布情况的监测和控制,并将收集的前一步骤后的聚合物分布情况反馈到后一步骤中的工艺配方中,从而使得后一步骤中具有较高的去除率/刻蚀率、良好的去除均匀性、可控的开口和接触孔侧壁形貌和特征尺寸以及较少的下层膜层的损伤等,大大改善了所述后一步骤后的工艺效果,进而可以保证自对准接触孔刻蚀的均一性,避免晶圆边缘区域的自对准接触孔中的聚合物残留过多,提高器件的电学性能和良率。

改善SONOS器件自对准接触孔漏电的方法.pdf
本发明公开了一种改善SONOS器件自对准接触孔漏电的方法,包括:1)进行SONOS器件自对准接触孔刻蚀;2)在接触孔的侧壁和底部以及SONOS器件中的未掺杂氧化膜上方,成长氮化硅膜;3)刻蚀氮化硅膜,使只在接触孔侧壁上保留氮化硅膜;4)用传统湿法流程清洗去除刻蚀产生的聚合物,得到SONOS器件自对准接触孔。本发明可以弥补常规自对准接触孔刻蚀中造成的栅极上侧墙的过度损耗,能够明显增加氮化硅膜侧墙残留的厚度,避免栅极与金属线短路,改善产品的自对准接触孔漏电,提高接触孔击穿电压,扩大SONOS器件自对准接触孔刻

自对准形成接触孔的方法、器件的制备方法、器件及设备.pdf
本发明提供了一种自对准形成接触孔的方法,包括在衬底上形成若干第一凹槽;在每个所述第一凹槽中依次生成栅极氧化层以及屏蔽栅,并在屏蔽栅的顶部形成栅间氧化层,然后在第一凹槽内填充栅极材料;对填充的栅极材料进行刻蚀,以去除部分栅极材料,形成栅极空腔,第一凹槽中剩余的栅极材料形成栅极;并刻蚀掉所述栅极空腔周围的衬底和栅极氧化层以形成衬底空腔,栅极空腔和衬底空腔构成栅极帽空腔;形成源区\阱区;在栅极帽空腔中填充层间介质层,以形成栅极帽;以栅极帽为掩膜选择性刻蚀所述源区\阱区,形成接触孔。解决了刻蚀的接触孔同栅极之间的

具有自对准接触孔与硅化物的器件及其制造方法.pdf
本申请公开了一种具有自对准接触孔与硅化物的器件,自对准接触孔的底部直接与硅接触,常规接触孔底部直接与硅化物接触。其制造方法为:在硅片上划分出采用自对准接触孔刻蚀工艺的第一区域和不采用自对准接触孔刻蚀工艺的第二区域。在硅片上淀积用于形成硅化物的金属之前,先在第一区域之上完整覆盖介质保护层。然后形成硅化物。接着去除残留的金属、以及第一区域的介质保护层。最后淀积金属前介质,并在第一区域以自对准刻蚀工艺、在第二区域以常规刻蚀工艺分别形成接触孔。本申请兼顾了自对准接触孔与硅化物两者的优势,又避免了两者所各自存在的缺
