
一种改善薄膜沉积均匀度的方法.pdf

永香****能手







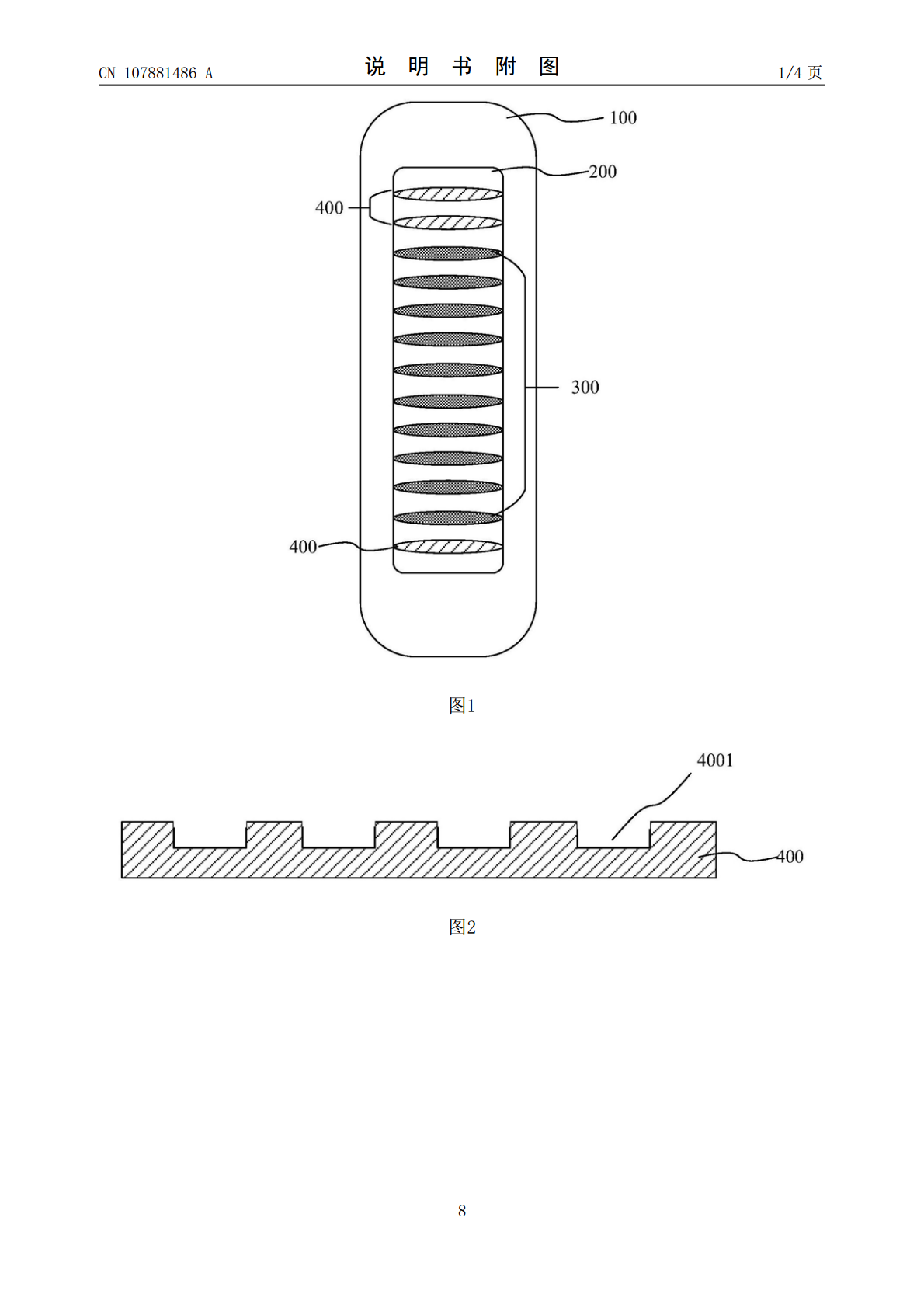
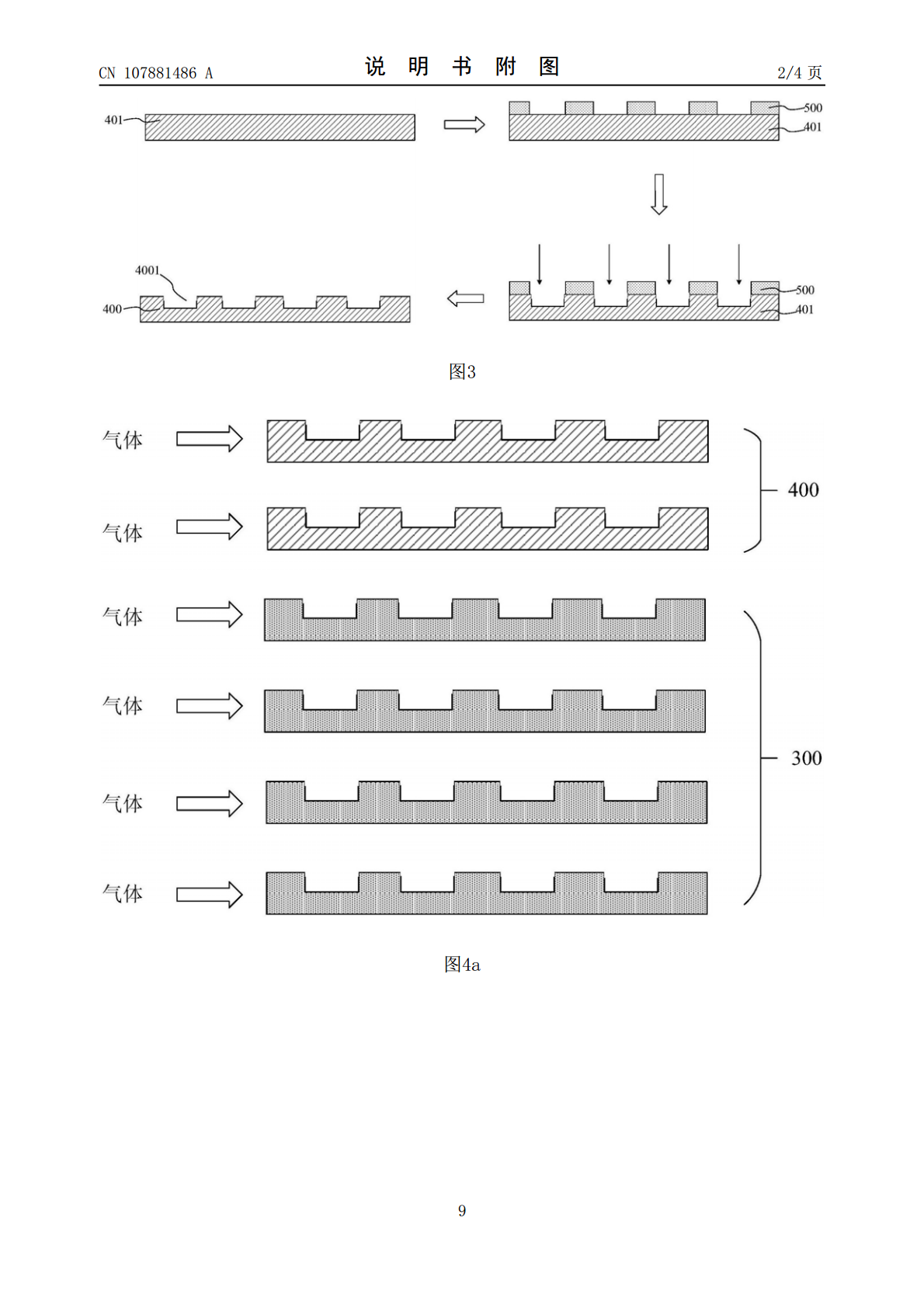
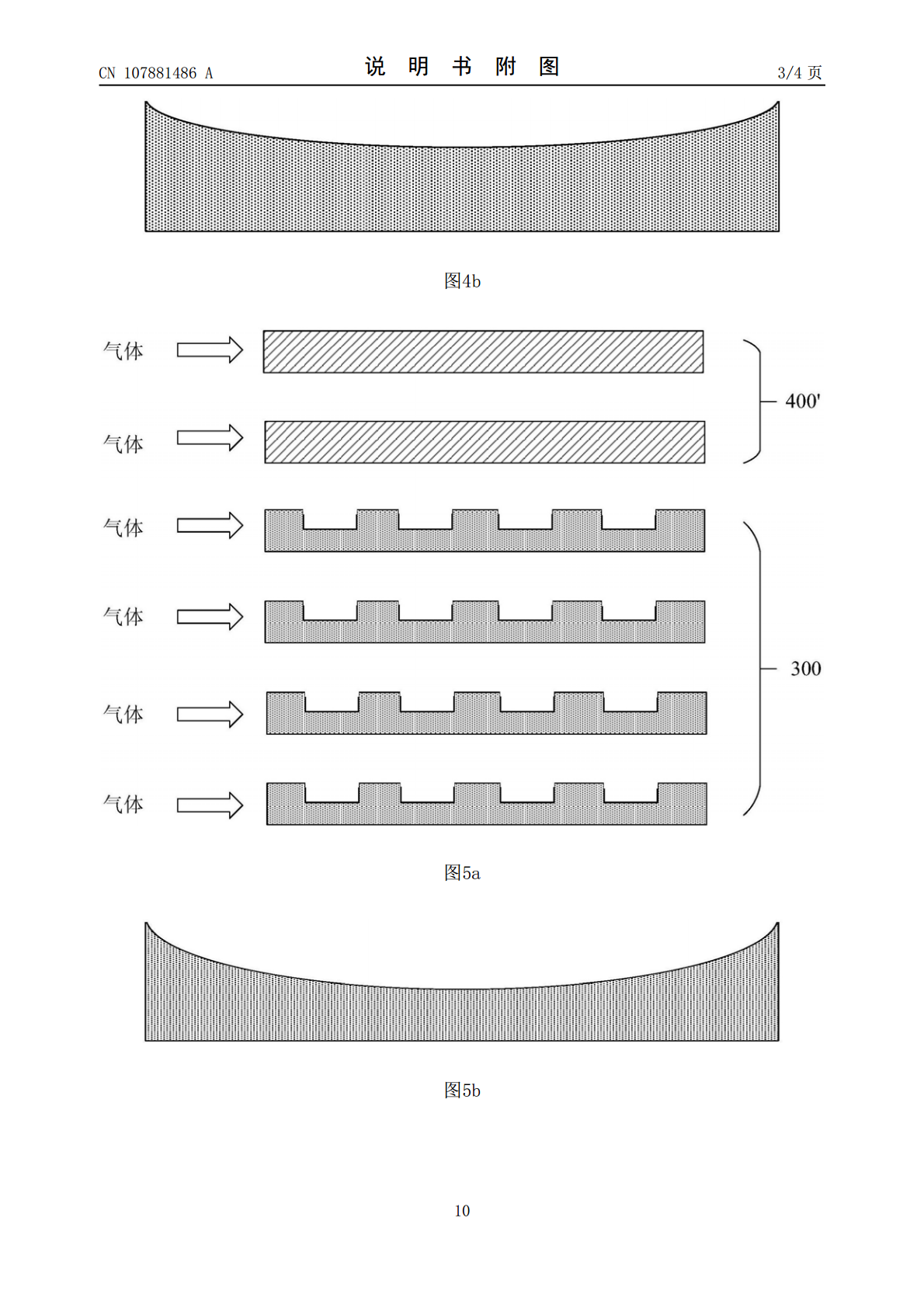
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种改善薄膜沉积均匀度的方法.pdf
本发明提供一种改善薄膜沉积均匀度的方法,该方法包括如下步骤:采用晶舟承载多片晶圆;所述晶舟具有头部和尾部,多片晶圆排列放置于晶舟的头部和尾部之间;在多片晶圆与晶舟头部,和/或在多片晶圆与晶舟尾部之间放置档控片;将承载有晶圆和档控片的晶舟置于反应炉管中并进行薄膜沉积;其中,所述档控片具有非平坦的表面结构。本发明导入具有非平坦表面结构的挡控片取代现有技术中的平坦的挡控片,藉由增加挡控片吸附面积增加吸附气体能力,可有效地降低临近挡控片产品边缘厚度,从而可有效改善芯片膜厚均匀度,平滑晶舟位置边缘良率损失的曲线以提

一种薄膜沉积方法和沉积薄膜.pdf
本发明提供了一种薄膜沉积方法,包括:载入承载有晶圆的晶舟至低压化学气相沉积炉内;预先加热晶圆,对低压化学气相沉积炉进行第一升温操作,在预热升温斜率下达到第一反应温度;形成薄膜于晶圆上,包含在低压化学气相沉积炉内导入反应气体、进行化学反应并沉积在晶圆的基板表面,在沉积过程时,对低压化学气相沉积炉内的温度进行在緩升/降温斜率下至少一段的緩升/降温反应操作,以使薄膜在晶圆上的中央区域与周边区域具有一致的沉积厚度;及在冷却降温斜率下冷却晶圆。本发明通过控制沉积过程中缓升/降温斜率,可改变晶圆从中央区域到周边区域的

薄膜沉积设备及薄膜沉积方法.pdf
本发明公开了一种薄膜沉积设备及薄膜沉积方法。该薄膜沉积设备包括一薄膜沉积腔,该薄膜沉积腔包括:腔体外壳,腔体外壳围成薄膜沉积腔的腔体;靶材托架,设置于腔体的中部,用于放置由组分A构成的靶材;基片台,设置于腔体中部,与靶材托架相对设置;激光入射口,设置于腔体外壳的侧面,与并靶材托架倾斜相对,用于入射激光以轰击靶材托架上的靶材产生等离子体羽辉;束源炉接口,设置于腔体外壳的侧面并与基片台倾斜相对,用于入射由组分B构成的分子束流;激光入射口与束源炉接口同时入射激光和分子束流。本发明能够有效避免脉冲激光沉积成膜过程

一种沉积炉管及沉积薄膜的方法.pdf
本发明公开了一种沉积炉管及沉积薄膜的方法,其中沉积炉管包括:炉体、气体反应腔、通气管道、抽气泵、温度控制器和晶舟,所述通气管道贯穿于气体反应腔,且所述通气管道上有至少两个通气孔。通过本发明的方案,由于通气管道贯穿于气体反应腔,且通气管道上开有至少两个通气孔,因此,在保持炉体内温度相同的情况下,利用所述通气管道向沉积炉管输送反应气体时,保证了气体反应腔内各个区域气流的相对平衡、气体浓度的相对均衡,进而使得晶圆表面沉积的薄膜厚度相同的同时,薄膜性质是一致的,提高了产品的良率。

一种多功能的离子沉积薄膜制备装置及薄膜沉积方法.pdf
本发明实施例公开了一种多功能的离子沉积薄膜制备装置及薄膜沉积方法,包括薄膜生长机构,进样承载机构,离子源提供机构、分子束外延机构和化学气相沉积机构;进样承载机构用于向薄膜生长机构中提供样品;离子源提供机构提供经过筛分后的待沉积离子,用于离子沉积;分子束外延机构产生分子束流,用于分子束外延生长;化学气相沉积机构产生气态物质,用于化学气相沉积。通过离子源提供机构、分子束外延机构和化学气相沉积机构的协同配合,一次操作过程中可完成分子束外延、化学气相沉积、离子沉积等多种薄膜制备功能,实现电中性分子和带电离子的共沉
