
一种优化分子束外延薄膜均匀性的方法.pdf

一只****签网








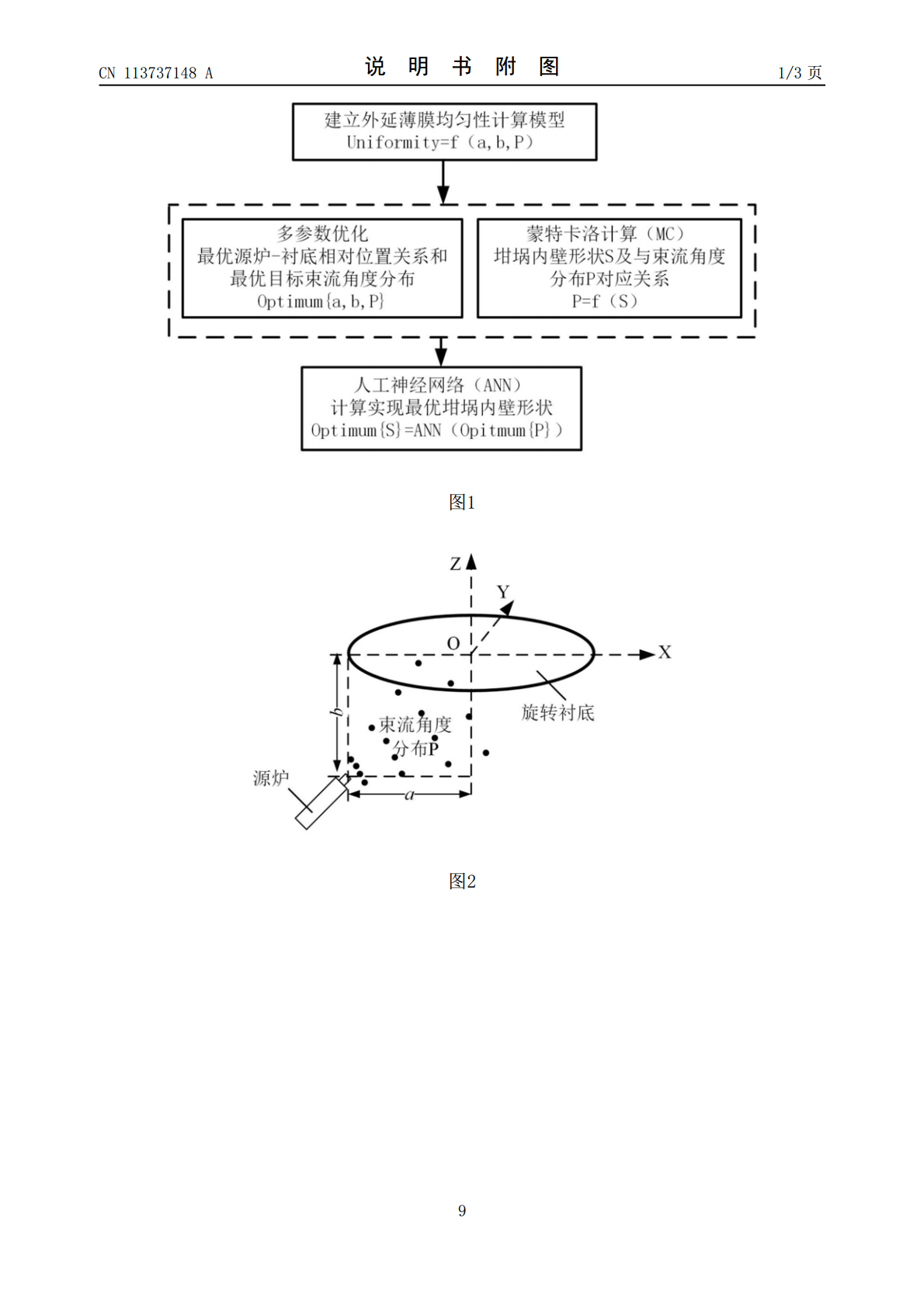
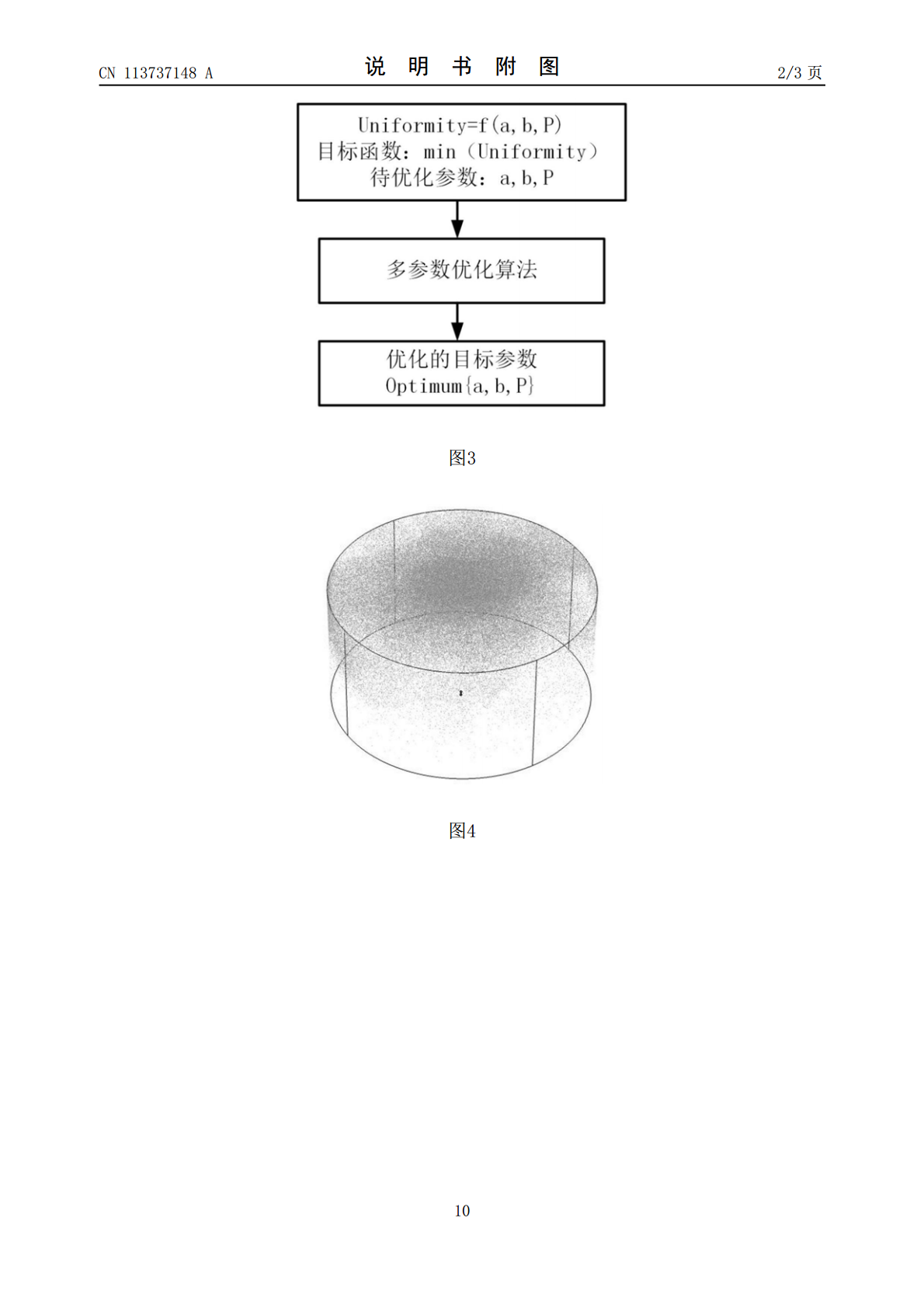
亲,该文档总共11页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种优化分子束外延薄膜均匀性的方法.pdf
本发明属于半导体薄膜生长技术领域,公开了一种优化分子束外延薄膜均匀性的方法,包括基于源炉‑衬底相对位置信息和源炉束流角度分布信息建立外延薄膜均匀性模型;针对外延薄膜均匀性模型,采用多参数优化方法计算得到外延薄膜均匀性最优时对应的最优目标参数;采用蒙特卡洛方计算得到源炉内坩埚的内壁形状与源炉束流角度分布之间的关系式;根据最优源炉束流角度分布参数和上述关系式计算得到源炉内坩埚最优的内壁形状参数;将最优源炉‑衬底相对位置参数和源炉内坩埚最优的内壁形状参数作为最优装备参数,基于最优装备参数进行分子束外延装备的设计

优化薄膜外延生长均匀性的装置、方法及外延生长设备.pdf
本发明公开了一种优化薄膜外延生长均匀性的装置、方法及外延生长设备。所述方法包括:使承载衬底的托盘同时绕第一轴线和第二轴线做圆周运动,以使所述衬底上任一点沿一非圆形轨迹做摆线运动,从而使沉积到衬底表面不同位置的原料的量相同,其中,所述第一轴线为托盘自身轴线,所述第二轴线与第一轴线相互平行且不重合。本发明通过使衬底表面点做摆线运动,使衬底表面点可经过更多的路径以覆盖到更大的源炉束流的入射区域,源炉到衬底表面不同位置的入射距离多次取均值后基本保持恒定,从而使衬底表面不同位置的入射通量基本相同,进而提高了薄膜生长

一种类分子束外延设备及薄膜制备方法.pdf
本发明为一种类分子束外延设备,包括:反应腔体、束源炉、加热装置、气体离化装置、样品台装置、真空系统;其中,气体离化装置为电容耦合等离子源;气体离化装置包括上极板和下极板,其中一极板与外部射频源连接,另一极板接地;束源炉具有金属蒸发区;上极板和下极板之间具有等离子体产生区;金属蒸发区与等离子体产生区在空间上相分离。

分子束外延生长GaN薄膜的新方法.docx
分子束外延生长GaN薄膜的新方法随着半导体行业的发展,氮化镓(GaN)材料在LED、LD、功率电子器件等领域的应用越来越广泛。而氮化镓生长的方法中,分子束外延生长(MBE)作为一种高效、高性能、可控性高的生长方法,也因此备受青睐。但是,传统的MBE生长方式存在着很多问题,如生长速度过慢、包含杂质的成膜率高,提高成品率和降低成本的难度大等等。针对这些问题,研究人员进行了大量的研究,提出了一系列新的方法,以期能够得到更好的GaN薄膜生长效果。一、使用非晶态氮载体非晶态氮载体是近年来出现的一种新的MBE生长方法

一种提高薄膜生长外延片均匀性的方法.pdf
一种提高薄膜生长外延片均匀性的方法,包括以下步骤:选取衬底,该衬底的规格尺寸大于等于预生长外延片的规格尺寸;设置一个环结构件,该环结构件的内径尺寸大小等于衬底的规格尺寸,环结构件的厚度与衬底的厚度可以相等或者不相等;将衬底放置入环结构件中,环结构件将衬底的边缘全部包围连成一个连续的生长区域;将衬底及环结构放置在生长室中进行生长,使得衬底上生长出预设规格结构的薄膜外延片;生长完成后,将环结构件取出,烘烤、清洗干净留待下次使用。本发明利用环结构件降低由于衬底边界条件带来的不利影响,最终获得均匀性很好的外延片。
