
一种用于覆晶封装芯片的凸块结构.pdf

Ch****49






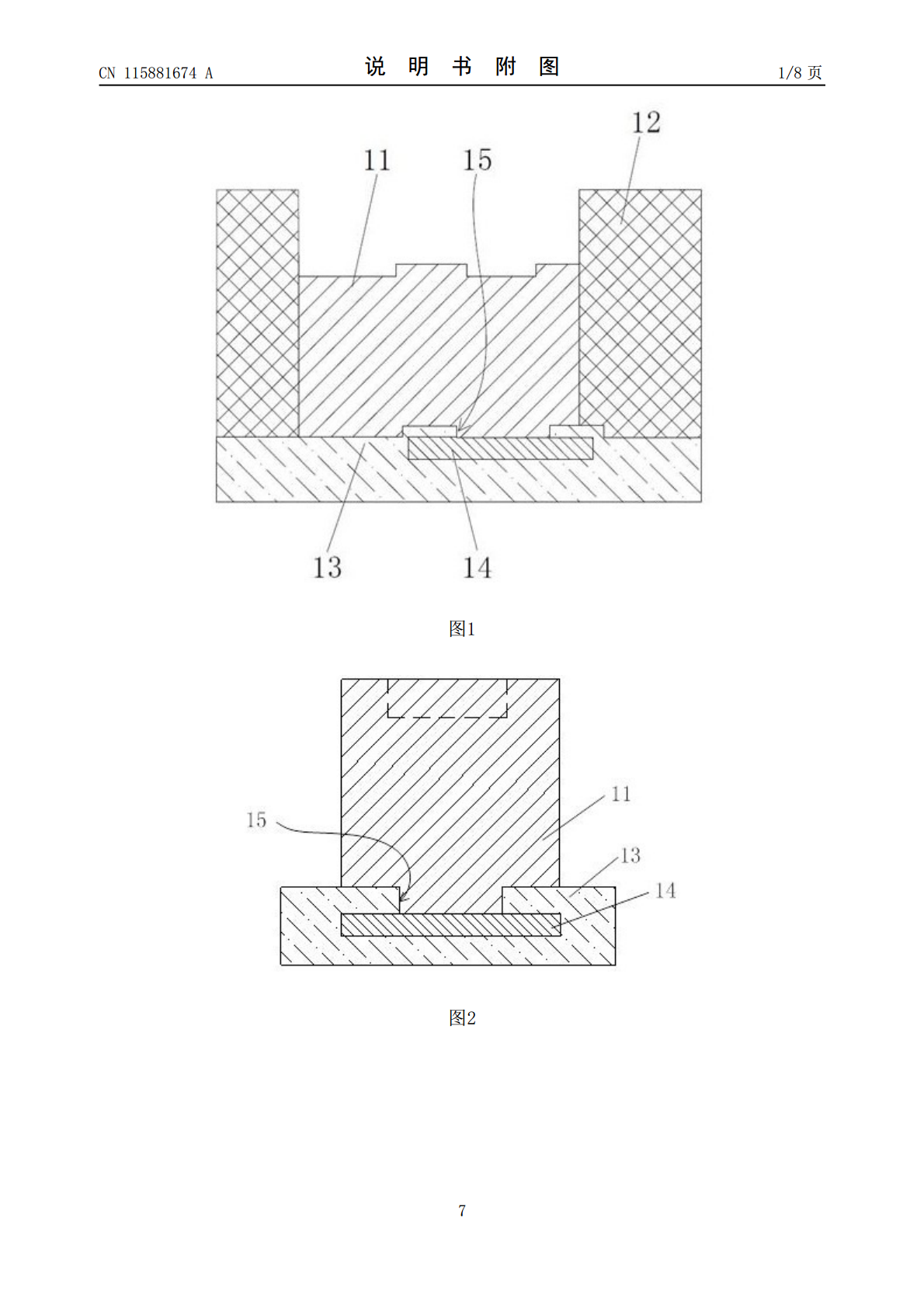
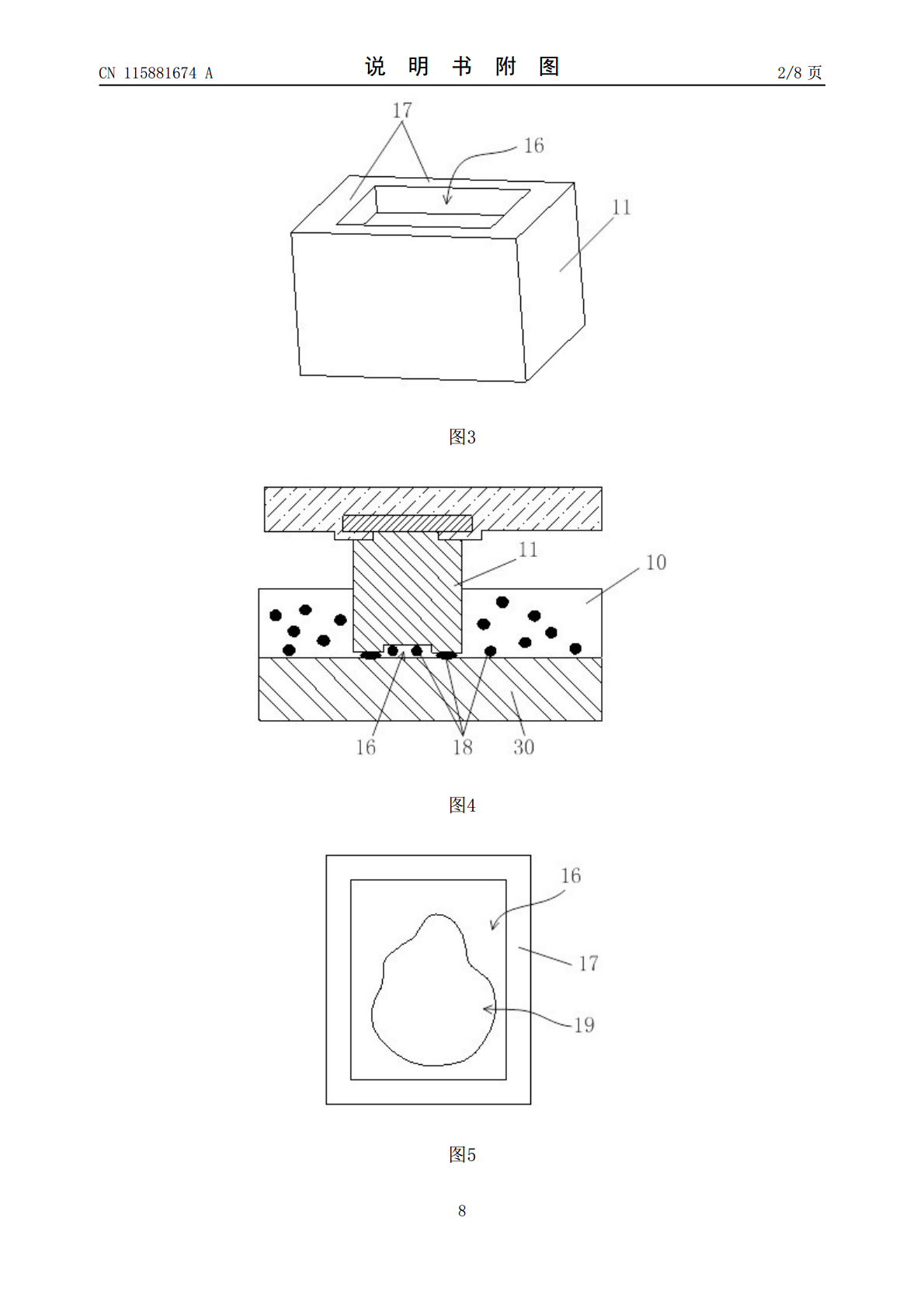
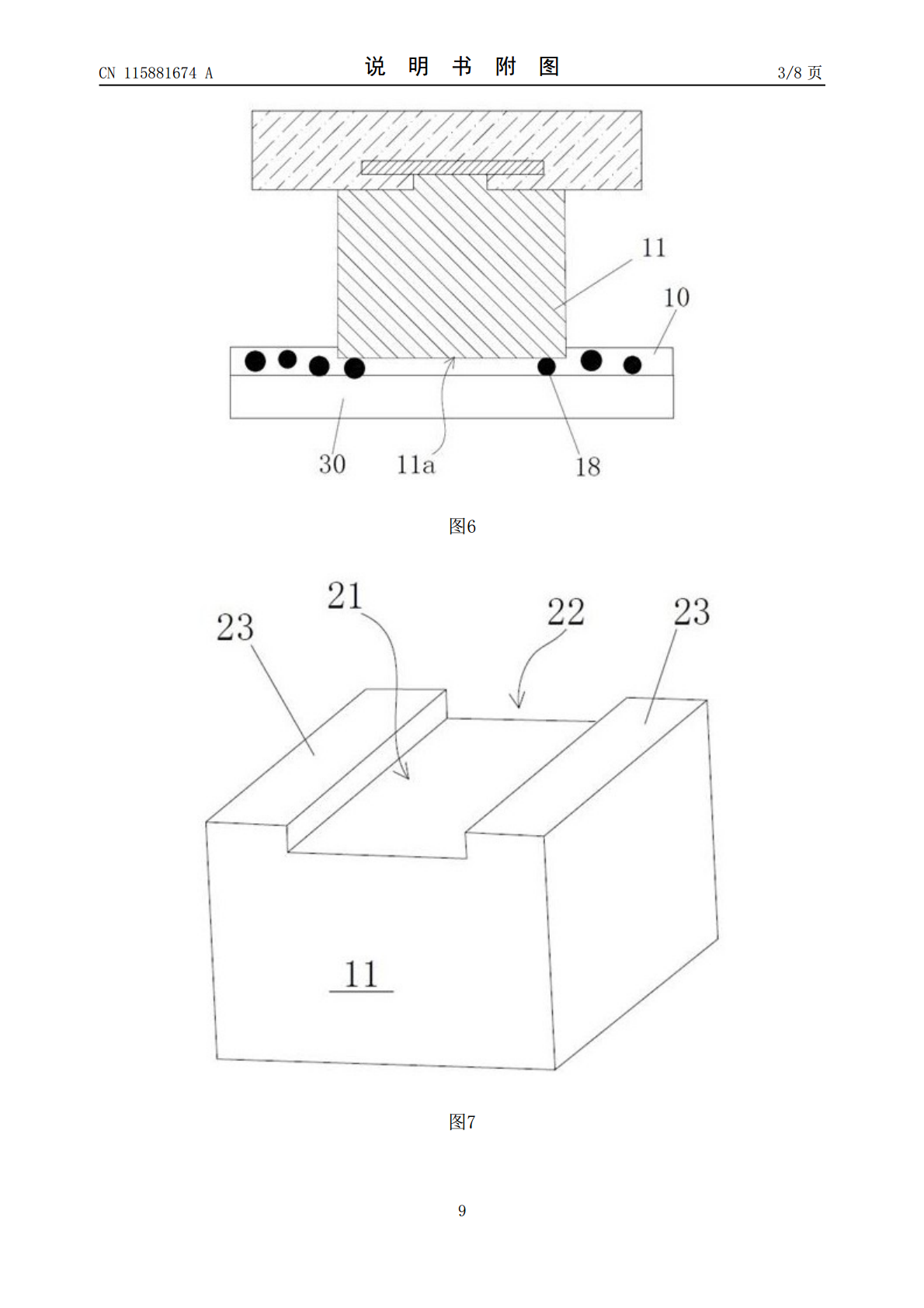

亲,该文档总共14页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种用于覆晶封装芯片的凸块结构.pdf
本发明公开了一种用于覆晶封装芯片的凸块结构,该凸块结构包括在凸块顶面布置的导流式凹槽,该凹槽居中地布置在凸块顶面上且贯穿凸块整个表面,其两端具有开口,仅在左右两侧形成凸起边界。与回字型凸起边界的凸块结构相比,本发明采用导流式凹槽凸块结构,在薄膜覆晶封装应用和卷带式覆晶封装应用时效果更优越。

一种叠层芯片的晶圆级铜凸块封装结构.pdf
本发明涉及一种叠层芯片的晶圆级铜凸块封装结构,包括第一硅承载层和第二硅承载层组成的叠层芯片,第二硅承载层铺设在第一硅承载层的底部形成凸起区域;第一硅承载层的底部和凸起区域上均生长有电性隔绝层,并留有第一开口和第二开口;第一开口中设有第一电性连接点;第二开口中设有第二电性连接点;电性隔绝层上生长有光阻层;光阻层上生长有金属层;金属层覆盖第一电性连接点和第二电性连接点;第一电性连接点上通过多次电镀形成第一铜凸块;第二电性连接点上通过多次电镀形成第二铜凸块;第一铜凸块和第二铜凸块顶部处于同一水平面;第一铜凸块和

凸块封装结构和凸块封装结构的制备方法.pdf
本发明的实施例提供了一种凸块封装结构和凸块封装结构的制备方法,涉及半导体封装技术领域,该凸块封装结构包括晶圆、保护层、第一电性组合层、导电柱、第二电性组合层和焊帽,导电柱的两端均形成了外凸弧面结构,使得导电柱与第一电性组合层、第二电性组合层的接触面积均得以大幅提升,从而提升了导电柱与第一电性组合层之间的结合力,同时提升了导电柱与第二电性组合层之间的结合力,提升了焊接凸块整体的结构强度。同时第一电性组合层覆盖焊盘开口,在进行微蚀刻工艺时能够缓解底部金属层产生的底切问题,进一步避免了凸块结构出现掉落的现象。

凸块封装结构和凸块封装结构的制备方法.pdf
本发明的实施例提供了一种凸块封装结构和凸块封装结构的制备方法,涉及半导体封装技术领域,该凸块封装结构包括芯片、保护层、基底粘接层、导电组合层、电性凸柱和帽层,其中基底粘接层为多层石墨烯材料,能够增强底部结构的稳定性以及疏水性,同时避免底切问题,此外基底粘接层形成有弧形凹槽,能够提升相邻层级之间的接触面,进而提升结合力。相较于现有技术,本发明提供的凸块封装结构,能够避免出现过度腐蚀形成的底切开口,同时结构更加稳定,底部结构结合力更好,且散热、导电性能均较佳,有效缓解了电迁移和热迁移带来的失效隐患。

凸块封装结构和凸块封装结构的制备方法.pdf
本发明的实施例提供了一种凸块封装结构和凸块封装结构的制备方法,涉及半导体封装技术领域,凸块封装结构,包括芯片、焊垫、保护层、基底导电层、第一组合导电层、导电柱和焊帽,其中,基底导电层包括多层的石墨烯结构。相较于现有技术,本发明提供的凸块封装结构及其制备方法,石墨烯填充于保护开口内,并覆盖保护开口,其能够避免出现过渡腐蚀形成的底切开口,同时结构更加稳定,避免了电极受力裂开的问题,且散热、导电性能均较佳,有效缓解了电迁移和热迁移带来的失效隐患。
