
一种雪崩二极管结构及其制备方法.pdf

飞舟****文章






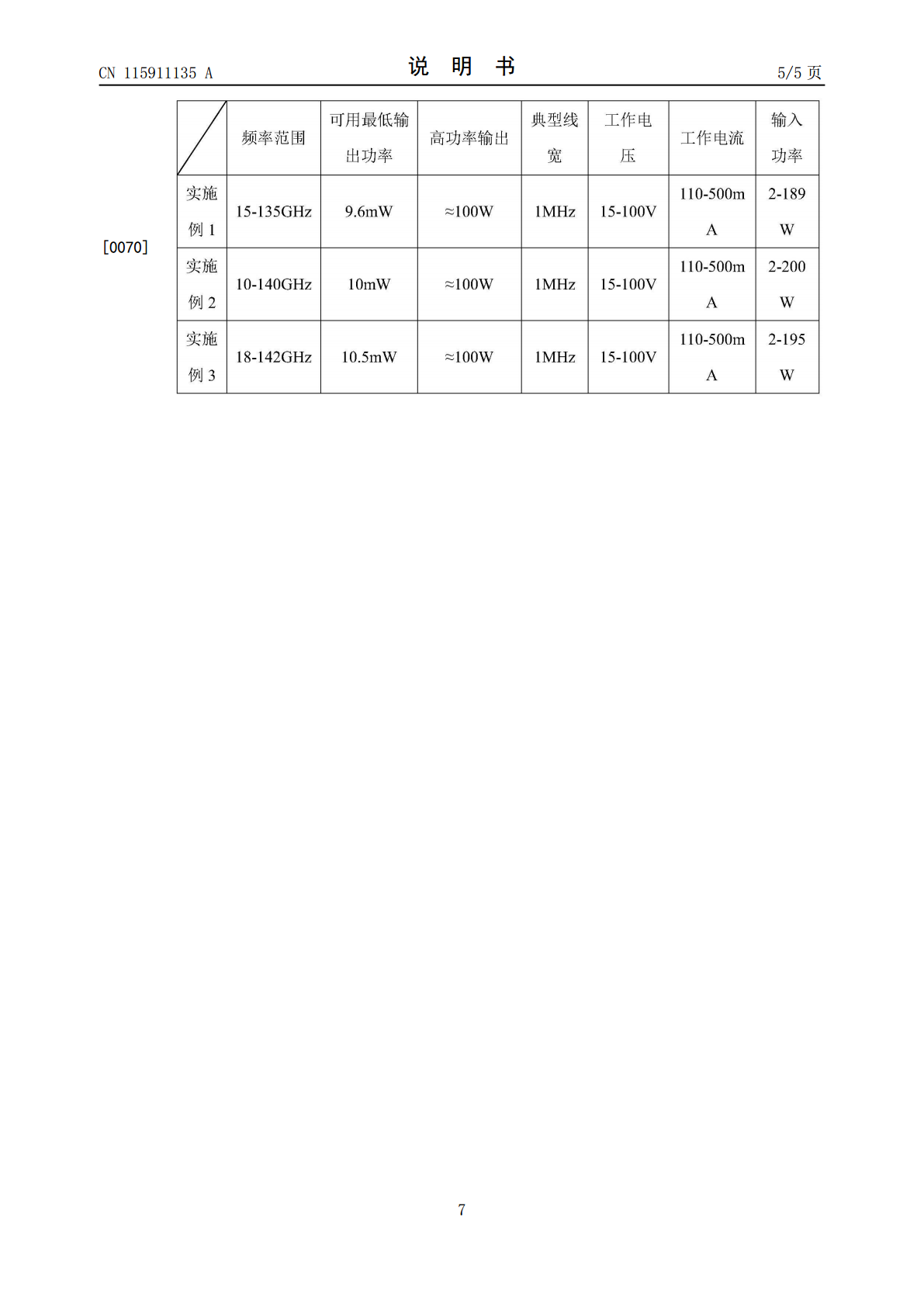

在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种雪崩二极管结构及其制备方法.pdf
本发明提供的一种雪崩二极管结构及其制备方法,包括依次堆叠的阳极、衬底、漂移区、N型区;所述N型区的中部制作有P+区,N型区的两端及P+区的边缘通过氧化硅覆盖,P+区的中部被阴极覆盖,氧化硅的的顶端及阴极的两端被氮化硅覆盖。本发明通过在漂移区内形成了Si‑GaAs异质结,由于GaAs相对于Si具有更高的电子迁移率,因此多数载流子也移动的比硅中更快,并且GaAs也有减小寄生电容和信号损耗的特性,从而有效提升了输出功率和频率;在低频大功率模式下,因雪崩击穿造成的净电荷起伏可以使输出脉冲具有更高的振幅,从而输出功

一种用于雪崩二极管的微结构金属引脚制备方法.pdf
本发明提供一种用于雪崩二极管的微结构金属引脚的制备方法,其特征在于它包括以下步骤:1)基片选择,2)基片清洗,3)蒸发,4)光刻,5)第一次湿法腐蚀,6)电镀,7)去胶,8)第二次湿法腐蚀,9)金属引脚的释放。本发明操作简单,使用方便,实施成本较低提高了引脚制备工艺后的线条控制精度,提高微结构制备的合格率及器件的产能,提高了企业经济效益。

2017103151295雪崩光电二极管器件及其结构参数的调整方法.pdf
(19)中华人民共和国国家知识产权局(12)发明专利申请(10)申请公布号CN107092760A(43)申请公布日2017.08.25(21)申请号201710315129.5(22)申请日2017.05.05(71)申请人中国科学院半导体研究所地址100083北京市海淀区清华东路甲35号(72)发明人曹思宇李传波余凯张均营成步文王启明(74)专利代理机构中科专利商标代理有限责任公司11021代理人任岩(51)Int.Cl.G06F17/50(2006.01)H01L31/107(2006.01)权利要

铟镓砷盖革雪崩二极管自淬灭环结构制备方法.pdf
本发明属于半导体光电器件技术领域,公开了一种铟镓砷盖革雪崩二极管自淬灭环结构制备方法,采用表面浅层Zn扩散工艺,在铟镓砷盖革雪崩二极管表面的iInP顶层上直接进行浅层Zn扩散,制备Zn掺杂自淬灭环结构,作为铟镓砷盖革雪崩二极管自身的被动淬灭电阻。本发明解决自由模式光子计数用铟镓砷盖革雪崩二极管存在的后脉冲高、死时间长的问题,通过实现低寄生效应的原位被动淬灭,有效提升铟镓砷盖革雪崩二极管的最大计数率,满足单光子计数探测需求。

一种台面结构快恢复二极管及其制备方法.pdf
本发明公开了半导体功率器件技术领域内的一种台面结构快恢复二极管及其制备方法。该二极管包括:N型硅衬底;N型外延层,N型外延层设置于N型硅衬底上方;P型注入层,P型注入层设置于N型外延层上方;氧化硅或氮化硅区,氧化硅或氮化硅区设置于P型注入层内;其中,N型硅衬底、N型外延层和P型注入层内均包含铂杂质,铂杂质在氧化硅或氮化硅区富集。该二极管中的铂杂质在氧化硅或氮化硅区富集,相较常规的快恢复二极管,该二极管具有较低的正向导通压降和反向恢复电流;同时该二极管中的氧化硅或氮化硅在硅中稳定性高,从而避免高温热扩散或弛
