
一种实现CASCODE模式的GaN HEMT功率器件.pdf

山柳****魔王







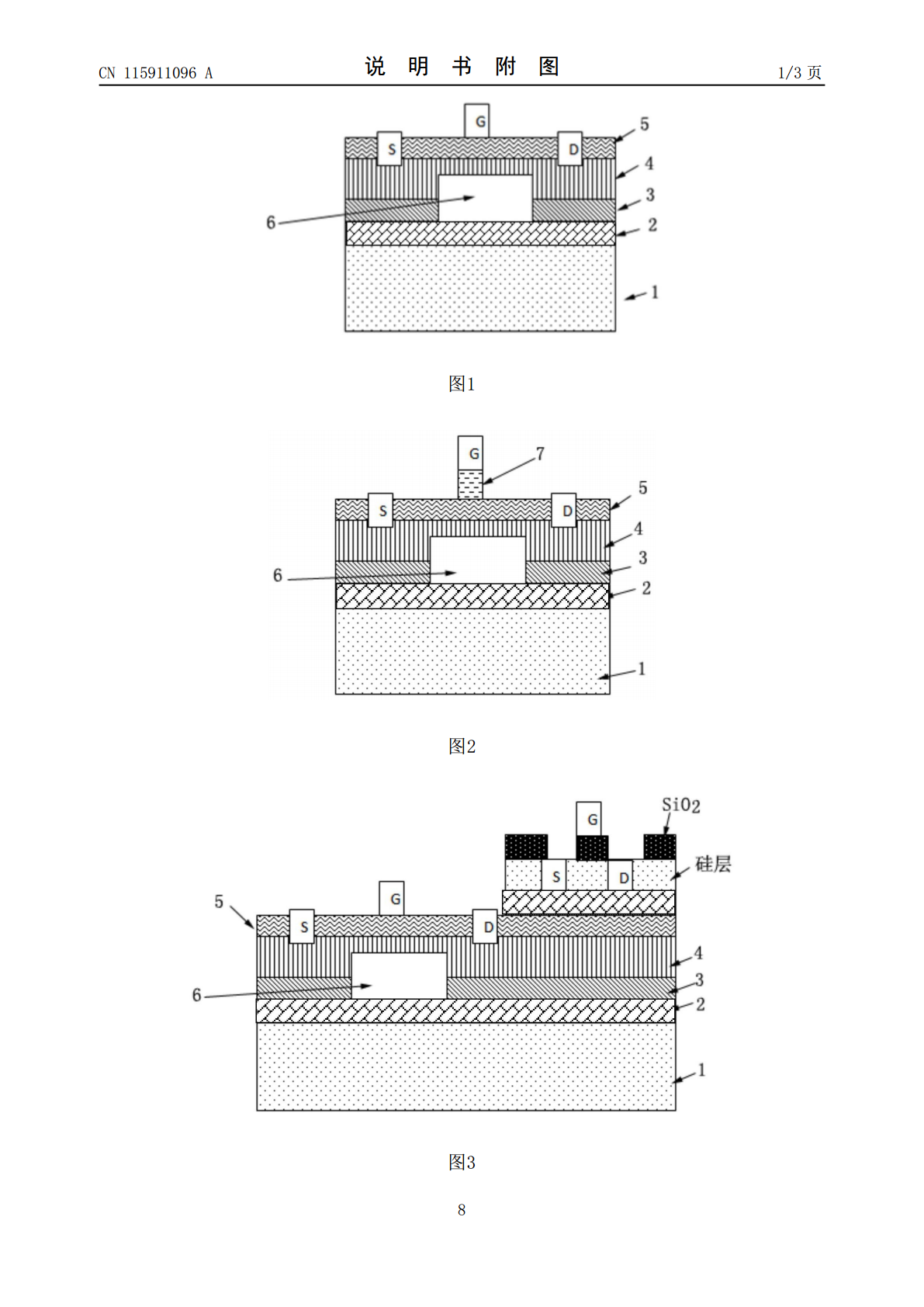
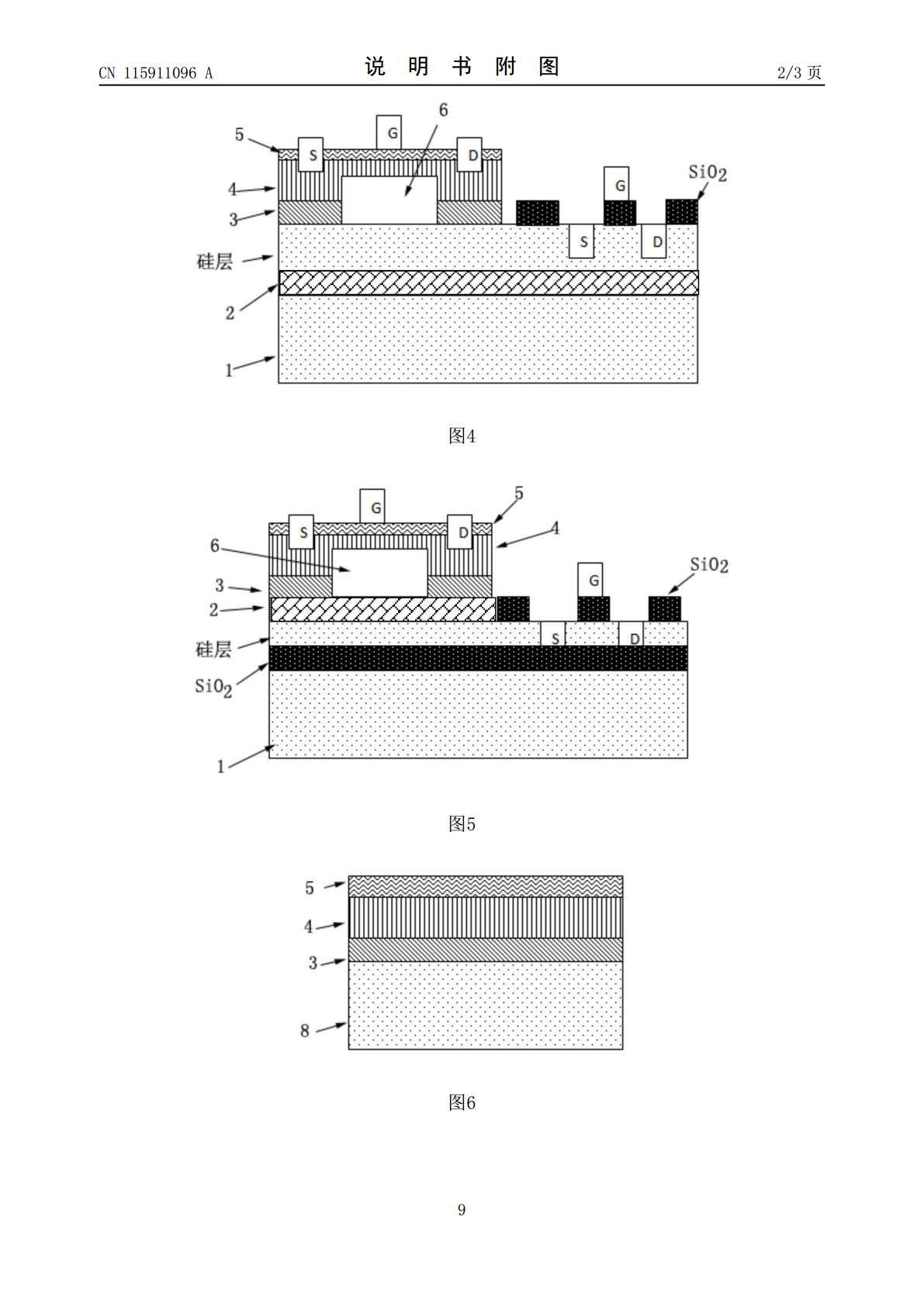
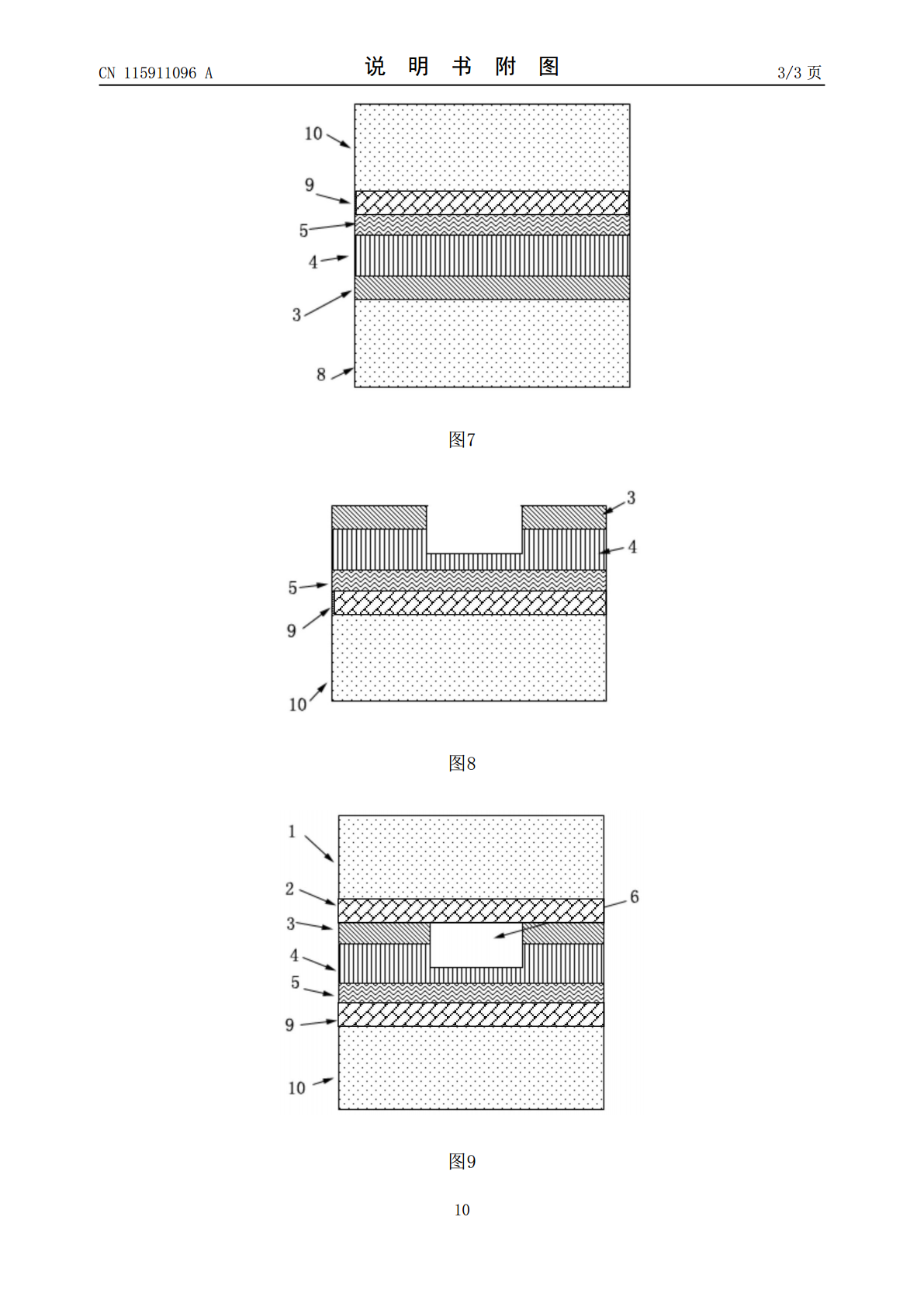
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种实现CASCODE模式的GaN HEMT功率器件.pdf
本发明公开了一种实现CASCODE模式的GaNHEMT功率器件,属于半导体技术领域,器件包括从下至上依次连接的第三衬底、第二中间层、缓冲层、GaN层和AlGaN层;AlGaN层上设置有源极、漏极和栅极,其中,源极、漏极均延伸连接至所述GaN层中;GaN层中设置有空腔,所述空腔的下端延伸至缓冲层中,空腔的上端位于源极和漏极的沟道下方,所述AlGaN层上连接有一个增强型硅MOSFET器件,其中,所述增强型硅MOSFET器件的源极和栅极做整个器件的源极和栅极,GaNHEMT功率器件作为整个器件的漏极。本发明

一种纵向GaN HEMT功率器件.pdf
本发明属于功率半导体技术领域,具体为一种纵向结构的GaNHEMT功率器件,包括AlN成核层、重掺杂AlGaN或GaN缓冲层、轻掺杂GaN沟道层、AlGaN势垒层、肖特基接触栅极、Mg掺杂的P‑GaN盖帽层、金属化漏极、GaN电流沉降层、SiO

高功率GaN HEMT器件建模研究.docx
高功率GaNHEMT器件建模研究随着高速通信、高频率、高功率和高温环境等要求的不断提高,针对纯GaN材料的高功率HEMT器件建模研究越来越受到人们的关注。由于新型高功率GaNHEMT器件具有高热稳定性、高频特性以及优异的高功率性能等优点,因此这种器件被广泛应用于计算机、通信、雷达、卫星通信等领域。GaN是一种优秀的材料,它具有高电场承受能力、高导电性、高晶格硬度、较高的熔点和导热性等特性,因此在高功率器件的设计中起着至关重要的作用。GaN材料的热稳定性和高导电性能使得它成为一种理想的材料,可用于设计高功率

一种提取GaN功率HEMT器件热阻抗的方法.docx
一种提取GaN功率HEMT器件热阻抗的方法Title:AMethodforExtractingGaNPowerHEMTDeviceThermalImpedanceAbstract:Inrecentyears,GalliumNitride(GaN)HighElectronMobilityTransistor(HEMT)deviceshavegainedsignificantattentioninpowerelectronicsduetotheirsuperiorelectricalandthermalpro

GaN HEMT微波功率器件的内匹配模块研制.docx
GaNHEMT微波功率器件的内匹配模块研制摘要:本文介绍了GaNHEMT微波功率器件的内匹配模块的研制。首先,我们讲解了该器件原理和性能特点。然后,我们提出了一种基于SmithChart的内匹配方法,并在ADS软件中进行了仿真。最后,我们通过实验验证了该内匹配模块的效果,证明了该方法的可行性和优势。本文的研究结果对于GaNHEMT微波功率器件的应用具有一定的指导意义。关键词:GaNHEMT、微波功率器件、内匹配模块、SmithChart、ADS软件引言:随着通信技术的不断发展,微波功率器件在通信、雷达、导
