
半导体结构及浅沟槽隔离结构制备方法.pdf

猫巷****雪凝







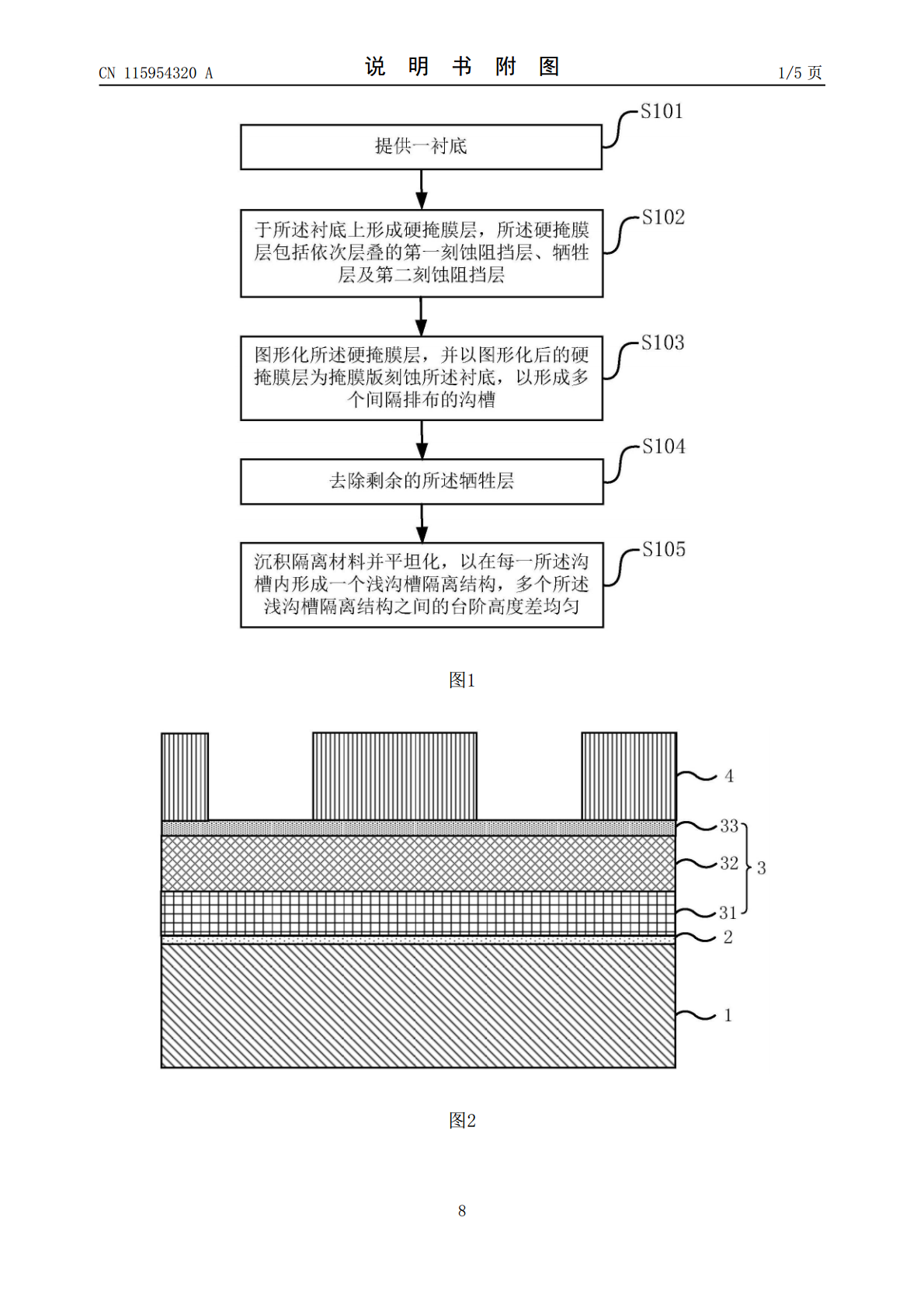
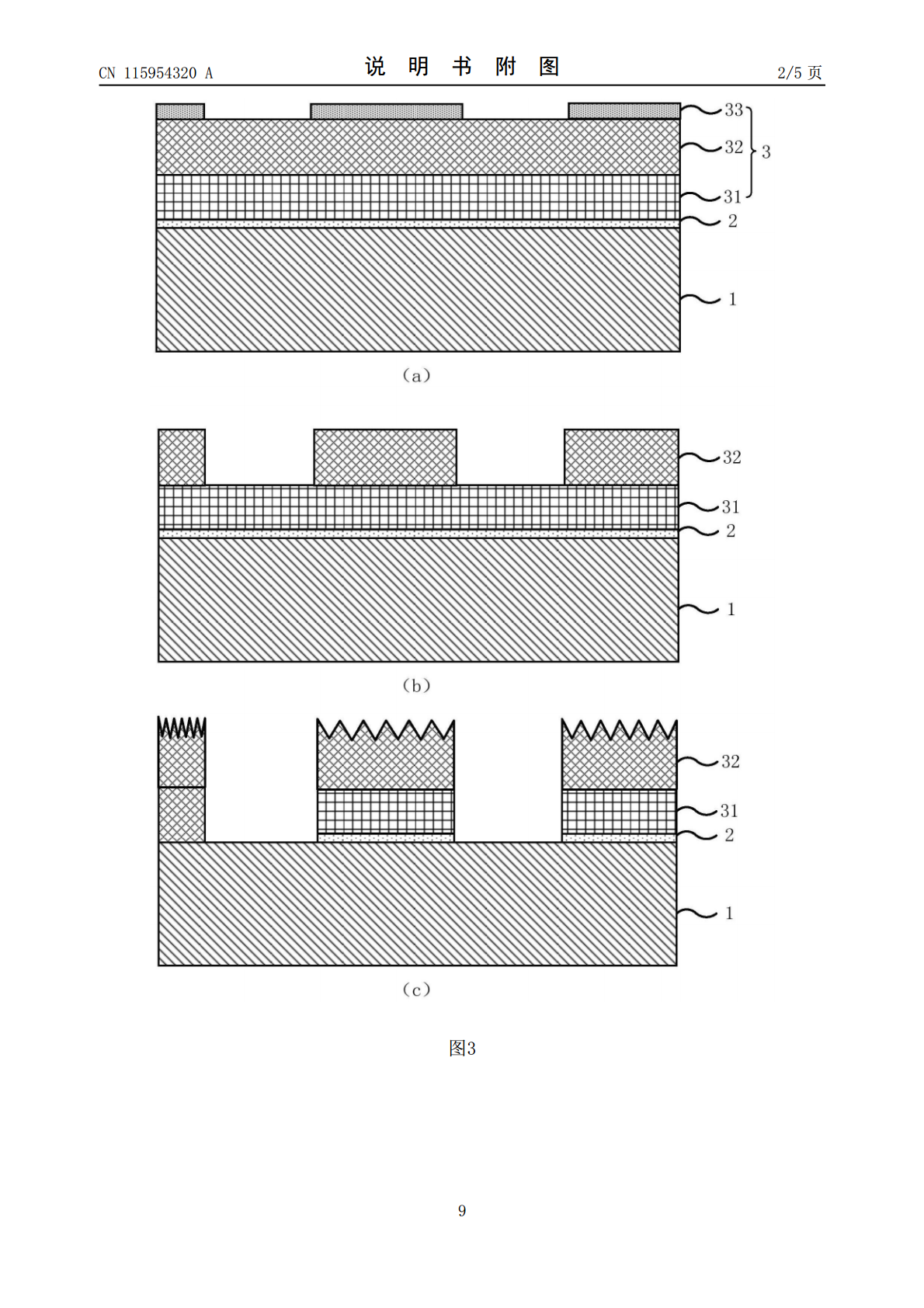

亲,该文档总共12页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

半导体结构及浅沟槽隔离结构制备方法.pdf
本申请提供了一种半导体结构及浅沟槽隔离结构制备方法。所述浅沟槽隔离结构制备方法包括:提供一衬底;于所述衬底上形成硬掩膜层,所述硬掩膜层包括依次层叠的第一刻蚀阻挡层、牺牲层及第二刻蚀阻挡层;图形化所述硬掩膜层,并以图形化后的硬掩膜层为掩膜版刻蚀所述衬底,以形成多个间隔排布的沟槽;去除剩余的所述牺牲层;沉积隔离材料并平坦化,以在每一所述沟槽内形成一个浅沟槽隔离结构,多个所述浅沟槽隔离结构之间的台阶高度差均匀。上述技术方案,通过在第一刻蚀阻挡层及第二刻蚀阻挡层之间设置牺牲层,避免了所述第一刻蚀阻挡层在沟槽刻蚀的

浅沟槽隔离结构的制备方法及浅沟槽隔离结构.pdf
本发明提供一种浅沟槽隔离结构的制备方法及浅沟槽隔离结构,其中化学机械平坦化的方法包括:提供一基底结构,基底结构包括衬底和研磨停止层,基底结构内具有多条不同宽度的隔离槽,隔离槽贯穿研磨停止层并贯穿衬底的上表面;沉积绝缘材料并进行退火工艺,以形成绝缘介质层,绝缘介质层的表面形成有不同深度的凹槽,每个凹槽位于相应的隔离槽的正上方;沉积第一分隔材料,以形成第一分隔层,在同等研磨条件下第一分隔层的去除速率低于绝缘介质层的去除速率;在同等研磨条件下进行化学机械平坦化处理,直至去除第一分隔层;对剩余的绝缘介质层进行湿法

浅沟槽隔离结构的制备方法及浅沟槽隔离结构.pdf
本发明提供一种浅沟槽隔离结构的制备方法及浅沟槽隔离结构,其中化学机械平坦化的方法包括:形成衬底,衬底内具有浅沟槽,且衬底表面具有研磨停止层,浅沟槽贯穿研磨停止层;沉积绝缘材料并进行退火工艺,以形成绝缘介质层,绝缘介质层的表面形成有凹槽,绝缘介质层的上表面不低于研磨停止层的上表面,凹槽的底端在衬底的上方,凹槽与浅沟槽一一对应,每个凹槽位于相应的浅沟槽的正上方;沉积第一分隔材料,以形成第一分隔层,在同等研磨条件下第一分隔层的去除速率低于绝缘介质层的去除速率;在同等研磨条件下进行化学机械平坦化处理,以在浅沟槽内

浅沟槽隔离结构的制备方法及半导体结构的制备方法.pdf
本申请涉及一种浅沟槽隔离结构的制备方法及半导体结构的制备方法。浅沟槽隔离结构的制备方法包括:提供基底;于所述基底内形成初始浅沟槽隔离结构,所述初始浅沟槽隔离结构于所述基底内隔离出多个间隔排布的有源区;于所述初始浅沟槽隔离结构的上表面和侧壁以及所述基底的上表面形成牺牲层;去除所述牺牲层,以得到浅沟槽隔离结构。通过在初始浅沟槽隔离结构的上表面和侧壁以及基底的上表面形成牺牲层,以对初始浅沟槽隔离结构进行保护,相较于常规的牺牲层只形成于基底的上表面的方式,本申请的牺牲层覆盖在初始浅沟槽隔离结构的上表面和侧壁以及基

浅沟槽隔离结构及其制备方法、半导体结构和芯片.pdf
本申请涉及半导体技术领域,特别是一种浅沟槽隔离结构及其制备方法、半导体结构和芯片,以解决相关技术中自然氧化物层无法去除完全,从而不利于后续线性氧化物层的生长,进而不利于浅沟槽隔离结构对有源区进行隔离的问题。一种浅沟槽隔离结构制备方法,包括:在硅片上形成浅沟槽结构,浅沟槽结构的表面形成有自然氧化物层;采用SiCoNi刻蚀工艺,将自然氧化物层去除,并在去除自然氧化物层的硅片表面形成保护层,保护层的材料包括:六氟硅酸氨;将保护层去除,并在去除保护层的硅片表面形成线性氧化物层。
