
一种无引线的全铜互连封装结构及其制备方法.pdf

白凡****12








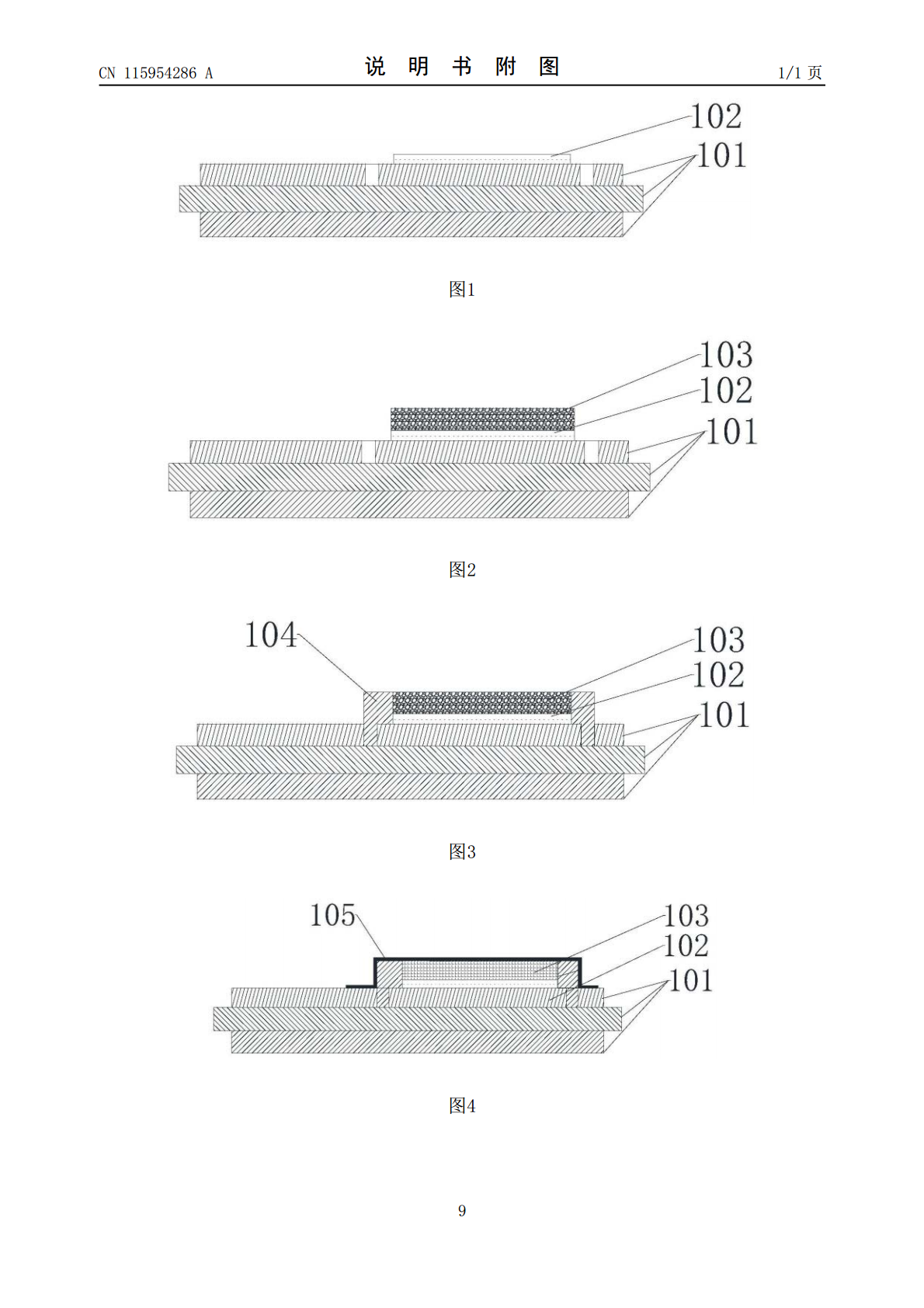
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种无引线的全铜互连封装结构及其制备方法.pdf
本发明涉及一种无引线的全铜互连封装结构及其制备方法;制备步骤为:在基板的特定位置上覆设含微纳米金属颗粒的膏体,形成贴片层;在贴片层上贴装芯片,采用烧结工艺,实现芯片与基板互连;在基板上制备围设芯片和贴片层外围的绝缘层;在芯片和绝缘层上端面、绝缘层的外围以及与绝缘层相邻的基板特定区域连续覆设含微纳米金属颗粒的膏体,采用烧结工艺对覆设的含微纳米金属颗粒的膏体进行烧结,形成与芯片和基板互连的互连层;通过无引线的全铜互连封装结构制备方法的提出以解决现有采用引线为铜线,铜线的线材硬度较大,键合时所需的键合压力较大导

一种芯片互连封装结构及其制备方法.pdf
本发明公开了一种芯片互连封装结构及其制备方法,属于芯片封装技术领域,包括:在载板上分离贴装正反面颠倒的第一芯片、第二芯片;对两颗芯片进行第一次塑封;对第一塑封层两侧贯穿开孔,并对第一芯片的背面、第二芯片正面的第一焊盘处对应的第一塑封层开设盲孔;向第一通孔中填充导电块;对导电块、第一芯片的背面、第二芯片正面的第一焊盘进行互连;进行第二次塑封;去除载板;进行第三次塑封;对第三塑封层开孔,以引出引脚以及第三焊盘。本发明能够实现多芯片双面互连,且封装结构产品更加薄型化;通过导电块引出第三焊盘,实现了多芯片的一体化

芯片粒精细互连封装结构及其制备方法.pdf
本发明公开一种芯片粒精细互连封装结构及其制备方法,方法包括在基板的第一侧面上贴装至少二颗芯片,并在芯片的第一表面上制备临时键合层;在基板的第二侧面制备塑封层,其中,基板上制备有微孔,塑封层的塑封材料能够自所述微孔流入至基板的第一侧面与临时键合层之间,以制备形成塑封层;释放临时键合层,并在相邻的两颗芯片的第一引脚阵列上键合用于将相邻的两颗芯片电气连通的硅桥结构;在塑封层上制备积层;在积层上制备焊锡球。本发明提供的方案使得在后续的工艺中,无须去除基板,也无须对塑封层的相应位置进行研磨减薄处理,因而简化了封装的

一种微米级单晶铜互连结构及其制备方法.pdf
本发明公开了一种微米级单晶铜互连结构及其制备方法,属于电子封装领域。所述结构主要包括基底、阻挡层、含磷铜种子层、铜针;所述基底为具有通孔和沟槽的介质层、具有盲孔的硅晶圆、具有铜柱窗口的半导体衬底中的一种;所述阻挡层设置在介质层的通孔和沟槽的内侧壁和底部、硅晶圆的盲孔的内侧壁和底部、或半导体衬底上的铜柱窗口底部;所述含磷铜种子层设置在与基底平行的阻挡层上方;所述铜针在含磷铜种子层上沉积得到。该结构在铜种子层中掺入磷元素,进行电镀时不需要添加剂的协助即可形成微米级单晶铜针,作为铜互连结构。本发明得到的铜互连结

引线框架、引线框架的制备方法、封装结构.pdf
本发明提供一种引线框架、制备方法、封装结构,所述引线框架包括基岛区、与所述基岛区相分离设置的第一引脚区,所述第一引脚区分布于所述基岛区的周侧;所述引线框架还包括用以提高所述基岛区和/或所述第一引脚区的稳定性的加强件;能够使基岛区的基岛和/或第一引脚区的引脚在周向得到较好的支撑,从而,在焊线温度条件下,所述基岛和/或所述引脚不会发生明显的变形翘曲,能够避免焊线过程中发生塌丝现象,提高最终的封装结构的良品率。
