
一种半导体器件结构及其制备方法.pdf

丹烟****魔王









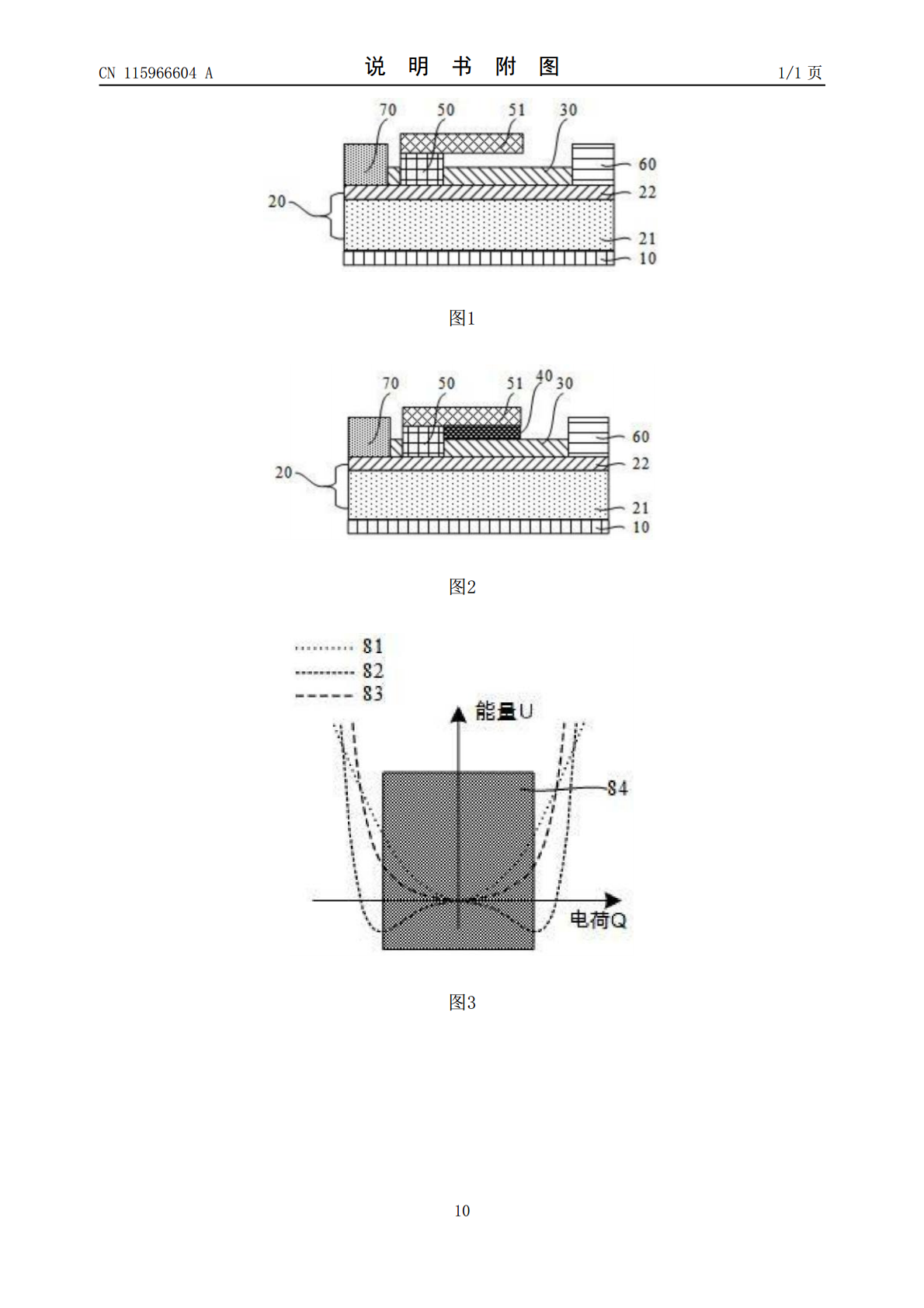
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种半导体器件结构及其制备方法.pdf
本发明提供一种半导体器件结构及其制备方法,器件结构包括:衬底层、器件外延层、场板介质层、负电容介质层、栅极层、场板电极;场板介质层设置于器件外延层上,负电容介质层设置于场板介质层上,栅极层设置于场板介质层和负电容介质层的第一侧,且栅极层自该第一侧朝第二侧延伸以至少覆盖部分负电容介质层,以形成场板电极。本发明通过在场板电极与场板介质层之间设置负电容介质层,引入了负电容结构,从而在产生等量电荷的情况下需要更少的输入能量,平衡了GaN基HEMT器件引入场板电极产生的附加电容,在保持场板电极带来的高击穿电压和高使

一种半导体器件结构及其制备方法.pdf
本发明提供一种半导体器件结构及其制备方法,所述半导体器件结构包括:衬底层、生长阻挡层、外延结构;衬底层的材料为(110)单晶硅;衬底层设置多个相间的凹槽,生长阻挡层覆盖凹槽的第一侧壁,外延结构覆盖凹槽的第二侧壁并突出于凹槽形成脊形外延部。本发明通过使用(110)单晶硅,使外延结构可以在侧壁生长有效的外延面,改善器件在晶圆上的空间利用率,提高单位晶圆可容纳的HEMT器件密度;同时利用(110)单晶硅上的外延生长结构,使脊形外延部可以与衬底层没有接触,从而降低层间应力产生位错的概率,降低器件对缓冲层的依赖;另

外延结构及其制备方法、半导体器件及其制备方法.pdf
本发明实施例公开了一种外延结构及其制备方法、半导体器件及其制备方法,该外延结构包括:衬底;半导体层,位于衬底一侧,半导体层远离衬底一侧的表面为金属极性面;氮极性面帽层,位于半导体层远离衬底的一侧。具有金属极性面的半导体层和氮极性面帽层形成复合极性外延结构,形成半导体器件时,具有强负电性的氮极性面帽层,在常温下即可与源极和漏极形成良好的欧姆接触,无需高温处理,能够降低工艺难度,半导体层可作为氮极性面帽层的湿法腐蚀自停止层,稳定阈值电压同时可提高跨导,从而提高器件性能。

一种半导体器件的接触结构及其制备方法.pdf
本申请公开了一种半导体器件的接触结构及其制备方法,所述半导体器件包括外延层以及位于所述外延层中的掺杂区,所述接触结构包括:层间介质层,设置于所述外延层上;接触孔,包括贯穿所述层间介质层的第一部分以及延伸至所述掺杂区中的第二部分,所述第一部分的尺寸大于所述第二部分的尺寸,并且所述第二部分在所述第一部分的底面开口,所述第二部分的底面设置于所述掺杂区中;接触层,包括设置于所述第一部分的底面的第一接触层和所述第二部分的底面的第二接触层;以及导电通道,设置于所述接触孔内并且与所述接触层接触。本申请通过在导电通道与外

垂直结构的半导体器件及其制备方法.pdf
本公开提供了一种垂直结构的半导体器件及其制备方法,属于半导体技术领域。该制备方法包括:制备外延片;调整所述外延片的姿态,使得所述外延片的生长方向平行于水平面;在所述外延片的第一侧沉积欧姆电极,在所述外延片的第二侧沉积肖特基电极,使得所述欧姆电极和所述肖特基电极分别位于所述外延片的相对两侧。本公开能够提高垂直封装时的可靠性。
