
IC封装流程PPT课件.ppt

星星****眨眼










亲,该文档总共31页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

IC封装流程PPT课件.ppt
概述IC的分类FLOWCHART一.磨片磨片方法分类和特点划片的分类和特点划片的方式三.装片工程树脂粘接法:(3).校正台将芯片的角度进行校正。競寞四.键合过程对键合引线的要求使用金线的理由键合过程示意图热超声金丝球焊的意义键合品质的评价方法(2)金球剥离强度试验:五.塑封工程2.器件的受热要求:密封腔体内的水分的主要来源:降低密封腔体内部水分的主要途径:塑封为什么属于非气密性封装?塑封材料的要求:4.热膨胀系数要高,导热率要低。使用塑封封装的理由:六.切筋工程切筋的过程(以SDIP24为例):切脚冲塑切
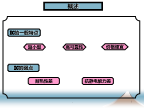
IC封装流程PPT课件.ppt
概述IC的分类FLOWCHART一.磨片磨片方法分类和特点划片的分类和特点划片的方式三.装片工程树脂粘接法:(3).校正台将芯片的角度进行校正。競寞四.键合过程对键合引线的要求使用金线的理由键合过程示意图热超声金丝球焊的意义键合品质的评价方法(2)金球剥离强度试验:五.塑封工程2.器件的受热要求:密封腔体内的水分的主要来源:降低密封腔体内部水分的主要途径:塑封为什么属于非气密性封装?塑封材料的要求:4.热膨胀系数要高,导热率要低。使用塑封封装的理由:六.切筋工程切筋的过程(以SDIP24为例):切脚冲塑切

IC-芯片封装流程ppt课件.ppt
IntroductionofICAssemblyProcessIC封装工艺简介IC制作涂覆光刻胶注入离子ICUsingInLife集成电路在生活中的应用WhyAssemblethedie?为什么要封装芯片?AssemblyProcessFlow封装流程图Taping贴膜BacksideGrinding背面磨晶WaferMount&Detaping去膜贴片AdhesiveAttach涂胶DieAttach粘片WireBond焊线Molding模封Marking打标BallMount植球SawSingulat

IC封装测试流程详解PPT课件.ppt
IntroductionofICAssemblyProcessIC封装工艺简介ICProcessFlowICPackage(IC的封装形式)ICPackage(IC的封装形式)ICPackage(IC的封装形式)ICPackage(IC的封装形式)ICPackage(IC的封装形式)ICPackageStructure(IC结构图)RawMaterialinAssembly(封装原材料)RawMaterialinAssembly(封装原材料)RawMaterialinAssembly(封装原材料)RawM

IC封装流程介绍ppt课件.ppt
封装流程介绍简介IC封装属于半导体产业的后段加工制程,主要是将前制程加工完成(即晶圆厂所生产)的晶圆上的IC予以分割,黏晶、打线并加上塑封及成型。其成品(封装体)主要是提供一个引接的接口,内部电性讯号可通过引脚将芯片连接到系统,并避免硅芯片受外力与水、湿气、化学物之破坏与腐蚀等。树脂(EMC)傳統IC主要封裝流程-1傳統IC主要封裝流程-2芯片切割(DieSaw)晶粒黏贴(DieBond)9焊线(WireBond)11拉力测试(PullTest)、金球推力测试(BallShearTest)以确定焊线之质量
