
一种图形化划道消除Ge/Si键合界面气泡的方法.pdf

一吃****福乾






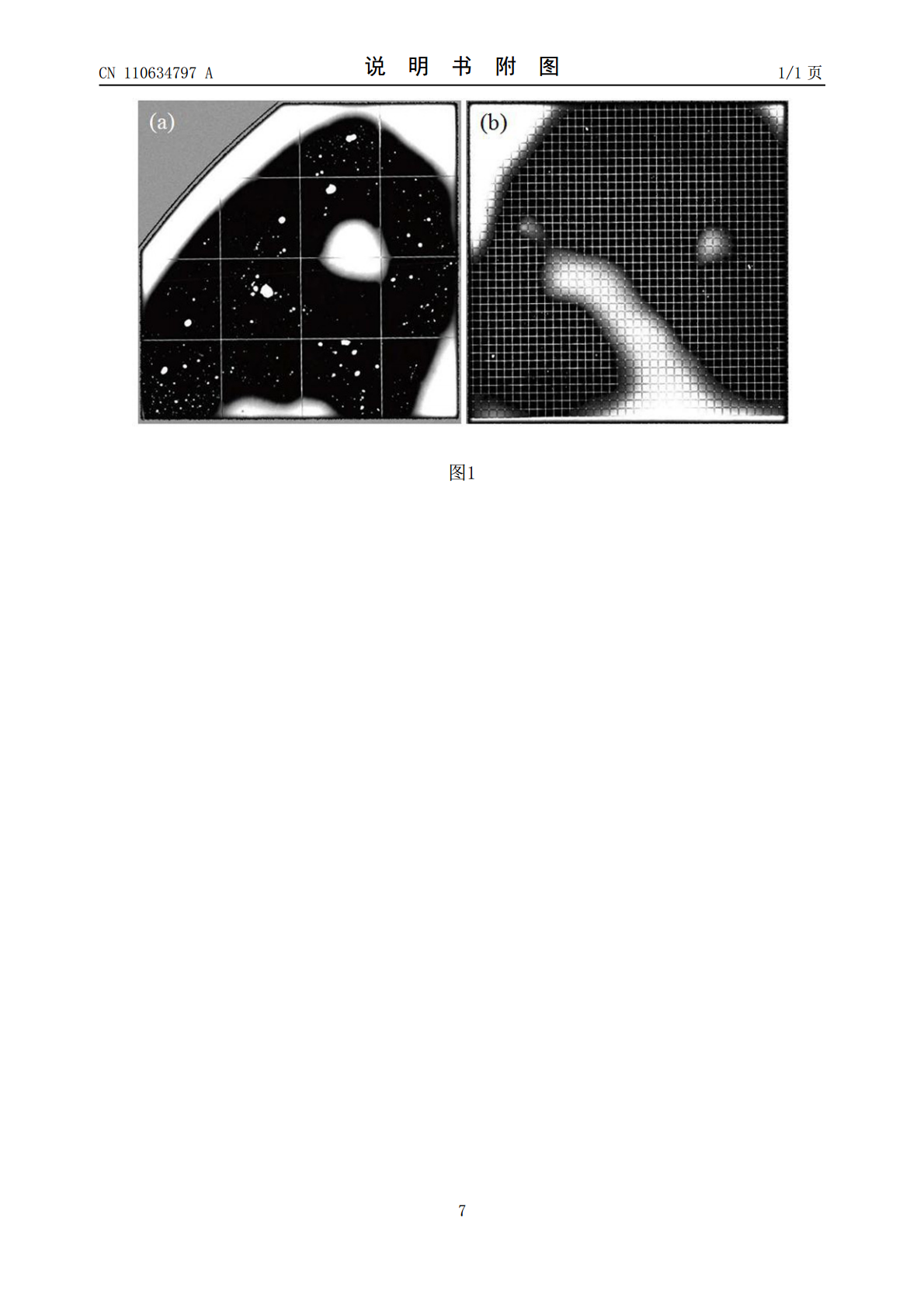
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种图形化划道消除Ge/Si键合界面气泡的方法.pdf
本发明公开了一种图形化划道消除Ge/Si键合界面气泡的方法,首先采用砂轮划片机在晶片表面切割出宽度为微米级等间距的凹槽,其次在Si片和Ge片表面生长一层a‑Ge作为键合中间层,通过切割出的凹槽实现退火过程中形成的副产物的有效排出,避免副产物的堆积。

测量键合晶圆面内键合强度的方法及气泡核的形成方法.pdf
本发明涉及测量键合晶圆面内键合强度的方法,涉及半导体集成电路制造技术,包括:提供第一晶圆,在所述第一晶圆上形成一气泡核形成层;形成光刻胶层,并进行曝光显影工艺,将需要形成气泡核的区域用光刻胶保护起来,其它区域显开;进行刻蚀工艺,以将未被光刻胶保护的区域的气泡核形成层刻蚀掉,保留被光刻胶保护的区域的气泡核形成层,并去除光刻胶,而形成气泡核;将第二晶圆与所述第一晶圆进行键合工艺,则在气泡核处形成键合气泡;以及测量并计算得到键合气泡半径和气泡核高度,并根据键合气泡半径、晶圆的杨氏模量、晶圆厚度及气泡核高度计算得

一种应用于MicroLED的键合及像素图形化制备方法.pdf
本发明公开了一种应用于MicroLED的键合及像素图形化制备方法,包括步骤:制备有图形化键合金属层的第一基板和制备有未图形化键合金属层的第二基板,第一基板和第二基板进行晶圆级金属键合实现MicroLED的键合,键合完成后对第二基板上的未图形化键合金属层进行像素图形化,实现MicroLED的像素图形化制备。本发明在键合金属制备时形成单面图形化,降低晶圆级键合时的对准要求和像素图形化时的金属刻蚀难度,消除侧壁围栏,减少金属飞溅和颗粒残留,大幅度提升器件的整体性能和良率。

气泡消除器、液体传输装置和消除气泡的方法.pdf
本发明提供了一种气泡消除器、液体传输装置和消除气泡的方法。根据本发明的气泡消除器具有与容纳气泡消除器的容器内腔相适应的截面轮廓,且气泡消除器的外表面设有朝外的尖刺结构。根据本发明的液体传输装置应用有上述气泡消除器。

一种晶圆键合方法及键合结构.pdf
本发明提供一种晶圆键合方法及晶圆键合结构,涉及半导体封装技术领域。方法包括:获取待键合的第一晶圆和第二晶圆;所述第一晶圆包括第一面;所述第二晶圆包括第二面;对所述第一晶圆的所述第一面涂覆键合胶形成键合面;在第一温度下的第一真空环境中对所述键合胶加热烘干;以预设间隔距离固定所述第一晶圆和所述第二晶圆,在第二真空环境中对所述键合胶加热至第二温度;在所述第二温度下将所述第一晶圆的所述键合面与所述第二晶圆的所述第二面相互接触,形成键合结构。该方法可以避免键合胶加热气化后部分组分形成的气体以气泡方式从胶内部溢出,进
