
一种硅基GaN薄膜及其外延生长方法.pdf

冬易****娘子







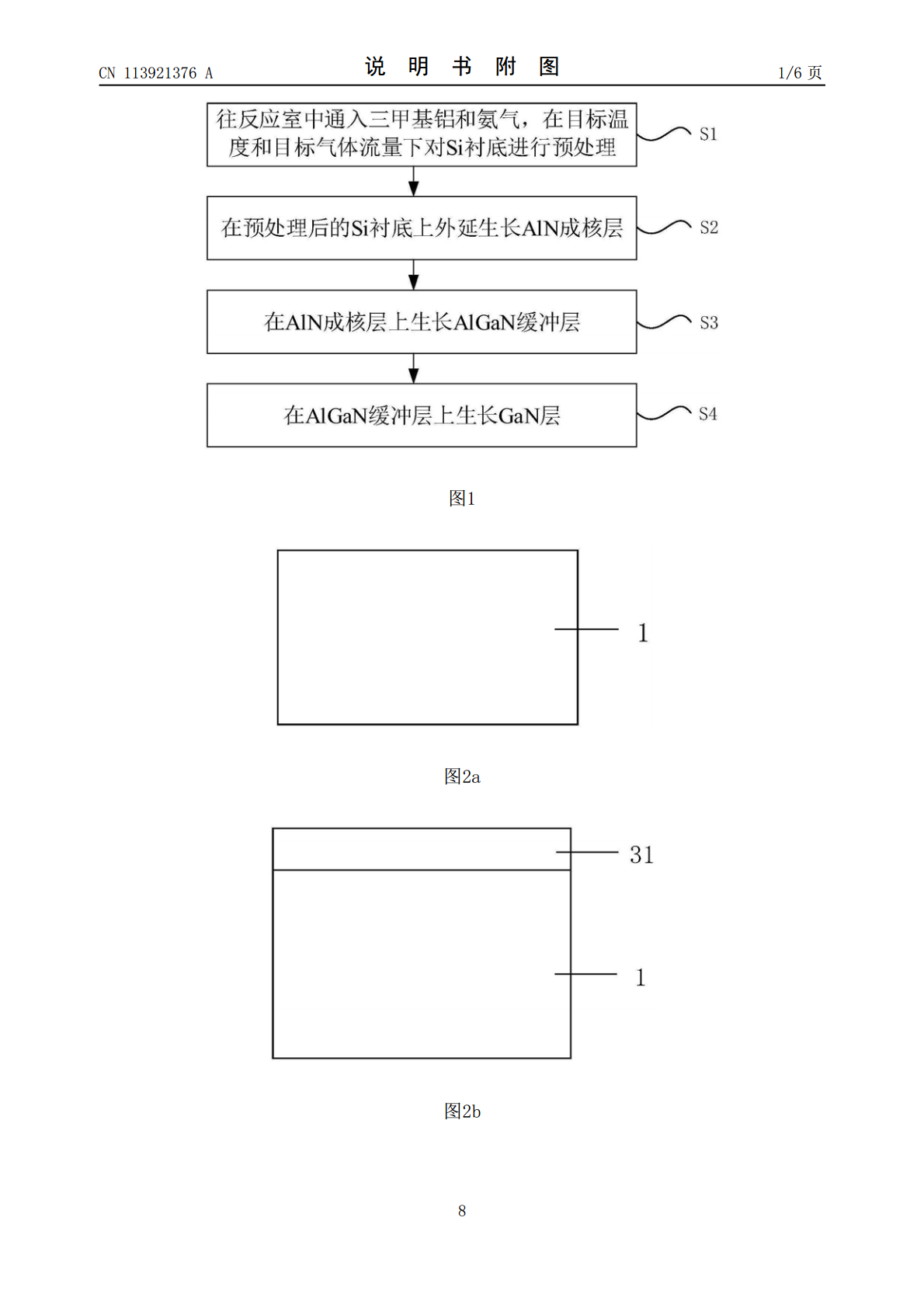
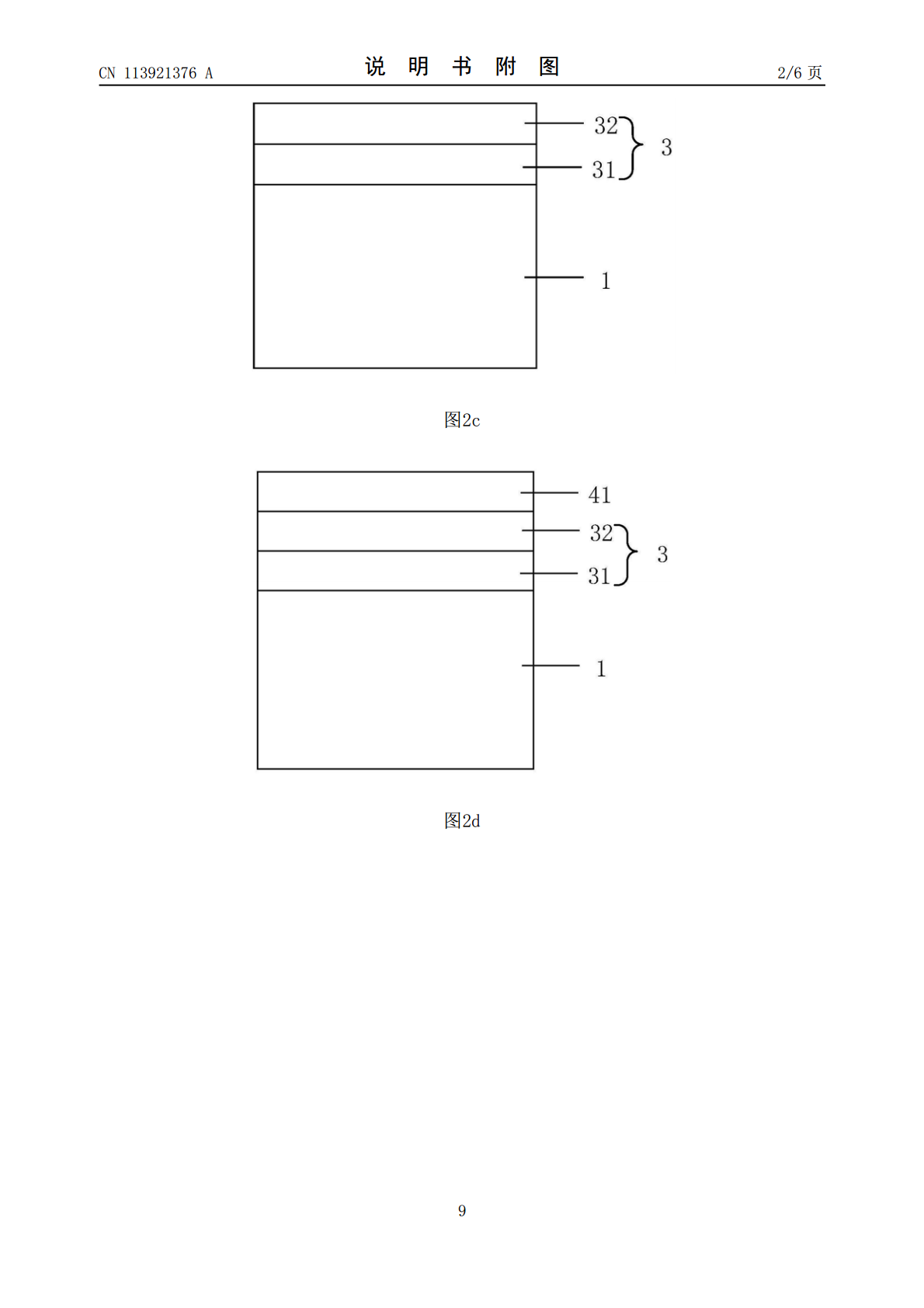
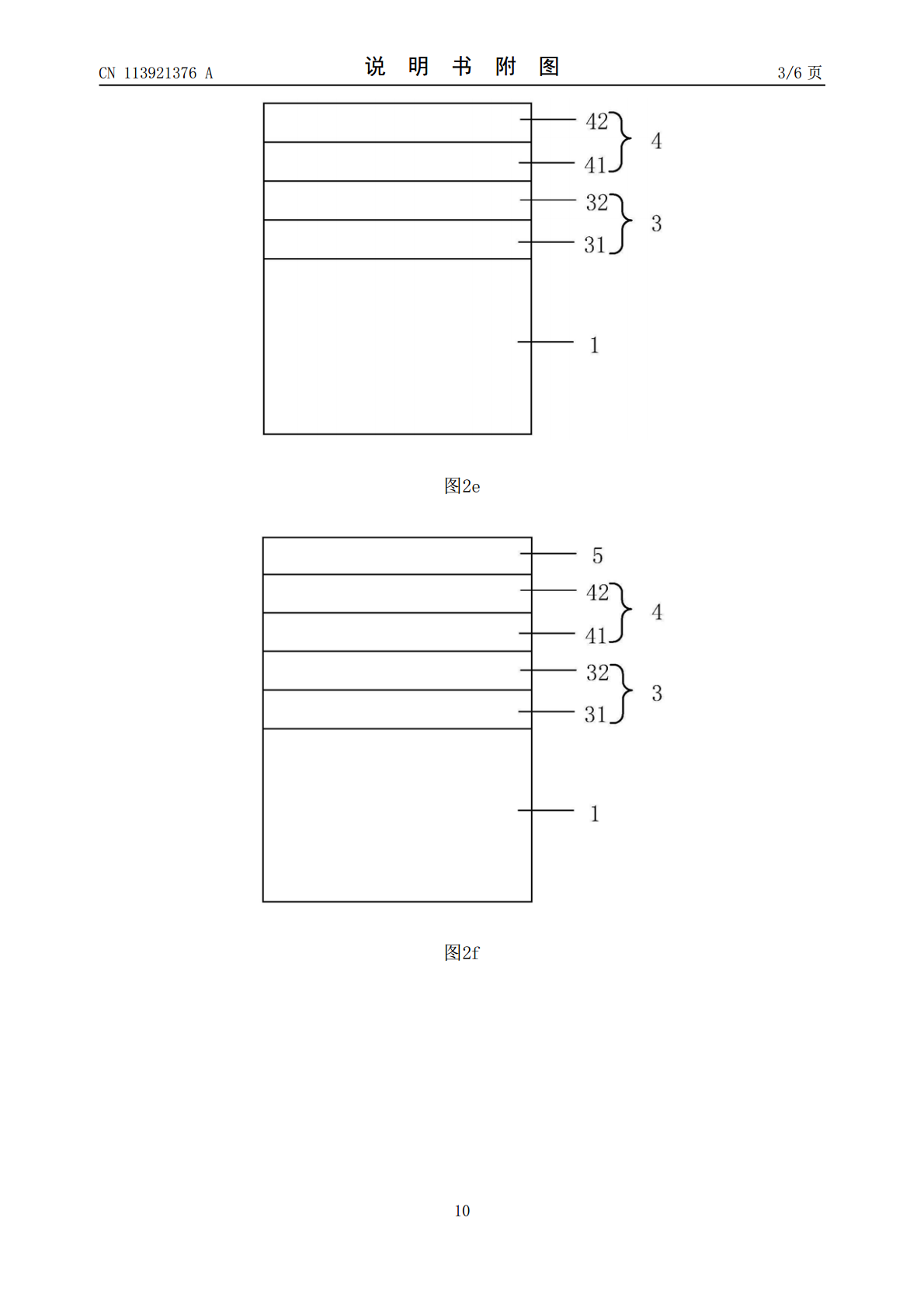
亲,该文档总共13页,到这已经超出免费预览范围,如果喜欢就直接下载吧~
相关资料

一种硅基GaN薄膜及其外延生长方法.pdf
本发明涉及一种硅基GaN薄膜及其外延生长方法,外延生长方法包括步骤:S1、往反应室中通入三甲基铝和氨气,在目标温度和目标气体流量下对Si衬底进行预处理;S2、在预处理后的所述Si衬底上外延生长AlN成核层;S3、在所述AlN成核层上生长AlGaN缓冲层;S4、在所述AlGaN缓冲层上生长GaN层。该外延生长方法先对Si衬底进行预处理,然后外延生长外延层,预处理会对Si衬底起到保护作用,使得Si衬底的表面更加平整,有利于之后AlN成核层淀积过程中Al原子的迁移,使之更容易到达平衡位置,此时AlN成核层更倾向

N极性GaN基薄膜材料的外延生长及特性研究的开题报告.docx
N极性GaN基薄膜材料的外延生长及特性研究的开题报告一、题目N极性GaN基薄膜材料的外延生长及特性研究二、研究背景氮化镓(GaN)是III族/V族电子化合物半导体材料,由于其热稳定性、宽禁带宽度、高能隙、高电场饱和速度和高载流子浓度等特性,成为研究和应用的热点。GaN材料的外延生长在构建高品质GaN衬底和深蓝绿色LED芯片方面具有重要的意义。在丰富的外延生长技术中,通过调节材料极性实现性能提升,已成为当前发展趋势之一。本项目将围绕N极性GaN基薄膜材料的外延生长及特性展开研究。三、研究内容及目标本项目将采

N极性GaN基薄膜材料的外延生长及特性研究的任务书.docx
N极性GaN基薄膜材料的外延生长及特性研究的任务书一、选题背景和目的宽禁带III-V族氮化物材料由于其具有较高的耐高温、高电压和高功率等特性,在半导体器件领域中具有广泛应用前景。其中,N极性GaN基薄膜材料是一种当前研究热点,其具有优异的电学、光学和力学性能,被广泛应用于LED、高电子迁移率晶体管等领域。但是,由于N极性GaN材料的外延生长和制备过程复杂,其制备性能还需要进一步研究和优化。因此,本文选题旨在研究N极性GaN基薄膜材料的外延生长及其特性,具体包括以下方面:从外延材料生长角度,探究N极性GaN

硅基GaN材料的生长及其优化的开题报告.docx
硅基GaN材料的生长及其优化的开题报告一、选题背景氮化物半导体材料由于其优异的电学、光学和热学性能,在半导体器件中具有广泛的应用。其中,氮化镓(GaN)材料作为一种典型的氮化物半导体材料,在高功率电子器件、深紫外LED、蓝光LED和LD、太阳能电池等领域有广泛的应用。GaN材料有两种生长方法:一种是基于硅衬底的GaN材料。这种方法具有良好的材料质量和较低的成本,因此它得到了长时间的关注。然而,这种方法也存在一些问题,例如硅基衬底材料和GaN之间的晶格匹配度不高等。近年来,另一种方法——基于氮化铝(AlN)

GaN基外延薄膜和异质结构的MOCVD生长和电学特性的开题报告.docx
GaN基外延薄膜和异质结构的MOCVD生长和电学特性的开题报告一、研究背景随着科学技术的发展和需求不断提高,高性能电子器件和光电器件的研究也越来越受到关注。GaN(氮化镓)材料因其优异的物理特性,如较高的硬度、耐腐蚀性、高热稳定性、高崩溃场强、较大的电子迁移率等,被广泛应用于高功率电子器件、深紫外光发射二极管、蓝绿光发射二极管、高温激光二极管和传感器等领域。GaN基外延薄膜和异质结构的制备技术是其应用的关键,而金属有机气相沉积(MOCVD)是一种常用的制备方法。二、研究目的本研究旨在探究GaN基外延薄膜和
