
一种TSV快速填充方法与装置.pdf

音景****ka







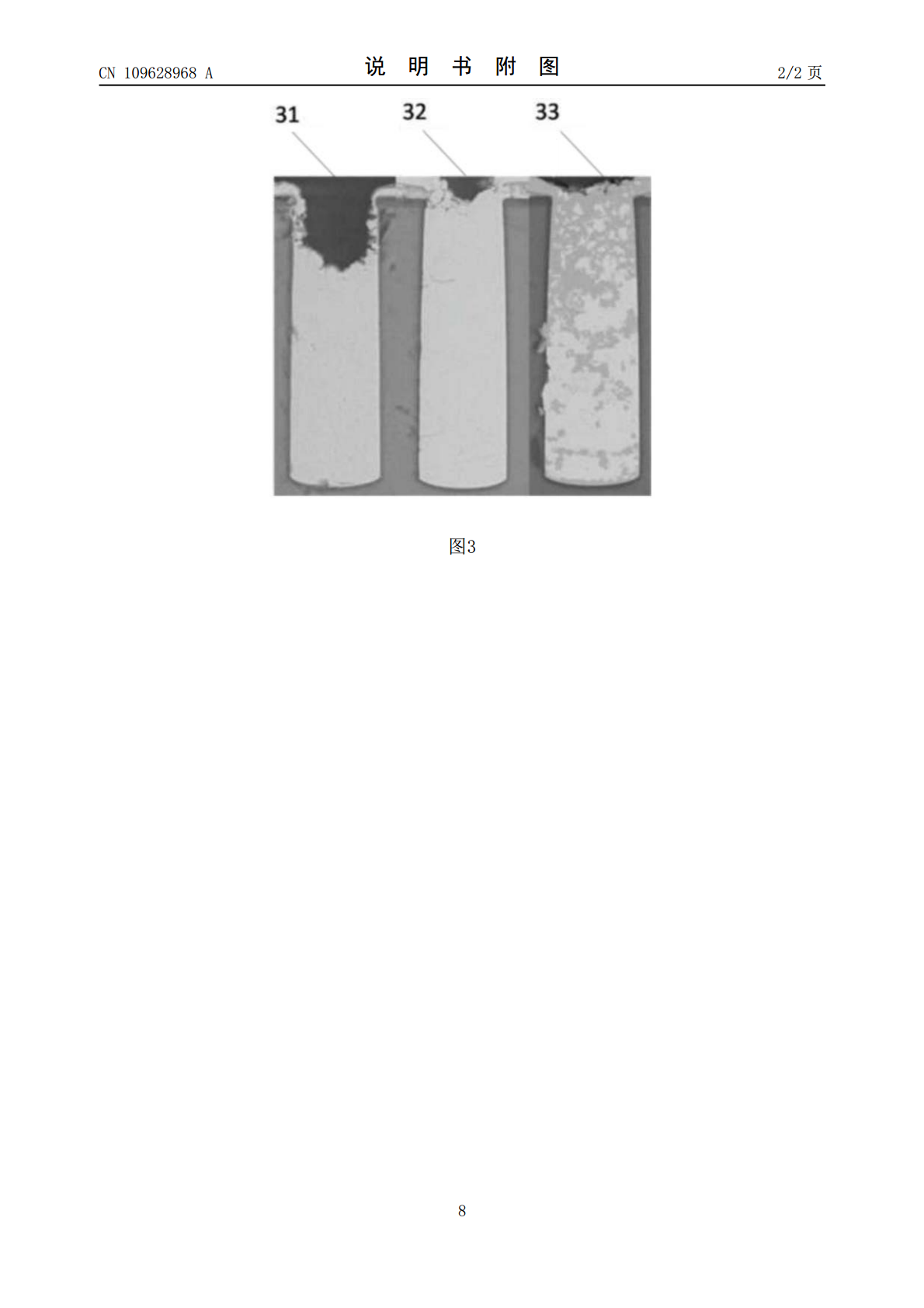
在线预览结束,喜欢就下载吧,查找使用更方便
相关资料

一种TSV快速填充方法与装置.pdf
本发明提供了一种TSV快速填充方法与装置,TSV快速填充方法包括如下步骤:预处理:将含TSV盲孔的硅片保持开口向上在金属纳米粒子悬浮液中放置20小时以上;取出所述硅片,在200‑500℃下加热15‑60min;电镀铜:将加热后的硅片进行电镀铜,至TSV盲孔被完全填充。TSV快速填充装置,包括电镀阳极、电镀阴极、电镀电源、电镀液和超声变幅杆。预处理后TSV孔中预先沉积有金属纳米粒子,再用上述TSV快速填充装置进行电镀铜,加快了铜的沉积速度,提高了生产效率。

一种TSV电镀铜填充效果的测试方法.pdf
一种TSV电镀铜填充效果的测试方法属于材料制备与连接领域。包括步骤1:将化学机械抛光后的TSV晶圆样品切割取样,并将取自晶圆上不同区域的TSV样品置于坩埚中;步骤2:随后将坩埚放入管式炉中,并在管式炉中通入氩气作为保护气体;以10℃/min的升温速度将管式炉中的温度升至后保温;保温过程完成后,关闭管式炉加热装置,保持样品仍然在氩气保护下放置于管式炉的石英管中。打开管式炉保温炉盖,将石英管以及其中的TSV样品进行空气冷却。步骤3:当管式炉中的温度降低至室温后,解除石英管的密封状态,将石英管中的样品取出,在金

一种高效电镀填充硅基TSV的方法.pdf
本发明公开一种高效电镀填充硅基TSV的方法,具体为:在晶圆上刻蚀制备TSV;在刻蚀TSV的晶圆上制备绝缘层;在含有绝缘层的晶圆上制备种子层;接着在晶圆双面贴干膜,单面光刻、显影;去除TSV侧壁端口部位的种子层;在图形化的一面粘贴干膜、另一面光刻显影;再次去除另一端口部位的种子层;再次通过光刻、显影;接着双向同步电镀填充铜,使TSV-Cu与TSV-pad一体成型无分离界面;去除干膜光刻胶、种子层。本发明将TSV通孔电镀填充工艺转化为两个类盲孔电镀填充工艺,TSV结构结合牢固且工艺更为灵活、方便,大大降低了高

一种电镀填充硅基TSV转接板的方法.pdf
本发明公开一种电镀填充硅基TSV转接板的方法,步骤包括:1)制备的带有双面干膜光刻胶的通孔晶圆,在其单面粘贴绝缘膜;2)单面电镀;3)去除步骤1)中的单面绝缘膜;4)将步骤3)中去除单面绝缘膜的一面对应阳极;5)继续填充未被填充的部分;6)去除光刻胶、种子层,制备无暇连接的Cu-TSV与Cu-Pad。通过本发明可以将TSV盲孔填充工艺移植到TSV通孔电镀填充工艺中,大大降低了TSV通孔电镀填充的难度;以更高的效率、更低的成本填充硅基转接板,结合牢固,且制备工艺更为灵活。

一种磁性粉末快速均匀填充的方法和装置.pdf
本发明提供一种磁性粉末快速均匀填充装置和方法,所述磁性粉末快速均匀填充装置包括送料斗、支撑架、线性移动模组和膜腔及磁场提供装置,所述送料斗包括密封端盖、充气气排、料斗固定支架、振料装置、料斗下蝶阀门和所述料斗下蝶阀门的驱动装置,所述送料斗通过所述支撑架与所述线性移动模组连接,所述支撑架与所述送料斗的连接处设置有弹性块,所述线性移动模组包括滑块、驱动装置和保护腔,所述支撑架通过螺栓与所述滑块固定连接,所述磁场提供装置由铁芯线圈组合和线圈电流调节控制电路组成。本发明主要解决了易燃磁性粉末在模腔中填充较慢且不均
